

PCB熔锡不良现象背后的失效机理
描述
样品信息
#1为失效样品,取#1样品中的RG11;#2为非同周期PCB板,取#2样品中的C37。
#1样品

#2样品

分析过程
外观分析

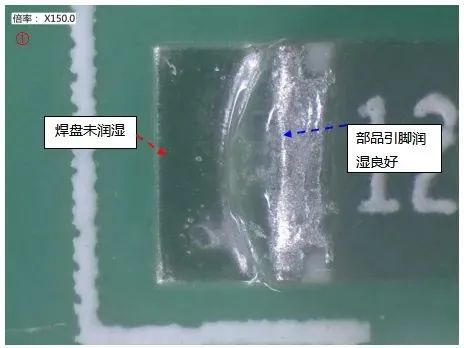
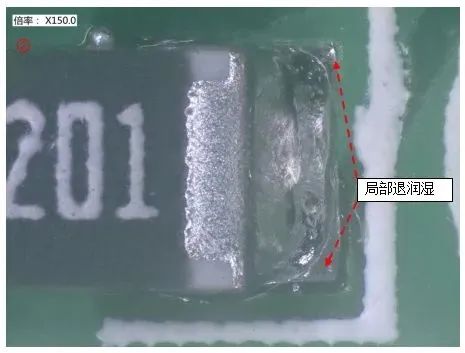
说明:#1样品RG11失效位置呈现无Sn润湿状态或退润湿状态,PAD面平整,有明显助焊剂残留。器件焊端均有明显的Sn润湿。
#1样 SEM分析
对#1失效点进行未润湿点的表征分析,下图为RG11典型PAD的SEM分析:
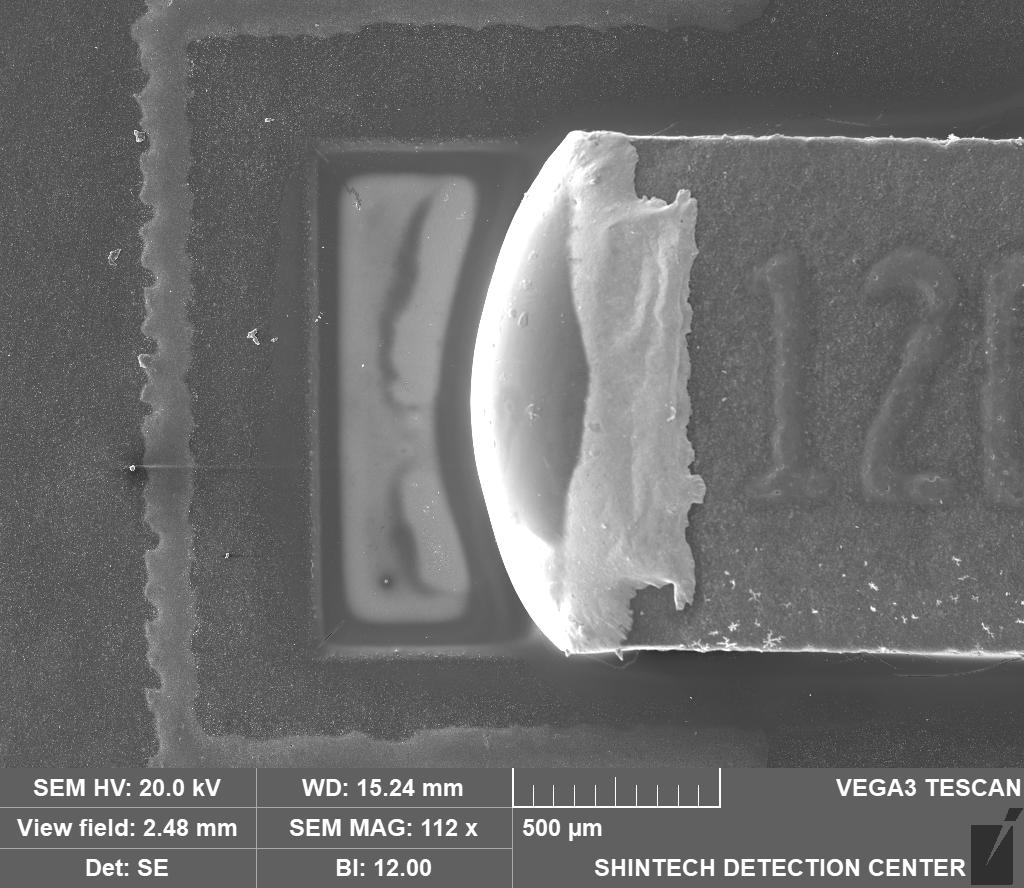

说明:#1样品RG11未润湿PAD,表面平整,且有明显的助焊剂残留。这说明在回流初期,Sn与这个面发生过作用。但由于润湿不良,导致焊锡无附着或退润湿异常。
#1样 EDS分析
对RG11失效PAD进行EDS成分分析如下:
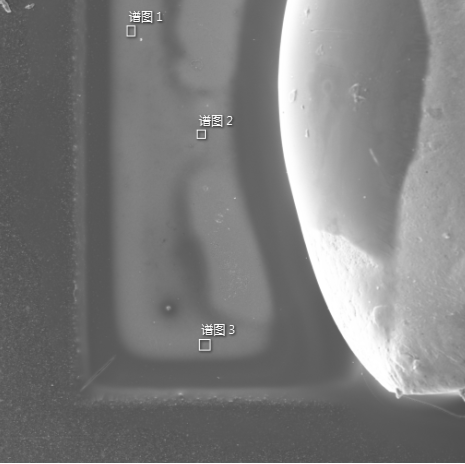



说明: 对失效PAD进行成分分析,未发现异常元素, C元素约占30%(助焊剂主要成分之一)。
#1样 切片分析
取#1样品中的RG11进行切片分析:
断面金相分析

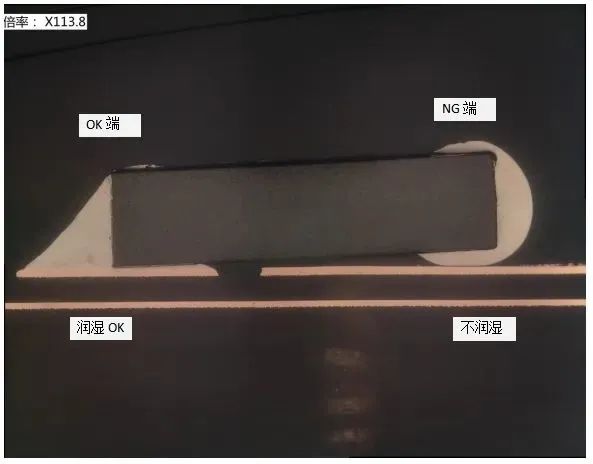
断面SEM分析

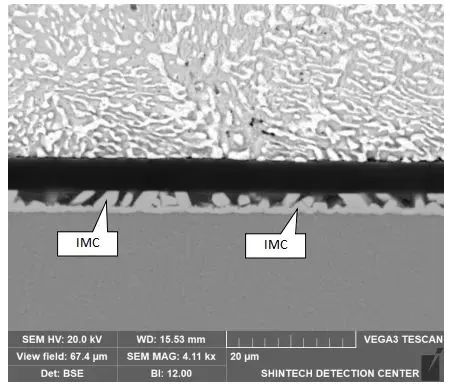
断面EDS分析


IMC厚度测量
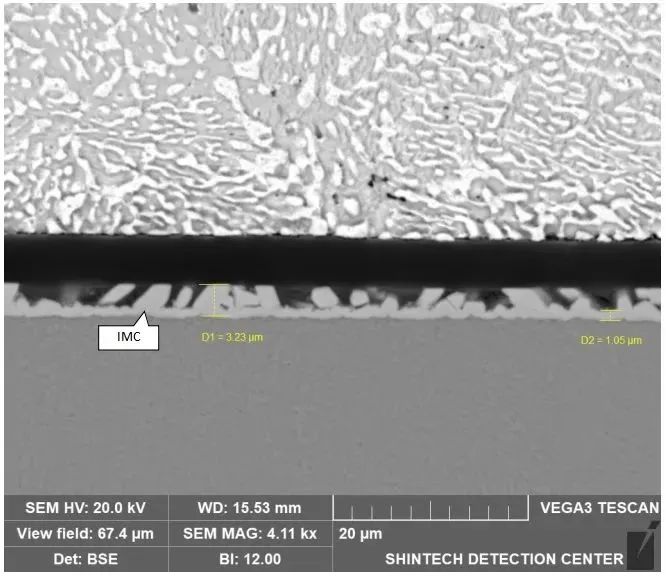
说明:
金相分析:#1样品RG11进行切片金相分析,不润湿点的焊锡主要收缩到器件端子的位置(图示),PCB PAD上不润湿。润湿良好的焊点延伸出来的PAD上有明显焊锡。
SEM&EDS断面分析:
#1样品RG11未润湿PAD表层呈现合金化状态(IMC层裸露),以Cu、Sn组成,整体比例约40:60,说明合金层(IMC)构成为Cu6Sn5 。
#1样品RG11未润湿PAD的IMC厚度最大3.23μm,IMC厚度最小1.05μm。
#2样 镀层厚度分析
针对未回流的PCB测试下记标识点位PAD:
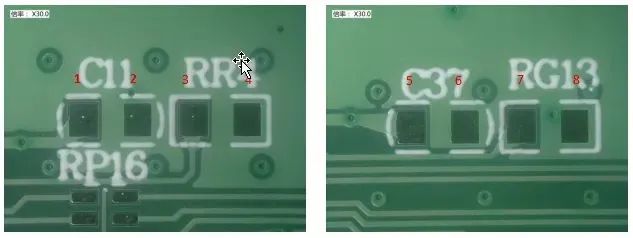
| 序号 | Sn厚度 | Cu厚度 |
| 1 | 9.217 | 16.23 |
| 2 | 5.704 | 15.20 |
| 3 | 6.748 | 13.63 |
| 4 | 7.321 | 19.13 |
| 5 | 1.283 | 12.66 |
| 6 | 1.146 | 12.33 |
| 7 | 1.488 | 12.26 |
| 8 | 1.055 | 12.98 |
注:厚度单位为μm。
说明:通过对#2的镀层分析可见,Cu+Sn(喷锡工艺),Sn的厚度Min1.055μm,Max 9.217μm,平均4.245μm。
#2样 断面分析
取#2样品C37对PAD位置进行切片分析:
断面SEM分析
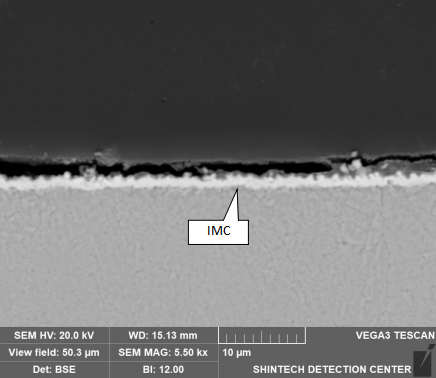
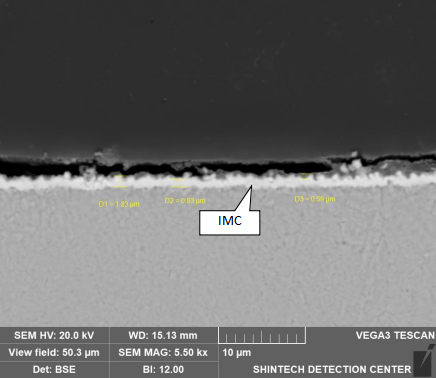
断面EDS分析



说明:对#2样品C37 PAD位置进行断面SEM分析, PAD表层呈现合金化状态(部分位置IMC层裸露),IMC厚度最大1.23μm,IMC厚度最小0.93μm,IMC层的Cu、Sn比例约40:60,说明IMC构成为Cu6Sn5。
分析结果
原因分析
结合上述分析来看,对PCB PAD不润湿的失效分析如下:
1.PCB焊盘的表面处理方式为热风整平(喷锡);
2.失效焊点PAD上无明显Sn(锡膏)附着,未发现异常元素, C元素约占30%(助焊剂主要成分之一);
3.断面分析表明未润湿位置具有典型特征:表面合金化,即IMC层裸露。通过元素分析,IMC层的Cu、Sn比例约40:60,说明IMC构成为Cu6Sn5。
4.PCB的镀层分析Sn的厚度Min1.055μm,Max9.217μm,平均4.245μm。#2样品C37对PAD位置进行断面SEM分析, PAD表层呈现合金化状态。
失效机理解析
PCB表面Sn镀层厚度不均匀,导致局部位置焊盘表面的镀层合金化,即IMC层(Cu6Sn5)裸露。由于IMC含有大量的Cu,其熔点远高于锡焊料,从而造成焊盘表面可焊性降低,回流焊接时易发生焊盘不润湿,焊锡爬至器件焊端的现象。
典型失效图示:
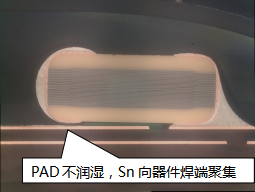
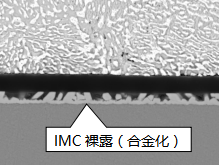
注:锡厚度不均匀导致的镀层合金化是热风整平(喷锡)工艺PCB常见的失效模式。
审核编辑:汤梓红
-
多圈电位器接触不良现象会造成什么难题_原因是什么2020-07-01 2814
-
PCB设计中的常见不良现象分析2019-04-20 9811
-
PCBA加工焊接的不良现象有哪些?原因分析2019-10-09 11099
-
因线路板通孔问题会对波峰焊接造成哪些不良现象2020-04-08 5477
-
SMT代工中OEM常见的不良现象有哪些?如何进行避免?2020-06-19 4272
-
PCB失效或不良的准确原因和机理资料下载2021-04-20 1257
-
PCBA样品焊盘的可焊性不良现象分析2021-10-20 4417
-
PCB熔锡不良失效分析2022-08-10 3400
-
PCB熔锡不良现象背后的失效机理2022-11-21 1861
-
smt贴片焊接不良的现象有哪些?2023-05-25 3329
-
PCBA加工中都会遇到哪些常见的不良现象?2023-08-22 2077
-
pcb板有哪些不良现象?pcb常见不良原因及分析2023-08-29 6826
-
保护器件过电应力失效机理和失效现象浅析2023-12-14 2286
-
SMT焊接中常见的不良现象有哪些?2024-03-30 2121
-
SMT贴片常见不良现象分析汇总2024-06-06 2310
全部0条评论

快来发表一下你的评论吧 !

