

请问一下在芯片制造中如何测薄膜的厚度呢?
EDA/IC设计
描述
在半导体制造业中,薄膜的厚度对器件的性能和质量有重要影响。薄膜的厚度决定了许多重要的物理和化学性质,对其折射、反射和透射的光学性质有直接影响,可以导致显著的量子尺寸效应,从而改变材料的电子、光学和磁性等。
准确测量和控制薄膜厚度对于优化器件性能、提高生产效率、确保器件可靠性等都具有重要的作用。
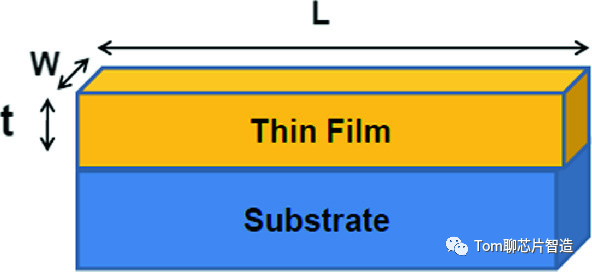
四探针法 四探针法(Four-point probe method),又可以被称作四点共线探针法,是一种用于测量薄膜方块电阻率的技术。四点共线探针技术是将四个等距的探针与未知电阻的材料接触。安装在探头中的探针被轻轻地放置在晶圆的中心,两个外部探针用于提供电流。两个内部探针用于测量样品表面产生的电压降。
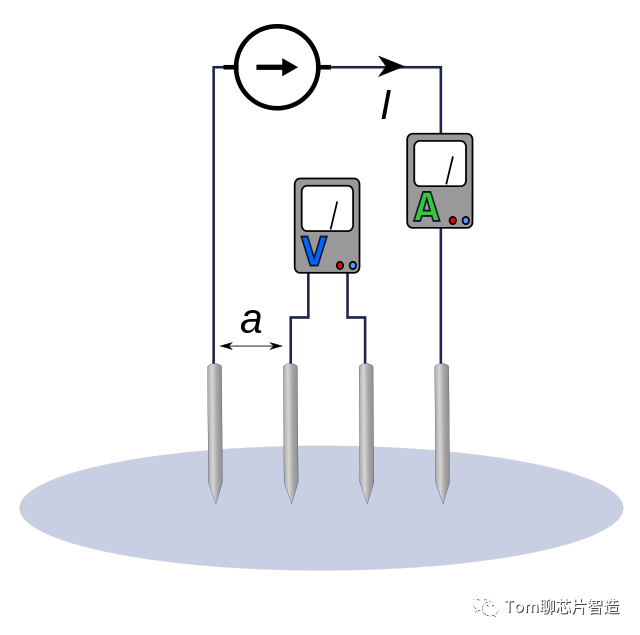
得到薄膜的方块电阻率后,通过公式反推,就可以得到薄膜厚度t,

ρ = 体积电阻率 (Ω-cm) V = 测量的电压(V) I = 测量的电流(I) t = 样品厚度 (cm) k = 校正因子 作用:测量不透明导电膜的厚度 椭偏仪 椭偏仪(Ellipsometry)是一种非接触、非破坏性的光学测量技术,它通过测量偏振光在被测物体表面反射后偏振状态的变化,从而推断出待测物质的性质。
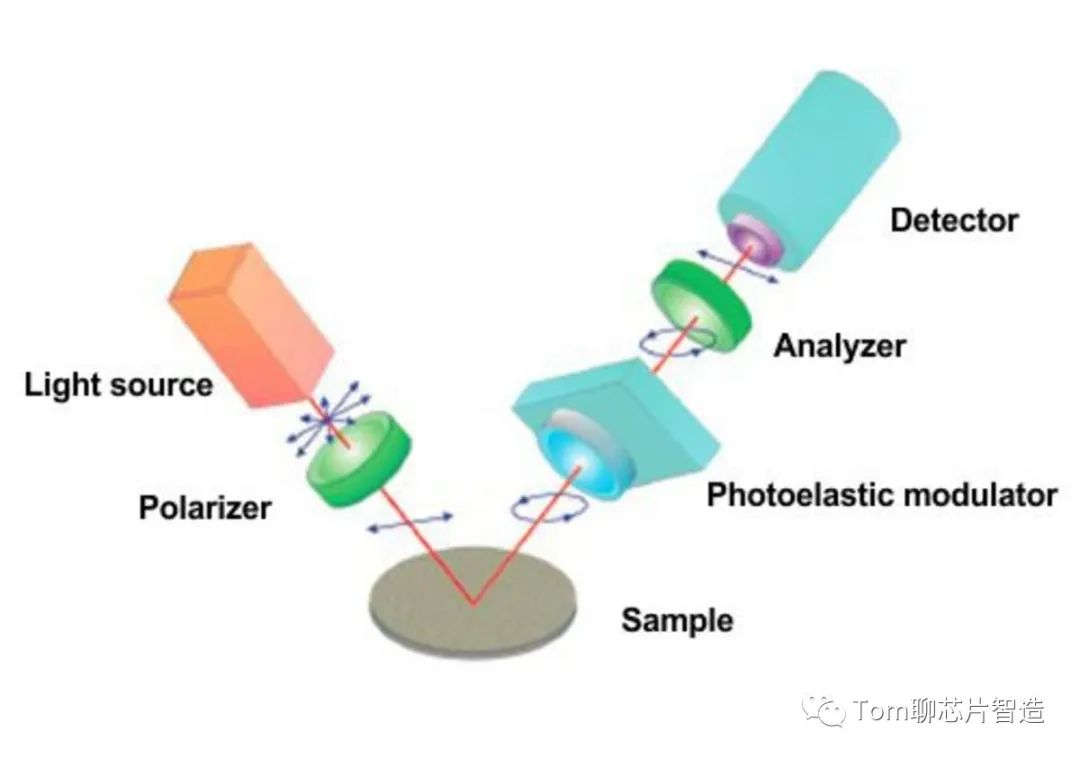
椭圆偏振仪通常由三部分组成:
光源:提供单色的线性偏振光。激光或者单色灯可用作光源。
分析器:在光线经过样品反射后,分析器用于测量反射光的偏振状态。通常是一个偏振片或者一种能够测量光的偏振状态的装置。
探测器:记录从分析器传来的光强度信息。
当线性偏振光照射到被测物体表面时,由于物体表面的光学性质(如折射指数和消光系数),反射光的偏振状态会从线性偏振变为椭圆偏振。
通过测量并比较反射光和入射光的光强度,通过对测量结果的解析,可以推断出薄膜的厚度和光学常数。
作用:测量透明薄膜与50nm以下的金属薄膜 X射线荧光光谱法
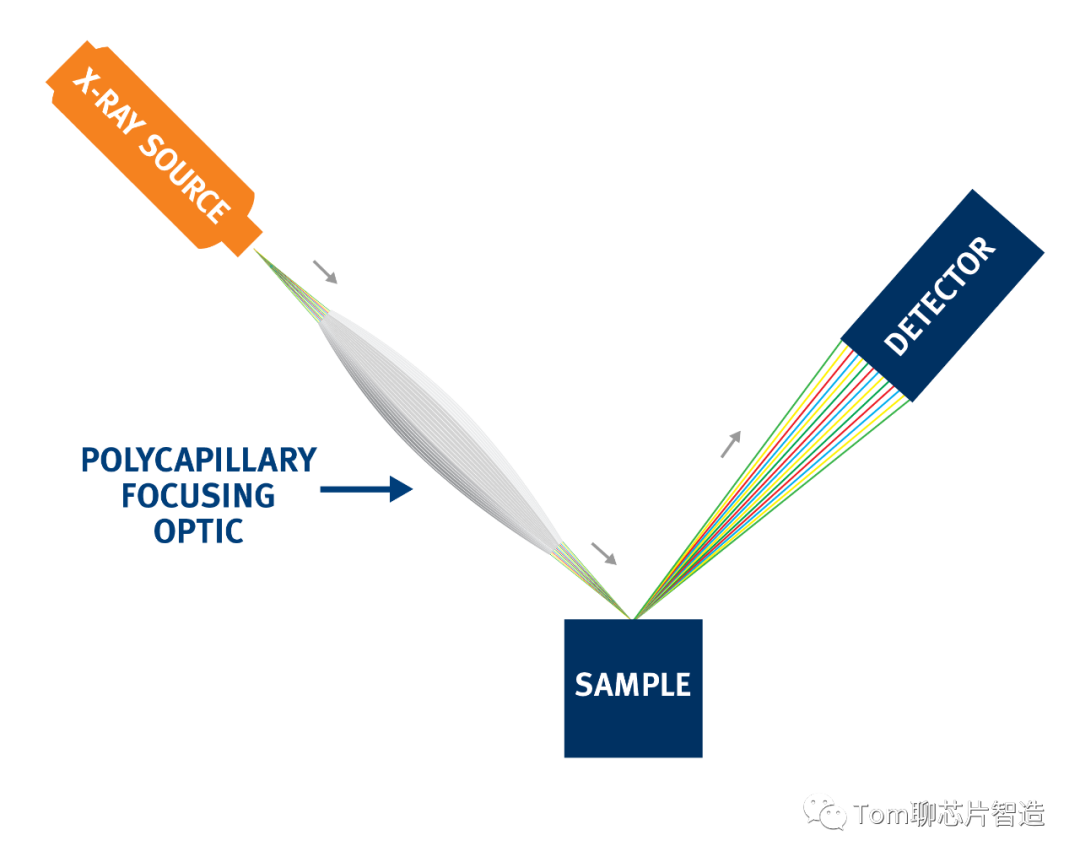
X射线荧光光谱法(XRF)是一种用于元素分析的无损检测技术,它能测量从硼(元素周期表上的第5个元素)到铀(第92个元素)的几乎所有元素。
XRF 分析仪通过测量样品被初级 X 射线源激发时发出的荧光X 射线来确定样品的化学成分。
样品中存在的每种元素都会产生一组对该特定元素来说是唯一的特征荧光 X 射线,通过比对 XRF 光谱,可以用于材料成分定性和定量分析。

作用:可识别合金、检测杂质元素,分析贵金属并确定膜层重量和膜层厚度。
审核编辑:刘清
-
芯片制造中薄膜厚度量测的重要性2025-02-26 3368
-
请问一下在Windows下怎么实现PC机与单片机AT89C51的串行通信?2021-05-28 2361
-
请问一下在SMPS设计中可以使用回馈产生器替代光耦合器吗?2021-06-10 1827
-
请问一下芯片制造究竟有多难?2021-06-18 3261
-
请问一下在使用stm32 rtc的时候到底是选用LSI还是LSE?2021-09-23 1966
-
请问一下在POE网络变压器中常用的POE电流路径是什么?2021-10-12 1729
-
请问一下在windows系统中不能使用ping命令应该如何解决?2021-10-25 1470
-
请问一下在AVR中PIN的含义是什么?2021-10-29 2193
-
请问一下在FreeRTOS系统下的LwIP-1.4.1是怎样移植的2021-11-03 2175
-
请问一下在Ubuntu上怎样去编译Linux固件呢2022-03-09 2040
-
请问一下在瑞萨电子MPU中DRP的运行效率如何?2022-09-26 2808
-
请问一下在RT-Thread studio上怎样去添加ADC+DMA呢?2022-10-11 2833
-
请问一下在电动机中电刷有什么作用呢?2023-03-10 1251
-
MEMS制造中精确测量薄膜厚度的方法研究与比较_陈莉2017-03-19 961
-
了解一下“薄膜厚度监控”2023-07-20 1639
全部0条评论

快来发表一下你的评论吧 !

