

可持续湿法工艺解决方案
电子说
描述
来源:《半导体芯科技》杂志
绿色目标。黄色解决方案。
凭借二十年在批量喷涂及其硬件方面的经验,Siconnex已成长为可持续湿法工艺设备的领先供应商。可持续发展和环境健康是我们的基因。BATCHSPRAY®技术在整个芯片制造周期中提供能源、介质材料和用水全面节约的工艺。”
半导体的生产消耗大量资源。通过采用可持续的产品和工艺,半导体行业可以减轻对环境的影响,并努力实现更加可持续的未来。Siconnex公司多年来一直致力于高效和节约资源的解决方案,其BATCHSPRAY®批量喷涂技术处于行业领先地位。
在公司自身使命宣言和客户的可持续发展目标的推动下,Siconnex不断增强其在可持续工艺流程方面的专业知识。其中一项进步是用于刻蚀后残留物清洁(Post Etch Residue Clean)的perc™工艺,它代表了我们最新的可持续产品。
1大挑战:聚合物去除
“我对perc™的经验是,在将晶圆送入多个干法刻蚀步骤后,我们成功找到了去除所有聚合物并实现更好的侧壁粗糙度的方法。在进行电气检查后,我们甚至发现与现有工艺相比,性能有所提高。我衷心感谢与Siconnex的出色合作和协作,为新工艺流程和现有流程寻找解决方案。”意法半导体公司的Julien Ladroue博士的陈述强调了在解决聚合物去除挑战和提高芯片生产性能方面perc™的成功实施。在器件缩放困难以及使用溶剂型工艺去除聚合物相关的困难背景下,perc™提供了一种无需额外溶剂介质的解决方案。
△图1:干法刻蚀工艺后(左)和perc™工艺后(右)对比。

△图2:等离子切割后清洁去除聚合物。
perc™是Siconnex的工艺创新,专为刻蚀后残留物清洁而设计。这种创新应用可以通过调整工艺配方来去除多种类型的聚合物。Siconnex独特的喷注技术可确保DIW(去离子水)流中仅需要一定量的酸,从而显著减少了酸流量。
除了去除聚合物之外,perc™工艺还能够控制配方内的金属损失。这带来了许多优点,包括保证聚合物去除、减少金属损失、大幅减少化学品消耗和水的使用、有效的废物处理及其他好处。
总体而言,perc™代表了芯片生产的重大进步,为聚合物去除提供了可持续且高效的解决方案,并有助于实现更加可持续和更具成本效益的工艺的总体目标。
2等离子切割后清洁
用于晶圆切割(wafer dicing)的等离子刻蚀是一种日益重要的干法刻蚀工艺,未来将对行业产生越来越大的影响。与机械切割或激光切割相比,这种方法在切割平面上节省大量的空间,同时还可以最大限度地减少残留物。
然而,等离子刻蚀切割(plasma etch dicing)也存在一些挑战。较厚的顶部光刻胶在处理后变得更加难以去除,并且由于晶圆已经被切割,所以侧壁聚合物的去除变得更加复杂。
为了应对这些挑战,Siconnex开发了一种称为“切割后清洁”(Post Dicing Clean)的工艺,该工艺可在单个工艺步骤中有效去除聚合物、光刻胶和残留物。通过处理放置和固定切割晶圆的整个框架和胶带,切割后清洁可有效去除侧壁上的聚合物。
此外,经过等离子体处理的光刻胶可以轻松去除,并且可以清除表面的残留物。
切割后清洁工艺有效地克服了等离子切割相关的缺点,提供了可持续且环保的解决方案。自从Siconnex最初为全自动300毫米晶圆厂提供系统以来,用于处理这些框架的技术已经运行了好几年。

△图3:300mm晶圆批量处理的一致性。
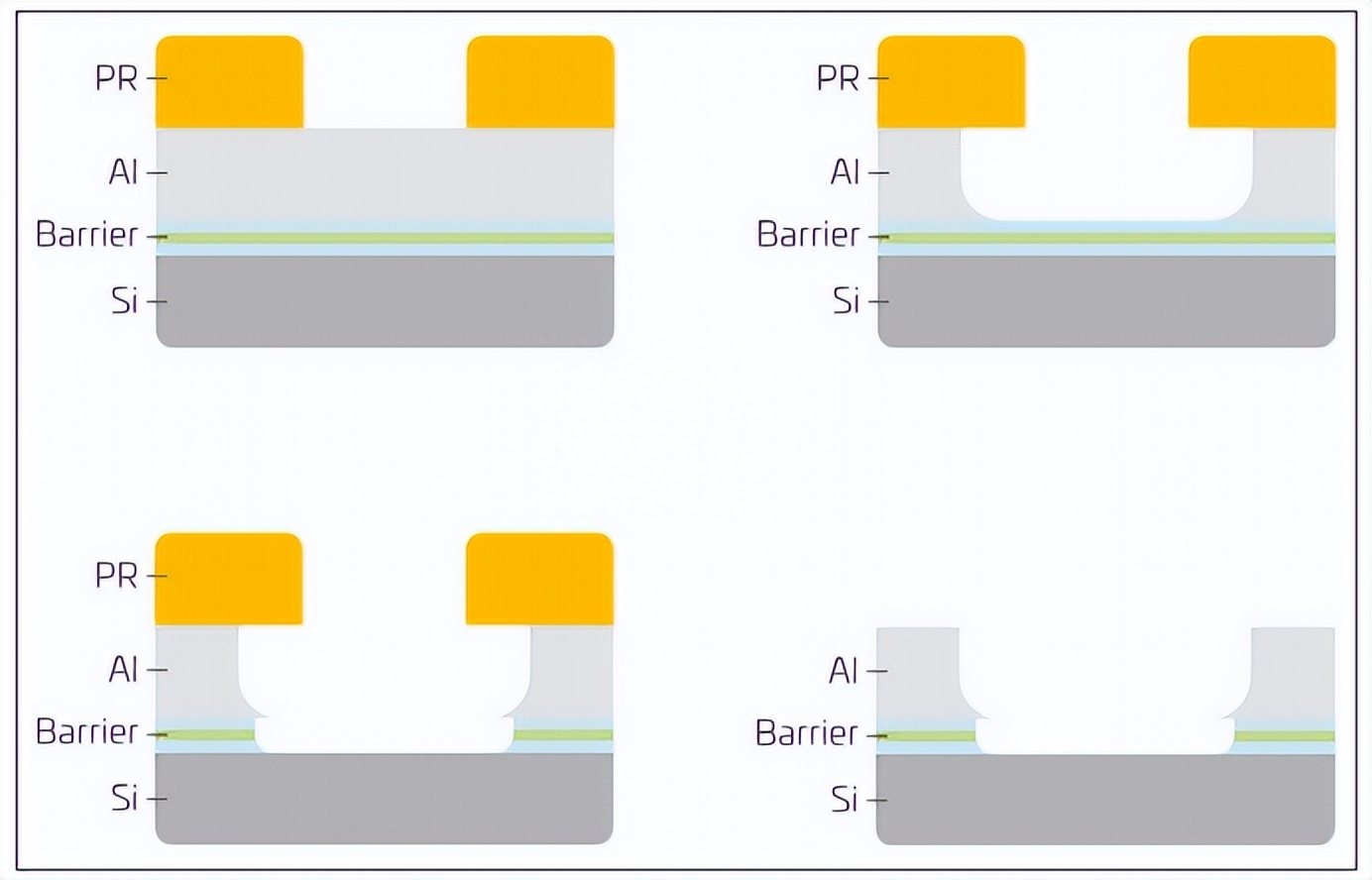
△图4:铝刻蚀、阻挡层刻蚀和光刻胶剥离的工艺流程示例。
3卓越的300毫米晶圆工艺
在批量喷涂系统中执行的湿法刻蚀和清洁工艺长期以来一直是200毫米晶圆厂的关键。然而,适用于200毫米的方法可能不适用于300毫米的假设是不正确的。300毫米晶圆工艺所获得的结果与200毫米晶圆工艺所获得的结果相同。
4percTM工艺的优点
金属损失:
•铝-铜:<20Å
•氮化钛:<15Å
•氧化硅无损失
每个腔室的吞吐量:
•136wph
•处理时间:21分钟
化学品消耗量:
•DIW:110升
•H2SO4:100ml
•H2O2:700ml
•HF:70ml
优点:
•可针对每种聚合物进行调节
•灵活的参数调整
•极低的化学品使用量
•使用点介质使用
•稳定的介质浓度
•开放的工艺处理时间
•一次性介质
•避免再污染
•高产量
•不需要额外溶剂
•废物处理简单
•提供4个腔室系统
•25W/50W腔体
•可用于2英寸-12英寸晶圆
在湿式工作台或单晶圆工具中进行的传统湿法工艺已使用多年,但在晶圆内均匀性、晶圆间均匀性、批次间均匀性、清洁度和可持续执行方面没有提供领先的结果。
Siconnex的BATCHSPRAY®设备可以显著提高所有这些方面性能,并满足更多规格。可以在单个系统中执行多个流程,从而无需使用多个工具。对于复杂的工艺顺序,例如AlSiCu刻蚀,然后进行雀斑刻蚀以去除所有剩余的硅晶粒,然后进行阻挡层刻蚀以刻蚀Ti、TiN、TiW和W等材料,以及随后的光刻胶剥离,所有这些都可以在一个系统中完成。此外,甚至连干法刻蚀工艺(如前面提到的阻挡层刻蚀)也可以被替代并可持续执行。
Siconnex凭借其全自动BATCHSPRAY®系统,为湿法工艺提供了领先的结果,使其成为300mm晶圆领域的理想匹配。Siconnex为可持续的300mm晶圆制造提供完整的硬件和工艺平台。通过开发新的可持续工艺和提供湿法工艺的尖端成果,Siconnex的安装量实现了快速增长。
Siconnex在半导体制造的前沿领域专注于可持续发展和持续创新。perc™工艺解决了聚合物去除的挑战,而“切割后清洁”工艺则解决了等离子刻蚀的复杂性。BATCHSPRAY®技术为300毫米晶圆厂的湿法工艺提供了卓越的结果,提高了均匀性、清洁度和可持续性。Siconnex会继续致力于开发新的、可持续的工艺,为该行业创造更加可持续和高效的未来。
审核编辑 黄宇
-
半导体湿法腐蚀设备2016-09-06 14675
-
湿法蚀刻问题2017-05-08 7551
-
湿法蚀刻工艺2021-01-08 4900
-
纳米磁性薄膜材料的湿法工艺2010-02-07 936
-
湿法贴膜技术在HDI细线路制作工艺中的应用(四)2006-04-16 1937
-
创新的Helieon可持续照明解决方案2011-01-21 752
-
风力涡轮机可持续的能源解决方案2020-09-28 3331
-
湿法蚀刻工艺的原理2022-07-27 4144
-
湿法刻蚀工艺的流程包括哪些?2023-02-10 7871
-
半导体工艺里的湿法化学腐蚀2023-08-30 6488
-
芯片湿法蚀刻工艺2024-12-27 2081
-
一文详解湿法刻蚀工艺2025-05-28 6635
-
湿法蚀刻工艺与显示检测技术的协同创新2025-08-11 1714
-
革新半导体清洗工艺:RCA湿法设备助力高良率芯片制造2025-12-24 986
-
小型Fab厂,适合选择哪种性价比高的湿法清洗解决方案2026-02-24 350
全部0条评论

快来发表一下你的评论吧 !

