

先进制程芯片分析能力介绍-微区分析技术TEM
描述
透射电子显微镜(Transmission Electron Microscope,简称TEM),是一种以电子束为光源的基于电子显微学的微观物理结构分析技术,分辨率最高可以达到0.1nm左右。TEM技术的出现,大大提高了人类肉眼观察显微结构的极限,是半导体领域必不可少的显微观察设备,也是半导体领域工艺研发、量产工艺监控、工艺异常分析等不可缺少的设备。
TEM在半导体领域具有非常广泛的用途,如晶圆制造工艺分析、芯片失效分析、芯片逆向分析、镀膜及刻蚀等半导体工艺分析等等,客户群体遍布晶圆厂、封装厂、芯片设计公司、半导体设备研发、材料研发、高校科研院所等。
TEM技术团队能力介绍
广电计量的TEM技术团队由陈振博士牵头,团队技术骨干的相关行业经验均在5年以上,不仅具有丰富的TEM结果解析经验,还具有丰富的FIB制样经验,具备7nm及以上先进制程晶圆的分析能力及各种半导体器件关键结构的解析能力,目前服务的客户遍布国内一线的晶圆厂、封装厂、芯片设计公司、高校科研院所等,并受到客户广泛的认可。
设备能力介绍

TEM设备
TEM型号:Talos F200X 参数
电子枪:X-FEG
200Kv时亮度1.8*109 [A/cm2/Sr]
EDS探头型号:Super-X
HRTEM信息分辨率:0.12 nm
HRSTEM分辨率:0.16 nm

TEM样品制备设备DB FIB
DB FIB型号:Helios 5 CX 参数
离子源:液态镓离子源
EDS探头型号/有效活区面积:Ultim Max65/65mm2
离子束分辨率:2.5 nm@30Kv
电子束分辨率:1.0 nm@1.0 Kv,0.6nm@15Kv
TEM服务项目介绍
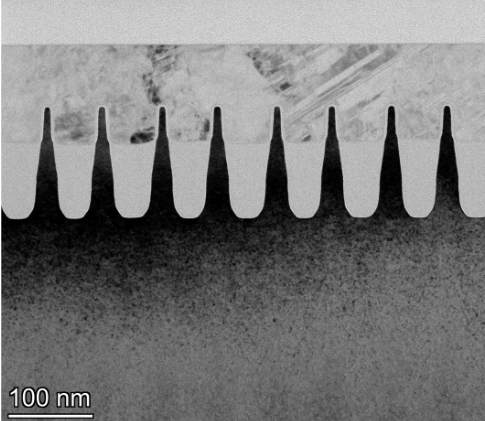
服务项目 | 服务内容 | 面向客户 |
晶圆制造 工艺分析 | 1、7nm及以上制程芯片晶圆制造工艺分析 2、MOSFET制造工艺分析 3、存储芯片制造工艺分析 | 晶圆厂 |
芯片失效分析 | 1、 芯片失效点位置分析,包含漏电、短路、烧毁、异物等异常失效点位的平面制样分析、截面制样分析以及 平面转截面分析。包含形貌观察、尺寸量测、成分分析。可精准到1.0 nm以内。 2、 芯片制造工艺缺陷分析,包含形貌观察、尺寸量测、成分分析,可精准到1.0 nm以内。 | 芯片设计 公司 |
芯片逆向分析 | 芯片关键工艺结构剖析,包含尺寸量测、成分分析等。 | 芯片设计 公司 |
半导体器件 失效分析 | MOSFET、VCSEL等半导体器件失效点位置分析,包含形貌观察、尺寸量测、成分分析,可精准到1.0 nm以内。 | 半导体器件设计公司 |
芯片及半导体器件封装工艺分析 | 封装工艺异常分析,如TSV孔、Via孔、RDL布线层异常分析。 | 封装厂 |
半导体 工艺分析 | 刻蚀工艺、镀膜工艺等半导体工艺分析 | 刻蚀设备商、镀膜设备商等半导体设备研发制造商 |
材料分析 | 材料成分分析、晶型分析、晶格缺陷分析、原子级高分辨分析等 | 高校、科研院所、材料研发企业 |
关于陈振博士

陈振 无锡广电计量副总经理
复旦大学材料物理专业博士,上海市“科技创新行动计划”技术平台负责人,无锡市发展改革研究中心决策咨询专家,南京大学和西安电子科技大学硕士研究生兼职导师,上海“菊园工匠”、“嘉定技术能手”,负责的先进制程芯片检测项目入选“上海市十大检验检测创新案例”。
曾参与国家重点研发计划项目2项,国家自然基金面上项目3项,国外高水平期刊发表SCI论文8篇,申请发明专利1项,出版光电传感器英文论著1部。
-
半导体芯片结构分析2024-01-02 8881
-
芯片失效分析简单介绍2012-09-20 13177
-
微流控分析芯片2018-06-22 2489
-
穿透式电子显微镜TEM2018-08-21 2897
-
555芯片等效图各功能区分析2021-02-25 7910
-
台积电先进制程芯片最新消息2021-02-22 3067
-
从代工厂看先进制程2022-01-27 1477
-
何谓先进封装/Chiplet?先进封装/Chiplet的意义2023-01-31 5701
-
先进制程芯片的“三大拦路虎” 先进制程芯片设计成功的关键2023-08-08 3104
-
芯片先进制程之争:2nm战况激烈,1.8/1.4nm苗头显露2024-01-04 2145
-
LED的TEM分析2024-11-15 1168
-
台积电美国芯片量产!台湾对先进制程放行?2025-01-14 1288
-
透射电子显微镜(TEM)与聚焦离子束技术(FIB)在材料分析中的应用2025-05-09 1254
-
湿法清洗和干法清洗,哪种工艺更适合先进制程的硅片2026-02-25 467
-
浅谈铝制程芯片去层核心分析方法2026-03-03 770
全部0条评论

快来发表一下你的评论吧 !

