

陶瓷散热基板投资图谱
电子说
描述
说来惭愧,陶瓷散热基板是最近才关注的领域,以前知道有市场需求和产业前景,但是因为半导体产业链过于复杂,心有余而力不足,加上陶瓷封装又属于芯片封装的小众领域,所有有意识地把这个细分品类给忽略掉了,归到了新材料的范畴当中。
最近因为机缘巧合,接连接触了几个相关项目,所以重点关注了这个门类的未来市场前景,抽时间整理了一下(公开信息整理,如有遗漏,请联系riseen)。
陶瓷散热基板中的“陶瓷”,并非我们通常认知中的陶瓷,属于电子陶瓷材料,主要用于陶瓷封装壳体和陶瓷基板,主要成分包括氮化铝(AlN)、氮化硅(Si3N4)、碳化硅(SiC)、氧化铍(BeO)等。与传统的陶瓷有个共性,主要化学成分都是硅、铝、氧三种元素。
为什么芯片封装中需要用到陶瓷散热基板,价值还是体现在陶瓷的“散热”性能上,主要把芯片工作中产生的热量及时从芯片体内导出,防止热量聚集,所以主要用于功率芯片、半导体照明、激光与光通信、汽车电子等领域。
本文力求通过6个要点,展示出整个行业的全貌:
1)陶瓷散热基板投资图谱

2)陶瓷散热基板投资逻辑
陶瓷散热基板属于芯片封装基板中的小众领域,大头主要还是有机基板,各种树脂材料为主(环氧树脂,聚苯醚树脂,聚酰亚胺树脂),量大、适用范围广,也是之前资本市场关注重点。
陶瓷散热基板虽然小众,但是针对的是高发热量的芯片,高发热量对应的是高功率,高功率对应的是高算力和高压、大电流,如果你认同高算力芯片的未来,高功率电子电力芯片的未来,以及汽车电子芯片的前景,那么这就是陶瓷散热基板的基本投资逻辑。
3)关注那些技术指标
三个重要的技术指标:热导率、热膨胀系数、抗弯强度,决定了不同的陶瓷散热材料的应用场景和未来前景。
热导率,单位W/(mk),主要就是衡量散热性能的,热导率越高,热量越容易散发,氮化铝热导率在200W/(m·K)左右,氮化硅热导率在100W/(m·K)左右。
热膨胀系数,热胀冷缩,单位温度变化所导致的长度量值的变化,陶瓷散热基板的热膨胀系数最好与芯片的热膨胀系数相匹配的,可以防止高温下出现错位和裂痕。
抗弯强度,指材料抵抗弯曲不断裂的能力,主要用于考察陶瓷等脆性材料的强度,体现的是机械强度。
4)为什么重点关注氮化铝(AlN)、氮化硅(Si3N4)
常用电子级陶瓷散热基板材料包括氧化铝(Al2O3)、碳化硅(SiC)、氧化铍(BeO)、氮化铝(AlN)、氮化硅(Si3N4)等,各自有不同的特性和应用场景,本文主要关注氮化铝(AlN)、氮化硅(Si3N4)。
综合各种材料的特性看,首先氧化铝(Al2O3)虽然工艺最成熟,价格低,但是存在热导率较低、热膨胀系数与Si不太匹配等劣势,限制了应用;碳化硅(SiC)热导率很高,但需要单晶状态,制备难,成本高;氧化铍(BeO)的热导率会随着温度升高大幅下降,而且有剧毒,并不适合大规模推广。
所以未来比较看好的还是氮化铝(AlN)、氮化硅(Si3N4),这二者综合性能突出,氮化铝(AlN)陶瓷散热基板热导率较高,热膨胀系数与Si、SiC和GaAs等半导体材料相匹配。而氮化硅(Si3N4)性能更为全面性,抗弯强度高(大于800MPa),耐磨性好,在机械性能要求较高的场景,比如汽车电子领域,更为适用。
5)陶瓷覆铜载板的技术路线(DBC、AMB、DPC)
陶瓷覆铜载板,将铜箔与陶瓷基板耦合,在通过刻蚀的形式,去除掉多余铜箔,将电路图印刷到载板上,形成有电路的陶瓷覆铜载板。主要技术路线有三种:
DBC( Direct Bonding Copper),通过热熔式粘合法,在高温下将铜箔直接烧结到Al2O3和AlN陶瓷表面而制成复合基板。
AMB( Active Metal Brazing),是陶瓷与含有活性元素Ti、Zr 的Ag、Cu焊料在高温下进行化学反应实现铜瓷结合。
DPC( Direct Plating Copper),采用溅镀工艺于基板表面复合金属层,并以电镀和光刻工艺形成电路。
6)一张图展示陶瓷封装
这部分不再赘述,一张图直观展示,陶瓷覆铜载板在IGBT封装中的位置。
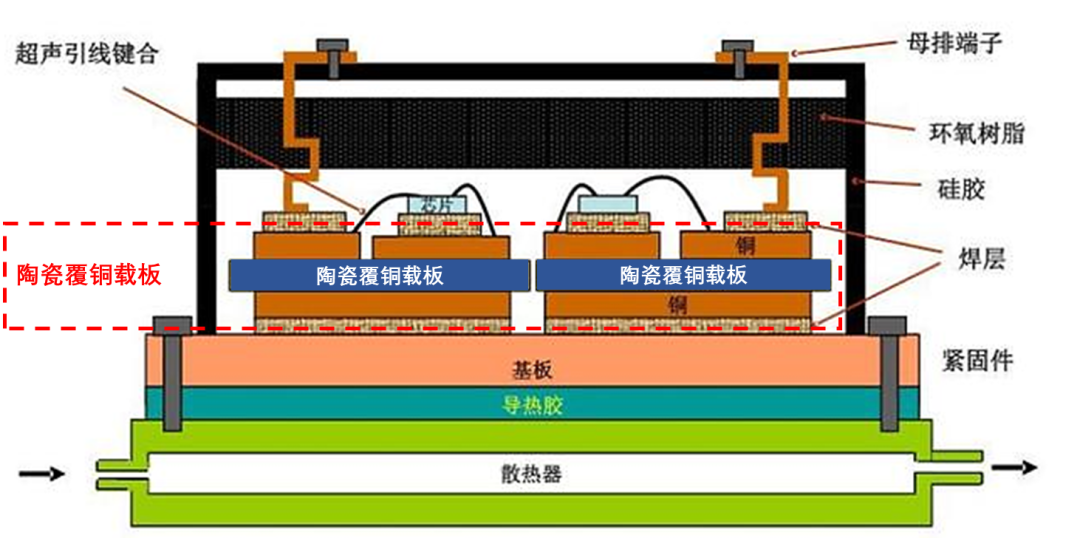
-
陶瓷基板成品检验efans_64070792 2026-03-17
-
热压烧结氮化硅陶瓷逆变器散热基板2025-08-03 1748
-
氮化硅陶瓷逆变器散热基板:性能、对比与制造2025-07-25 2182
-
DOH技术工艺方案解决陶瓷基板DBC散热挑战问题2025-03-01 2632
-
高导热陶瓷基板,提升性能必备2024-07-23 1357
-
什么是DPC陶瓷基板?DPC陶瓷基板有哪些特点?2023-12-07 3745
-
氮化铝陶瓷基板的导热性能在电子散热中的应用2023-06-19 2430
-
为什么要选择陶瓷基板作为封装材料?2021-04-19 2351
-
先进陶瓷材料应用——氧化铝陶瓷基板2021-03-29 1665
-
为什么你需要一块DPC陶瓷基板2021-01-18 1325
-
PCB陶瓷基板的发展前景分析2020-10-23 2058
-
陶瓷基板与铝基板的比较2017-09-14 6292
-
在IGBT模块中氮化铝陶瓷基板的应用如何?2017-09-12 8384
-
散热基板之厚膜与薄膜制程差异分析2012-02-21 3062
全部0条评论

快来发表一下你的评论吧 !

