

面对台积电打出的“CoWoS封装”牌,大陆厂商是否有一战之力?
电子说
描述
今年6月中旬,台积电的股东常会上,证实这样一则消息:近期AI订单需求突然增加,先进封装需求远大于现有产能,公司被迫紧急增加产能。台积电董事长刘德音指出,台积电今年CoWoS产能已经较去年实现倍增,且明年将在今年的基础上再度倍增。
不过在台积电对先进封装的加码之下,CoWoS封装产能依旧紧缺。8月9日,据中国台湾媒体报道,一官员表示英伟达等国际大厂的GPU、AI系统交由广达或是纬创等台厂接单,须视台积电提供的芯片产能,若台积电CoWoS先进封装测试产能不够,将冲击供应链厂商接单。但该官员还称:“台积电芯片的制造能力不是问题,但封装产能须跟上脚步,台积电打电话向她反映,在竹南、龙潭的CoWoS封装技术产能跟不上客户需求。”
CoWoS产能报警外加台积电大力布局之下,也引发了人们对于该技术的思考。CoWoS技术,究竟有何种魅力?
01. 什么是CoWoS?
CoWoS,是Chip on Wafer on Substrate的简称。这一长串名词可以分为CoW与WoS。CoW,将芯片(有源硅芯片)堆叠在中介层(无源硅片)上,WoS则是将中介层再堆叠在基板上,三层堆叠最终形成立体封装形式。
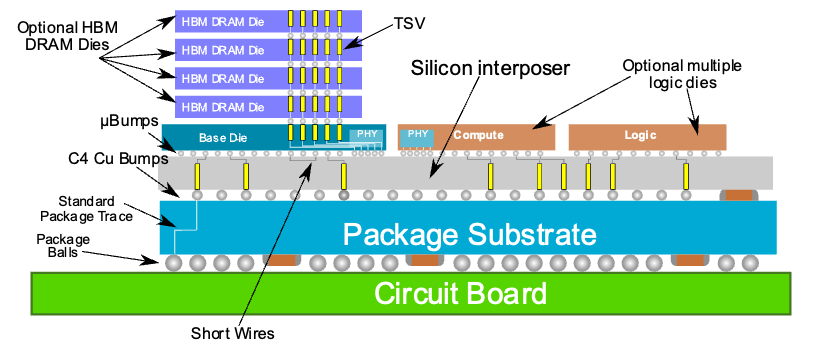
CoWoS封装 图源:wiki chip
这种封装形式被称为2.5D封装,与3D封装工艺相比,CoWoS封装中的不同芯片仍旧处于同一平面之上,但在片与片之间的通信方式上由引线或基板改为了wafer。
为什么造芯片要“卷”这种多层封装形式呢?
其实,这个在市中心盖高层的想法相同——节省地块面积以及提升通信速度。传统封装,芯片与芯片之间独立封装,它们之间的信息交换需要通过底层的基板进行。目前片外通信绝大多数都依靠PCIE接口,如今的PCIE6.0×16接口理论上最快能达到128GB/s,看起来很快,但与片内通信相比是“小巫见大巫”。据谷歌云服务器中心公布的数据显示,应用在AI大模型计算上的TPU,其芯片内部通信速度已经达到1000PB/s,相比最快的PCIE通信还要快8,192,000倍。还有一点非常重要,目前AI服务器亟待解决“内存墙”问题,CoWoS可以将CPU与HBM封装在一起,可以很好的解决片与片之间的通信效率问题。目前CoWoS已经成为最流行的AI服务器GPU的封装技术。

先进封装与传统封装区别 图源:中泰证券
从芯片面积的应用上来说,3D封装的立体结构具有更好的电气性能与力学性能支持。垂直通信中硅通孔通信速度同样能极大提升信息传输效率。此外,芯片与芯片之间更短的连接也能降低功耗与成本。但以目前的芯片封装技术还难以解决多个芯片堆叠产生的散热与良率不高的问题,因此,以CoWoS为代表的2.5D封装出现了。2.5D封装可以很好的克服基板上难以高密度布线导致的芯片引脚数不足的问题。
2.5D封装技术本质上是一类封装技术的代称,它并不是2D与3D封装的降级或升级版,其技术路线也相对独立,因此随着封装技术的持续发展,还会出现融合多种封装技术的“4D封装”,这里不展开讨论,我们回头看CoWoS封装的工艺。
与3D封装相同,芯片与中介层之间的通信也通过硅通孔(TSV)实现。打孔,首先要在中介层硅片上涂抹光刻胶,然后进行光刻,刻蚀,沉积等步骤在硅片上制造出内部含铜的通孔,最终让芯片与基板通过通孔与基板相连接。
根据中介层材质的不同,CoWoS封装可以分为三类。一种是CoWoS-S,即使用Si衬底为中介层。第二种是CoWoS-R,相比第一种,该技术应用重现布线层(RDL)为中介层。第三种是CoWoS-L,L指的是Local Silicon Interconnect and RDL Interposer,它融合了芯粒技术与RDL做中介层。
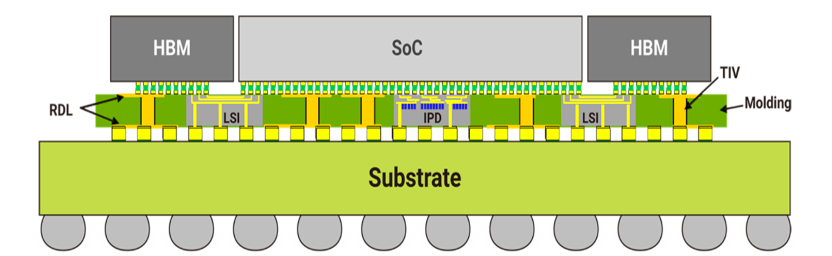
CoWoS-R封装 图源:GitHub
但无论中介层采用哪种材质或技术,这三类封装仍旧属于平行技术。CoWoS-S的成本最高,不过由于是全硅片中介层,其性能理论上也是最好的。CoWoS-R可以简单的理解为将一块专用芯片间高速通信的PCB当作中介层。CoWoS-L则是以上两种技术的混合,即使用局部的硅桥进行芯片之间的电气互联,硅桥以外的位置使用RDL层或substrate进行代替。
02. CoWoS为什么是关键
从技术角度看,CoWoS能最大程度的发挥其他先进生产技术的潜能。
(1)HBM
AI服务器中,HBM正在扮演越来越重要的角色。过去HBM产量不高,堆叠层数也较少,传统芯片封装技术还足以应付。不过如今HBM已经出现12+1层堆叠(12层DRAM颗粒与1层控制芯片),超高的带宽需求才让CoWoS封装成为关键。通过将HBM与CoWoS 集成,内存与处理器之间的距离就能更近,从而缩短互连长度并实现处理器和内存之间更快、更高效的数据传输。内存带宽的增加对于人工智能、高性能计算和图形处理等内存密集型应用非常有利。
(2)Chiplet
Chiplet又称为小芯片。该技术通过将大型SoC划分为更小的芯片,使得每个部分都能采用不同的制程工艺进行生产,因此能够有效提升良率生产效率。CoWoS 和Chiplet的结合可以提高系统级性能和功效,尤其是在一些集成了电源管理的SoC上表现更好。
尽管CoWoS的作用十分重要,但这并不能说明厂商目前可以随意应用这项技术。文章开头提到,产能已经成为限制CoWoS发挥的重要问题。
CoWoS封装起源于2012年,由台积电研发,并于2016年首次与HBM结合封装。2023年以来,AI技术的爆炸式进步成为台积电CoWoS封装增长的催化剂。据台积电披露2022年数称,CoWoS封装已经占总收入5%以上,且将以每年近20%的速率增长,远高于台积电总营收增长预计的10%。
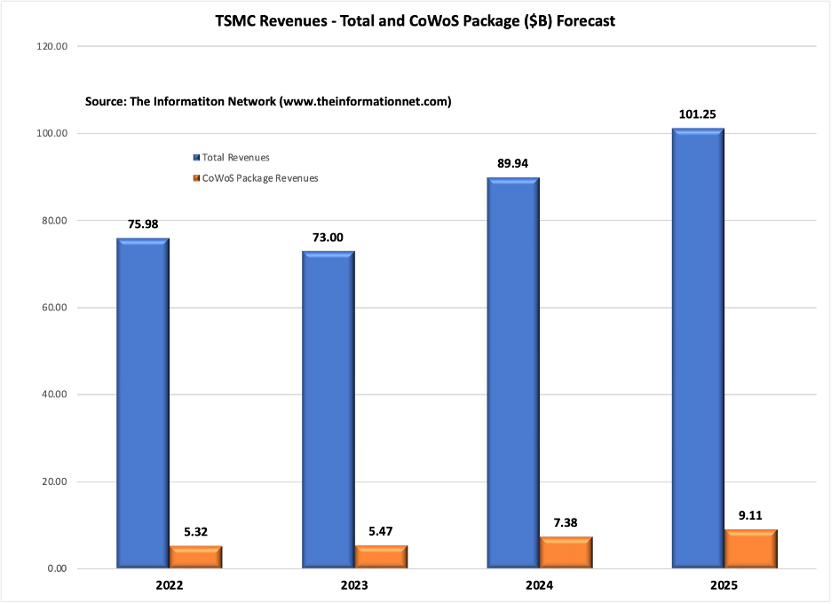
CoWoS占台积电营收预测 图源:Information Network
据台积电数据显示,当前AMD、Broadcom、Marvell和Nvidia是台积电CoWoS后端技术的最大消费者。2023年先进封装需求大增以来,台积电已经多次发出CoWoS产能预警,因此,目前台积电的各个客户之间已经开启了“产能争夺战”。
2023年台积电针对CoWoS的扩产,与本次AI爆火的最大受益者英伟达、AMD相关。DigiTimes数据显示,台积电目前的CoWoS产能大约8000-9000片/月,不过英伟达与AMD两家就占用了大约 70% 到 80% 的产量。第三名的博通仅占10%。剩下10%的产能才分配给其他公司。
扩产之下,究竟能有多少产能分到除了巨头之外的企业还是未知数,CoWoS产能危机或许还将拉大头部AI企业与其他企业的差距。而从AI芯片企业角度看,争夺未来的台积电产能也将成为企业发展的关键。
03. CoWoS的对手
AI爆单,就连台积电也无法独自容下如此巨大的AI增长需求。因此,寻求其他先进封装成为诸多AI芯片厂商当前的重要任务。
财联社数据显示,进入2023年后,A股中,先进封装概念股均有了不同程度上涨。凯格精机、甬矽电子、晶方科技、同兴达、长电科技等先进封装概念股表现强势,其中凯格精机7月以来股价累计最大涨幅达75%。
事实上,很多消息都表明,很多厂商都在努力承接台积电产能不足溢出的订单。日月光作为传统封装的龙头企业,最近开始大力扶持先进封装。同花顺金融研究中心在最近的调研中指出,中国大陆市场份额第一的封测厂商长电科技也成功开发除了2.5D与3D封装技术,在晶圆级封装(WLP)、堆叠封装(PoP)等领域,覆盖面可追平日月光。

全球封装市场 图源:财联社
除了独立研发先进封装技术外,在CoWoS相关赛道上,中国大陆仍有一战之力。
(1)创意电子
创意电子成立于1998年,已经在中国台湾证券交易所公开上市;2003年,台积电参与投资创意电子,并成为最大股东;2017年,创意电子(南京)有限公司成立,这意味着台积电的关键核心封装技术被引入内地。本次世界半导体大会暨南京国际半导体博览会上,记者采访了创意电子总监肖有军。
肖总表示,创意电子南京公司的成立,主要面向本土化需求。目前创意电子拥有自己独立的APP平台,可以为CoWoS等先进封装技术赋能。此外,创意电子自研G Link技术也可以强化CoWoS封装上,芯片与芯片之间互联的能力。记者了解到,目前台积电&创意电子联盟已经推动南京大范围芯片产业发展,客户已经遍及全国,几乎可以覆盖芯片设计到制造的全流程。
(2)长电科技
长电科技是一家全球领先的集成电路制造和技术服务提供商。无论从市场占比还是营收情况看,长电可以已经长期位于中国封测领域的龙头位置。资料显示,目前长电科技的技术覆盖了高集成度的晶圆级封装(WLP)、2.5D/3D封装、系统级封装(SiP)、高性能倒装芯片封装和先进的引线键合技术等。
记者注意到,长电于2021年发布的XDFOI多维先进封装技术,同样使用2.5D硅通孔封装技术,利用Chiplet将不同芯片封装在中介层上(RDL Stack Interposer,RSI)。官方资料显示,该技术可以更好的适配HBM与GPU的连接。尽管该技术与台积电CoWoS并无技术冲突,但本质上这两种封装原理的底层逻辑类似,因此可以直接视为国产CoWoS。有媒体报道称,长电科技 XDFOI 技术可将中介层厚度控制在 50μm 以内,微凸点(µBump)中心距达到40μm,可以达到更高集成度、更强模块功能和更小封装尺寸。
04. 总结
综上所述,CoWoS封装技术凭借其独特的TSV硅通孔和Chiplet集成方法,为摩尔定律的延续提供了重要的推动力。在迎接AI的挑战中,它展现出巨大的潜力,尤其是在高带宽内存HBM与GPU之间的协同应用中。不过CoWoS技术的产能问题仍然是一个待解决的挑战,许多制造商正在积极竞逐有限的产能资源。
在国内,创意电子与长电科技等公司已经在类似技术领域取得了初步突破,为技术的进一步发展奠定了基础。我们可以预见,CoWoS将继续在决胜人工智能领域的道路上发挥不可或缺的杀手锏作用,为未来的科技创新开辟更加广阔的可能性。
-
台积电CoWoS产能未来五年稳健增长2025-02-08 1365
-
台积电CoWoS产能将提升4倍2024-09-06 1712
-
先进封装领域竞争白热化,三星重组团队全力应对台积电挑战2024-09-02 1533
-
消息称台积电首度释出CoWoS封装前段委外订单2024-08-07 1659
-
AMD寻求CoWoS供应商替代台积电,为AI加速卡生产寻找替代品2024-01-05 1321
-
CoWoS先进封装是什么?2023-07-31 6300
-
台积电CoWoS订单增加 生产线满载运行2020-04-12 3363
-
印度本土手机厂商难以与大陆品牌竞争,重振战略是为大陆品牌代工2019-12-11 3602
-
传比特大陆拖欠台积电3亿美元账款2018-11-08 3419
-
外媒称台积电暂停对比特大陆的芯片供应2018-11-06 3919
-
台积电7nm订单侧面解读 带领大陆半导体行业发展2018-01-24 1778
-
台积电拟在大陆设12寸厂,助力大陆半导体发展2014-12-22 1592
-
大陆厂商LED芯片业者实力劣于日、韩两国2012-09-20 3368
-
大陆对台采购面板签约金为53亿美元 年增56%2010-04-10 516
全部0条评论

快来发表一下你的评论吧 !

