

双束聚焦离子束FIBSEM在微电子技术中的应用
电子说
1.4w人已加入
描述
近期不少客户朋友咨询博仕检测工程师,关于芯片横截面采用FIB切片分析的制样品的问题,这篇文章分享给大家,希望能帮到大家。
聚焦离子束技术(FIB)原理:
聚焦离子束(FIB)系统利用镓离子源和双透镜聚焦柱,用强烈的聚焦离子束轰击标本表面,以进行精密材料去除、沉积和高分辨率成像。简单来说是聚合了FIB处理样品和SEM观察成相的功能。其中FIB是将Ga元素离子化成Ga+,然后利用电场加速,再利用静电透镜聚焦将高能量的Ga+打到指定点从而达到处理样品的功能。
(PS大多数商用FIB都用Ga源,也有部分具有He和Ne等离子源)
聚焦离子束FIB切片截面分析过程:
FIB技术可以精确地在器件的特定微区进行截面观测,形成高分辨的清晰图像,并且对所加工的材料没有限制,同时可以边刻蚀边利用SEM实时观察样品,截面分析是FIB最常见的应用。这种刻蚀断面定位精度极高,在整个制样过程中样品所受应力很小,制作的断面因此也具有很好的完整性。这种应用在微电子领域具体运用场合主要有:定点观测芯片的内部结构;失效样品分析烧毁的具体位置并定位至外延层;分析光发射定位热点的截面结构缺陷。
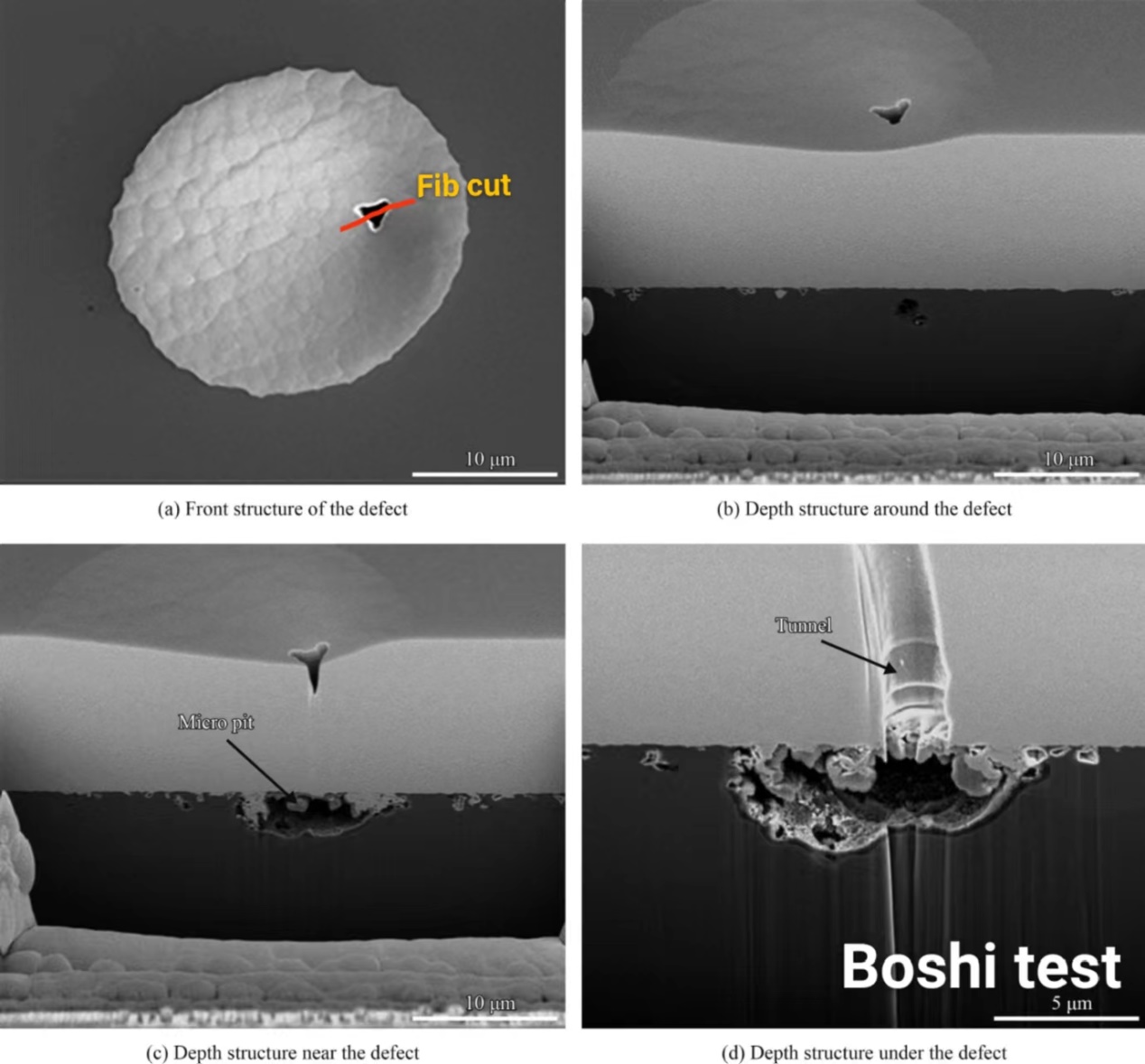
聚焦离子束-扫描电子显微镜双束系统 FIB-SEM应用
聚焦离子束-扫描电镜双束系统主要用于表面二次电子形貌观察、能谱面扫描、样品截面观察、微小样品标记以及TEM超薄片样品的制备。
FIB-SEM测试:
线路板PCB电路断裂位置,利用SEM观察铜箔金相。

FIB切割PCB电路截面分析
FIB切割PCB电路截面分析
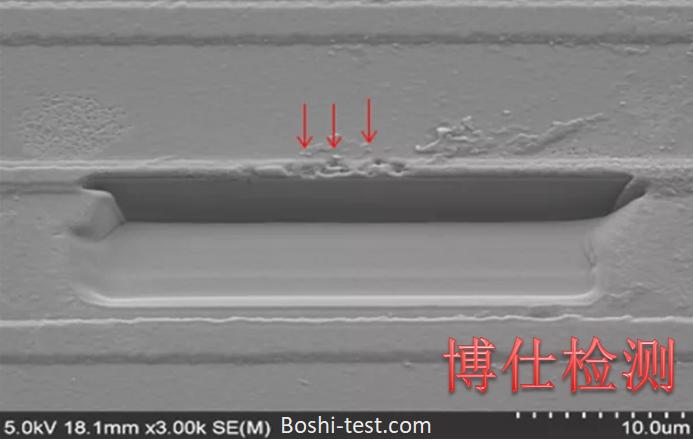
微米级芯片样品缺陷FIB-SEM截面测试
半导体芯片横截面分析 -FIB-SEM EDS 测试

审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
Dual Beam FIB(双束聚焦离子束)2018-09-04 4181
-
聚焦离子束应用介绍2020-02-05 2954
-
聚焦离子束FIBSEM切片测试【博仕检测】2023-09-05 2242
-
聚焦离子束技术介绍2023-01-16 3455
-
聚焦离子束一电子束(FIB-SEM)双束系统原理2024-11-14 1770
-
聚焦离子束系统的结构、工作原理及聚焦离子束双束系统2024-12-17 2068
-
聚焦离子束双束系统在微机电系统失效分析中的应用2025-01-24 1484
-
什么是聚焦离子束(FIB)?2025-02-13 1660
-
详细聚焦离子束(FIB)技术2025-02-18 3212
-
聚焦离子束技术在现代科技的应用2025-03-03 963
-
聚焦离子束技术在纳米加工中的应用与特性2025-03-26 975
-
聚焦离子束双束系统 FIB - SEM 的技术剖析与应用拓展2025-04-10 1453
-
聚焦离子束技术:纳米加工与分析的利器2025-04-28 871
-
聚焦离子束(FIB)技术分析2025-08-28 1322
-
聚焦离子束技术在TEM样品制备中的应用2025-11-11 520
全部0条评论

快来发表一下你的评论吧 !

