

硅基MCT红外探测器的钝化初步研究
描述
碲镉汞(MCT)材料的表面钝化是红外探测器制备中的关键工艺之一。高性能MCT器件需要稳定且可重复生产的钝化表面和符合器件性能要求的界面。因此,探究MCT表面钝化技术具有重要意义。国际上,MCT钝化技术包括磁控溅射、热蒸发、原子层沉积以及MBE等。
据麦姆斯咨询报道,近期,华北光电技术研究所的科研团队在《红外》期刊上发表了以“硅基碲镉汞红外探测器表面钝化研究”为主题的文章。该文章第一作者和通讯作者为戴永喜工程师,主要从事红外探测器芯片的研究工作。
本文通过对硅基MCT红外探测器的钝化进行初步研究,对比了MBE钝化与磁控常规钝化的膜层状态以及后续的电流-电压(Ⅰ-Ⅴ)曲线特征,最终发现MBE原位钝化技术可极大减少MCT的表面复合,提高Ⅰ-Ⅴ曲线的反向平坦区,进而得到更稳定的MCT红外探测器。
实验步骤
样品制备
利用MBE生长系统在CdTe/Si复合衬底上制备MCT。采用发射式高能电子衍射仪和红外高温计原位监控生长过程,主要监控外延的表面状态与表面温度。
用相同方法制备两个3 in硅基外延MCT样品A与B。
表征测试
在样品A的MCT材料生长后,直接在MBE设备内对其进行原位钝化,外延一层厚度约为200 nm的CdTe。然后将样品A利用磁控溅射设备生长一层厚度约为200 nm的ZnS。
在样品B的MCT材料制备好以后,利用磁控溅射设备生长双层复合钝化膜层CdTe/ZnS(厚度分别为100 nm和200 nm)。
用封闭石英管对钝化后的样品A与样品B进行热处理。利用椭偏仪测试样品的膜层厚度与折射率。使用聚焦离子束(FIB)技术处理样品A与B,获得平整清晰的横截面。利用扫描电子显微镜(SEM)观测钝化层表面及其横截面形貌。然后进行红外探测器加工,最终制备图1所示的器件结构。利用美国Keithley公司生产的4200-SCS系统进行Ⅰ-Ⅴ特性测试。
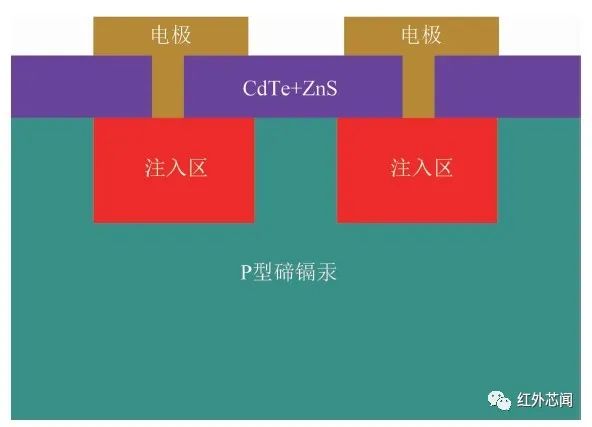
图1 器件结构图
结果与讨论
钝化膜层的折射率分析
准备两片晶向为[110]的双面抛光硅片,分别通过MBE和磁控溅射生长厚度均为200 nm的CdTe。膜层生长完成后,利用法国SOPRA公司生产的光谱式椭偏仪完成了表1所示的膜层厚度与折射率表征。
一般来讲,折射率可以表征钝化膜层的致密性。用椭偏仪表征膜层的厚度与折射率。从表1中可以看出,MBE生长的CdTe膜层的折射率为3.02,大于磁控溅射生长的钝化膜层的折射率。也就是说,在一定条件下,MBE原位钝化生长的CdTe 比磁控溅射生长的CdTe致密。以前曾有文献报道过此结果。
表1 MBE和磁控溅射生长的CdTe的膜层厚度与折射率

钝化表面及其横截面形貌
本次实验选取两片短波硅基材料。其中一片用MBE法进行原位钝化,生长厚度为200 nm的CdTe膜层;另一片用磁控溅射法进行钝化,生长厚度为100 nm的CdTe膜层。图2所示为用SEM观察MBE钝化表面及其横截面形貌的结果。图3所示为用SEM观察磁控溅射钝化的结果。

图2 通过MBE法原位钝化的CdTe的SEM图
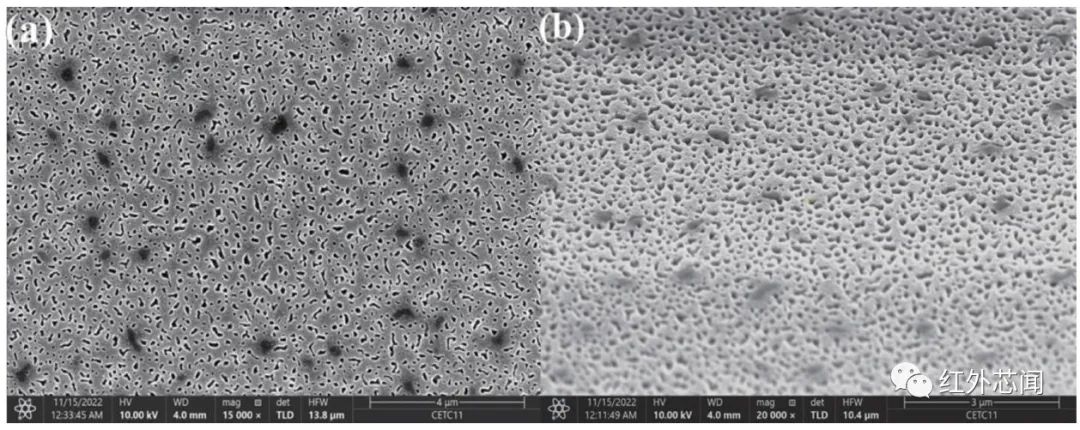
图3 通过磁控溅射法钝化的CdTe的SEM图
通过对比图2与图3可以看出,MBE原位钝化的CdTe呈较致密细致的单晶态,原位钝化的CdTe表面形貌较好,缺陷孔洞较少。由图2(b)可以发现,CdTe在生长过程中形成了晶粒,因此用SEM观察时其表面有细小的晶粒物质。另外,该表面出现相同方向的生长波纹,这是由MBE生长中的[211]晶向到碲化镉生长时发生偏转导致的。
磁控溅射钝化的CdTe表面形貌较差。图3(b)中出现了大量的不规则孔洞。它们可能是生长过程中原子团簇沉积到衬底上,经过后退火形成的缺陷孔洞。
图4是MBE原位钝化的器件横截面的SEM图。图5是磁控溅射钝化的器件横截面的SEM图。通过对比两者可以看出,用SEM观察截面时,MBE原位钝化的CdTe孔洞较小、数量也较少。磁控溅射钝化的CdTe孔洞较大且数量也较多。这些孔洞大多来源于生长过程中的缺陷。有些孔洞甚至直接贯穿整个钝化层。这些较大的孔洞对探测器流片过程中的接触孔腐蚀等其他工艺是否会产生进一步影响,需要我们进一步去研究。
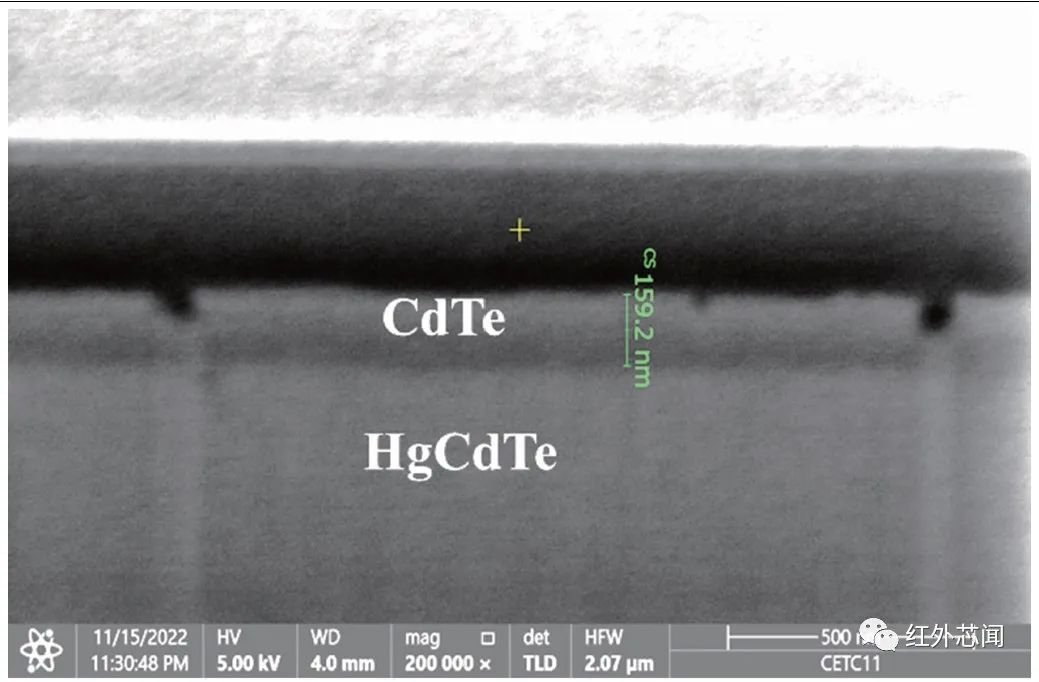
图4 MBE原位钝化的FIB截面的SEM图
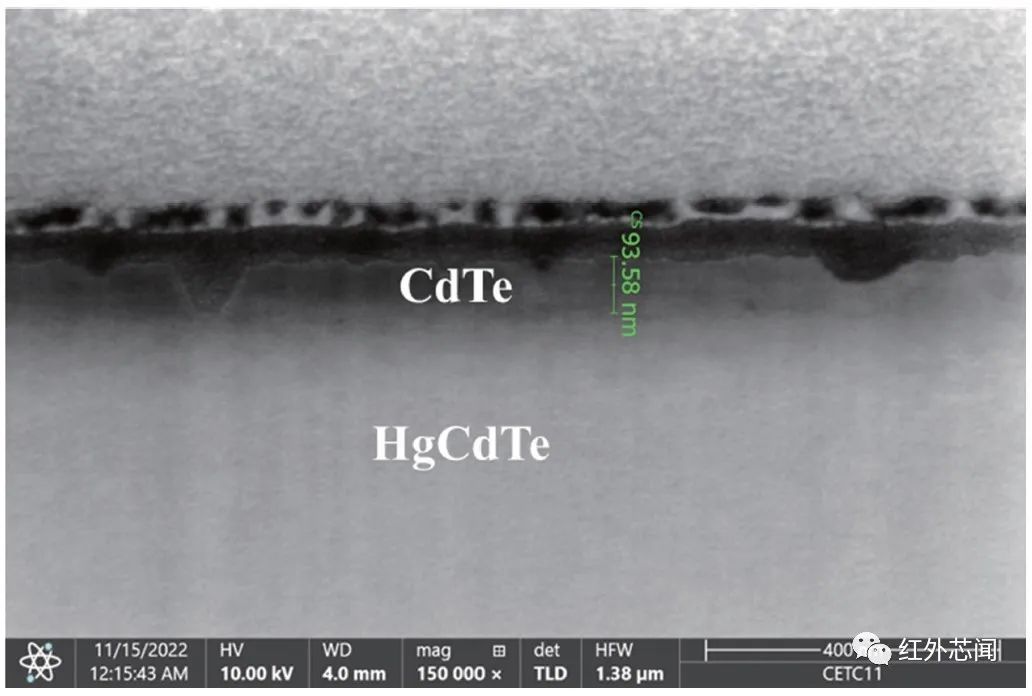
图5 磁控溅射钝化的FIB截面的SEM图
从钝化层与MCT接触的分层来看,MBE原位钝化的分层更明显。两种不同钝化条件的芯片的热处理条件是相同的。原位钝化MCT和碲化镉之间主要依靠的是化学键作用,退火时310℃的温度不足以造成Te-Cd断裂,仅存在Hg交换,所以退火后界面没有形成较好的“互扩散层”。磁控溅射钝化的CdTe与MCT在经过310℃热处理后形成了较好的“互扩散层”。
不同钝化技术下的Ⅰ-Ⅴ性能
在相同条件下同时对MBE原位钝化的短波硅基材料与磁控溅射钝化的短波硅基材料进行了热处理、光刻图形与电极沉积等器件流片工艺。对于采用不同钝化工艺制备的MCT短波红外焦平面器件,利用液氮制冷,待温度稳定后使用美国Keithley公司生产的4200-SCS系统进行Ⅰ-Ⅴ特性测试。图6是MBE钝化芯片的Ⅰ-Ⅴ曲线,图7是磁控溅射钝化芯片的Ⅰ-Ⅴ曲线。

图6 MBE原位钝化芯片的Ⅰ-Ⅴ测试图

图7 磁控溅射钝化芯片的Ⅰ-Ⅴ测试图
Ⅰ-Ⅴ电学特性可以较好地表征器件P-N结的电学特性,也可以从侧面表征钝化层的质量。优质的钝化层可以较好地消除材料表面的悬挂键,降低表面暗电流,使器件的电学性能得到进一步提升。
通过对比不同钝化条件的Ⅰ-Ⅴ测试结果可以看出:(1)MBE原位钝化芯片的Ⅰ-Ⅴ结果是,零偏阻抗值为2.8 GΩ,电流值为3.45 nA,反向平坦区可以达到600 mV。(2)磁控溅射钝化芯片的Ⅰ-Ⅴ结果是,零偏阻抗值为1.4 GΩ,电流值为2.41 nA,反向平坦区为300 mV。从数据对比来看,磁控溅射钝化芯片的Ⅰ-Ⅴ结果较差,这可能是由于常规CdTe钝化的红外探测器在生长CdTe/ZnS双层钝化膜前,MCT材料经溴基腐蚀液腐蚀后,MCT材料表面会有一段时间暴露于大气中,此时表面会发生氧化,形成的表面态对材料表面复合速率影响较大。钝化层表面缺陷孔洞较多,也会影响表面的复合速率,导致器件的暗电流变大、Ⅰ-Ⅴ性能变差。对于MBE原位钝化的CdTe,在MBE生长完MCT后直接进行原位钝化,不会使材料暴露在大气中,因此CdTe与MCT之间可以形成一个良好的界面。MBE原位钝化的CdTe表面缺陷孔洞较少,因此它的Ⅰ-Ⅴ性能较好。
结束语
从折射率的表征结果发现,MBE原位钝化膜层的致密性比磁控溅射常规钝化膜层好,而且MBE原位钝化的钝化层表面的缺陷孔洞较小,钝化层与MCT本身的晶格匹配度较好。对于MBE原位钝化的CdTe,在MBE生长完MCT后直接进行原位钝化,不会使材料暴露在大气中,因此CdTe与MCT之间可以形成一个良好的界面。MBE原位钝化芯片的Ⅰ-Ⅴ性能结果较好,零偏阻抗值为2.8 GΩ,电流值为3.45 nA,反向平坦区可以达到600 mV。实验结果表明,原位钝化生长技术具有更致密的CdTe膜层和更洁净的表面,MBE原位钝化比磁控溅射钝化有更明显的优势。MBE原位钝化技术将是未来发展的重要方向之一,其参数优化以及钝化后的热处理是我们以后研究的重点。
审核编辑:彭菁
-
被动红外探测器和主动红外探测器的区别2024-09-20 5072
-
硅基锗PIN光电探测器的研究进展综述2024-04-25 4798
-
红外探测器有几种?如何划分?2023-08-02 4337
-
红外探测器:热探测器与光子探测器2023-07-19 3759
-
红外探测器的分类2023-07-11 4049
-
混合硅基光电探测器的各项性能研究2023-04-23 3199
-
红外InAsSb探测器:符合RoHS标准,可替MCT2023-04-07 2704
-
综述:硅基BIB红外探测器研究进展2023-02-07 4039
-
台面型InGaAs/InP基PIN短波红外偏振探测器原型器件2022-12-01 2540
-
红外探测器——热探测器详解2022-11-08 4910
-
被动式红外探测器和主动式红外探测器有什么区别2020-12-24 5902
-
中国科学院近红外硅基光电探测器研究获进展2020-11-09 3400
-
红外探测器2019-04-16 2874
-
被动红外探测器技术研究2011-03-15 2017
全部0条评论

快来发表一下你的评论吧 !

