

倒装晶片的组装的回流焊接工艺
PCB设计
描述
在回流焊接炉中,倒装晶片和其他元件要被焊接在基板上。在此过程中,如果加热的温度太高,或者时间太长 ,助焊剂便会在润湿整个焊接面之前挥发或分解完,造成润湿不良或其他焊接缺陷。另外,在复杂的混合装配中 ,大的元件比小的元件温度要低,造成每个焊点温度的不均匀。元件焊球的不共面性在此也应受到关注。锡铅共 晶材料的焊球如果蘸取助焊剂的量恰当,即使其只是刚好接触到焊盘,在回流焊接过程中也会与焊盘焊接良好。 由于焊球大小的差异,假设基板平整没有变形,则只有3个的焊球接触到焊盘。实际情况是基板不会完全平 整,可能并不是3个较大的焊球接触焊接面。我们注意到,在焊接过程中,由于焊球的“坍塌”,非常显著地降 低了基板焊盘与元件之间的距离。正是因为这种“坍塌”,使得那些原本没有和焊盘接触的焊球也在此过程中焊 接完好,如图1和图2所示。但是那些太小的焊球尽管有这种补偿作用仍然会存在接触问题,引起电气开路。在回 流炉中,焊点形成完整的坍塌连接是关键。

图1 焊接之前 图2 焊接之后
(1)回流环境的考虑
在空气中回流焊接,形成电气连接并非难事。ˉ但我们仔细检查会发现一些非常显著的焊接缺陷。一些焊盘只 是部分的润湿,很少焊点会形成完整的“坍塌”连接,甚至可以发现有些元件可能轻微的歪斜。对于无铅焊接而 言,问题更严重。
倒装晶片在氮气中回流焊接有许多优点。在较低氧气浓度下回流焊接,条件比较宽松,可以获得很好的焊接良 率。由于减少了氧化,可以获得更好的润湿效果,同时工艺窗口也较宽。在氮气回流环境中熔融的焊料表面张力 较大,元件具有很好的自对中性,可控坍塌连接会更完整,焊接良率也会较高。对于无铅焊接工艺,特别是当基 板焊盘的表面处理方式是OSP时,推荐使用氮气,控制回流炉内氧气浓度在50 ppm左右。但是氮气的使用会导致 成本增加25%~50%。需要在良率和成本之间考虑平衡。如果在此情况下要考虑应用空气回流焊接,则推荐使用 DR(Direct-Ramp)形态的焊接温度曲线。另外,一些小的元器件,如0201/0402在氮气中回流焊接会产生较多 的立碑缺陷,这些都是需要我们综合考虑的。
(2)回流焊接温度曲线设置
对于混合装配,在同一产品上既有助焊剂装配又有锡膏装配,所以焊接温度曲线需要仔细的优化。主要从这几 个方面进行优化设置:升温的速度、助焊剂活化温度和时间、液相以上时间,以及回流温度和冷却速度。一 般来说,锡膏或助焊剂会针对以上参数推荐一个范围给使用者,但这个范围比较粗糙,由于我们工厂的产品千差 万别,没有一个所谓通用的“标准”焊接温度曲线,需要对不同的产品进行优化。优化参考的标准是焊接完成后 ,焊接不良率要,产品无明显的翘曲变形,外观没有因温度而造成的损伤,焊点形成完整并且足够的焊接强 度,焊点光亮无氧化。对于一些复杂的装配,电路板上既有小的倒装晶片,又有较大的元件,如BGA或连接插座 等,由于热容的差异,如果不仔细地优化炉温设置,有时板上的温度差会高达15~20°C,造成基板严重翘曲变 形,焊点因为应力而开裂。基板的翘曲变形对倒装晶片的装配良率影响明显,综合元件焊球大小的差异,其影响 有时非常显著。
回流温度曲线形态有RSR(RampˉSoak-Ramp )(如图3所示)和DR(DirectRamp)两种,根据锡膏和助焊剂 的特性而定。RSR在以下情况下被应用得比较多:
·板上元件较多而且差异很大;
·需要减少焊点内空洞;
·要求预热温度小于1.5°C/s时受限于产量和设备能力。
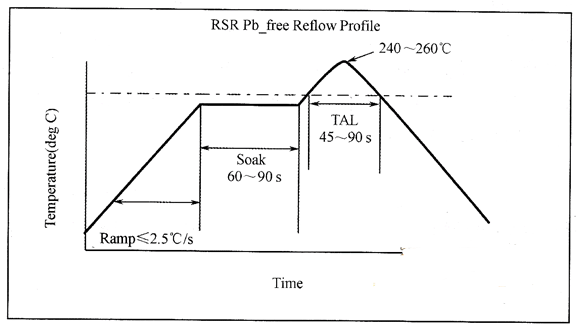
图3 RSR形态的温度曲线
DR温度曲线(如图4所示)有以下特点:
·可以有比较小的升温速度(0.5~1.0°C/s);
·适合厚度为1.6 mm或更薄的板上装配小的CSP、BGA、芯片和片状元件;
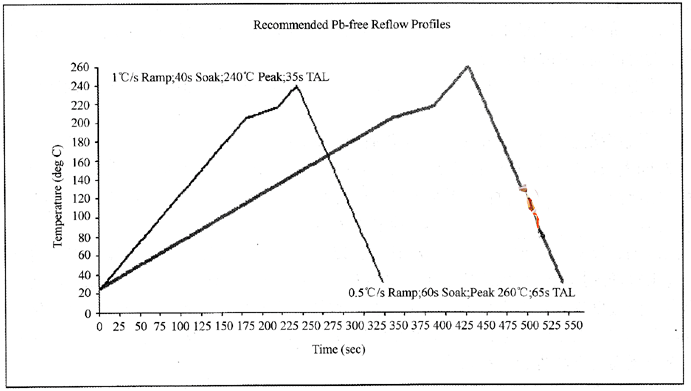
图4 DR形态的温度曲线
在元件封装工艺中或电路板上元件较少而且都是相同元件时,趋向应用DR形态的回流焊接温度曲线,可以获得 较高的产量,焊接品质也可以满足要求。但不同产晶需要优化出对应的温度曲线,如图5所示。怎样进行温度曲 线的优化呢?需要了解在焊接各个阶段,如果焊接温度设置不当,可能会出现的问题,那么,我们就会有针对性 的来进行优化设置了。
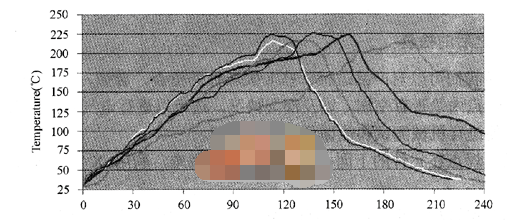
图5 不同产品对应不同的温度曲线
一般从室温升高到助焊剂活化温度,升温速度要求小于2.5℃/s,太快的升温会对元件造成热冲击,除此之外, 还会导致助焊剂急剧挥发造成锡珠、锡塌和元仵“爆米花”等现象。比较小的升温更有利于减少电路板上的温度 差。
锡铅焊膏中助焊剂活化温度一般为120~150℃,无铅锡膏中助焊剂活化的温度较高,一般为150~200℃。在此 温度,助焊剂的活性被激发,清洁焊接面,去除焊接表面的氧化物,润湿焊接表面,防止焊接面在炉内的再次氧 化。如果设置的温度过高,助焊剂会急剧挥发,一部分甚至会分解,导致焊接面清洁润湿不良,或焊接面氧化, 焊接完后焊点内出现空洞。过低的温度设置会导致助焊活化时间不足,焊接表面的油污和氧化物不能完全去除, 导致焊接不良。另外,会有较多的助焊剂留在回流焊接阶段而导致焊点内过多的空洞。适当的助焊剂活化时间不仅可以很好的润湿焊接面,还可以降低焊点中的空洞。但是太长的活化时间反而会导致焊点内 空洞的急剧增加,原因是助焊剂在此阶段过度挥发,焊接面及焊料氧化,在回流阶段没有足够的助焊剂覆盖在熔 融的焊料金属表面,导致过多的氧化。所以在此温度下的时间需要细心的优化。
一般对于无铅工艺,助焊剂活化的时间为60~90 s,对于锡铅工艺,助焊剂活化时间为2.5~3 mln。
在回流焊接过程中,液相以上时间要适当,时间太短,焊点可能不完整,容易出现“冷焊”;时间太长,则会 有氧化的问题,焊点发黑无光泽,元件及电路板容易损坏,而且焊点内金属间化合物会过度生长。对于无铅工艺 ,控制液相以上时间在45~90 s,推荐为60 s。锡铅工艺,液相以上时间控制在60~75s,推荐为60 s。
回流的温度一般要求高于液相温度15~30℃,原则是在满足焊接要求的情况下,尽量使用较低的焊接温度 以降低由于高温引起的翘曲变形、焊点的氧化及控制金属间化合物在焊点内的过度生长。但太低的回流温度会导 致焊接不充分,或者焊料不能完全熔化,出现“冷焊”。太高的回流温度不仅带来产品的翘曲变形,焊点的氧化 ,还会损坏元件和基板,焊点内金属间化合物也会长得很大。
冷却速度在无铅工艺中已备受关注,原因是其影响焊点的微观结构和可靠性。比较慢的冷却速度,焊点内金属 间化合物尺寸会很大,同时锡的结晶颗粒也会比较粗,这些对焊点的可靠性都不利。而比较快的冷却速度有利于 减少焊点内金属间化合物的形成,锡晶颗粒也会比较细。但是快速的冷却会导致基板和元器件严重的翘曲变形。 所以,在优化此参数时需要平衡考虑。另外,在组装倒装晶片时,在强制热风回流炉设置中往往被忽略的一个参 数就是风扇的转速。太强的气流有时会将细小的元件吹跑,或导致元件便移。一般可以调整其转速在3 500转/min左右。
-
氮气回流焊 vs 普通回流焊:如何选择更适合你的SMT贴片加工焊接工艺?2025-05-26 2929
-
锡膏回流焊接工艺要求2024-09-18 1599
-
SMT贴片中的回流焊接工艺2023-12-18 1765
-
SMT焊接工艺介绍:回流焊、波峰焊、通孔回流焊2023-11-18 14649
-
晶圆级CSP装配回流焊接工艺控制,看完你就懂了2021-04-25 4903
-
通孔回流焊工艺在PCB组装中有什么样的作用2020-12-15 1366
-
通孔回流焊接工艺的特点2020-10-26 6458
-
通孔回流焊工艺原理_通孔回流焊接工艺的优缺点2020-04-14 20764
-
倒装晶片的组装的回流焊接工艺2018-11-23 3130
-
通孔回流焊接工艺2018-09-04 2007
-
回流焊接設定方法2016-05-06 856
-
回流焊接工艺2008-09-04 3637
全部0条评论

快来发表一下你的评论吧 !

