

晶圆级CSP的返修完成之后的检查
PCB设计
2586人已加入
描述
返修之后可以对重新装配的元件进行检查测试,检查测试的方法包括非破坏性的检查方法,如目视、光 学显微镜、电子扫描显微镜、超声波扫描显微镜、X-Ray和一些破坏性的检查测试,如切片和染色实验、老 化和热循环测试,以及机械测试(推拉,跌落,振动,扭转和弯曲)等。例如,可以用X-Ray检查返修前后 焊点的情况,是否短路,在焊点内是否有空洞存在等。如图1所示。
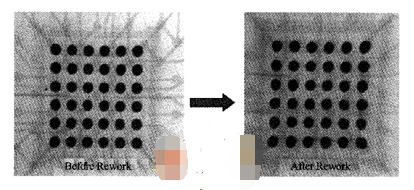
图1 X-Ray检查返修前后的焊点
对焊点切片后,利用显微镜检查焊点内空洞的情形,检查其是否润湿良好等。如图2所示。
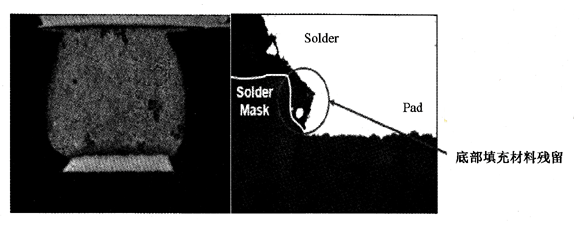
图2 对焊点切片检查,因为底部填充材料残留,导致焊接过程中润湿不良
利用上面介绍的关于非破坏性和破坏性的检查方法,可以确定返修工艺是否可靠,还可以开发和优化返修工艺,以获得满意的良率和可靠性。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
晶圆级CSP的元件的重新贴装及底部填充2023-09-28 1400
-
晶圆级CSP装配回流焊接工艺控制,看完你就懂了2021-04-25 4917
-
晶圆级CSP应该如何进行维修?返修工艺详细说明2021-02-11 2795
-
晶圆级CSP装配工艺的锡膏的选择和评估2018-11-22 2641
-
晶圆级CSP的锡膏装配和助焊剂装配2018-09-06 1709
-
晶圆级CSP的返修工艺2009-11-20 746
全部0条评论

快来发表一下你的评论吧 !

