

环保无铅锡膏好在哪里?
电子说
描述
回流焊后焊点缺陷有很多种类,例如柯肯达尔空洞,热蠕变和电迁移。随着电子元器件小型化发展,焊点尺寸日趋微型化,焊接的缺陷导致空洞面积越来越大。柯肯达尔空洞对焊点的可靠性带来巨大的挑战。同时随着电子技术发展,焊点需要面对各种复杂服役温度场景。在高温作用下会在焊点生成热应力并导致焊点变形。此外电迁移会发生在电流密度大元器件中。
1. 柯肯达尔空洞
1.1成因
柯肯达尔效应是一种无铅锡膏焊接时常见的且会影响焊点可靠性的效应。柯肯达尔空洞的形成主要是由取代固溶体化学成分的本征扩散率差异(非互易扩散)引起的。在热老化过程中,焊点金属间化合物层由于温度影响会不断生长。比如说SnAgCu无铅锡膏制作的焊点在受热时会加速金属元素扩散现象。在Cu3Sn和Cu6Sn相中,Cu是比Sn更快的扩散组分。Cu向外扩散要快于Sn向Cu扩散 (Sn和Cu之间的原子通量不平衡),因此在Cu3Sn内部和Cu3Sn/Cu界面会留下空位。空位不断积聚最终会发展为柯肯达尔空洞。
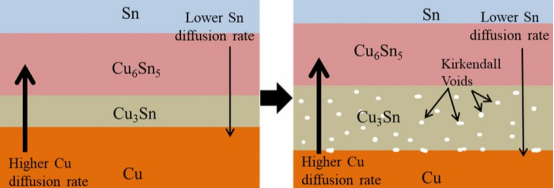
图1. 柯肯达尔空洞形成示意图。
1.2空洞影响及解决方法
不同金属间化合物相对应的热膨胀系数不同会造成内部应力。在受到应力作用下,焊点空洞附近会逐渐形成微裂纹。随着应力作用的叠加裂纹进一步扩展,最终导致脆性断裂。由于空洞的出现会导致焊点机械可靠性降低, 因此空洞率需要控制在10%以内。业界目前对于抑制空洞生成主要采用添加掺杂物质的方法。例如往无铅锡膏中加入镍来起到抑制空洞的效果。镍的加入使Cu3Sn层变薄。对于电镀铜基板,添加少量镍减少了空洞的数量。
2. 无铅锡膏热蠕变现象
2.1 成因
在高温作用下形成的热应力作用于元器件和焊点会导致热蠕变。焊点在使用过程中会不断地受到热循环的影响。由于电子器件, 基板和无铅锡膏焊点的热膨胀系数不匹配,不可避免地造成应力。随着温度升高,原子扩散速度加快,位错开始移动,导致晶界滑移,从而使焊点出现塑性变形。
2.2 热蠕变影响及解决方法
随着老化时间增加,焊点处的应变力会增加。当工作温度提高且载荷保持固定时,焊点会很快的变形并断裂。类似的,在低温环境和高载荷作用下,焊点依旧会变形并断裂。有研究发现往无铅锡膏中加入少量掺杂物例如Bi和Ni,可使锡银铜无铅锡膏位错移动减少,起到提高抗热蠕变作用。

图2. 不同温度下应变力和时间的关系。
3. 无铅锡膏电迁移
电子产品封装密度和互连数增长的非常快,这大大增加了电流密度。而电流密度是电迁移现象的主要诱因。电迁移是在高电流密度下由于电子和金属原子之间的动量转移而引起的物质迁移。电流密度增加会使元器件内部的生成焦耳热。温度随之上升并加速物质扩散和造成阴极侧空洞生成,最终造成焊点开路问题。
深圳市福英达工业技术有限公司是一家全球领先的微电子与半导体封装材料方案提供商。福英达锡膏,锡胶等产品润湿效果好,粉末颗粒均匀,焊后可靠性强。欢迎进入官网了解更多信息。
审核编辑 黄宇
- 相关推荐
- 锡膏
全部0条评论

快来发表一下你的评论吧 !

