

半导体后端工艺:晶圆级封装工艺(上)
描述
封装完整晶圆
晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。除此之外,重新分配层(RDL)封装、倒片(Flip Chip)封装及硅通孔 ^1^ (TSV)封装通常也被归类为晶圆级封装,尽管这些封装方法在晶圆切割前仅完成了部分工序。不同封装方法所使用的金属及电镀(Electroplating)^2^绘制图案也均不相同。不过,在封装过程中,这几种方法基本都遵循如下顺序。
^1^ 硅通孔(TSV , Through-Silicon Via): 一种可完全穿过硅裸片或晶圆实现硅片堆叠的垂直互连通道。
^2^ 电镀 (Electroplating): 一项晶圆级封装工艺,通过在阳极上发生氧化反应来产生电子,并将电子导入到作为阴极的电解质溶液中,使该溶液中的金属离子在晶圆表面被还原成金属。
完成晶圆测试后,根据需求在晶圆上制作绝缘层(Dielectric Layer)。初次曝光后,绝缘层通过光刻技术再次对芯片焊盘进行曝光。然后,通过溅射(Sputtering)^3^工艺在晶圆表面涂覆金属层。此金属层可增强在后续步骤中形成的电镀金属层的黏附力,同时还可作为扩散阻挡层以防止金属内部发生化学反应。此外,金属层还可在电镀过程中充当电子通道。之后涂覆光刻胶(Photoresist)以形成电镀层,并通过光刻工艺绘制图案,再利用电镀形成一层厚的金属层。电镀完成后,进行光刻胶去胶工艺,采用刻蚀工艺去除剩余的薄金属层。最后,电镀金属层就在晶圆表面制作完成了所需图案。这些图案可充当扇入型WLCSP的引线、重新分配层封装中的焊盘再分布,以及倒片封装中的凸点。下文将对每道工序进行详细介绍。
^3^ 溅射 (Sputtering): 一项利用等离子体束对靶材进行物理碰击,使靶材粒子脱落并沉积在晶圆上的工艺。

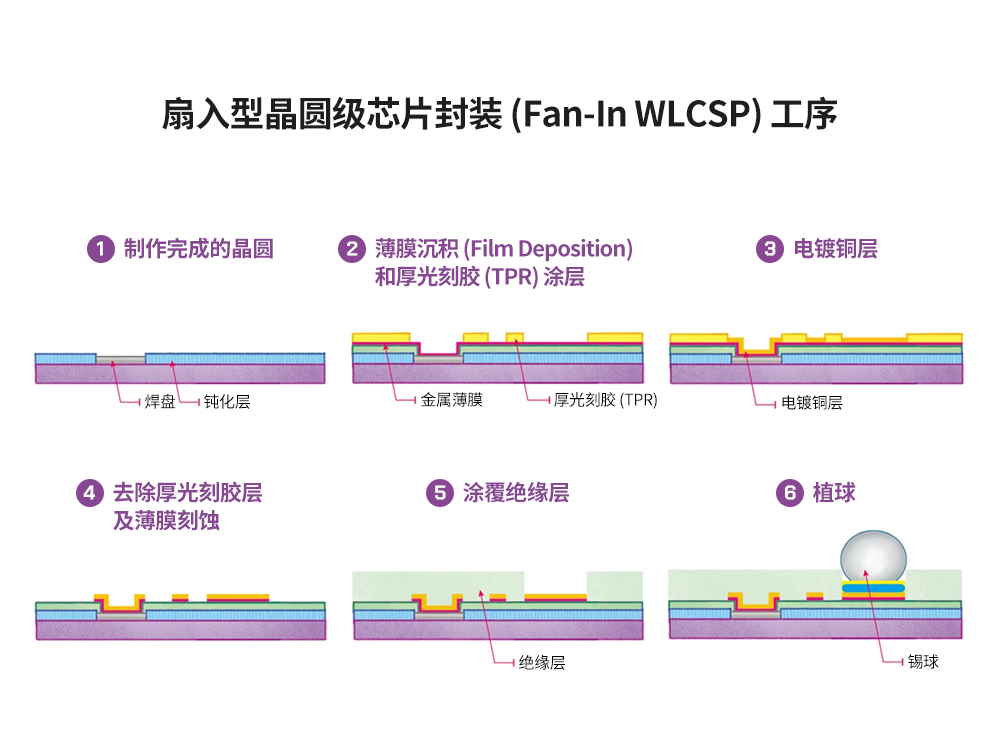
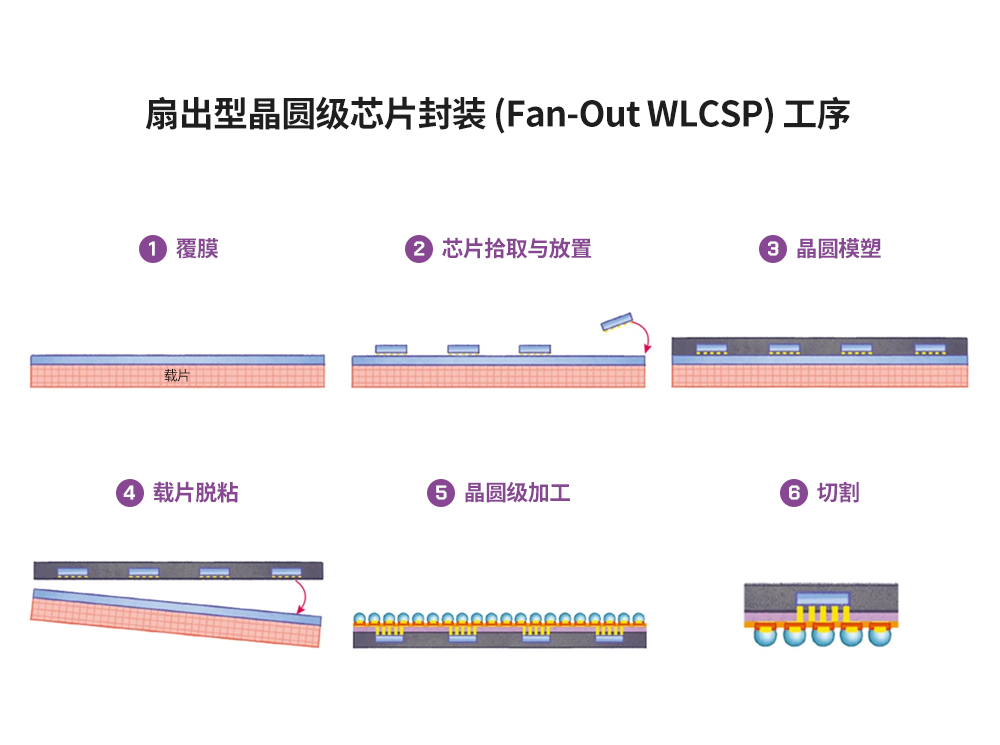
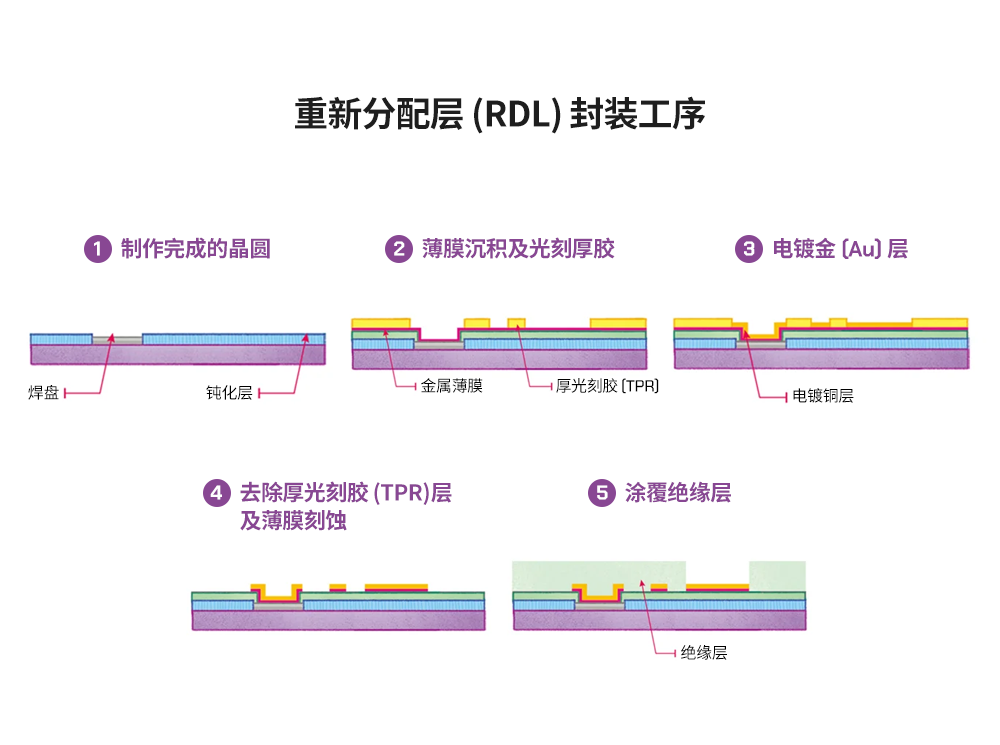
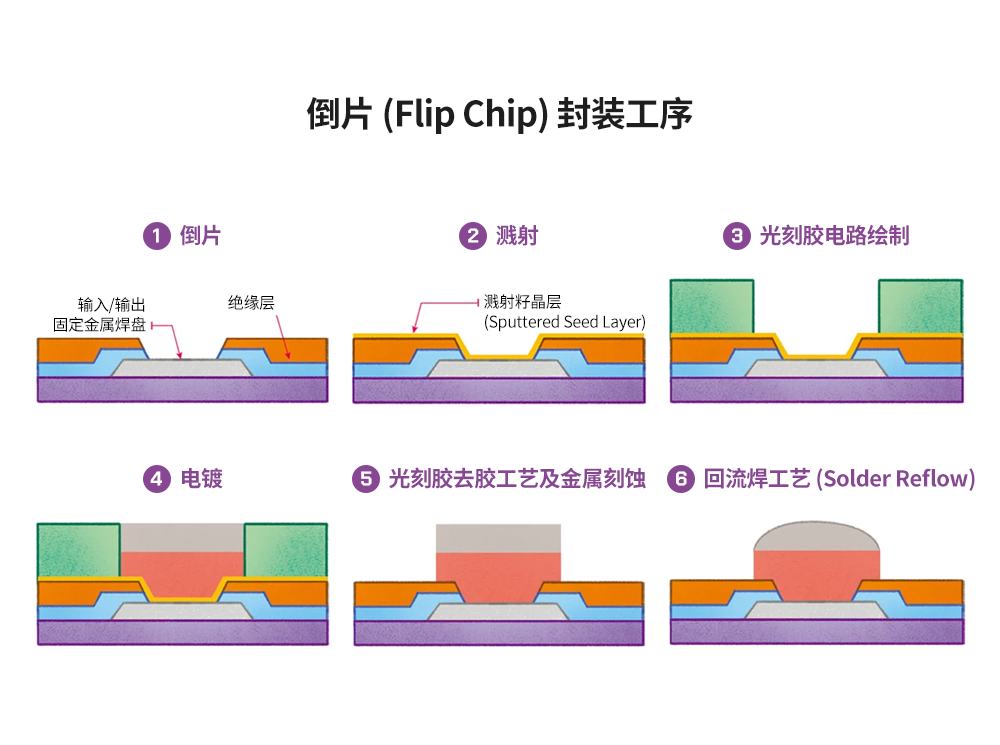

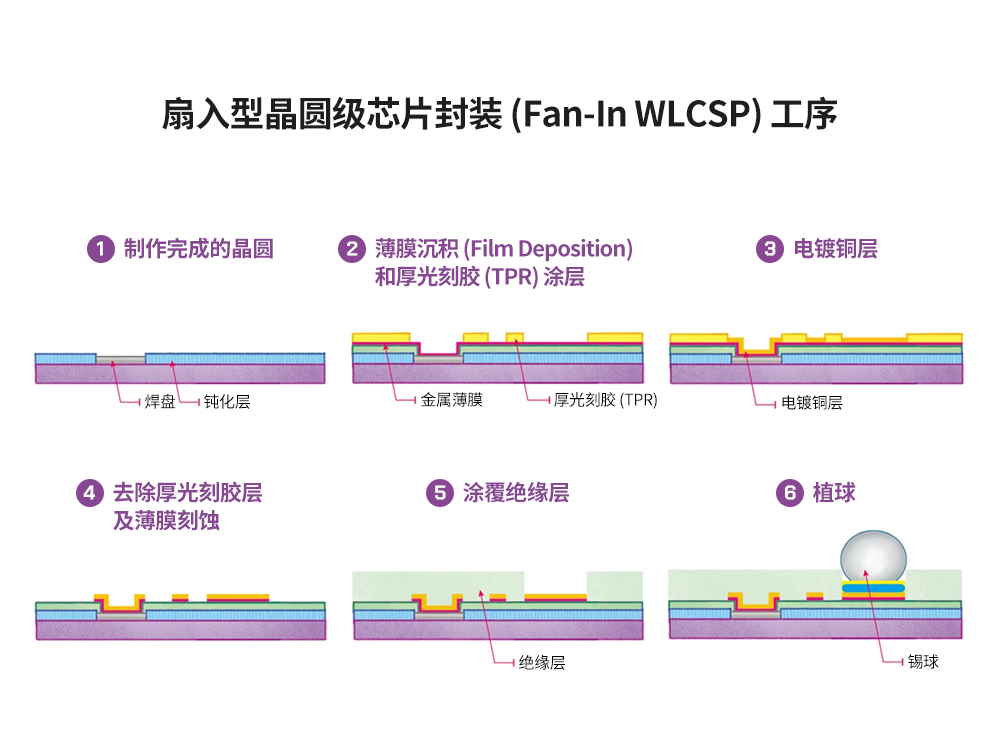
▲图1:各类晶圆级封装工艺及相关步骤
光刻工艺:在掩模晶圆上绘制电路图案
光刻对应的英文是Photolithography,由“-litho(石刻)”和“graphy(绘图)”组成,是一种印刷技术,换句话说,光刻是一种电路图案绘制工艺。首先在晶圆上涂覆一层被称为“光刻胶”的光敏聚合物,然后透过刻有所需图案的掩模,选择性地对晶圆进行曝光,对曝光区域进行显影,以绘制所需的图案或图形。该工艺的步骤如图2所示。
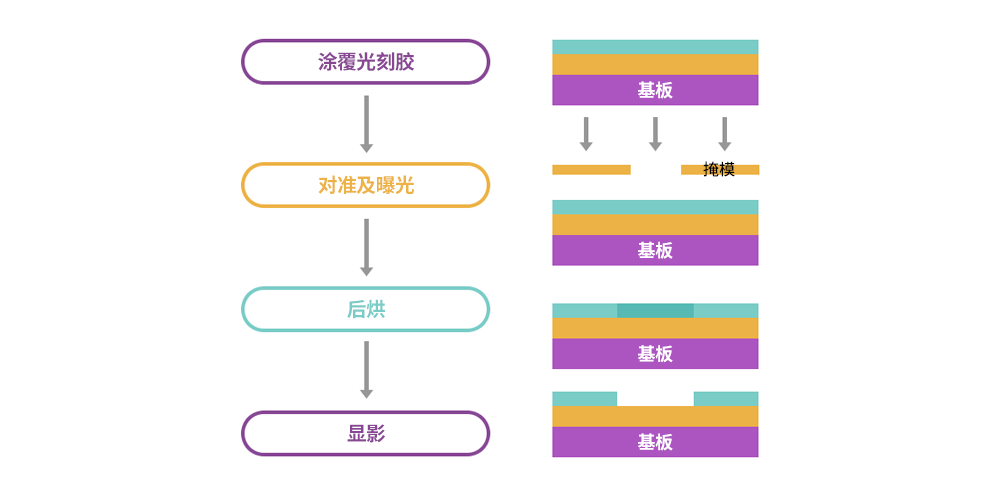
▲图2:光刻工艺步骤
在晶圆级封装中,光刻工艺主要用于在绝缘层上绘制图案,进而使用绘制图案来创建电镀层,并通过刻蚀扩散层来形成金属线路。
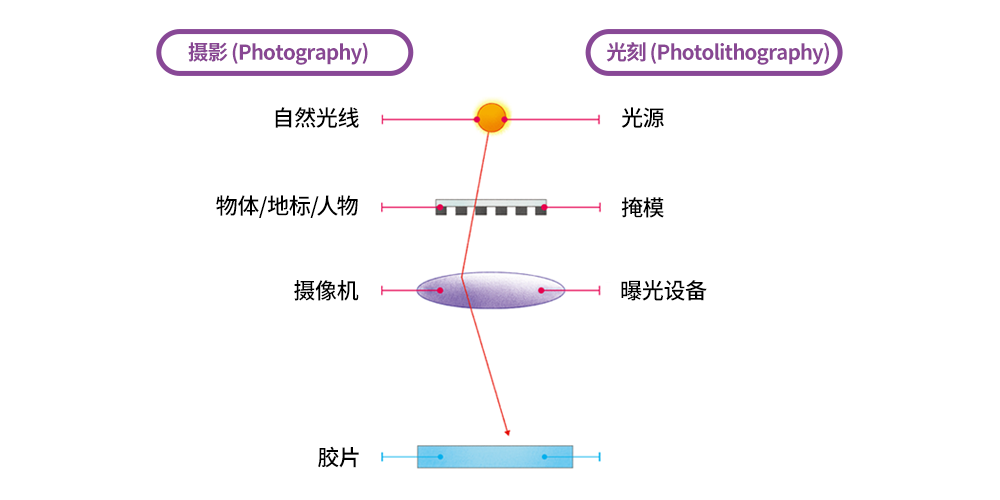
▲图3:摄影与光刻的对比
为更加清楚地了解光刻工艺,不妨将其与摄影技术进行比较。如图3所示,摄影以太阳光作为光源来捕捉拍摄对象,对象可以是物体、地标或人物。而光刻则需要特定光源将掩模上的图案转移到曝光设备上。另外,摄像机中的胶片也可类比为光刻工艺中涂覆在晶圆上的光刻胶。如图4所示,我们可以通过三种方法将光刻胶涂覆在晶圆上,包括旋涂(Spin Coating)、薄膜层压(Film Lamination)和喷涂(Spray Coating)。涂覆光刻胶后,需用通过前烘(Soft Baking)来去除溶剂,以确保粘性光刻胶保留在晶圆上且维持其原本厚度。
如图5所示,旋涂将粘性光刻胶涂覆在旋转着的晶圆中心,离心力会使光刻胶向晶圆边缘扩散,从而以均匀的厚度分散在晶圆上。粘度越高转速越低,光刻胶就越厚。反之,粘度越低转速越高,光刻胶就越薄。对于晶圆级封装而言,特别是倒片封装,光刻胶层的厚度须达到30 μm至100 μm,才能形成焊接凸点。然而,通过单次旋涂很难达到所需厚度。在某些情况下,需要反复旋涂光刻胶并多次进行前烘。因此,在所需光刻胶层较厚的情况下,使用层压方法更加有效,因为这种方法从初始阶段就能够使光刻胶薄膜达到所需厚度,同时在处理过程中不会造成晶圆浪费,因此成本效益也更高。但是,如果晶圆结构表面粗糙,则很难将光刻胶膜附着在晶圆表面,此种情况下使用层压方法,会导致产品缺陷。所以,针对表面非常粗糙的晶圆,可通过喷涂方法,使光刻胶厚度保持均匀。

▲图4:光刻胶涂覆的三种方法
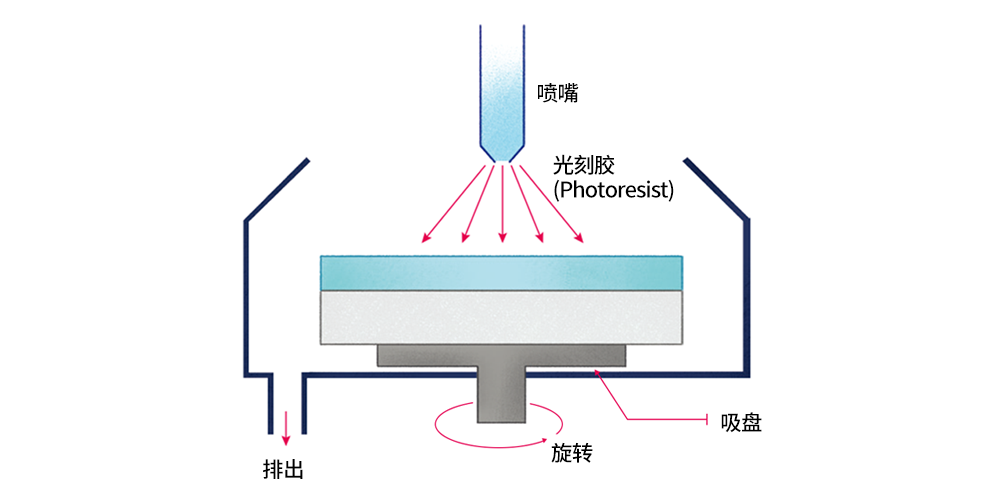
▲图5:旋涂方法示意图
完成光刻胶涂覆和前烘后,接下来就需要进行曝光。通过照射,将掩模上的图案投射到晶圆表面的光刻胶上。由于正性光刻胶(Positive PR)在曝光后会软化,因此使用正性光刻胶时,需在掩模去除区开孔。负性光刻胶(Negative PR)在曝光后则会硬化,所以需在掩模保留区开孔。晶圆级封装通常采用掩模对准曝光机(Mask Aligner)^4^或步进式***(Stepper)^5^作为光刻工艺设备。
^4^ 掩模对准曝光机(Mask Aligner): 一种将掩模上的图案与晶圆进行对准,使光线穿过掩模并照射在晶圆表面的曝光设备。
^5^ 步进式***(Stepper): 一种在工件台逐步移动时,通过开启和关闭快门控制光线以进行光刻的机器。
显影(Development)是一种利用显影液来溶解因光刻工艺而软化的光刻胶的工艺。如图6所示,显影方法可分为三种,包括:水坑式 显影(Puddle Development),将显影液倒入晶圆中心,并进行低速旋转;浸没式显影(Tank Development),将多个晶圆同时浸入显影液中;喷淋式显影(Spray Development),将显影液喷洒到晶圆上。图7显示了静态显影方法的工作原理。完成静态显影后,通过光刻技术使光刻胶形成所需的电路图案。

▲图6:三种不同的显影方法
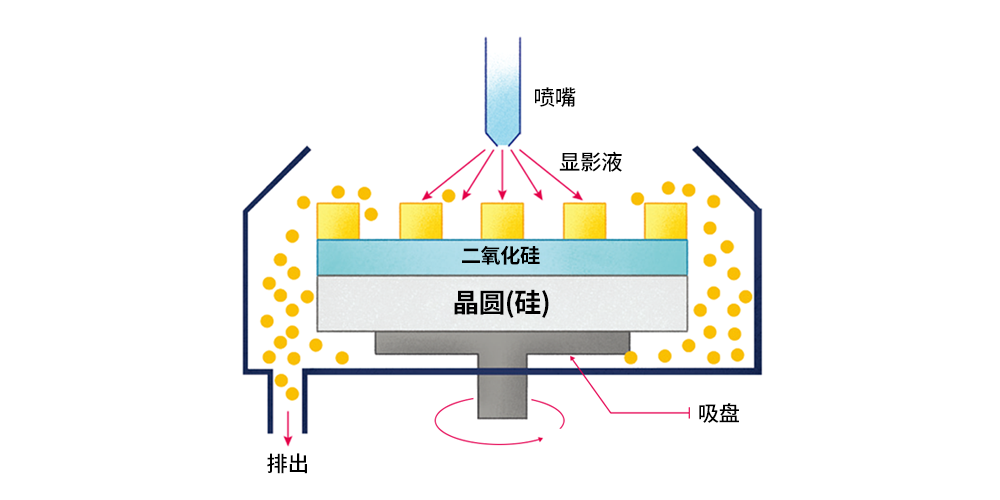
▲图7:水坑式显影方法的工作原理
审核编辑:刘清
-
晶圆级封装的五项基本工艺2024-01-24 3830
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1781
-
提供半导体工艺可靠性测试-WLR晶圆可靠性测试2025-05-07 7143
-
晶圆凸起封装工艺技术简介2011-12-01 5419
-
晶圆级CSP贴装工艺吸嘴的选择2018-09-06 2435
-
晶圆封装有哪些优缺点?2021-02-23 6774
-
新型封装工艺介绍2011-12-29 1359
-
半导体生产封装工艺简介2020-03-27 9936
-
两种标准的半导体制造工艺介绍2022-03-14 8362
-
半导体后封装工艺及设备2023-07-13 1354
-
半导体后端工艺:了解半导体测试(上)2023-07-24 4792
-
半导体封装工艺的研究分析2024-02-25 2217
-
闲谈半导体封装工艺工程师2024-05-25 4568
-
详解不同晶圆级封装的工艺流程2024-08-21 4963
-
深入探索:晶圆级封装Bump工艺的关键点2025-03-04 6336
全部0条评论

快来发表一下你的评论吧 !

