

晶圆键合的种类和应用
制造/封装
描述
随着半导体日益月新的发展,先进制程貌似已发展到极限,不再是提高器件性能的关键,再继续降低线宽受限于***以及其他关键材料,变得尤为困难。将制程往前推进1nm需要巨大的投入,性能的提升却比较有限,XY平面方向很难再有所突破,故而众多厂家多将眼光投向Z垂直方向的研究。Z轴方向研究主要为将晶圆减薄,通过TSV进行信号的延伸和互连,晶圆键合技术则是其中必不可少的重要工艺。
晶圆键合技术: 晶圆键合技术是将两片不同结构/不同材质的晶圆,通过一定的物理方式结合的技术。晶圆键合技术已经大量应用于半导体器件封装、材料及器件堆叠等多种半导体应用领域。随着市场应用对半导体器件集成度要求的进一步提高,基于成本和效率的考虑,晶圆键合越来越多的被用于2.5D及3D芯片堆叠,SOI,XOl,CMOS等制造工艺中,甚至已经成为最为关键的核心工艺。
晶圆键合的种类和应用具体如下图:

临时键合: 对于减薄后的晶圆,其物理结构和稳定性因背面的必要磨削而大大降低,在接下来的薄晶圆加工和制作单个微芯片中,超薄晶圆非常容易被损坏,因此在减薄晶圆前将一个载体晶圆与要加工的晶圆暂时性的牢固连接在一起。这些载体晶片可以是硅片,玻璃片或者蓝宝石片。这个过程被称为临时键合,其有助于保护晶圆在随后的处理中免受损坏。 临时键合后的晶圆组,客户即可安全进行减薄作业,目前一般减薄目标厚度在50-100um, 最新工艺在向20-30um 厚度发展。减薄后,还可能进行RDL, 以及其它背面工艺。这些工艺也将考验临时键合胶的耐温性、耐化性等工艺性能。 当薄晶圆完成一系列的加工后,则需要将临时支撑的载体晶圆与其分离,这个过程称之为解键合。薄晶圆使用特殊载盘进行单片清洗后即可交付后续测试、切片等工艺工序。

UV激光解键合:

308nm,343nm 和355nm 为目前主流方向,其他波段应用极少,吾拾使用的是355 nm 的固态激光方案。
直接键合: 可在较低键合温度下(通常在150℃以下)实现硅和玻璃、玻璃与不锈钢、医用钛、超导合金等金属键合以及各种陶瓷、金属间结合。 允许衬底之间在原子水平上的完美结合,因此不需要使用粘合剂、焊料或任何其他粘合剂。 可以将膨胀系数非常不同的材料粘合在一起。 对灰尘和表面状态不太敏感,无需直接键合所需的超高表面粗糙度以及洁净度。 可支持多尺寸晶圆键合,最大可达12英寸。
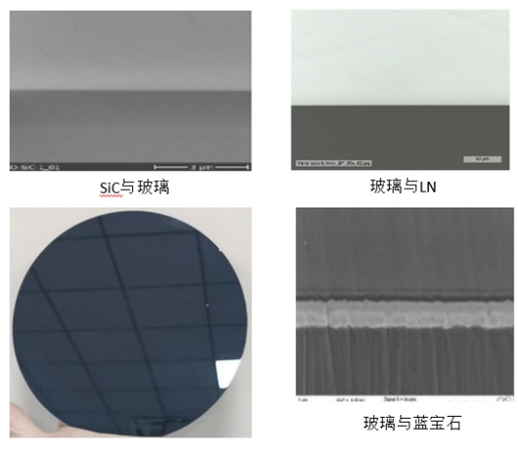
编辑:黄飞
全部0条评论

快来发表一下你的评论吧 !

