

IGBT的失效模式与失效机理分析探讨及功率模块技术现状未来展望
描述
失效率是可靠性最重要的评价标准,所以研究IGBT的失效模式和机理对提高IGBT的可靠性有指导作用。欢迎识别二维码加入IGBT产业链微信群及通讯录。压接型IGBT器件与焊接式IGBT模块封装形式的差异最终导致两种IGBT器件的失效形式和失效机理的不同,如表1所示。本文针对两种不同封装形式IGBT器件的主要失效形式和失效机理进行分析。
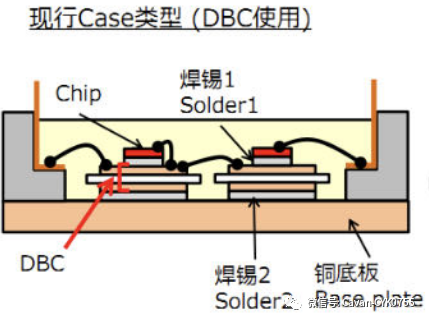

1. 焊接式IGBT模块
封装材料的性能是决定模块性能的基础,尤其是封装材料的可靠性对模块的可靠性具有非常重要的影响,其中最主要的指标是热膨胀系数,其次是电导、热容和热导率等。材料热膨胀系数的不同往往是造成模块失效的根本原因。IGBT会在不同条件下产生温度波动,材料热膨胀系数的不同会导致热应力不同,从而对器件内部产生影响。所以相邻界面材料的热膨胀系数差异应尽可能小。焊接式IGBT模块封装常用材料的热膨胀系数(α)如图1所示。

1.1键合引线脱落:焊接式IGBT模块的失效模式中,键合引线的脱落是最容易发生的,有资料表明引线的脱落可以占到IGBT模块失效的70%左右。键合引线一般是铝引线,在引线长期受热应力反复作用达到一定程度后,电流快速流过时发生电弧闪络,就会造成键合线剥落脱离,在键合线与芯片相接触部分的界面上产生焊坑,并且可以在芯片上检测到焊料残留。
如图3所示,其实在焊线脱离之前,由于功率循环的作用,剪切应力不断施加在界面上,会导致焊料层因材料疲劳出现裂纹,裂纹生长甚至出现分层、空洞或气泡,并最终导致引线的脱落。
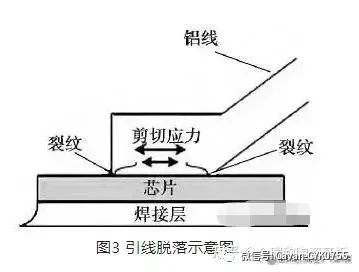
改进焊接的工艺,如利用超声键合技术和利用铜引线键合技术可以显著提高引线的粘附质量。利用银烧结技术和在焊线上涂聚酰亚胺也会实现很好的功率循环能力,一定程度提高焊线和焊层的寿命。
1.2焊接层疲劳:焊料层疲劳也是一种常见的焊接式IGBT模块失效模式。所谓的焊料疲劳是由于焊层与接触面断裂或分层,造成器件的热阻增加,加快了器件整体的失效,如图4 所示。图5 为1200V/150A IGBT芯片工作时表面的温度分布,芯片对角线的温度梯度差达到了40℃,焊料界面退化的直接原因是由于热膨胀系数的差别引起的高应力。焊料界面的断裂增加了相应芯片区域的局部热阻,从而使芯片温度局部增加。
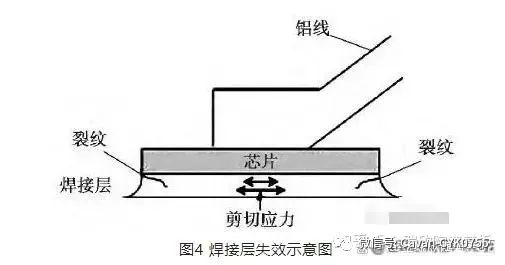
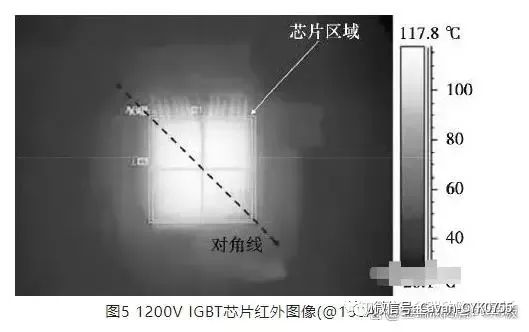
如果断裂从边缘开始,温度相对较低的芯片区域温度增加,而芯片中心最高温度保持不变。当断裂从中心最高温度开始时,芯片中心最高温度会迅速增加。这种正反馈循环加速会加快整个界面焊料层的疲劳进度,因而会降低功率模块的寿命。
1.3金属化重建:焊接式IGBT模块经历反复温度波动后会在金属化的铝层中出现颗粒状的结构。在结温高于110℃时,温度循环加热阶段的周期性应力会导致颗粒超过其弹性应变极限,从而导致塑性变形。利用扫描声学显微镜(SAM)可以很好地检测,图6给出了功率循环期间各种不同温度的影响。图6(a)给出了3200000个功率循环,在85~125℃时的IGBT表面金属化图像;图6(b)给出了7250个功率循环,功率循环温度差ΔT=131K,θhigh=171℃时IGBT表面金属化图像;图6(c)给出了16800个功率循环,40~200℃后二极管的表面金属化图像。
 接触面的金属层重建导致接触电阻增加是产生故障的根本原因。比如经过几百次功率循环后,AlN衬底上的铝层厚度可以达到300μm,界面的表面粗糙度增加超过10倍。有研究表明引线键合边缘部分下面的重建效应被抑制,原因是聚酰亚胺覆盖层抑制了表面金属化重建,因为任何覆盖层都将限制颗粒的运动,如图7所示。
接触面的金属层重建导致接触电阻增加是产生故障的根本原因。比如经过几百次功率循环后,AlN衬底上的铝层厚度可以达到300μm,界面的表面粗糙度增加超过10倍。有研究表明引线键合边缘部分下面的重建效应被抑制,原因是聚酰亚胺覆盖层抑制了表面金属化重建,因为任何覆盖层都将限制颗粒的运动,如图7所示。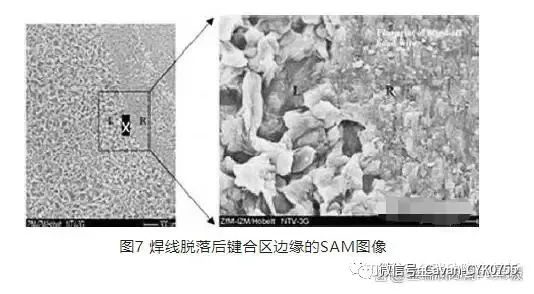
2. 压接型IGBT器件:压接型IGBT器件与焊接式IGBT模块结构有很大区别,失效模式与失效机理不尽相同。压接型IGBT器件不仅设计紧凑,可实现双面散热,而且可以克服焊接式IGBT键合引线的失效模式。同时各部件靠压力接触避免了热膨胀系数不同的焊层与各层的刚性连接。当然压接型IGBT也不是完美的,压接模块没有介电隔离,压力不均以及弹簧松弛等也是与焊接模块不同的可靠性问题。压接型IGBT失效根源也有与焊接式IGBT相似的地方,比如热膨胀系数不匹配或热应力造成部件形变等原因。
2.1微动磨损:微动磨损是压接型IGBT器件最常见的失效模式。造成微动磨损最根本的原因也是热膨胀系数的不匹配,造成各个界面的材料在膨胀和收缩过程中产生微小的相互摩擦和滑动,如图8所示。微动磨损会造成各接触面的相对摩擦,进而使表面粗糙度增加,使表面接触热阻和接触电阻增加。这样在功率循环过程中会不断增加芯片的结温,造成失效加速。
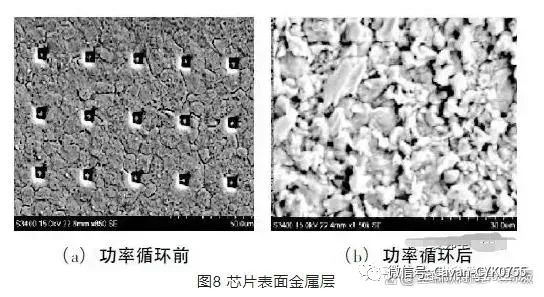
2.2微烧蚀:压接型IGBT器件功率循环试验之后,可以用光学显微镜观测到一些银片和钼片之间有很严重的烧蚀后消融现象,如图9所示。
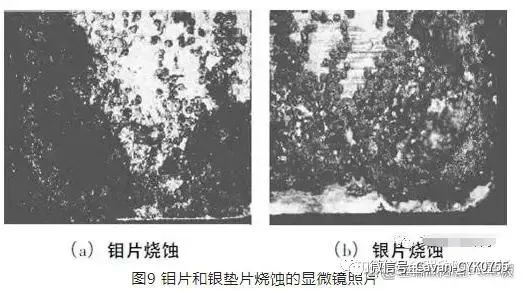
这种局部烧蚀是由于芯片微小电弧放电所致。相接触表面有彼此的材料残留,这种机制与机械工程领域中的电火花加工工艺(electrical discharge machining,EDM)十分相似,所以也可称这种机理为微小放电。压接型IGBT器件通过外部施加一定的压力保持组件间的电气与机械连接,两接触面间的压力过小会造成接触不良。接触不良还会导致接触面间存在一定的电压差,进而产生电弧放电。T.Poller等人提出了导致压接型IGBT器件局部接触不良的原因,如图10所示。
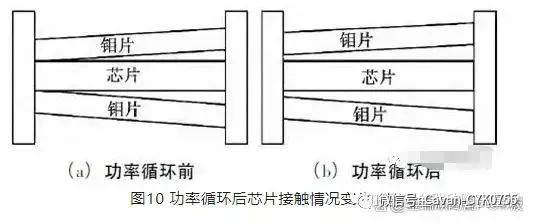 在通负载电流之前,封装内部的各芯片由于压力不均导致只有一侧是相互接触,这时模块的基本功能还能实现。在关断负载电流之后,IGBT停止发热,各部件开始降温收缩。由于热膨胀系数的不同,各部分与管壳相比时间常数更小,所以收缩更快。这样会导致内部芯片完全失去接触。
在通负载电流之前,封装内部的各芯片由于压力不均导致只有一侧是相互接触,这时模块的基本功能还能实现。在关断负载电流之后,IGBT停止发热,各部件开始降温收缩。由于热膨胀系数的不同,各部分与管壳相比时间常数更小,所以收缩更快。这样会导致内部芯片完全失去接触。
2.3栅氧层损坏:如图11所示,在压接型IGBT器件中,IGBT芯片上有一层附加金属层以便承受住巨大的压力。
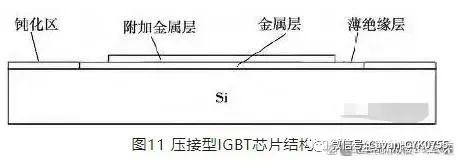 另一种失效模式可能是栅极和发射极的氧化层损坏造成的极间短路。一个正常完好的IGBT器件的栅极漏电流通常在微安范围,那么栅射电阻RGE在千欧级及以下范围时就可以判定器件短路。进一步说就是栅射电阻减小导致栅极漏电流增大。若栅极驱动电路不能提供已经增大了的栅极电流,栅射电压VGE的值就会下降。这样就会造成芯片中的导电通道变窄,导致集射电压VCE阶梯状(如图12所示,图中n为循环次数)。如上所述,集射电压的变化会造成芯片上的裂痕。如图13所示,梳状发射极上很多有单条裂痕。同时可以从图13(a)可以看到附加金属层与发射极分层,这样可能导致IGBT芯片和相接触钼片相对滑动。
另一种失效模式可能是栅极和发射极的氧化层损坏造成的极间短路。一个正常完好的IGBT器件的栅极漏电流通常在微安范围,那么栅射电阻RGE在千欧级及以下范围时就可以判定器件短路。进一步说就是栅射电阻减小导致栅极漏电流增大。若栅极驱动电路不能提供已经增大了的栅极电流,栅射电压VGE的值就会下降。这样就会造成芯片中的导电通道变窄,导致集射电压VCE阶梯状(如图12所示,图中n为循环次数)。如上所述,集射电压的变化会造成芯片上的裂痕。如图13所示,梳状发射极上很多有单条裂痕。同时可以从图13(a)可以看到附加金属层与发射极分层,这样可能导致IGBT芯片和相接触钼片相对滑动。
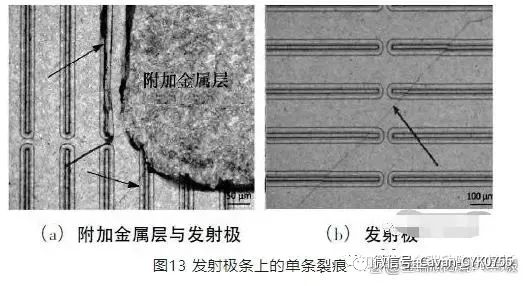
图14(a)所示的是大范围裂纹,这就是钼片一端倾斜导致一端压力过大造成的。图14(b)所示IGBT芯片附加金属区的裂痕和磨损。图14(c)所示的是第三种类型裂痕,这是某一小片区域因为个别点压力过大造成了芯片的损坏。所有上述的损坏都是因为局部应力过大,而压力过大是由于栅极氧化层的损坏造成的。
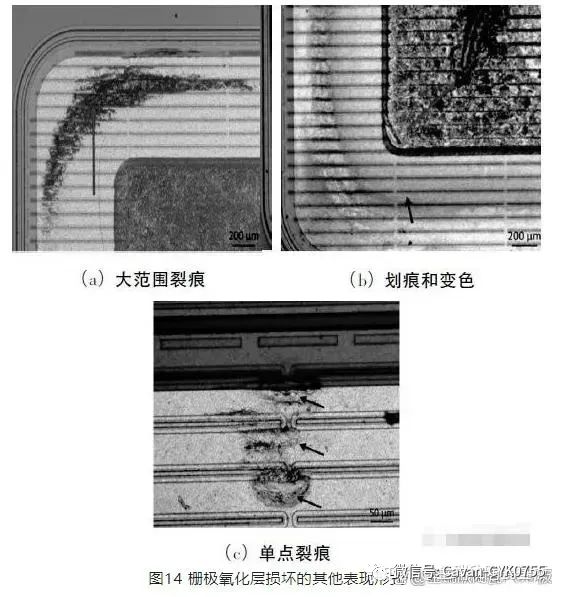 2.4 弹簧失效:弹簧失效也是压接型IGBT一种特有的失效模式。弹簧失效一般包括弹簧疲劳、弹簧应力松弛、磨损等。栅极弹簧会随着时间推移和温度的变化出现应力松弛现象,如图15所示。弹簧松弛后会导致栅极探针与栅极表面接触不良,进而增加了接触电阻,提升了结温,加速器件失效。
2.4 弹簧失效:弹簧失效也是压接型IGBT一种特有的失效模式。弹簧失效一般包括弹簧疲劳、弹簧应力松弛、磨损等。栅极弹簧会随着时间推移和温度的变化出现应力松弛现象,如图15所示。弹簧松弛后会导致栅极探针与栅极表面接触不良,进而增加了接触电阻,提升了结温,加速器件失效。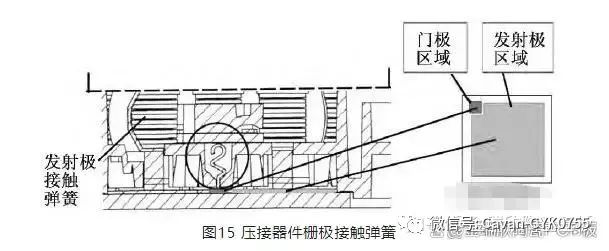 弹簧应力松弛与材料、温度和时间有关,具体函数关系可表示为
弹簧应力松弛与材料、温度和时间有关,具体函数关系可表示为
式中:σ是经过t小时后弹簧剩余应力值;σ0是弹簧初始应力值;A和B是与温度有关的材料常数。在功率循环过程中,弹簧在快速加热和冷却过程中会出现热疲劳,甚至到最后有可能发展成为弹簧断裂。弹簧的热疲劳主要与功率循环的温度设定情况和弹簧刚性(弹簧的材料、几何形状)有关。
2.5宇宙射线:宇宙射线是焊接式和压接型IGBT的一种共有的失效机制,也会导致器件的失效烧毁。宇宙射线导致的失效无法预测,没有任何先兆。IGBT与其他器件如二极管、晶闸管和GTO等相比对宇宙射线造成的影响更加敏感。宇宙射线主要是宇宙空间中超新星爆发所产生的高能粒子。这些最初的宇宙射线通常无法直接到达地球表面,但会与大气中的其他粒子碰撞分解为诸如π介子、μ介子和中子等其他高能粒子。宇宙射线一般来说破坏芯片非常随机,其作用的位置和芯片数量也很随机。高能粒子中的一小部分中子穿过IGBT器件和硅原子核发生碰撞,产生背散射粒子,这些离子会再次产生一个局部电荷浓度很高的等离子体。在空间电荷区中这些载流子分离产生电流脉冲,如果因等离子体产生的电场强度超过一定阈值,碰撞电离产生的载流子就会高于因扩散机制流出等离子体的载流子。这种放电称为"流光",类似于气体放电。在数百皮秒内,器件局部被自由载流子湮没,产生一个局部电流管道。最后半导体器件就被非常高密度的局部电流破坏了,如图16所示。

3. 结语
焊接式IGBT模块和压接型IGBT器件内部都是多层结构。焊接式IGBT是将Si芯片通过焊料焊接在DCB板上,再通过铝键合引线连接Si芯片和外接电路。其中键合线脱落是焊接式IGBT模块最常见的失效模式。焊接式IGBT模块通过各个不同材料焊接在一起,不同材料热膨胀系数的不同是焊接式IGBT模块失效的最主要的原因。压接型IGBT是靠压力将各部件连接,这样完全消除了传统焊接式IGBT技术中与键合线和焊接层相关的失效形式。压接型IGBT器件虽然消除了键合线和焊接层带来的失效,但引入了外部压力以及弹簧,所以存在一些由于压力不均匀或弹簧疲劳带来的失效。
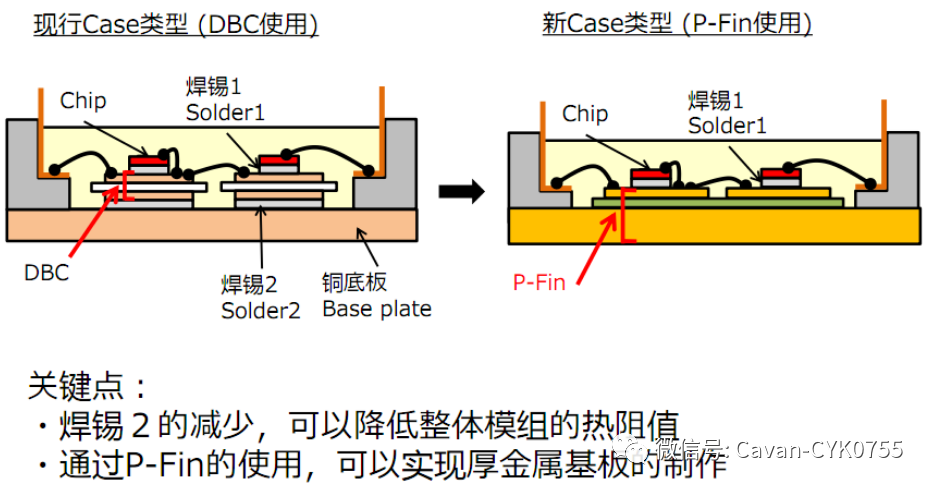
从上述分析可以看到焊接式IGBT与压接型IGBT的失效模式是不同的,其中只有宇宙射线对器件的损坏是共有的失效模式。两者其他的失效模式也是在经历功率循环的过程中热膨胀系数不匹配所造成的,所以在提高IGBT器件可靠性时,新材料的研发和使用至关重要。同时,利用一些新技术也可以提高IGBT的可靠性。很少有文献提到对压接型IGBT比如选用材料、芯片布局和制造工艺等技术上的改进,这也是以后需要进一步深入研究的方面。
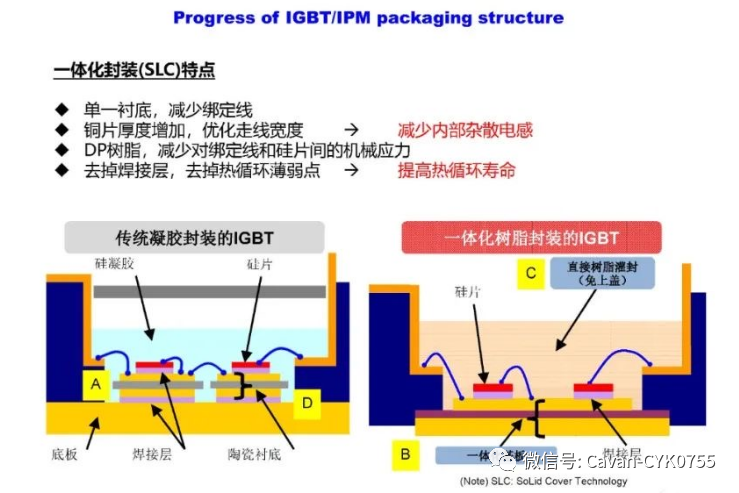
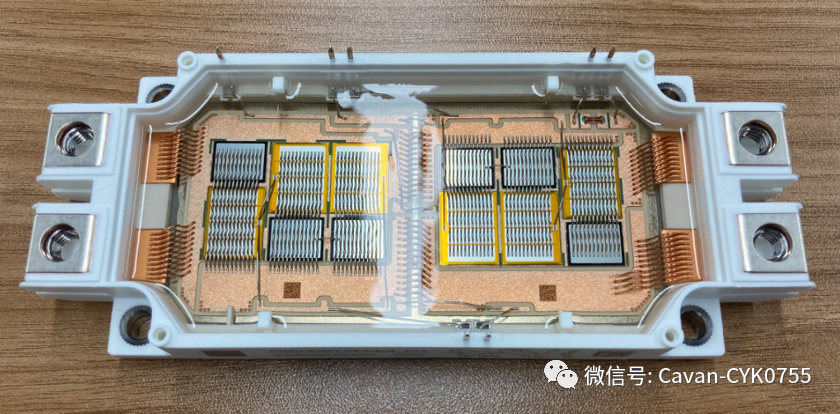
碳化硅功率模块是使用碳化硅半导体作为开关的功率模块。 碳化硅功率模块用于转换电能,转换效率高 — 功率是指电流和电压的乘积。碳化硅半导体带隙宽,用于 MOSFET 中时,开关损耗极低,因此相较于普通的硅器件,可允许更高的开关频率。同时,与传统的硅半导体相比,碳化硅半导体能够在更高的温度和更高的电压下工作。

碳化硅功率模块的生产工艺流程主要包括陶瓷基板排片、银浆印刷、芯片贴片、银烧结、真空回流焊、引线框架组装焊接、引线键合、等离子清洗、塑封、X光检测、测试包装等环节。

碳化硅半桥模块的生产工艺流程图
-
电容的失效模式和失效机理2011-12-03 9391
-
求IGBT失效机理分析2012-12-19 3478
-
IGBT的失效机理2017-03-16 4240
-
IGBT传统防失效机理是什么?2021-03-29 2145
-
从安全工作区探讨IGBT的失效机理2010-02-22 3830
-
高压IGBT关断状态失效的机理研究2016-05-16 1036
-
什么是电阻器的失效模式?失效机理深度分析必看2017-10-11 14403
-
元器件的长期储存的失效模式和失效机理2017-10-19 1314
-
MEMS惯性器件典型失效模式及失效机理研究2018-05-21 10243
-
电容失效模式和失效机理分析2021-12-11 4818
-
电阻器常见的失效模式与失效机理2022-02-10 1127
-
IGBT失效模式和失效现象2023-02-22 1365
-
压接型与焊接式IGBT的失效模式与失效机理2023-04-20 4595
-
IGBT器件失效模式的影响分析2024-04-18 2673
-
晶闸管的失效模式与机理2024-05-27 3364
全部0条评论

快来发表一下你的评论吧 !

