

关于铝镓氮(AlGaN)上p-GaN的高选择性、低损伤蚀刻
电子说
描述
引言
GaN基高电子迁移率晶体管(HEMT)由于其高频和低导通电阻的特性,近来在功率开关应用中引起了广泛关注。二维电子气(2DEG)是由AlGaN/GaN异质结中强烈的自发和压电极化效应引起的,这导致传统器件通常处于导通状态,即耗尽模式。
我们通过精确控制p-GaN层的蚀刻深度,同时对底层AlGaN势垒造成较小蚀刻损伤,对于恢复接入区域中的高密度电子是必要的,这是p-GaN栅极HEMT制造中较关键的工艺。通常,我们为了完全耗尽沟道中的2DEG以进行常关操作,会在外延技术中采用厚的p-GaN层和薄的AlGaN层。
由于过度蚀刻,AlGaN势垒进一步变薄,即使是几纳米,也可能导致接入区电导率的急剧下降,这意味着器件输出性能的下降。另一方面,未蚀刻的Mg掺杂p-GaN层可以形成导致断态泄漏的导电沟道。因此,对于具有更高驱动电流、更低关断泄漏和改进动态导通电阻的高性能E模式HEMT器件,需要精确控制p-GaN蚀刻深度,同时对AlGaN表面造成较小损害。
实验与讨论
在这项工作中,英思特使用了两种在6英寸Si衬底上外延生长的p-GaN/AlGaN/GaN和AlGaN/GaN异质结构。一种是p-GaN (80nm)/Al0.25Ga0.75N(15nm)/无意掺杂的GaN(300nm)/缓冲层(4.2μm)/Si(1mm),另一种是Al0.25Ga0.75N(15nm)/无意掺杂的GaN (300nm)/缓冲层(4.2μm)/Si(1mm)。在本文的其余部分中,它们被称为p-GaN样品和AlGaN样品。
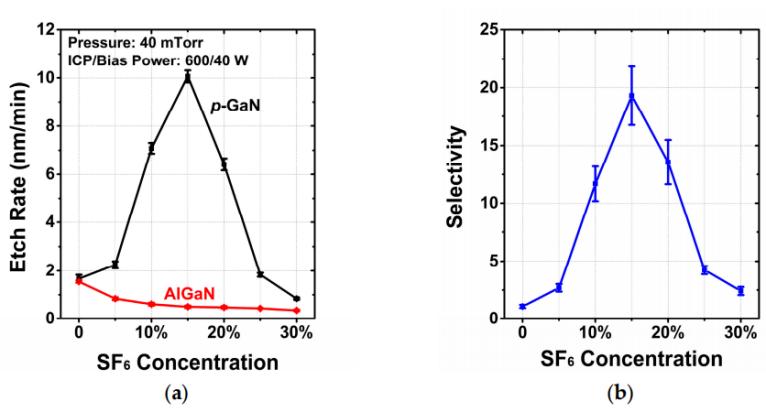
图1:(a)的蚀刻速率、p-GaN和AlGaN之间的(b)选择性对六氟化硫浓度的依赖性
SF6浓度选择性蚀刻工艺对环境中的SF6浓度有着很强的依赖性(如图1)。当SF6浓度从0增加到15%时,观察到p-GaN刻蚀速率显著增强。由于活性氯的催化生成,进一步增加SF6气体流量。综上所述,添加SF6对p-GaN的刻蚀有两个方面的影响,并且可以优化浓度以获得较佳效果。p-GaN 蚀刻。对于AlGaN样品,由于非挥发性AlFx的形成充当强大的蚀刻停止层,蚀刻速率随着SF6浓度的增加而单调降低。
为了全面研究所开发工艺对p-GaN/AlGaN晶圆的实际效果,英思特用AFM测量了不同刻蚀时间的刻蚀深度。蚀刻过程非常线性,直到到达AlGaN表面。图2中的X-SEM清楚地显示出在优化工艺下经过2.5分钟的蚀刻后,AlGaN表面非常光滑且几乎没有凹陷,从而证明了对 AlGaN层的高选择性蚀刻。
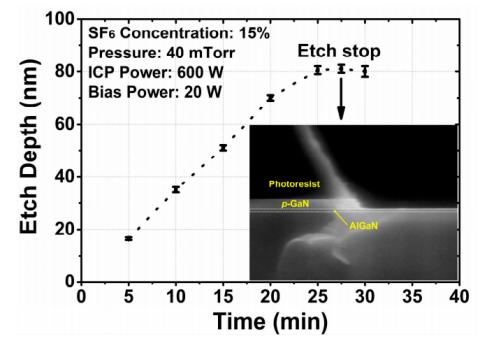
图2
为了进一步评估所开发的选择性蚀刻工艺对AlGaN表面的影响,我们以非接触模式对上述样品A和样品B优化工艺下的刻蚀拍摄了表面形貌的AFM图像。正如图3所见,对于样品 A,暴露的AlGaN表面非常光滑,均方根(RMS)表面粗糙度为0.428nm,这与生长的AlGaN表面(0.446nm)相似。这归因于所开发的高选择性蚀刻的优点及其低功率造成的表面损伤非常小。
然而,对于样品B的非选择性p-GaN蚀刻,暴露的AlGaN表面粗糙度高达0.987nm。这相当于生长的p-GaN表面,由于Cp2Mg的掺杂,其具有1.053nm RMS粗糙度。显然,样品B AlGaN 表面要粗糙得多,因为由于非选择性蚀刻的性质,其形貌基本上继承自生长的p-GaN 层。
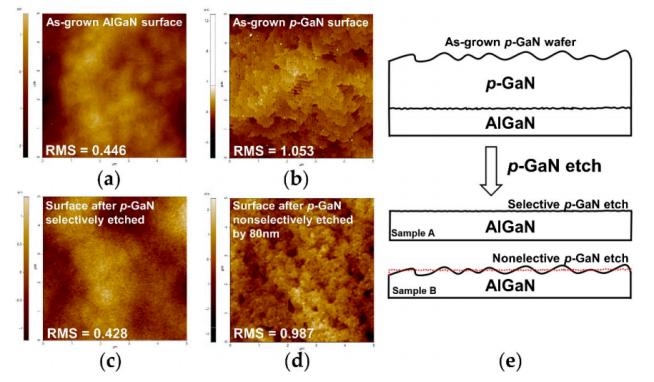
图3:表面形态
结论
在这项工作中,英思特通过使用BCl3/SF6混合物在AlGaN上成功开发了p-GaN的高选择性ICP刻蚀工艺,实现了41:1的高选择性。在这样的AlGaN表面上,制备的Ni/Al2O3/AlGaN MIS 电容器表现出与外延AlGaN表面相当的C-V特性。这一现象表明,蚀刻p-GaN层后AlGaN表面几乎没有损伤,使得该工艺将有希望应用于高性能p-GaN栅极HEMT的制造。
审核编辑 黄宇
-
什么是高选择性蚀刻2025-03-12 1160
-
AlGaN/GaN结构的氧基数字蚀刻2023-10-10 1755
-
载体晶圆对蚀刻速率、选择性、形貌的影响2023-05-30 1669
-
为下一代芯片推出高选择性蚀刻2023-03-20 3128
-
氮化镓晶体管GaN的概述和优势2023-02-27 2342
-
AlGaN/GaN的光电化学蚀刻工艺2022-07-12 2033
-
关于AlN和GaN的刻蚀对比研究—江苏华林科纳半导体2022-01-14 4417
-
基于 KOH 的 AIN 和 GaN 体的选择性湿化学蚀刻2022-01-05 1774
-
采用可控湿法蚀刻速率的AlGaN/GaN的精密凹槽 华林科纳2021-12-13 3650
-
《炬丰科技-半导体工艺》GaN的晶体湿化学蚀刻2021-07-07 2435
-
什么是GaN透明晶体管?2020-11-27 2904
-
为什么GaN会在射频应用中脱颖而出?2019-08-01 2763
-
通过选择性控制系统口诀了解选择性控制系统应用2019-04-21 13105
全部0条评论

快来发表一下你的评论吧 !

