

浅析IGBT中的MOS结构—Rds(on)
电子说
描述
在推导MOS的IV特性时,我们通过建立了电阻R和电压V之间的关系,从而消除欧姆定律中的电阻R,得到电流与电压之间的关系,但这里所讨论的电阻仅仅是沟道电阻。
对于IGBT中的MOS结构而言,其电阻不仅包括沟道电阻,还包括N-base区域的体电阻。
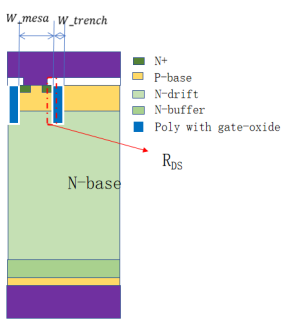
回顾 表达式如下,
表达式如下,

MOS正常工作状态下,  ,可以忽略上式右边第二项,于是沟道部分的电阻可表达为,
,可以忽略上式右边第二项,于是沟道部分的电阻可表达为,

假设如图所示,沟槽之间的MESA宽度为 ,沟槽的宽度为
,沟槽的宽度为 ,那么对于周期性排布的MOS结构来说,其方阻(电阻乘以面积,即
,那么对于周期性排布的MOS结构来说,其方阻(电阻乘以面积,即 )为:
)为:

对于N-base区域的体电阻计算,可以做一个简化的推导,简化条件为:
1.电子从MOS沟道注入后,积累在沟槽栅氧的外侧;
2.电子到达沟槽底部后再向下扩散;
3.电子在N-base区域以45°角向背面扩散;
4.扩散路径中各处电子浓度、迁移率相同,即N-base中具有相同的电阻率 。
。
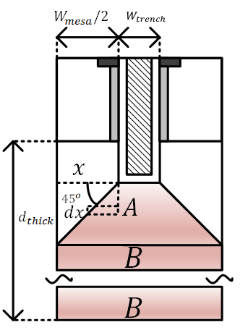
这里对这几个简化条件的合理性做一个说明:
1.因为MOS工作过程中,栅极持续施加正电压,因此靠近栅氧的半导体能带被电子占有的概率更高,所以从源极注入的电子更倾向于在栅氧表面积累;
2.沟道底部距离沟槽底部之间的区域相较整个N-base区域而言,电阻占比很小,计算中可以忽略;
3.稳态工作下,器件内部处于电中性状态,因此内部电场基本可以忽略,电流由扩散电流主导;
4.扩散运动的绝大部分电子分布在45°角的范围内。
根据电阻的表达式: ,其中L为电路路径方向的长度,S为电流路径的截面积。显然,可以将体电阻划分为A和B两个区域,A区域为一个等腰梯形,B区域为一个长方形。
,其中L为电路路径方向的长度,S为电流路径的截面积。显然,可以将体电阻划分为A和B两个区域,A区域为一个等腰梯形,B区域为一个长方形。
A区域的电阻对梯形积分即可计算得到,

B区域的电阻即长方形的面积,

所以,N-base总电阻即将 相加而得,
相加而得,

与沟道电阻的方阻计算相似,将 乘以面积
乘以面积 即可得到N-base的方阻,并将乘积整理成,
即可得到N-base的方阻,并将乘积整理成,

将沟道电阻与N-base电阻相加,即得到MOS的总电阻Rds(on)方阻,

至此,我们就基本完成了对IGBT中MOS结构的静态工作机理分析。
举例,对于一个MOS,其相关参数设计如下,mesa宽度为4 ,沟槽宽度为1.5
,沟槽宽度为1.5 沟槽深度为3
沟槽深度为3 ,栅氧厚度为100
,栅氧厚度为100 ,沟道内的电子迁移率
,沟道内的电子迁移率 ,N-base内的电子迁移率
,N-base内的电子迁移率 ,假设在栅极施加电压为10V的条件下,其N-base内的电子浓度为1e16
,假设在栅极施加电压为10V的条件下,其N-base内的电子浓度为1e16  计算芯片厚度从10
计算芯片厚度从10 增加到100
增加到100 ,沟道电阻在整体电阻中的占比。
,沟道电阻在整体电阻中的占比。

-
IGBT中的MOS结构—输入电容(上)2023-11-29 4132
-
如何识别MOS管和IGBT管?2019-05-02 5142
-
MOS管和IGBT管有什么区别?2020-07-19 3654
-
IGBT和MOS管以及可控硅的区别在哪2021-09-09 6756
-
浅析IGBT驱动2012-06-16 2418
-
浅析MOS管介绍与应用2021-11-13 1623
-
MOS管和IGBT管的区别2022-04-24 12493
-
MOS管和IGBT管有什么差别2023-01-30 4129
-
MOS管和IGBT的结构特点与区别2023-02-23 777
-
MOS管和IGBT管的区别说明2023-02-24 871
-
igbt和mos管的优缺点2023-05-17 2649
-
详解:MOS管和IGBT的区别2022-07-21 7653
-
威兆MOS和IGBT在光伏储能中的应用2022-08-03 3938
-
igbt与mos管的区别2023-12-07 3609
-
MOS管和IGBT的结构区别2024-06-09 2080
全部0条评论

快来发表一下你的评论吧 !

