

微结构硅基光电二极管的近红外响应特性实验研究
描述
宽带隙红外光谱响应由于其在硅基光电探测器中的潜在应用而受到了广泛关注。据麦姆斯咨询报道,近期,中国科学院微电子研究所集成电路先导研发中心、中国科学院大学集成电路学院和电子科技大学光电科学与工程学院的科研团队在《电子科技大学学报》期刊上发表了以“微结构硅基光电二极管的近红外响应特性研究”为主题的文章。该文章第一作者为罗海燕,主要从事硅光子学、微电子学等方面的研究工作。
本文通过使用离子注入将硫元素扩散至硅材料内,结合飞秒脉冲激光加工工艺构建微结构硅,最终实现了制造的PN型黑硅光电二极管在中红外光谱的响应。对掺杂后的微结构硅进行霍尔测试以获取其电学性能,同时对比了不同离子注入剂量下光电二极管的光学和电学性能,研究了微结构硅在中长波红外光谱的响应机理,为商业化微结构硅图像传感器提供了理论依据。
实验过程
在室温下,将300 μm厚度、7.8-11.2 Ω•cm电阻率的单面抛光P型(100)面单晶硅进行离子注入,注入剂量分别为1×10¹⁴、1×10¹⁵和1×10¹⁶离子/cm²,注入能量为1.2 keV 32S+,注入深度大约40 nm。离子注入后采用快速热退火方式修复晶硅表面缺陷。P型单晶硅背面采用热扩散技术高掺杂硼1020 cm⁻³。实验中使用1 kHz的飞秒脉冲激光进行微纳加工,其核心参数包括100-fs、800 nm的中心波长,激光通量为0.5 J/cm²。具体操作步骤为:将直径200 μm的激光光斑通过焦距为10 cm的透镜聚焦于真空腔中的硅衬底,形成10 mm × 10 mm的方形图案区域,单个脉冲的平均能量密度为0.48 J/cm²;激光加工工艺结束后采用快速热退火设备在氮气气氛中600℃下进行30 min热退火。
本文使用日本Shimadzu公司生产的配备积分球检测器的UV3600型号UV-Vis-NIR分光光度计对微结构硅的反射率(R)和透射率(T)进行测量,通过A=1−R−T计算吸收率(A)。载流子的浓度和迁移率通过霍尔效应测试系统在室温下测量获取。为了研究硅材料中的硫杂质形成的杂质态/中间能级是否增强了硅在近红外至中红外波段的光谱响应,采用傅里叶变换(FTIR)光电流光谱测试方法。测试原理为:FTIR发出的红外光经内部的迈克逊干涉仪调制后输出至外部光路,该光束通过偏振片后变为s或p线偏振光,经过200 Hz的信号调制后辐照样品表面,样品产生的光电流随后输入到锁相放大器,经解调后的直流信号进一步反馈至FTIR光谱仪。最终,在步进扫描的模式下获得样品在近红外至中远红外波段的光电流频谱。具体操作步骤为:将调制的FTIR球状光源聚焦于微结构硅的光电二极管样品,其产生的光电流可以通过外部锁相放大器进行解调,最后反馈回FTIR的外部端口收集数据。
实验结果与分析
图1显示了采用不同离子剂量注入的硅样品的吸收率。可以看出,采用脉冲激光熔化处理的方式对硅样品进行微结构加工,其在可见光和近红外光谱范围内显示出最高的吸收率,而未采用激光熔化处理方式制备的样品显示出最低的吸收率。然而,后续的热退火工艺会降低微结构硅在近红外区域的光谱吸收。飞秒激光熔化处理制备的微结构硅具有较高的可见至近红外光谱吸收,这主要归因于硫元素掺杂诱导的杂质能级吸收和微结构表面产生的光捕获效应。
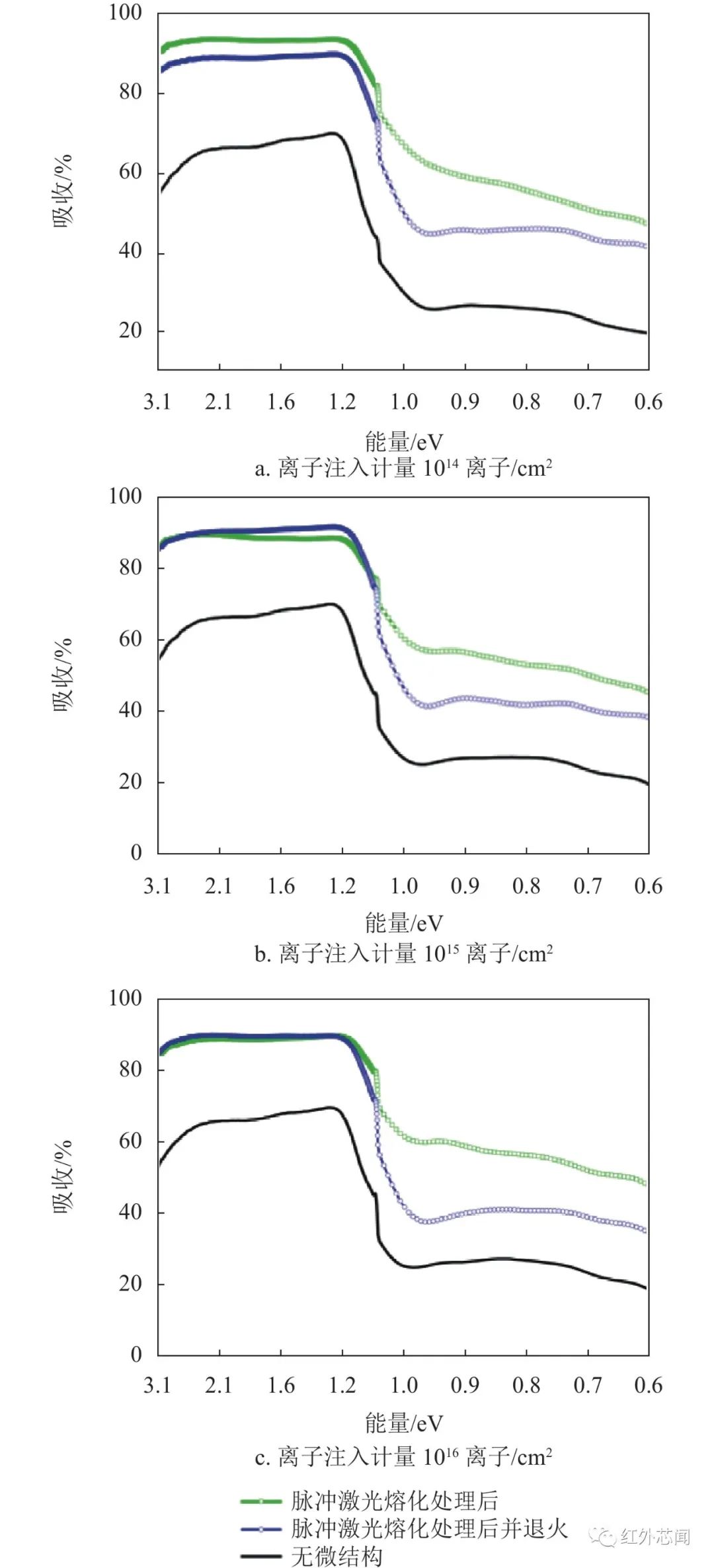
图1 不同离子剂量注入的硅样品吸收率测试
图2a显示硅中硫元素掺杂剂形成了杂质能带,引起了传统硅材料光学带隙范围以外的近红外至中红外光谱吸收。因此,硫掺杂硅材料在近红外光谱范围内显示出高吸收率。同时,脉冲激光熔化重建硅表面后产生了一系列的微型锥体结构,导致入射光的多次反射和吸收,如图2b所示。热退火处理工艺明显降低了近红外光谱范围内的吸收率,这主要是由两个方面引起:1)退火消除了微结构硅表面的纳米结构,降低光捕获效应;2)退火导致硅基体材料内的化学键重排,导致硫杂质的光学失活。

图2 微结构硅对可见及近红外光响应机理示意图
由于相同的激光参数加工产生的微结构硅样品表面结构相似,因此,近红外光谱范围内的吸收强度主要取决于掺杂剂的杂质剂量。这也从侧面验证了在近红外光谱范围内观察到的微结构硅样品吸收率的大幅增强实际上取决于硫元素的相关能级(~614 meV)。进一步地,在热退火过程之前,微结构硅样品的吸收率相对于掺杂剂量没有显著变化,如图3所示。离子注入剂量为10¹⁵、10¹⁶离子/cm²的微结构硅样品表现出相似的吸收率,而以10¹⁴离子/cm²注入的微结构硅样品表现出不明显的下降。
经过热退火工艺处理后,不同离子注入剂量的微结构硅样品吸收率均有所下降。认为热退火过程中晶粒会扩散到过饱和硫元素掺杂剂和缺陷的晶界处。这些缺陷包括空位、悬空键和浮动键。一旦缺陷扩散至晶界处,它们将不再对硅中杂质带的近红外吸收做出贡献,从而减少了对微结构硅样品对近红外至中远红外光谱的吸收。此外,当退火温度达到650 ℃以上时,硅禁带中的硫元素才会发生显著的再分布。在此过程中,S原子与缺陷簇复合,这意味着S原子将在硅体材料表面相互键合。这种键合现象导致有效的硫元素掺杂浓度活性降低。
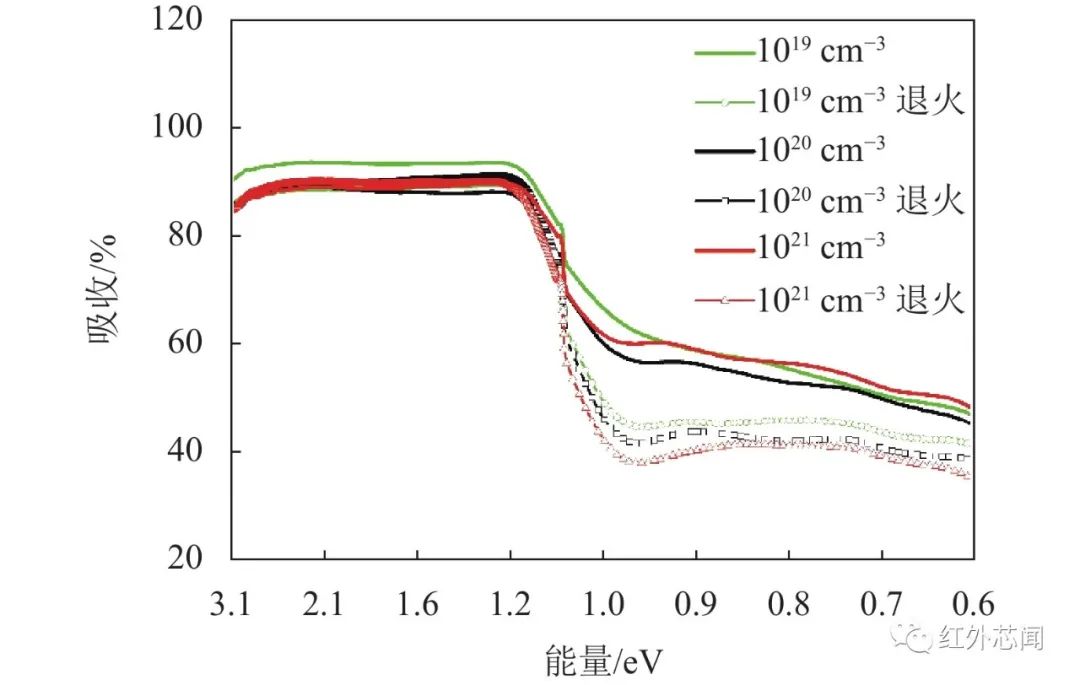
图3 不同离子注入剂量的微结构硅样品退火前后吸收率对比
进一步对不同离子注入剂量的微结构硅的载流子密度和迁移率进行霍尔测试。随着离子注入剂量的增加,体材料的单层密度逐渐增加,而迁移率不断降低。根据半导体Shockley-Read-Hall(SRH)复合效应,在硅和锗等间接带隙半导体材料中,载流子寿命随着掺杂浓度的增加而降低。迁移率降低导致载流子复合概率增加,电子寿命降低。因此,随着硫元素掺杂剂量的增加迁移率降低的结论与SRH复合效应一致。热退火工艺过程中,由于热扩散效应,体材料的单层载流子密度显著降低。
对快速热退火后的微结构硅样品进行器件制备。采用热蒸发的方法在硅样品上下表面沉积500 nm的铝金属薄膜,器件结构如图4a、图4b所示。为了获得良好的器件欧姆接触,将沉积铝电极的微结构硅样品在氮气气氛中400℃退火20 min。其近红外至中远红外波段光谱的响应曲线结果如图4c所示。进一步表征注入剂量在10¹⁴离子/cm²样品的中长波红外波段响应光谱如图4d所示。
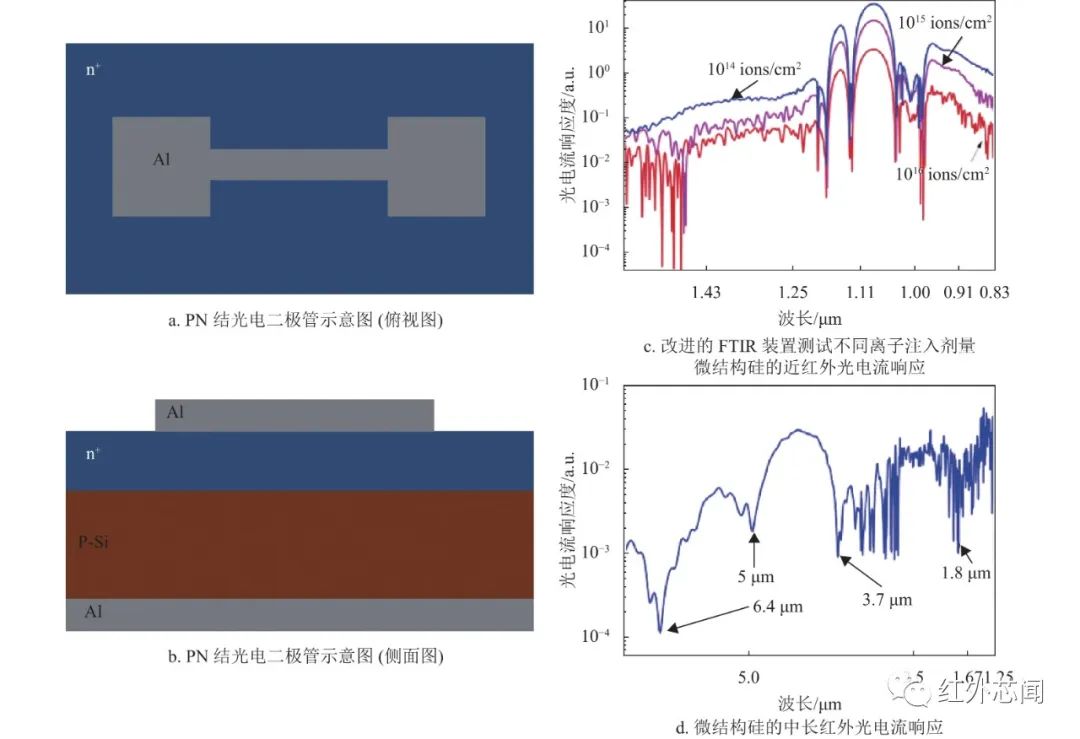
图4 基于微结构硅的光电二极管性能示意图
表1说明了与可见至中长波红外光响应光谱特征相对应的S原子杂质能级。对该PN型光电二极管进行光暗电流I-V曲线测试,光电流的测试采用1064 nm半导体激光器,功率为0.01 W,测试结果如图5所示。I-V结果证实了在硅衬底和掺杂S层之间形成了良好的欧姆接触。
表1 硅材料中S原子杂质能带对应的中长波红外光谱响应特征峰
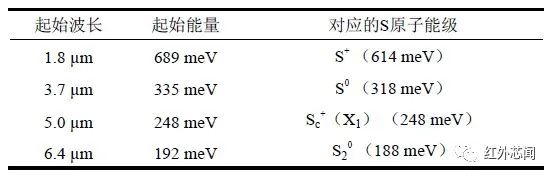
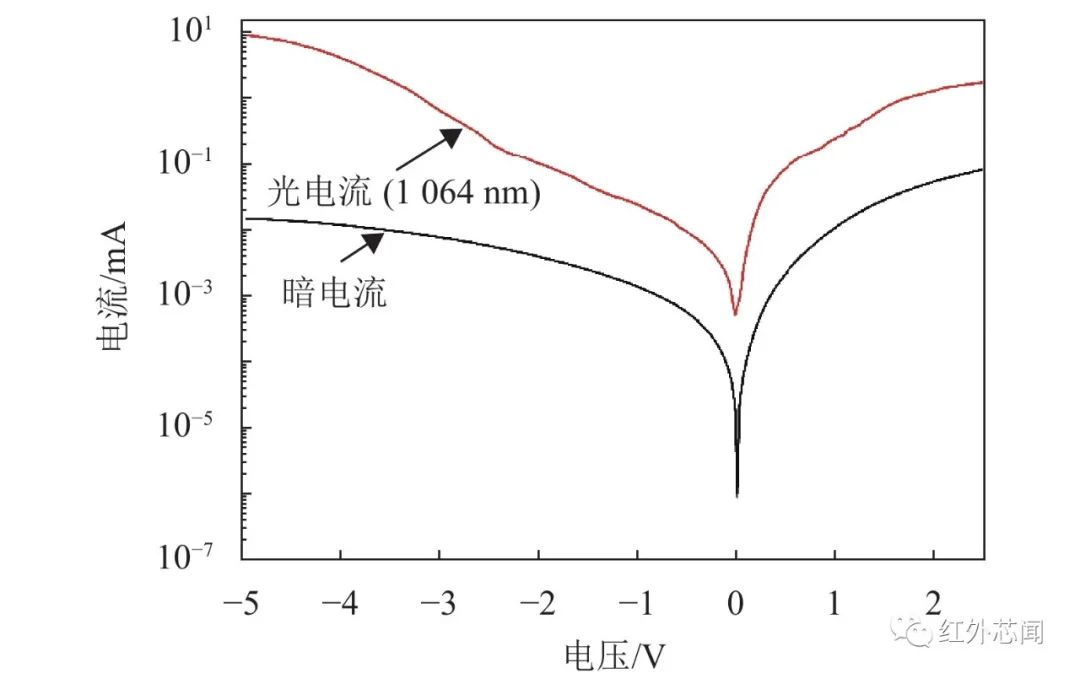
图5 10¹⁴离子/cm²的微结构硅光电二极管光暗电流I-V曲线
结束语
本文通过对硅材料进行不同剂量的硫元素离子注入,结合脉冲激光熔化处理和快速热退火技术,得到以下结论:
1)离子注入硫元素掺杂会引起硅在近红外光谱范围内吸收增强,拓展本征硅的光学吸收范围;
2)采用脉冲激光熔化技术能够实现硫元素在硅中一定厚度的超掺杂。基于超掺杂硅的PN光电二极管表现出近红外至中长波红外光谱响应,充分验证了掺杂硫元素能够在硅禁带中引入杂质能带,引起光生载流子的产生。
综上,在构建结构硅的近红外图像传感器时,适当地优化硫族元素的注入浓度、注入深度和微结构的纵深比,可改善掺杂层与衬底的内建电场,提高光电二极管的光电流;通过后续退火工艺参数的优化,能够极大地降低器件暗电流,减少离子注入和激光加工工艺带来的晶体缺陷问题。这些改进的方案使微结构超掺杂硅光电二极管更适用于低成本宽带红外硅基探测器。
审核编辑:刘清
-
VEMD8082硅PIN光电二极管技术解析与应用指南2025-11-12 1182
-
什么是光电二极管的响应度?2024-04-18 5474
-
光电二极管的特性参数及其测量2023-12-22 6817
-
发光二极管和光电二极管的区别2022-10-19 9385
-
硅光电二极管具有哪些基本特性2022-04-14 12337
-
推荐硅光电二极管、pin光电二极管国产厂家2019-12-11 6491
-
近红外硅光电二极管灵敏度更高,误差率不超过1%2019-12-05 5874
-
雪崩光电二极管的主要特性_雪崩光电二极管的工作原理2019-08-01 14468
-
光电二极管暗电流温度特性的测量2017-12-02 16463
-
光电二极管结构_光电二极管的作用_光电二极管应用2017-11-30 34462
-
硅光电二极管应用研究2016-08-08 1127
-
雪崩光电二极管,雪崩光电二极管是什么意思2010-02-27 1724
-
硅光电阵列光电二极管2009-11-11 768
-
光电二极管,什么是光电二极管2009-09-16 2949
全部0条评论

快来发表一下你的评论吧 !

