

半导体制造中FIB、SEM关键技术原理
描述
聚焦离子束(Focused Ion beam,FIB)是一种利用电透镜将离子束聚焦成非常小尺寸的显微切割仪器。 聚焦后作用于样品表面。其主要的作用分为以下三种:
1、产生二次电子信号取得电子图像,该项功能和SEM相似,且二者可搭配使用效果更好。
2、通过强电流离子束对表面原子进行剥离,完成微纳米级别的表面形貌加工工作,该项功能在形貌分析方面用的较多。
3、以物理溅射的方式搭配化学气体的反应,有选择性的剥离金属,氧化硅层或者沉积金属层。
聚焦离子束的系统是利用电透镜将离子束聚焦成非常小尺寸的显微切割仪器,目前商用系统的离子束为液相金属离子源,金属材质为镓,因为镓元素具有低熔点、低蒸气压、及良好的抗氧化力;典型的离子束显微镜包括液相金属离子源、电透镜、扫描电极、二次粒子侦测器、5-6轴向移动的试片基座、真空系统、抗振动和磁场的装置、电子控制面板、和计算机等硬件设备,外加电场于液相金属离子源,可使液态镓形成细小尖端,再加上负电场 牵引尖端的镓,而导出镓离子束,在一般工作电压下,尖端电流密度约为1埃10-8 Amp/cm2,以电透镜聚焦,经过一连串变化孔径可决定离子束的大小,再经过二次聚焦至试片表面,利用物理碰撞来达到切割之目的。
扫描电子显微镜(scanning electron microscope,SEM)是一种介于透射电子显微镜和光学显微镜之间的一种观察手段。 其利用聚焦的很窄的高能电子束来扫描样品,通过光束与物质间的相互作用,来激发各种物理信息,对这些信息收集、放大、再成像以达到对物质微观形貌表征的目的。 新式的扫描电子显微镜的分辨率可以达到1nm;放大倍数可以达到30万倍及以上连续可调;并且景深大,视野大,成像立体效果好。
WIP (Working In Progress)
WIP在制品管理, 通常是指领出的原材料,在经过部分制程之后,还没有通过所有的制程,或者还没有经过质量检验,因而还没有进入到成品仓库的部分,无论这部分产品是否已经生产完成,只要还没有进入到成品仓库,就叫WIP,在MES中则体现为Lot的制程。
扩展电阻测试(SRP)技术
SRP(Spreading resistance profile)即扩散电阻分布是一种以较高分辨率测试半导体材料扩散电阻、电阻率、载流子浓度分布等电学参数的方法,属于一种实验比较的方法,该方法的步骤是先测量一系列点接触的扩展电阻(Rs是导电金属探针与硅片上一个参考点之间的电势降与流过探针的电流之比),再用校准曲线来确定被测样品在探针接触点附近的电阻率,进而换算成系列测试点所对应的的载流子浓度。
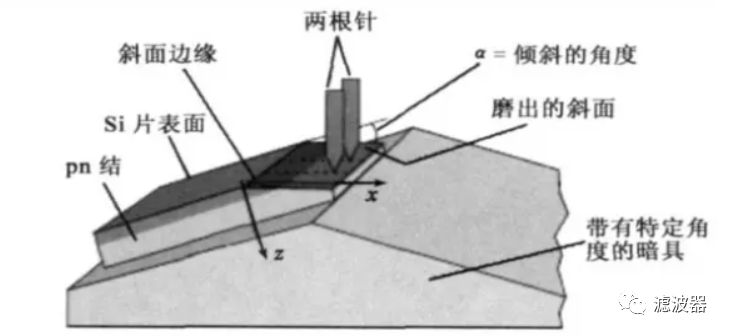
SRP测试原理图
为了提升空间分辨率,同时根据目标测量深度不同,可以将样品截面方向磨成一系列的角度,将硅片磨角后可以测量分辨深度方向5 nm以内电阻率的变化。扩展电阻法能够测试Si、InP、GaAs、SiC等外延、扩散、注入工艺中载流子浓度空间分布情况,成为半导体材料制备及工艺生产中比较重要的测试手段之一。
审核编辑:汤梓红
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1873
-
半导体制冷—— 2 1 世纪的绿色“冷源”2010-04-02 6225
-
想了解半导体制造相关知识2012-02-12 6737
-
《半导体制造工艺》学习笔记2012-08-20 68126
-
半导体制造2012-07-11 5212
-
半导体制造技术经典教程(英文版)2014-03-06 26616
-
半导体制程2018-11-08 5595
-
聚焦离子束显微镜(FIB-SEM)2020-01-16 4970
-
半导体制造的难点汇总2020-09-02 4989
-
MEMS工艺——半导体制造技术2021-04-08 4507
-
FIB-SEM双束技术及应用介绍2021-04-29 4751
-
半导体制造技术节点:电子科技飞速发展的幕后英雄2024-03-26 2792
-
微电子制造中的FIB-SEM双束系统:技术应用与进展2024-10-31 1484
-
FIB - SEM 技术在半导体芯片领域的实践应用2025-08-14 1118
-
FIB-SEM双束系统的工作原理与应用2025-09-18 947
全部0条评论

快来发表一下你的评论吧 !

