

传统封装工艺流程简介
电子说
描述
在晶圆制作完成后,会出货给封装厂,封装厂再将一粒粒的芯片封装起来。我这里所说的传统封装是指以打线为主的封装方式,比如DIP,QFP,SOP,QFN等,不包括倒装。这里就简单介绍一下传统封装的工艺流程及工艺特点。
1,晶圆减薄(Grind)
随着晶圆直径的增加,其厚度也相应增加。4inch晶圆一般厚度为525um,6寸为625um,8寸775um,12寸925um。过厚的芯片不仅不利于散热,还会导致封装尺寸过大。因此需要将晶圆减薄到50-200um。
晶圆减薄技术主要有:机械切削,化学机械抛光(cmp),湿法刻蚀,干法刻蚀等。
2,划片切割(Dicing)
它将一个大的晶圆切割成许多单独的小块,每个小块是一个“芯片”(Chip,die),这些芯片是单个集成电路的基本单位。目前比较常见的划片方式有三种:刀片切割,激光切割,等离子切割等。
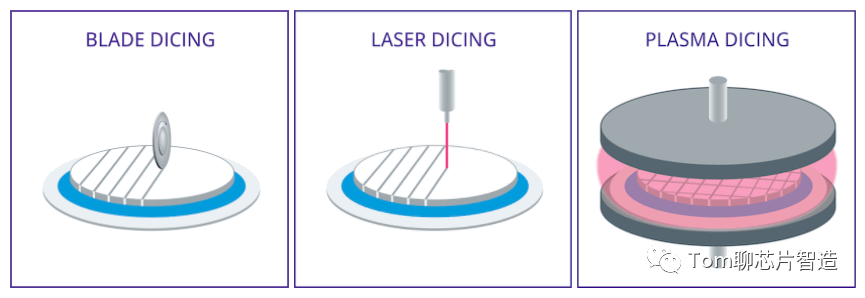
刀片切割: 使用金刚石刀片进行物理切割。这是一种成本效益较高的传统方法,但会对芯片边缘造成机械应力,而产生崩边(正崩或背崩)。
激光切割: 使用高强度的激光精确切割晶圆。这种方法特别适用于处理薄晶圆或需要极高精度的场景。
等离子切割: 使用等离子体束进行切割,适用于复杂或敏感的集成电路。
3,芯片贴装(Die Attach)
它指的是将一粒粒的芯片固定在基板或框架上。贴装一般有三种方法:共晶法,焊接法,导电胶粘贴法等。
共晶法:利用Au和Si可形成共晶体的特点进行共晶熔接。
焊接法:用Pb-Sn合金薄膜作为中间层,在保护气氛中加热,进行熔融焊接。
导电胶粘贴法:将含有银粉的环氧树脂(银浆)涂敷在框架或基板上,再将芯片放置其上,固化后可以将芯片牢牢粘接。
4,打线键合(WB wire bonding)
主要是用超细的金属线(通常是金或铝线)将芯片上的电极连接到封装的框架或基板上。打线键合包括两种主要方法——热压键合和超声键合。不过在实际的生产中,会将热压与超声结合在一起使用。
5,塑封(Molding)
塑封是为了保护和隔离芯片、金属引线、框架的内腿以及其他易受损的部分。塑封是将工件和树脂安装在模具中,加热模具,使树脂液化充满模具,降温保持一定时间后,树脂凝结为固态即可取出。取出后的固态树脂没有经过完全固化,还要在烘箱中进行完全的固化处理。
6,切筋(trimming)
引线框架的各腿是用筋连接着的,起支撑作用,塑封固化后,需要将其连筋切掉。
7,打标(marking)
在塑封的环氧树脂上打上产品型号,商标,批次等信息。
8,电镀外脚(Plating)
对裸露在外的引线框架外脚电镀Sn-Pb合金,这样不仅可以提高外脚的抗氧化性,还有利于后续与印刷电路板的焊接。
9,成型
对外脚进行冲压弯曲,并切掉多余的部分,形成一粒粒的封装产品。
审核编辑:汤梓红
-
半导体封装工艺流程的主要步骤2025-05-08 5997
-
SMT组装工艺流程的应用场景2023-10-20 1249
-
SMT组装工艺流程的应用场景(多图)2023-10-17 3124
-
封装工艺流程--芯片互连技术2022-12-05 2482
-
芯片封装工艺流程讲解2022-10-31 13000
-
覆铜基板工艺流程简介2021-12-13 3669
-
芯片封装工艺流程是什么2021-08-09 73400
-
集成电路芯片封装工艺流程2021-07-28 14218
-
芯片封装测试的流程你了解吗IC封装工艺详细PPT简介2019-05-12 30357
-
倒装晶片的组装工艺流程2018-11-23 4929
-
ic封装工艺流程2010-07-18 3613
-
LAMP-LED封装工艺流程图2010-03-29 3843
-
BGA的封装工艺流程基本知识简介2010-03-04 7085
-
IC芯片的封装工艺流程2008-05-26 29476
全部0条评论

快来发表一下你的评论吧 !

