

半导体行业之晶体生长和硅片准备(六)
描述
磨削方位指示器
一旦晶体在切割块上被定向了,我们就可以沿着切割块的这一根轴线打磨出一个平面或缺口(具体可以见下图所示)。平面或缺口的位置沿着一个主要的晶体平面,对具体的晶圆取向进行详细的检查就可以作出相应的判定。

在晶圆工艺制作的过程中,平面的平整度参数可以作为一个可视化的参考来定位晶圆片的具体方向。为了将晶片的方向总是总是保持朝向一个主晶面方向的状态,一个最为常见的方式就是在晶圆片上放置第一个图案掩模来作为参考标志。
在大多数晶体中,在晶圆的边缘都会有第二个较小的次级平面。第二个次级平面与主要平面的位置可以作为一个代码,用来显示两个平面间晶圆片的取向和电导率类型。具体的代码表示以及对应关系在下面的图中有比较详细的展示。

对于直径较大的晶圆,在晶圆上刻一个缺口来表示晶圆晶体的具体取向(具体的见下图所示)。
晶圆切片
晶圆片是从比较大的晶体上切下来的,这种晶体一般就是圆柱状的,在切割操作时,需要使用具有金刚石涂层的内径(ID)锯或线锯(具体可以在下图中见到)。内径锯可以看成是在薄的圆形钢板中间剪了个洞而形成的。孔的内部是切削刃,一般都会镶满钻石。内径锯有刚性,但不会太厚。结合上面这些因素,它减小了切口(切割宽度)尺寸,这一点又会反过来防止切片过程中浪费了相当数量的晶体。

对于直径较大的晶圆(尺寸大于300mm时),采用线锯的方式可以确保切割面的平整、小锥度和与最小限度的“缺口”损失。
晶片标记
大面积晶圆在晶圆制造工艺中具有很高的价值。为了防止一些处理上的失误并且保证对晶圆的准确跟踪,对它们加以识别是非常必要的。条形码或数据点阵码,通常是方形图案,它们一般是通过激光雕刻的方式刻在晶圆片上的(具体如下图所示)。激光点方法对于300mm及更大的晶圆是标准的方法。

粗糙抛光
半导体晶圆片的表面必须保证没有不规则和锯齿损伤,并且必须是绝对平坦。第一个要求来自构成器件表面的微小维度和亚表面层的小尺寸。更新的器件尺寸工艺条件下(特征尺寸)需要将损伤控制在纳米(nm)范围内。为了类比对于半导体器件相对尺寸,我们可以想象在下图中(和房子的墙一样高),大约8英尺(2.4米)晶圆片顶部,在顶部的起伏要保持在1或2英寸(25或50毫米)或更少的范围内。

平整度是小维度图形的绝对要求。高级图案化处理需要将所需的图案化图像投影到晶片表面。如果表面不是平坦的,那么投影图像就会失真,就像电影图像在非平面屏幕上放映会失焦一样。磨平和抛光过程可以分为两个步骤:粗磨和化学/机械抛光(如下图所示)。粗糙的抛光是研磨料浆研磨工艺中的一种惯例,但需要微调到半导体行业中的精度上。粗抛光的主要目的是去除在晶圆片切片过程中晶圆表面留下的损伤。
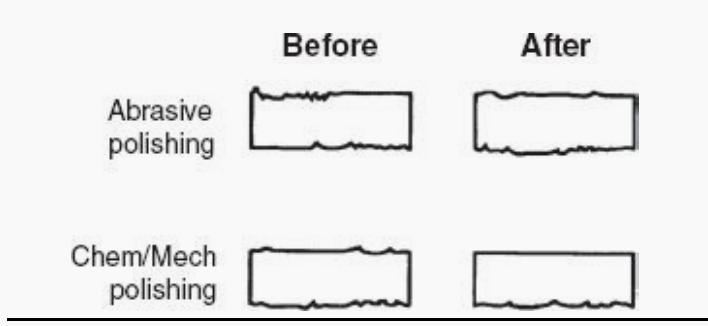
审核编辑:刘清
-
【转帖】一文读懂晶体生长和晶圆制备2018-07-04 3550
-
NaCLO3晶体生长控温实验分析设计2009-12-23 779
-
晶体生长参数的检测与优化2010-03-01 641
-
基于嵌入式Linux的晶体生长控径系统的研究2010-03-12 791
-
GT Advanced推全新MonoCast晶体生长系统2012-02-05 800
-
半导体硅片介绍及主要种类 半导体行业发展情况2022-09-29 9461
-
解决方案|半导体晶体生长测温2022-07-24 1601
-
半导体行业之晶体生长和硅片准备(一)2023-12-18 1735
-
半导体行业之晶体生长和硅片准备(二)2023-12-22 1778
-
半导体行业之晶体生长和硅片准备(三)2023-12-25 2308
-
半导体行业之晶体生长和硅片准备(四)2023-12-28 2277
-
半导体行业之晶体生长和硅片准备(五)2024-01-05 1159
-
晶体生长温控仪数据采集解决方案2024-10-25 909
-
芯片制造工艺:晶体生长、成形2024-12-17 2109
-
晶体生长相关内容——晶型控制与衬底缺陷2024-12-30 1745
全部0条评论

快来发表一下你的评论吧 !

