

LPCVD技术助力低应力氮化硅膜制备
模拟技术
描述
氮化硅膜在MEMS中发挥关键作用,LPCVD技术助力低应力氮化硅膜的制备。
氮化硅膜在MEMS中应用十分广泛,可作为支撑层、绝缘层、钝化层和硬掩膜使用。SiN极耐化学腐蚀,疏水性使它可以作为MEMS压力传感器、MEMS流量传感器等的钝化层使用。氮化硅的导电带隙约为 5eV,比热氧化物低很多,但它没有施主和受主能级,所以表现为绝缘体。由于SiN具有约为1014Ω•cm的电阻率和107V/cm的介电强度,它通常可以作为绝缘层。同时,SiN具有良好的热绝缘性约为20W/(m•K)和好的弹性模量约250GPa,使它常与SiO2组成复合支撑层使用。
氮化硅窗格是低应力氮化硅膜最直接的应用,其用量小,单价高。用于透射电镜的氮化硅支撑膜窗格相比于传统的铜网微栅具有熔点高、化学惰性强、强度高等特点,主要用于原位加热、液体环境或含碳样品的透射电镜(TEM)观察实验。市面上要求的氮化硅窗格上表面的氮化硅厚度20nm~200nm,要求应力接近零。那么,通过LPCVD如何制备低应力甚至零应力的氮化硅薄膜呢?
LPCVD是低压化学气相沉积(low-pressurechemical vapor deposition)的缩写,低压主要是相对于常压的APCVD而言,主要区别点就是工作环境的压强,LPCVD的压强通常只有10~1000Pa,而APCVD压强约为101.3KPa。
采用LPCVD制备化学计量比Si3N4,沉积温度和压强范围分别为700~900°C和200~500mTorr。此工艺制造出来的Si3N4膜具有1GPa以上的大应力,易引起百纳米厚的膜层断裂和脱离。因此,想要用到LPCVD的SiN大于100nm的膜,必须制备出低应力膜层。该薄膜通常被称为富硅氮化硅,工艺中用过量硅淀积,其过量硅可通过在淀积过程增加SiH2Cl2 (DCS)和NH3的比值实现,通常比例越高,应力越小。如果 SiH2Cl2/ NH3的值为6:1淀积温度为850°C且压强为500mTorr,那么淀积出的薄膜接近零应力。
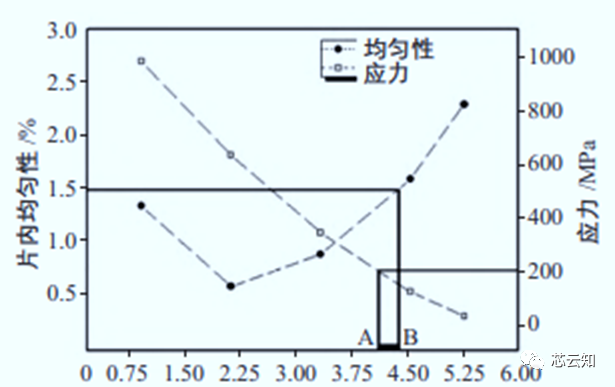
图 SiH2Cl2 (DCS)和NH3的比值与应力及片内均匀性的关系(引用:张泽东《低压化学气相沉积制备低应力氮化硅膜的研究》)
沉积过程一般可概括为以下步骤:
1)给定组成(和流量)的反应气体和用来稀释的惰性气体引入反应室。实验中采用SiH2Cl2(DCS)和NH3作为反应气体,N2作为惰性气体;
2)气体物质向衬底方向流动;
3)衬底吸收反应物;
4)被吸附的原子迁移进行成膜化学反应;
5)反应的气体副产物被排出反应室。
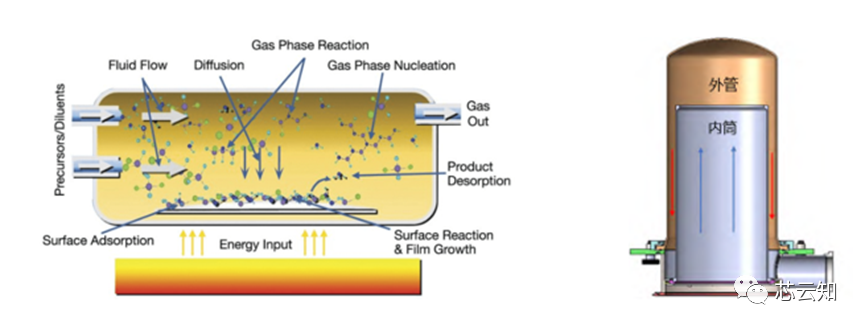
图 卧式LPCVD炉和立式LPCVD炉示意图
沉积过程中有2点注意:1. 炉管入气口和出气口与炉管中心温度差异达20°C,导致同一炉SiNx薄膜应力出现大的波动,提高中心温度后,片间应力差异低于3%;2. 远离入气口硅片反应气体浓度低于入气口,淀积的膜厚低于入气口处。适当增加反应气体流速。
与卧式LPCVD设备相比,立式LPCVD设备的主要优点为:1) 工艺管为双管式结构,气流场一致性好;2) 颗粒度低,易于控制,维护周期长;3 ) 反应室内氧气浓度低、自然氧化层薄。在结构上,工艺腔采用双管式结构,内管为直筒式结构,以提高气流场均匀性;增加舟旋转功能,以提高晶圆表面的气体浓度一致性。
审核编辑:黄飞
-
氮化硅LPCVD工艺及快速加热工艺(RTP)系统详解2022-10-17 14500
-
技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径2026-03-20 517
-
氮化硅陶瓷基板助力新能源汽车市场2021-01-21 1252
-
氮化硅基板应用——新能源汽车核心IGBT2021-01-27 1771
-
低热量化学气相工艺制备氮化硅2009-06-12 1299
-
氮化硅陶瓷基板的5大应用你知道吗?2022-11-10 3708
-
高导热率氮化硅散热基板材料的研究进展2022-12-06 2053
-
氮化硅陶瓷在四大领域的研究及应用进展2023-07-05 5177
-
氮化硅陶瓷基板生产工艺 氮化铝和氮化硅的性能差异2023-07-06 3059
-
沉积氮化硅薄膜的重要制备工艺——PECVD镀膜2023-09-27 7491
-
氮化硅薄膜制备方法及用途2024-11-24 3638
-
氮化硅薄膜的特性及制备方法2024-11-29 4389
-
LPCVD氮化硅薄膜生长的机理2025-02-07 1695
-
通过LPCVD制备氮化硅低应力膜2025-05-09 1611
-
氮化硅陶瓷封装基片2025-08-05 1614
全部0条评论

快来发表一下你的评论吧 !

