

如何获得高纯度的EUV光源?EUVL光源滤波系统的主流技术方案分析
电子说
描述
EUV光源系统中的带外光
目前,商用EUV***采用激光等离子体型-极紫外(LPP-EUV)光源系统,主要由驱动激光器、液滴锡靶、收集镜组成。在驱动激光器两次精确轰击液滴锡靶后,锡将被完全电离并产生高能量的EUV辐射,由收集镜反射并聚焦到一个焦点(IF点)后进入后续光路的传输。
在激发和聚焦EUV的过程中,往往伴随着其它波段光(Out-of-band, OoB)的产生与汇聚。这些光有的可以使用背景氢气去除,有的对光刻胶不敏感,因此它们带来的影响很小。但是,还有些波段的光却会对整个光刻系统造成严重的损伤并影响最终的成像性能,如:300 nm以下的深紫外光(deep ultraviolet, DUV)和红外光(infrared, IR)。前者产生于激光轰击锡靶的过程,由于光刻胶对该波段光非常敏感,因此会导致光刻图案对比度的降低;而后者则来源于驱动激光,其高能量将使光学元件、掩膜、晶圆出现不同程度的加热现象,从而降低图案精度并损伤光学元件。不仅如此,收集镜表面对前者的反射率大小几乎与EUV相同,而对后者反射率则接近100%,如图1所示。以IR为例,作为驱动光源的激光器功率要求为20 kW,在经过收集镜反射与汇聚后,其达到IF点的功率仍有近10%,也就是约2 kW;然而,若要使IR对整个系统几乎不产生影响,则需要再将其IF点处的功率缩小至少1%,也就是仅20 W以下。在如此高要求下,倘若不对这些OoB辐射进行滤除,使其都经过收集镜反射并进入到后续光路,将会极大地降低光源系统的性能,因此滤除OoB辐射是非常必要的。
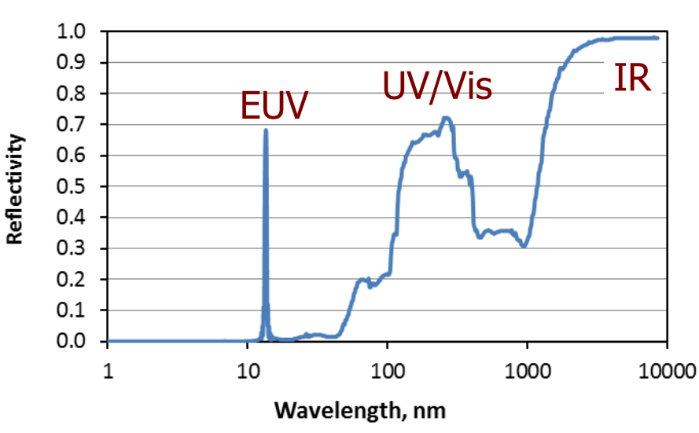
图1 收集镜表面钼/硅多层膜(周期为6.9 nm,钼/硅比为0.4的50层钼/硅多层膜)对不同波段光的反射率计算结果 ^[^ ^1]^
EUV***光源系统中的滤波结构
中国科学院上海光机所强场激光物理国家重点实验室林楠、冷雨欣团队就EUV***光源系统中存在的带外波段问题,系统阐述了EUVL光源滤波系统的关键技术、主要挑战和未来趋势。
在EUVL光源系统中,由等离子体产生的DUV和源于驱动光源的IR通常会对光刻性能和光学系统寿命产生较大的影响,并且收集镜表面的钼/硅多层膜结构对其均具有高反射率,因此EUVL光源滤波系统主要针对这二者展开设计。DUV的能量强度较低,使用透射式或反射式的独立薄膜结构可以实现良好的滤波效果,但由于薄膜结构机械强度较低的特点容易导致薄膜破裂等问题,使用寿命较短。与之相比,具有高能量的IR无法简单使用薄膜滤波器来滤除,而是需要在收集镜衬底上加工多层光栅结构并镀膜(如图2所示),以将特定波长的IR通过衍射的方式实现滤除并保留尽可能多的EUV辐射(如图3所示)。该方法对光栅结构的设计、加工与量测均提出了非常高的要求,尤其体现在对光栅表面粗糙度与多层膜均匀性的控制,以及以高度为主的光栅结构参数对反射率的影响,其对我们量测的要求需要达到仅几纳米甚至亚纳米量级。就整个EUVL光源系统而言,其滤波对象决定了最终的滤波系统难以单一结构形式存在,其需要同时考虑独立式的薄膜结构与收集镜内置光栅结构,以实现对光刻性能产生影响的OoB作整体滤除,从而保证EUV光源的纯度。
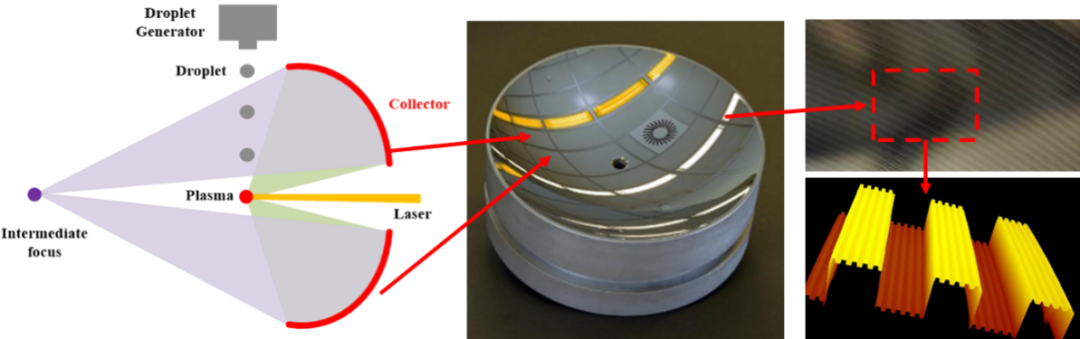
图2 收集镜内置光栅结构示意图

图3 收集镜内置光栅结构对IR滤波的原理示意图
总结与展望
文章综述了EUVL光源滤波系统的主流技术方案,分析了滤除OoB辐射的关键技术,并结合实际应用,探讨了目前面临的主要挑战与未来发展趋势。EUV光源的性能决定了光刻图案的性能,为最终获得高纯度EUV光源,无论是在提升滤波系统的设计方案、工艺制造上的先进性,还是在提升量测方式上的先进性,其都是缺一不可的。
审核编辑:刘清
-
EUV不能只靠高NA,大功率光源也该提上日程了2023-02-13 6347
-
放电等离子体极紫外光源中的主脉冲电源2010-04-22 2092
-
怎么获得被测光源的光功率分布?2019-08-15 1789
-
深圳机器视觉led光源有什么优势2021-01-11 3106
-
投影光源的未来是主流光源LED吗?2010-03-19 1223
-
电光源的驱动电功率频率对光源品质的影响2011-04-22 1089
-
UVLED点光源优势介绍2017-09-19 1011
-
激光光源DLP拼接技术与LED光源的优劣分析2017-10-12 1513
-
直流驱动LED光源系统介绍及LED光源技术的分析2017-11-14 1456
-
一种基于最先进激光器的新型实验室EUV光源2019-03-16 6647
-
哈工大的史诗级成果:DPP-EUV光源2021-02-01 31953
-
这个光源的波长能成为EUV光刻机新的光源技术2021-03-30 10068
-
EUV***的核心光源 大功率光源也提上日程2023-02-17 9020
-
EUV光刻技术面临新挑战者2025-02-18 3310
-
探秘高纯度铜箔,解锁高品质 PCB 的性能密码2025-02-21 1233
全部0条评论

快来发表一下你的评论吧 !

