

一文解析异构集成技术中的封装天线
RF/无线
描述
概述:
本文简要介绍了封装天线在异构集成技术背景下的应用需求以及实现形式,列举了LTCC工艺、HDI工艺以及使用三种中介层实现封装天线的具体例子。
目录:
为什么选择异构集成技术 封装天线的实现
为什么选择异构集成技术
毫米波频段具有大带宽以及频谱资源丰富等优势,可满足通信系统高分辨率以及高传输速率的需求,因而被广泛应用于移动通信、物联网、自动驾驶以及生物医学等领域。在毫米波的场景下,天线与电子器件尺寸也更小,达毫米级别,毫米波系统不断向微型化、高效能、高集成度、低功耗和低成本的方向探索。
但在高性能的毫米波系统的实现过程中,单一的硅基工艺或者是化合物半导体工艺(如砷化镓以及氮化镓)都无法完美地平衡性能、成本、功率与集成度之间的要求[1]。 1965年,戈登·摩尔提出著名的摩尔定律,其内容为当价格不变时,集成电路上可容纳的元器件数目,约每隔 18-24 个月便会增加一倍,性能也将提升一倍,值得注意的是,摩尔定律并非一个通过严格数学证明得到的结果,而是一个统计规律,是对集成电路产业发展的合理推测。近半个世纪以来,硅基工艺始终遵循摩尔定律演进,取得了巨大的成功,芯片工艺节点从微米、亚微米、深亚微米,到近几年的7nm、5nm、3nm不断缩小,集成度不断提高,硅基工艺是目前为止最为成熟的集成电路工艺。 Ⅲ-Ⅴ族化合物半导体一般禁带宽度较大,击穿场强大,同时具有良好的耐高温性,能承受较高的功率,可用于大功率器件的制造,其电子迁移率也较高,十分适合用于制备高频器件。
表1 材料参数对比[1]
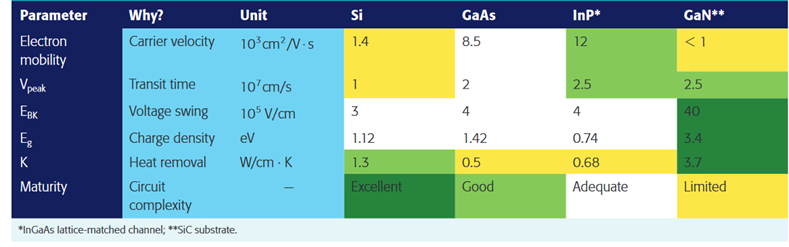
对于毫米波系统而言,硅和化合物半导体材料各有优劣。硅基工艺成熟,集成度高,成本低,可用于制造复杂度高的大规模电路,但是由于硅材料本身的限制,它的禁带宽度较小,击穿场强较小,器件容易失效,且硅的载流子迁移率也相对较低,这两个因素不利于硅材料在高频电路中的广泛使用。Ⅲ-Ⅴ族化合物半导体制备的器件性能好,但集成度低,与硅基工艺的差别可达几个数量级,且制造成本高昂。随着毫米波系统小型化、高集成度、高能效等需求的不断发展,把硅基工艺的优点与化合物半导体器件的优点结合起来各取长处的异构集成技术是未来毫米波射频微系统的一个可行选择。
封装天线的实现
天线在射频系统中起着关键性的转换作用,能够实现电磁波与电信号之间的相互转换,是无线电设备不可或缺的一部分。AiP(antenna-in-package,封装天线)这个名词由南洋理工大学张跃平教授于2006首先提出,促进了封装天线技术的发展与广泛应用。在高度集成的毫米波系统中,封装天线可以很好兼顾体积以及工作性能两个方面,因而深受广大芯片及封装制造商的青睐。如图1所示为电路系统中封装天线的设计方案,与系统集成于一个封装内。
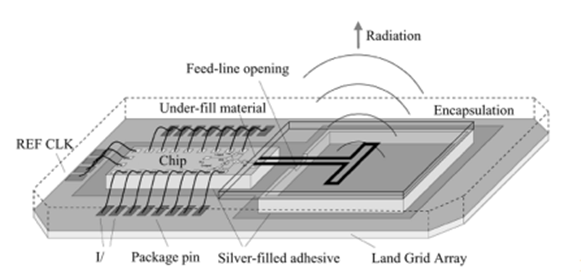
图1 一种封装天线结构[2]
2009年孙梅博士及张跃平教授将栅格天线应用于封装天线的设计中[3],使用LTCC(low temperatrue co-fired ceramic,低温共烧陶瓷)工艺实现了工作于60 GHz的栅格阵列封装天线,如图2所示,测得天线最大增益为13.5 dBi,带宽范围内辐射效率大于85%,应用LTCC工艺,栅格天线在封装天线领域展现出了极大的应用潜力。

图2 栅格阵列天线
2017年,来自IBM的刘兑现团队研究了一款应用于5G Ka波段通信的封装天线[4],采用HDI(high-density interconect,高密度互联)工艺实现,HDI堆叠结构由顶部堆积层、核心层以及底部堆积层组成,如图3所示,贴片阵列天线如图4所示,这种基于有机基板的多层堆叠结构可将相控阵模组与射频芯片集成于一体,支持水平极化与垂直极化,证明了在Ka波段相控阵中使用多层有机基板实现封装天线设计的可行性。
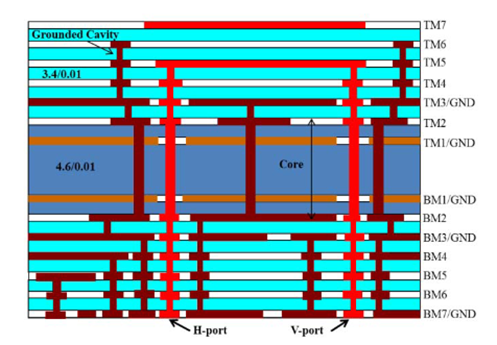
图3 HDI堆叠结构
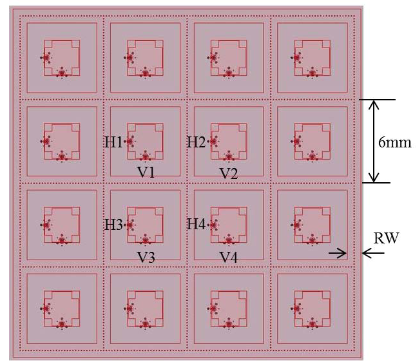
图4 贴片阵列天线
为适应异构集成技术的应用背景,封装天线的实现技术也应有所变化,利用封装工艺的优点以实现更佳的性能。异构集成技术的实现与先进封装技术的发展密不可分,现行的2.5D/3D封装都属于立体封装,可充分利用芯片面积和高度,相较于传统封装,其互连线的长度更短,信号传输更快。
在先进封装中,不同的转接板(也被称为中介层或插入层)材料具有不同的优势,其适用场景往往也不一样,故而对中介层材料的选择十分关键。中介层材料可分为三类,分别为硅、玻璃以及有机材料。
目前最为常用的是硅基中介层。硅基中介层的大范围应用得益于成熟的硅基工艺,在硅基中介层中,能够采用与晶圆布线层相同的工艺流程,相比于传统基板布线,能够减小线宽、线间距,提高布线精度,增强可靠性。硅中介层是目前来说工艺最为成熟,应用十分广泛的一种中介层材料,在基于硅中介层的2.5D/3D封装中,其垂直互连使用TSV技术实现,RDL则用于解决系统平面互连的问题。在毫米波封装天线实现过程中,互连损耗是不得不考虑的一个重要因素,基于先进的工艺实现的封装天线可以与芯片直接互连,在进一步降低尺寸的同时减少信号的串扰。2022年,Y. Huang等人(上海交通大学毛军发院士团队、周亮团队)提出一种工作于W波段背腔天线结构,采用基于BCB材料的硅基MEMS光敏复合薄膜多层布线工艺实现封装天线的互连,具有较低的互连损耗,同时能够保证天线的高增益和阻抗带宽[5],该结构采用高阻硅衬底,可适用于封装天线设计,天线实物图如图5所示。
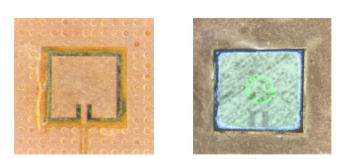
图5 采用BCB材料互连的封装天线
其次是玻璃中介层。玻璃中介层的电阻率高,介电常数低,在射频领域有很大的应用前景,除此之外,玻璃中介层还具有机械稳定性强,翘曲小,成本低廉等优点,而且在玻璃中介层中,同样也有对应的玻璃通孔技术 TGV(Through Glass Vias,玻璃通孔),因而也能支持 2.5D/3D 封装,但由于目前工艺限制,TGV的深宽比与TSV相比仍有差距,且孔壁粗糙度较大,孔壁倾斜较为明显,这限制了玻璃基板的大规模应用,在未来都是需要解决的问题。如图6所示,2022年Y. Su等人设计了一个77 GHz汽车雷达天线,采用TGV实现层间互连[6]。天线结构由五层玻璃,六层金属层组成,这种采用玻璃晶圆工艺和晶圆堆叠的方式制造的天线可以提高布线能力,实现复杂的天线设计。
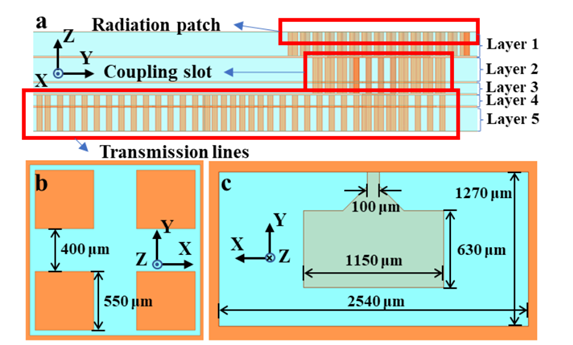
图6 五层玻璃堆叠实现的汽车雷达天线
除硅和玻璃外,有机材料也是中介层的选择之一。常见的有机中介层有PTFE(Polytetrafluoroethylene,聚四氟乙烯),LCP(Liquid Crystal Polymer,液晶聚合物)以及PI(Polyimide,聚酰亚胺)等。与传统的板材相比(如FR4)有机中介层因在毫米波频段具有较低的tanδ而受到广泛的关注[7],2023年,H. Araki等人基于所提出的低介电常数、低损耗角正切值的新型PI材料为中介层制成的封装天线结构如图7所示[8],它的传输损耗更低,相比传统PI中介层,这种新型PI材料更加适用于毫米波封装天线。
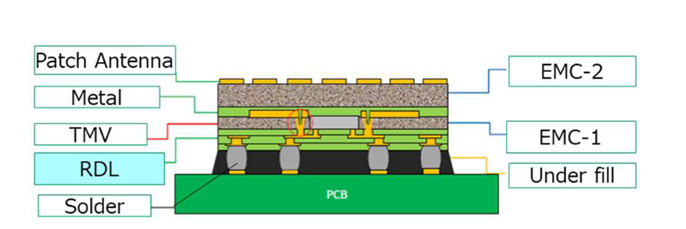
图7 基于新型PI材料实现的封装天线
结语
在异构集成技术中,封装天线是一个非常重要的一部分。为了实现高效的毫米波通信,需要对封装天线进行深入的研究,考虑天线设计、封装工艺和材料选择等多个领域的交互影响,以满足实际应用的需求。
审核编辑:黄飞
-
基于板级封装的异构集成详解2025-07-18 3107
-
封装天线技术的发展动向与新进展2019-07-16 5189
-
异构集成的三个层次解析2020-07-07 3133
-
天线封装技术简化了汽车车内雷达传感器设计2021-09-02 4154
-
超异构芯片TDA4内核解析2022-12-09 2430
-
一文解析Chiplet中的先进封装技术2023-07-17 7473
-
一文看懂PCB天线、FPC天线的特性.zip2023-03-01 1625
-
异构集成时代半导体封装技术的价值2023-11-28 1270
-
一文了解相控阵天线中的真时延2023-12-06 4091
-
什么是异构集成?什么是异构计算?异构集成、异构计算的关系?2023-11-27 12572
-
华芯邦科技开创异构集成新纪元,Chiplet异构集成技术衍生HIM异构集成模块赋能孔科微电子新赛道2024-01-18 1722
-
2.5D封装与异构集成技术解析2024-10-30 3108
-
异构集成封装类型详解2024-11-05 2877
-
人工智能应用中的异构集成技术2024-12-10 2156
-
一文解析多芯片封装技术2024-12-30 2498
全部0条评论

快来发表一下你的评论吧 !

