

一文详解芯片上的集成技术
EDA/IC设计
描述
1
集成的层次
电子系统的集成主要分为三个层次(Level):芯片上的集成,封装内的集成,PCB板级集成,如下图所示:
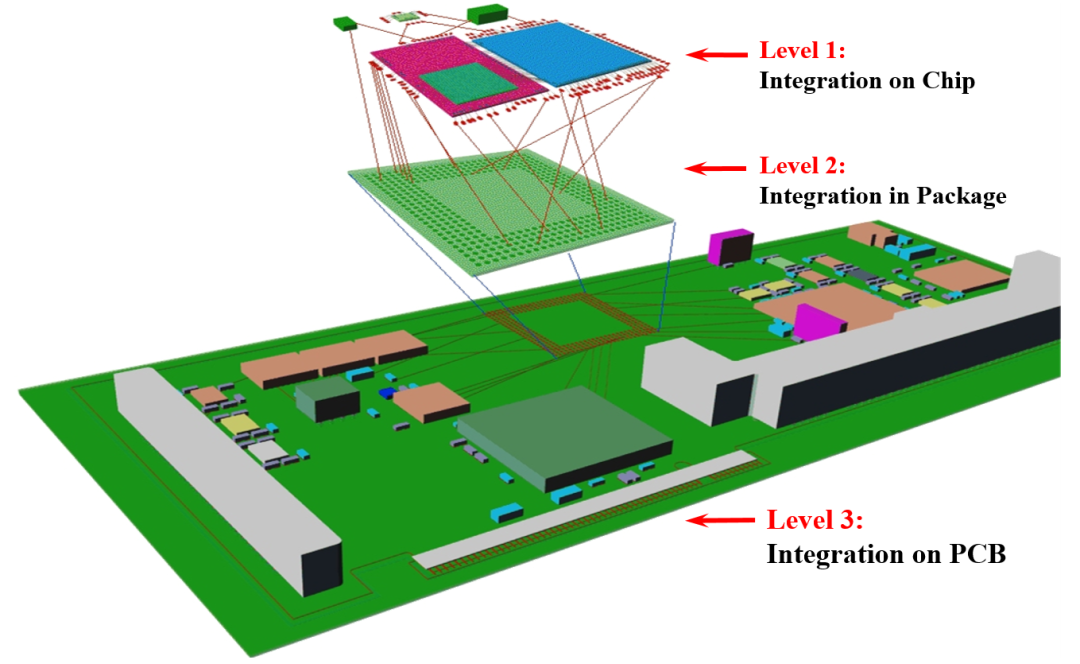
封装内集成的基本单元是上一步完成的裸芯片或者小芯片Chiplet,我们称之为功能单元 (Function Unit),这些功能单元在封装内集成形成了SiP。
芯片上的集成
从极简的视角来说,我们需要了解三类材料和三类工艺。导体、半导体、绝缘体虽然芯片上的材料非常多,现代集成电路中用到的材料几乎要穷尽元素周期表,所有的材料可以分为三大类:导体、半导体、绝缘体。导体负责传输电子,绝缘体负责隔离电子,其中最重要的自然是半导体,因为它是可变的,它有时候变成导体(导通),允许电子通过,有时候可变成绝缘体(关断),阻隔电子通过。并且,这种变化是可控的,通过设计特别的结构,并施加电流或者电压来控制。

加工艺,减工艺,图形转移
加工艺简单来说就是在基底上增加材料,例如,离子注入,溅射、化学气相沉积CVD,物理气象沉积PVD等都可以归类为加工艺。
减工艺简单来说就是在去除材料,例如刻蚀,化学机械抛光CMP,晶圆整平等都可以归类为减工艺。
图形转移是三类工艺里面最多且最难的,因为每一步的加工艺或者减工艺基本都要以图形转移为依据。图形转移就是将设计的出来的图形,转移的晶圆上,涉及到的是掩膜、光刻、光刻胶。
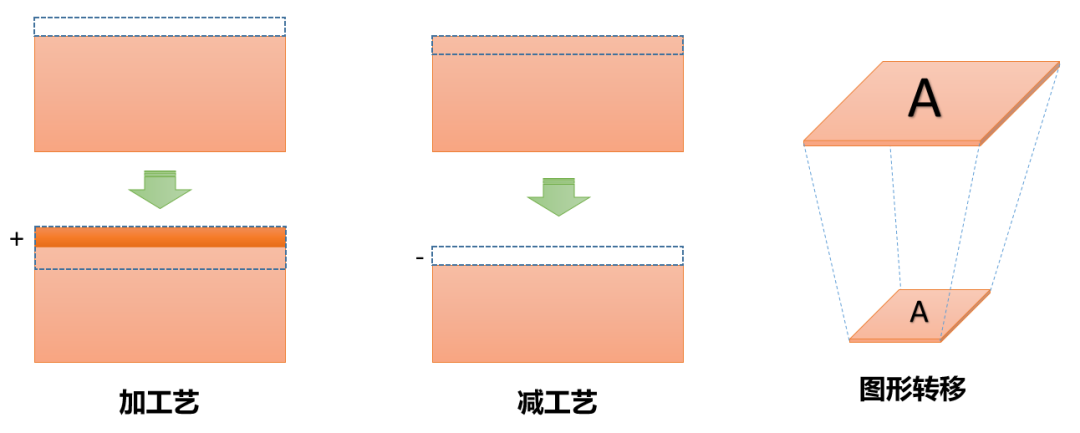
产品是晶圆,晶圆被切割后就形成了芯片Chip或者芯粒Chiplet,为下一个层次的集成做准备。
封装内的集成
封装内集成不会用到半导体的特性,因此封装内集成所用的材料主要分为两大类:导体和绝缘体,集成的主要目的就是将上一层次(芯片上的集成)所完成的芯片或芯粒在封装内集成并进行电气互联,形成微系统封装内集成的结果就是形成以SiP、先进封装为代表的功能单元,我们可以称之为微系统。
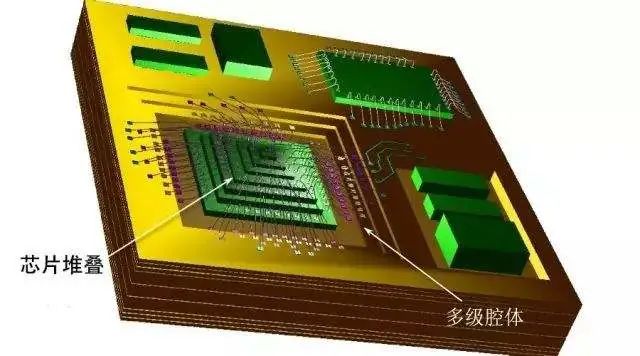
PCB上的集成
今天,PCB上基本都是双面安装元器件,板层也能达到几十层,高密度HDI板、刚柔结合板,微波电路板,埋入式器件板等都在广泛应用。 和封装内的集成一样,PCB上集成也不会用到半导体的特性,因此所用的材料主要分为两大类:导体和绝缘体。


Integration
2
集成的环节
芯片上集成的环节
芯片上的集成主要分为两大环节:器件制造和金属互连,也称为前段工艺FEOL和后段工艺BEOL。
器件制造(前段工艺)
器件制造就是在单晶硅片上通过光刻、刻蚀,离子注入,溅射、化学气相沉积,物理气象沉积、化学机械抛光、晶圆整平等工艺步骤,制造出被我们称为功能细胞的晶体管、电阻、电容、二极管等。现在的5nm工艺可以在1mm²毫米的面积上制造出超过1亿只以上的晶体管。 下图所示为FinFET晶体管在显微镜下的照片,其中较高的白色横梁为栅极G,矮横梁为Fin,其宽度约为栅极宽度的0.67倍,栅极的两侧为源级S和漏极D。
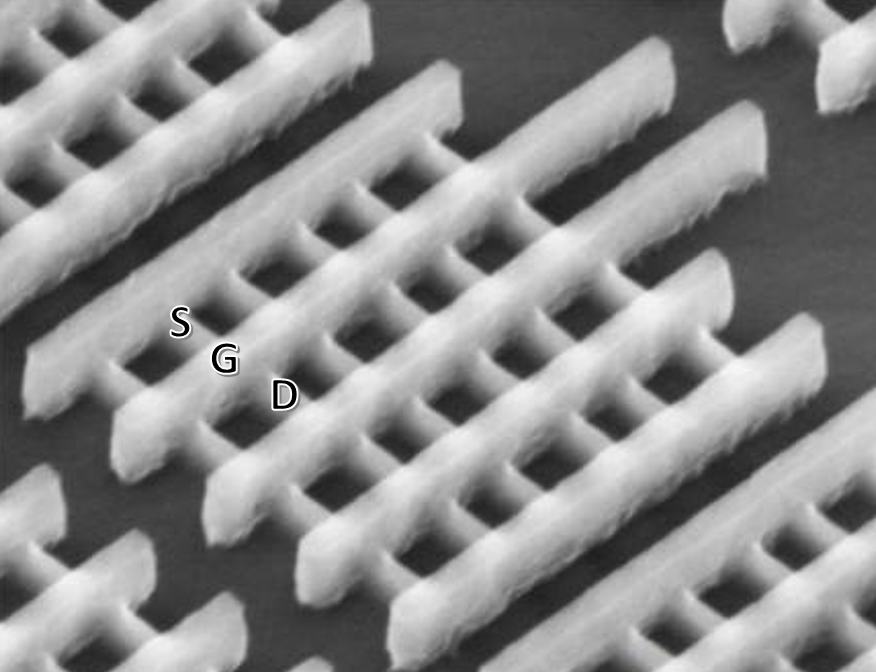
金属互连(后段工艺)
晶体管层制造好后,通过钨等金属制造接触孔contact连接晶体管和首层布线,然后通过多层金属布线和过孔进行电气互连,早先的芯片用铝布线,现在的芯片多用铜布线。
下图所示为芯片上的金属互连线在显微镜下的照片,可以看出多层布线结构,目前的工艺可以支持超过10层以上的金属布线。
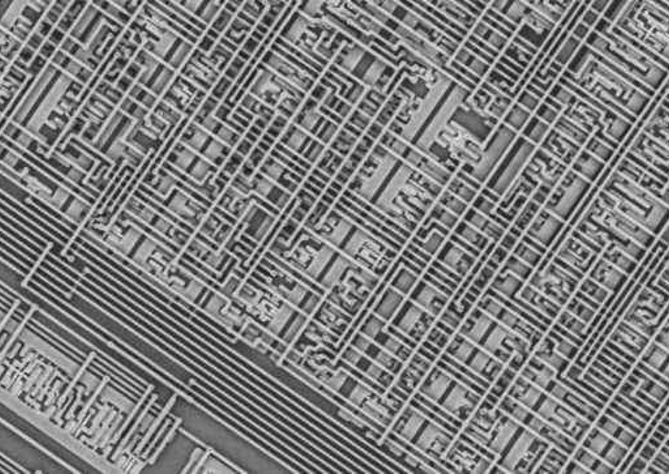
下图给出了前段工艺FEOL和后段工艺BEOL的结构示意图,先在硅基底上制造晶体管,然后通过金属互连将它们连接起来并引出到芯片的PAD。
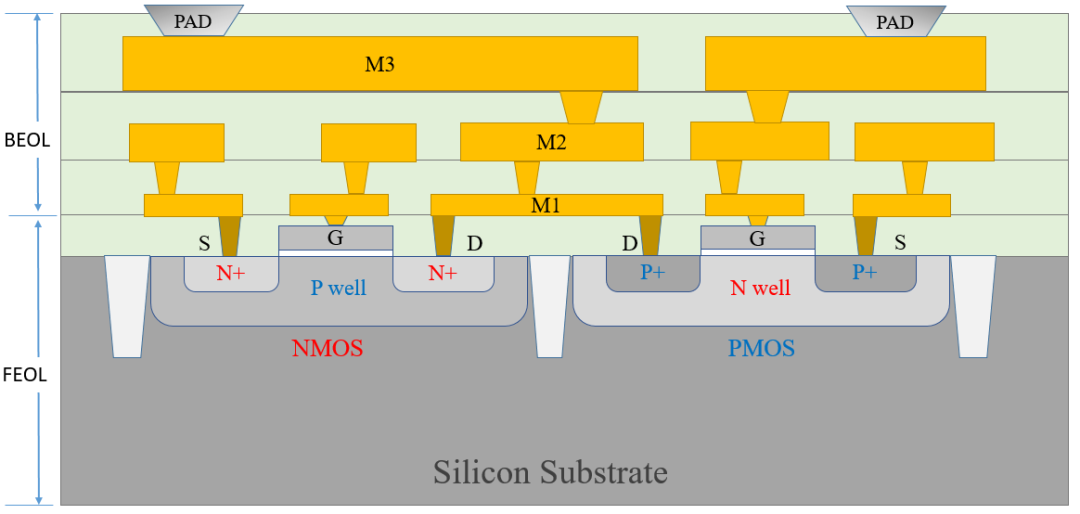
封装内集成的环节
通过键合线Bond Wire将芯片的PAD连接到封装基板或者引线框架,然后再连接到外部引脚,通过引脚的排列方式,可分为BGA,CGA,QFP,LCC,SOP,DIP等多种封装形式。
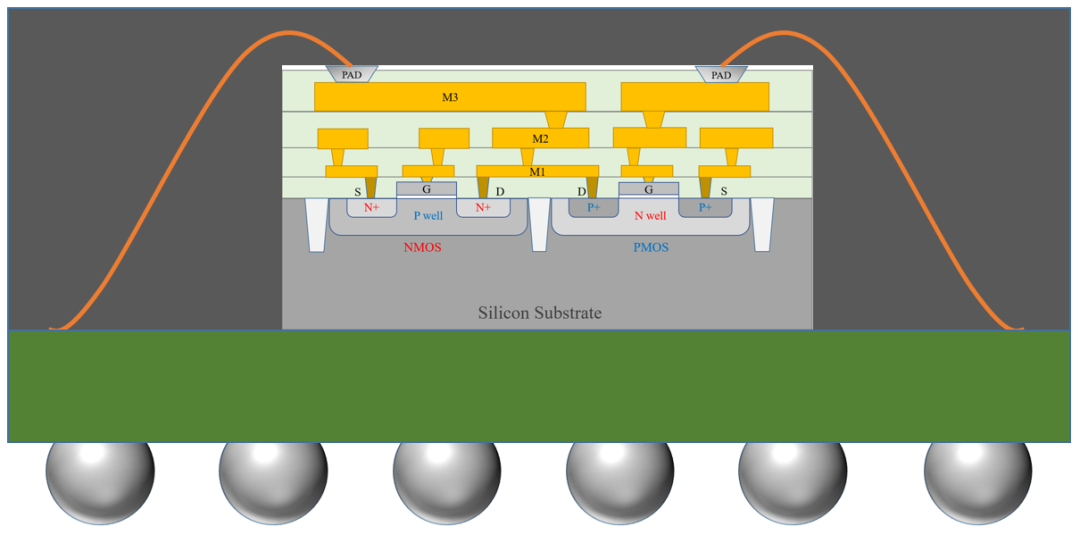
为了提高封装内的功能密度,需要在封装内集成更多的功能单元,传统的键合线连接方式已经无法满足要求,人们发明出多种多样的先进封装技术,下面我们就看看其中最为典型的技术。
芯片上的RDL和TSV制作
在芯片表面布线,通过RDL (Redistribution Layer) 重新布线层将PAD连接到占位更宽松的位置并制作凸点Bump,我们称之为XY平面的延伸。 然后通过Bump,芯片就可以直接安装在基板上了,这种工艺被称为倒装焊 Flip Chip,看看下面的图,你就会明白为啥叫倒装了。
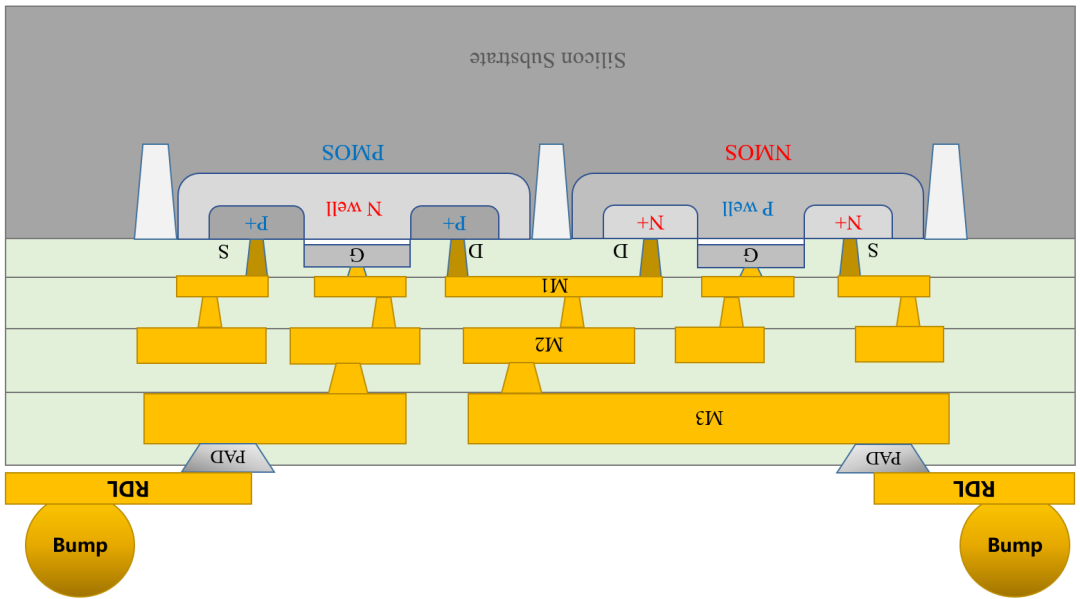
倒装焊芯片由于无法堆叠,因此无法进行Z轴的延伸,人们就发明出了能打穿整个芯片体的通孔技术,被称作TSV(Through Silicon Via)技术。
TSV有许多工艺难点需要克服,我认为最需要解决的是TSV的位置选择和孔径缩小。
下图就是芯片上的TSV示意图,通过TSV可将芯片上下表面通过金属导体连接起来,为芯片堆叠做好了准备。
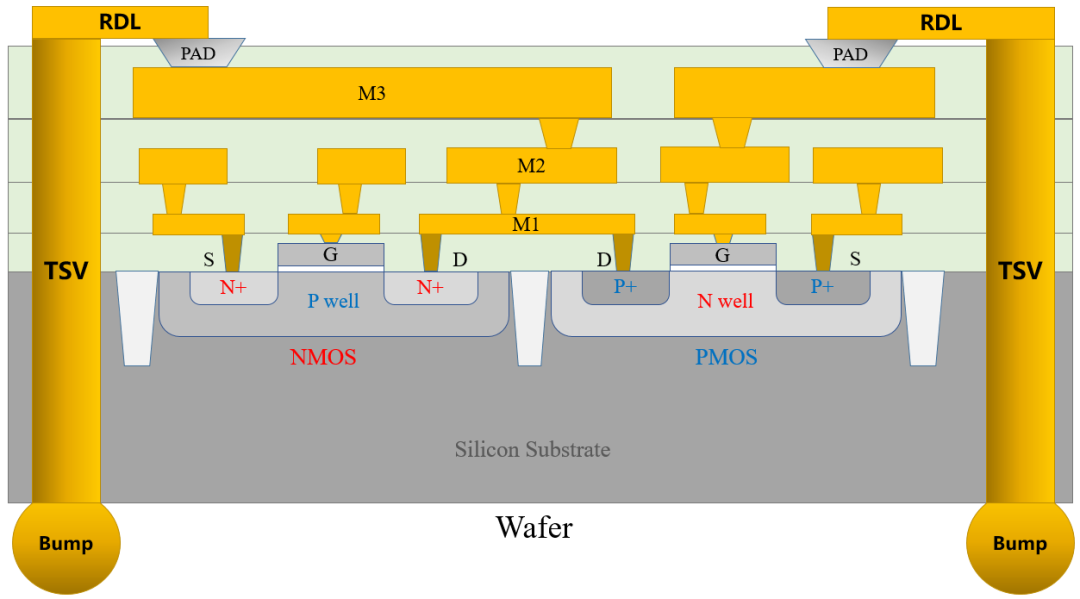
Interposer上的RDL和TSV制作
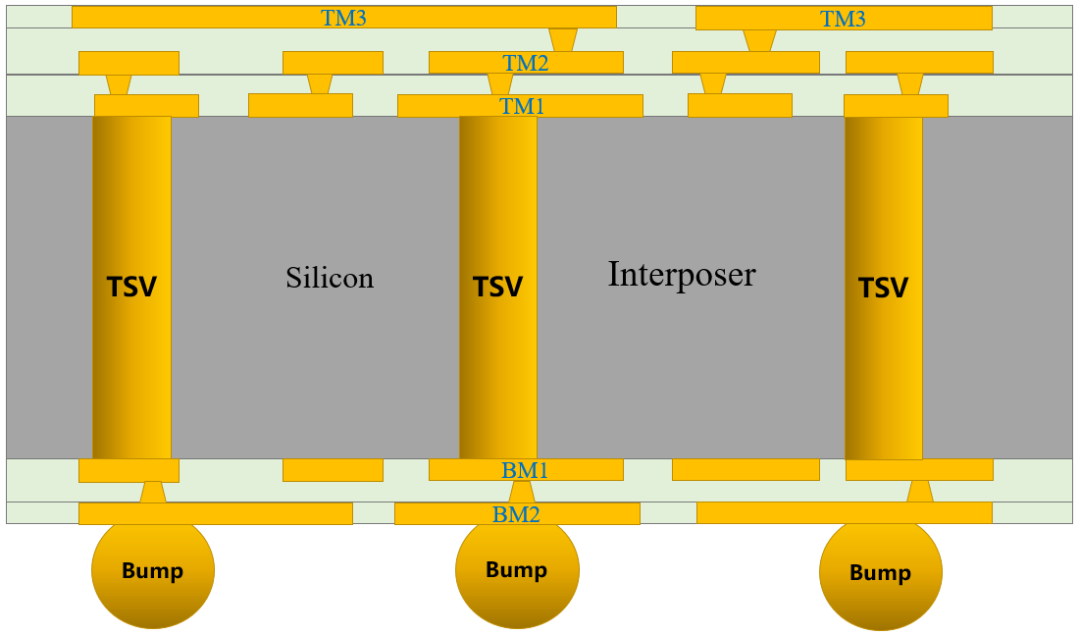
Substrate上的互连线路制作
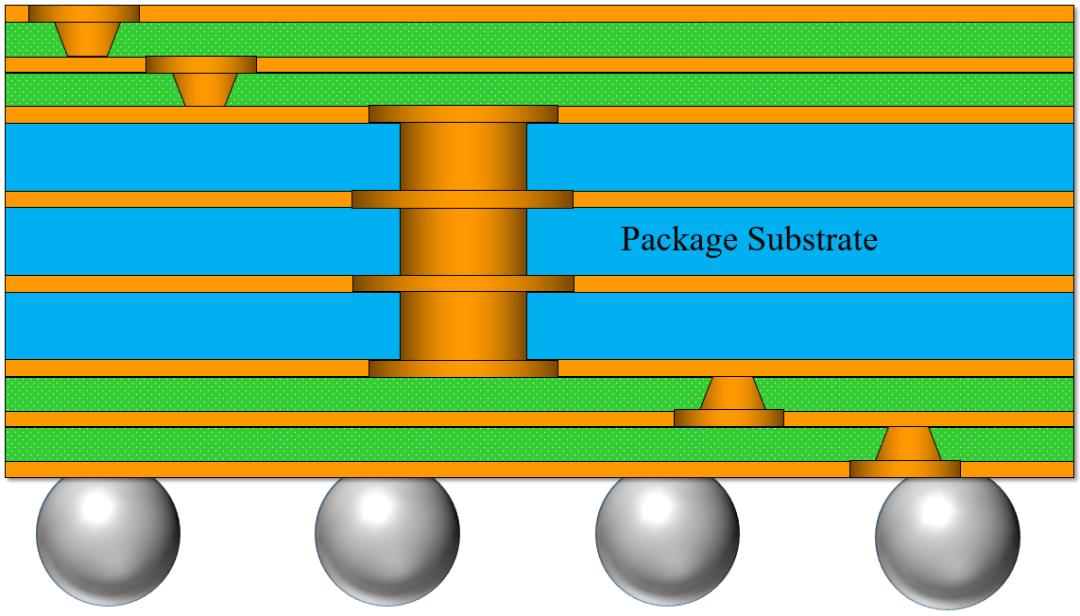
封装基板一般顶部安装器件,底部通过BGA和PCB连接。
器件装配及封装
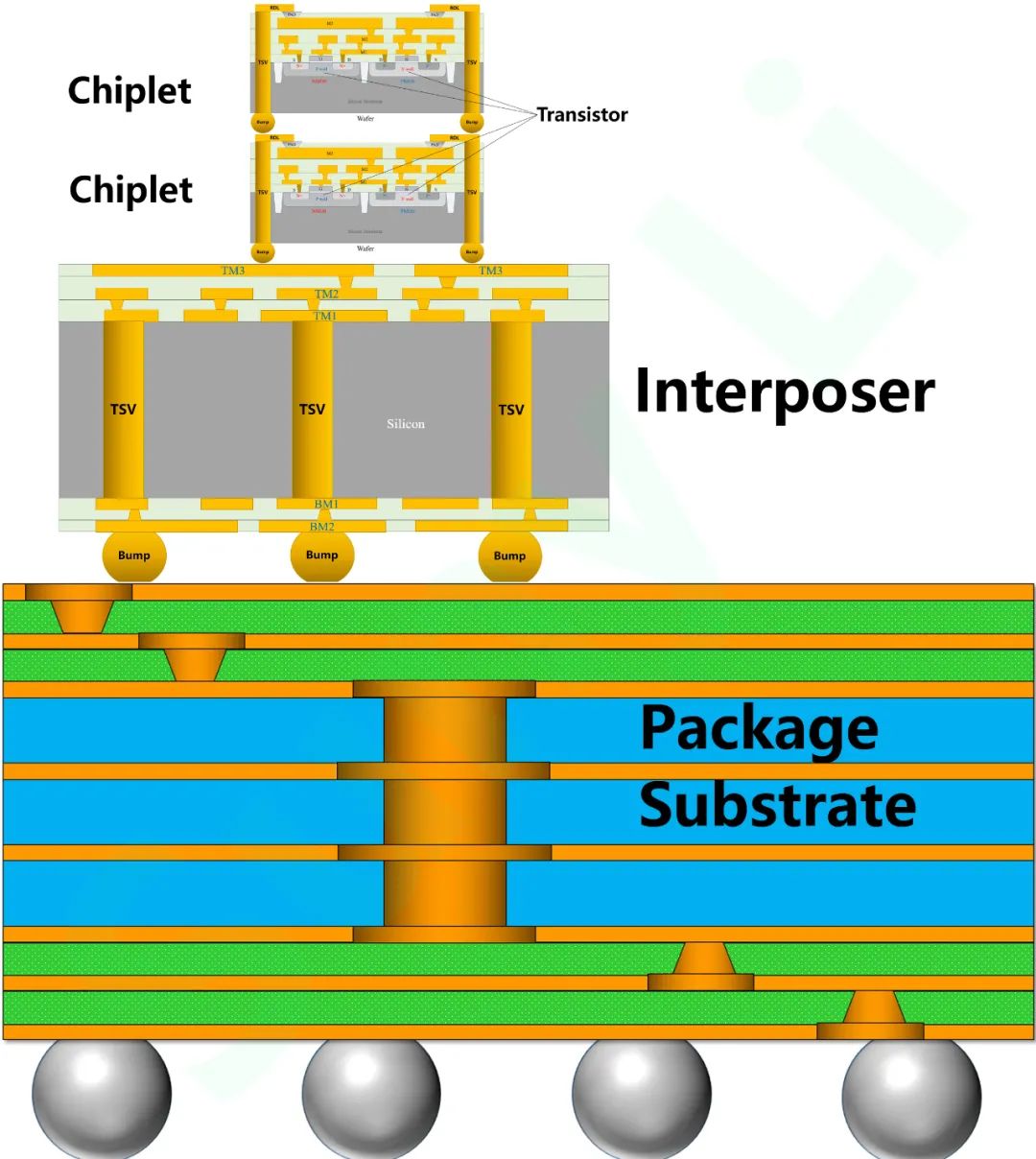
PCB上集成的环节
芯片在封装内集成完成后,尺寸还不够大,另外有些分立元器件、例如大的电容、变压器等也无法集成到芯片封装内部,因此,对于电子产品来说,PCB始终是必不可少的。
PCB互连线路的制作
PCB的制造工艺和有机基板类似,其布线密度没有有机基板高,结构也相对比较简单。PCB上多采用通孔结构,虽然现在高密度HDI板也采用了盲埋孔结构,但通孔由于结构简单,成本低廉,在PCB中得到了普遍的应用。下图所示为6层通孔结构PCB,通过PCB,可将器件固定并进行电气互连。
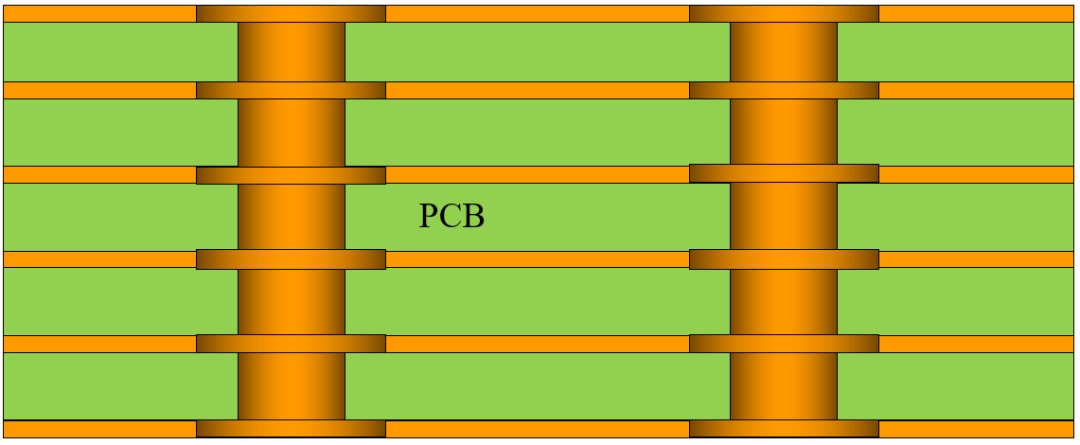
PCB上元器件装配
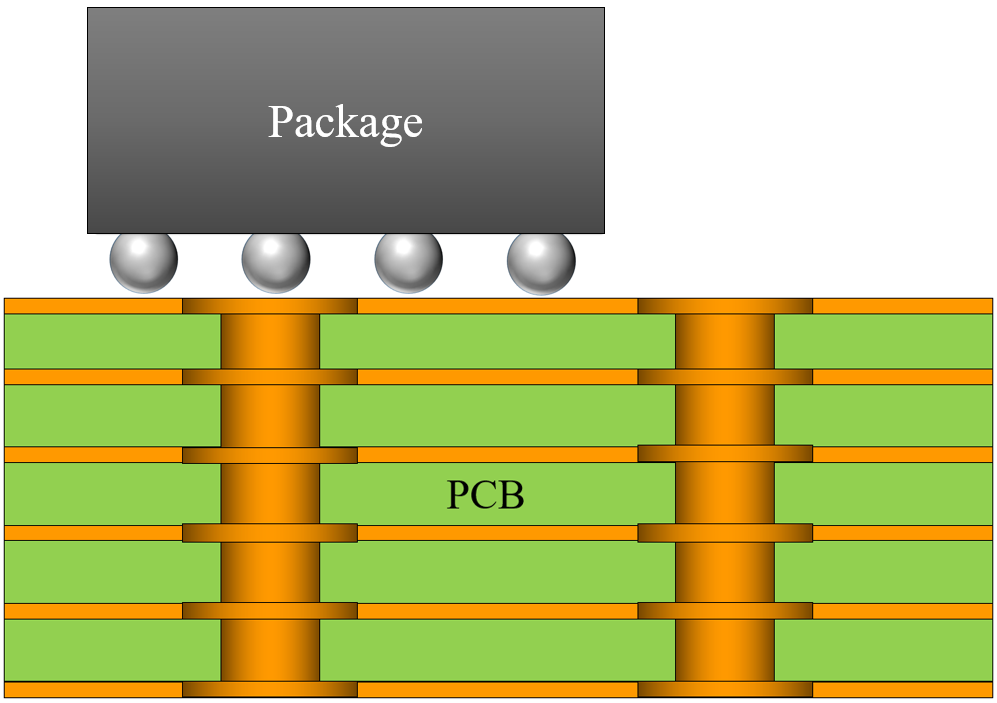
从Transistor到PCB的全图
下面,我们给出一张从晶体管(Transistor)到PCB的集成全图,如下所示:
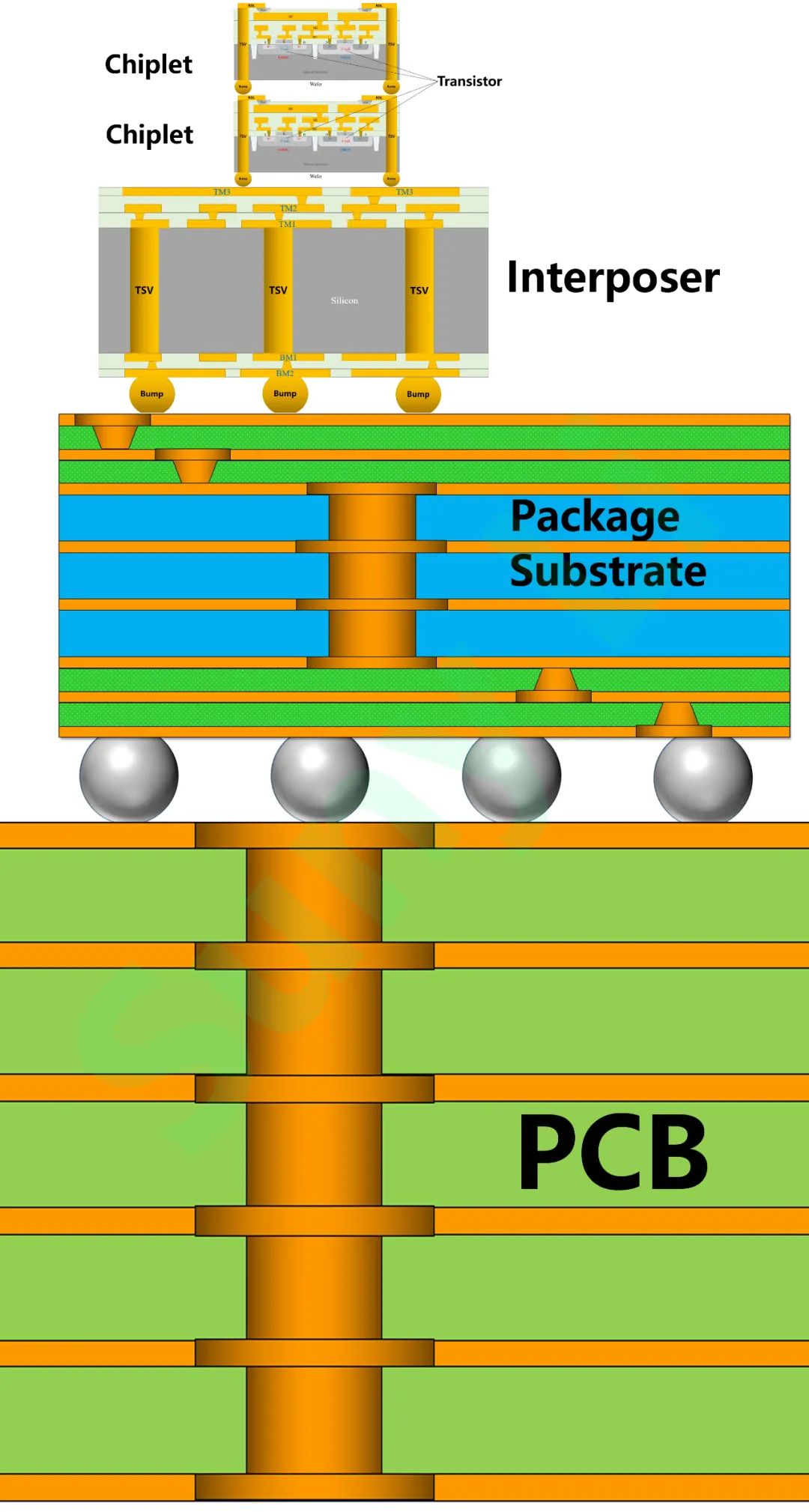
晶体管(NMOS或PMOS)在硅基底上制造完成后,通过接触孔连接到芯片上的金属布线,再连接到芯片的Pad,然后通过RDL连接到3DTSV,通过uBump连接到硅转接板上的RDL和2.5DTSV,再通过Bump连接到封装基板,然后通过封装基板上的连线和过孔连接到BGA,最后连接到PCB上的布线和过孔。
审核编辑:黄飞
-
 jf_56030067
2024-11-12
0 回复 举报赞 收起回复
jf_56030067
2024-11-12
0 回复 举报赞 收起回复
-
一文详解多芯片组件MCM技术2022-09-01 11413
-
集成电路芯片封装技术知识详解2008-05-12 76739
-
一文详解芯片逆向工程的设计与流程2018-09-14 4248
-
一文分享集成芯片的各种封装2020-10-29 7252
-
一文详解蓝牙模块原理与结构2020-11-26 5378
-
一文详解精密封装技术2022-12-30 2603
-
一文详解分立元件门电路2023-03-27 4954
-
一文详解pcb和smt的区别2023-10-08 5864
-
一文详解pcb地孔的作用2023-10-30 3112
-
一文详解pcb不良分析2023-11-29 2281
-
一文详解pcb的msl等级2023-12-13 16751
-
一文详解pcb微带线设计2023-12-14 6691
-
一文详解pcb的组成和作用2023-12-18 3753
-
集成芯片原理图详解2024-03-19 4515
-
一文详解多芯片堆叠技术2025-04-12 3290
全部0条评论

快来发表一下你的评论吧 !

