

等离子刻蚀ICP和CCP优势介绍
描述
过去50年里,影响最深远的技术成就也许就是晶体管小型化的稳步推进,它们的集成密度越来越高、功耗越来越低。
自从20多年前,我们就一直听到这样的警告:这种无穷小的演变即将结束。然而年复一年,优秀的新型创新成果还在继续推动半导体行业进一步发展
刻蚀可以分为湿法刻蚀和干法刻蚀。湿法刻蚀各向异性较差,侧壁容易产生横向刻蚀造成刻蚀偏差,通常用于工艺尺寸较大的应用,或用于干法刻蚀后清洗残留物等。 等离子体刻蚀设备是一种大型真空的全自动的加工设备,一般由多个真空等离子体反应腔和主机传递系统构成。等离子体刻蚀设备的分类与刻蚀工艺密切相关,其原理是利用等离子体放电产生的带化学活性的粒子,在离子的轰击下,与表面的材料发生化学反应,产生可挥发的气体,从而在表面的材料上加工出微观结构。
根据产生等离子体方法的不同,干法刻蚀主要分为电容性等离子体刻蚀和电感性等离子体刻蚀。 电感性等离子体刻蚀(ICP)技术通过射频电源激发气体产生等离子体,是物理过程和化学过程共同作用的结果,在真空低气压下,ICP射频电源产生的射频输出到环形耦合线圈,以一定比例混合的气体经耦合辉光放电,产生高密度的等离子体,在下电极RF射频作用下,这些等离子对基片表面进行轰击,基片材料的化学键被打断,与刻蚀气体反应生成挥发性物质,以气体形式脱离基片,从真空管路被抽走。
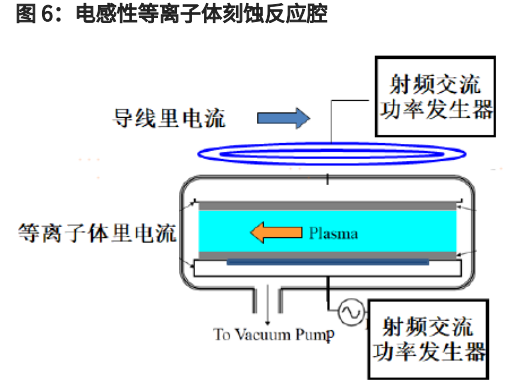
ICP刻蚀的优势包括:
能够在较低的压力下运行,从而提供更好的剖面控制。
刻蚀速率快、选择比高、各向异性高、刻蚀损伤小、大面积均匀性好、刻蚀断面轮廓可控性高和刻蚀表面平整光滑等优点。
广泛应用在硅、二氧化硅、III-V族化合物、金属等材料的刻蚀上。
电容式等离子刻蚀(CCP)技术则是通过在电极上施加射频电压来产生等离子体,其中电极与等离子体之间形成一个电容。在CCP刻蚀过程中,电子在电场的作用下获得能量,进而引发气体分子的电离。CCP刻蚀通常在较高的压力下进行,适用于氧化物、氮化物等绝缘材料的刻蚀。
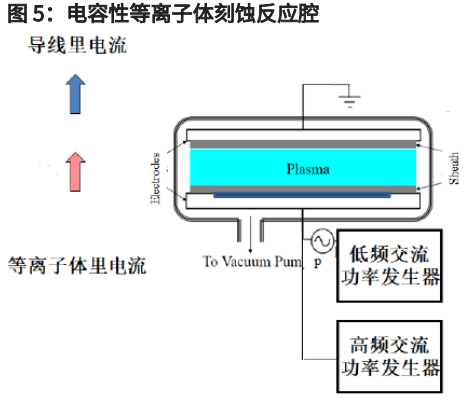
CCP刻蚀的特点包括:
适用于刻蚀绝缘材料,如氧化硅、氮化硅等。
刻蚀过程中产生的离子能量较高,有利于实现深孔或高方面比结构的刻蚀。
由于其较高的工作气压,CCP刻蚀通常需要考虑等离子体的均匀性和刻蚀速率的平衡。
实际应用角度为:
刻蚀键能较大如oxide的物质,用CCP;刻蚀金属/多晶,ICP更好。
前道难点工艺,深硅槽刻fin这种,都还是要应用ICP。后段互联层挖深孔刻lowk这种,还是要用到CCP。
具体设备选型,要结合实际刻蚀layer的材料,现有工艺benchmark,成本、产能综合考虑。
审核编辑:黄飞
-
北方华创发布全新一代12英寸高端电感耦合等离子体刻蚀设备NMC612H2026-03-26 879
-
远程等离子体刻蚀技术介绍2025-06-30 1758
-
半导体刻蚀工艺技术-icp介绍2025-05-06 5957
-
干法刻蚀的概念、碳硅反应离子刻蚀以及ICP的应用2025-01-22 3486
-
为什么干法刻蚀又叫低温等离子体刻蚀2024-11-16 2031
-
半导体干法刻蚀技术解析2024-10-18 4275
-
什么是电感耦合等离子体,电感耦合等离子体的发明历史2024-09-14 3723
-
中微公司喜迎ICP刻蚀设备Primo nanova®系列第500台付运里程碑2024-03-21 1700
-
干法刻蚀常用设备的原理及结构2024-01-20 17572
-
等离子体应用2022-05-18 3859
-
等离子显示器的工作原理是什么?PDP等离子显示器有哪些特点?2021-06-07 2305
-
庆祝!北方华创ICP刻蚀机交付已突破1000腔2020-12-11 3303
-
等离子切割机有什么优势?2019-09-27 3492
-
高亮度LED等离子刻蚀技术2011-10-31 1653
全部0条评论

快来发表一下你的评论吧 !

