

TPAK SiC优选解决方案:有压烧结银+铜夹Clip无压烧结银
电子说
描述
TPAK SiC优选解决方案:有压烧结银+铜夹Clip无压烧结银
第三代半导体以及新能源汽车等新兴电力电子领域的出现和发展,对于功率模块的发展不仅仅停留在芯片技术的迭代,同时为了满足更高的需求。性能取决于封装技术的高占比率,汽车行业对于成本效率、可靠性和紧凑性有着很高的要求,新的封装技术和工艺日益浮出水面。
相比之前的标准化模块封装,近年来各具特色的模块封装类型都慢慢发展起来,比如:DCM、HPD和TPAK等等。并且其中细节部分也有着不一样的改进,如DBB技术、Cu-Clip技术、激光焊接、SKiN、单/双面水冷、银烧结、铜烧结等等,无疑给模块封装技术增添了更多组合的可能,以应对不同的性价比和应用。
在IGBT的封装失效模式中,焊料的疲劳和键合线故障导致的失效是器件失效的两大主要原因。在IGBT多层结构中,芯片下方的散热通道是散热的主要途径,芯片下面焊料是其中的重要组成部分,也是最容易发生焊料疲劳退化的位置。
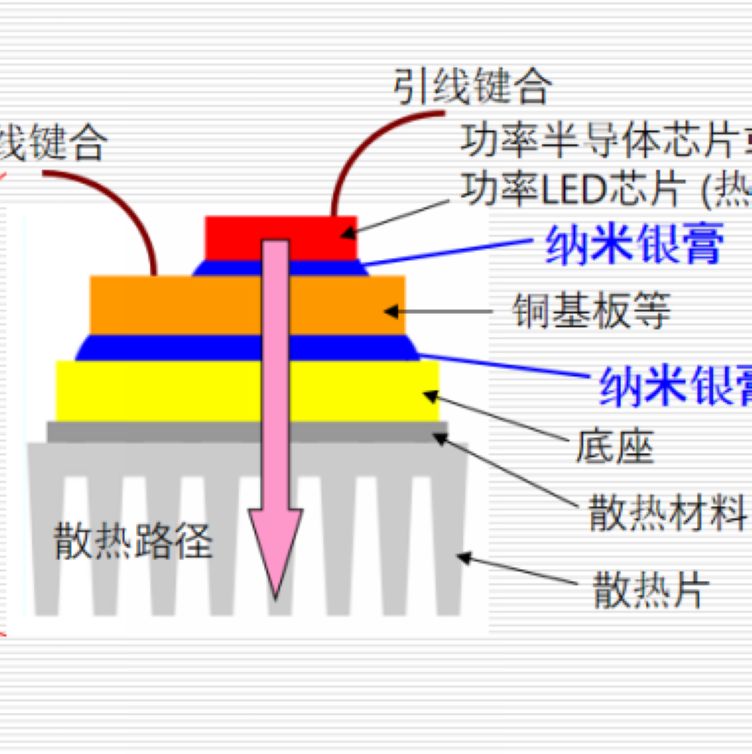
AS9300系列烧结银
一 传统焊料缺点
传统钎焊料熔点低、导热性差,在工作期间产生的热循环过程中,由于材料间CTE差异,在材料间产生交变的剪切热应力,在应力的连续作用下,容易导致焊料层疲劳老化、产生裂纹,进而发展为材料分层,由于裂纹和分层的产生,焊料层与各层材料间的接触面积减小,热阻变大,加速了焊料层的失效,难以满足车规高功率SiC器件封装的可靠性及其高温应用要求。
二 铝线键合缺点
由于铝及其合金价格低、热导率高,25℃时为237(W/mK),铝线键合是目前模块封装中应用最广泛的一种芯片互连技术。但由于铝的热膨胀系数23.2×10-6K-1与硅芯片的热膨胀系数4.1×10-6K-1相差较大,在长时间的功率循环过程中容易产生大量热量并积累热应力,引起键合线断裂或键合接触表面脱落,导致模块失效。在电流输出能力要求较高的情况下,芯片表面键合引线的数目过多,会引起较大的杂散电感,同时对电流均流也有一定影响。
三 烧结银AS9386+铜Clip无压烧结银AS9376优点
为解决高功率密度车用模块中芯片下面焊料疲劳与键合线故障问题,善仁新材针对Tpak SiC封装,为客户提供了一个创新的材料解决方案:有压烧结银AS9386+铜Clip方案。芯片与AMB间的连接采用烧结银AS9386代替传统焊料,5mm*5mm碳化硅芯片推荐烧结银BLT厚度30UM左右。银的熔点高达961℃,不会产生熔点小于300℃的软钎焊连接层中出现的典型疲劳效应,大幅提高了模块的功率循环能力;芯片上表面采用无压烧结银AS9330焊接铜Clip的一体化leadframe替代铝线键合,可以减小模块内部的杂散电感,提升了芯片表面电流的均流性,增强了模块整体的过流能力。铜比铝更优异的导热能力,也提升了模块整体的散热能力。有效地提升了模块整体的出流能力和可靠性。
推荐:1使用较薄的Clip,建议厚度0.5-1.0mm之间,连接的位置热机械应力会更小,但满足必要的载流能力的同时,尽量使用较薄的Clip。
2可以通过开孔来缓解应力,孔的形状大小和芯片接触的边缘位置又有所考究,这需要结合实际来具体设计完善的。
3 推荐TPAK模块在内外部都采用了烧结银(sintering)作为连接方式。模块内部,芯片通过银烧结层与AMB相连,代替锡焊层。在模块外部,TPAK的底板也烧结到散热器上,代替导热膏涂层。两者共同作用,不仅使得系统的散热能力上了一个台阶,而且TPAK本身的可靠性,特别是功率循环次数,也获得了很大提高。另外,散热性能的提高意味着同样尺寸的芯片可以在限定的结温下输出更大的电流,或是输出同样的电流下用较小尺寸的芯片,实现芯片降本。
四 测试数据
按照AQG-324标准,获取模块在随机激励条件下的振动频率,研究铜夹Clip方案模块被迫抵抗外部随机振动的能力与结构设计合理性。
根据仿真结果:模块整体应力较小,最大应力出现在与塑封体相交的铜排端子处部位,其中最大应力不超38MPa,安全系数取1.35,满足安全使用条件。
在对应PSD频谱作用下,模块最易损坏的部分是与塑封相交的铜排端子处部位,与模型的应力分布相吻合,其中模块最低寿命为9.9×104s满足22h要求。电感部分对模块整体电感进行仿真,仿真结果模块电感4.9nH满足设计要求。
前期验证考虑芯片最大结温是否满足芯片耐受温度。使用软件PLECS,依据数据手册计算相应芯片损耗,根据热仿真结果芯片最高温度小于140℃,满足设计要求。
总的来说,善仁新材推出的车规级SIC Tpak器件材料解决方案:采用有压烧结银AS9386和铜夹Clip无压烧结银技术实现了高可靠性、低热阻、低杂散电感器件设计。银烧结技术使用银浆替代传统焊料,降低模块整体热阻,提高芯片和AMB互连的可靠性,有效增强模块的功率循环能力。铜夹Clip技术利用Leadframe一体化的铜排代替键合铝线,可以有效地减小模块内部杂散电感,拥有更高的电流输出能力的同时可以增强芯片的散热,提高模块的可靠性。
审核编辑 黄宇
-
烧结银的中国创新之路:从280℃到130℃2026-05-04 173
-
为什么无压烧结银膏在铜基板容易有树脂析出?2025-10-05 4364
-
无压烧结银膏应该怎样脱泡,手段有哪些?2025-10-04 4936
-
150℃无压烧结银最简单三个步骤2025-02-23 1249
-
裸硅芯片无压烧结银,助力客户降本增效2024-10-29 1452
-
低温无压烧结银在射频通讯上的5大应用,除此之外,烧结银还有哪些应用呢?欢迎补充2024-09-29 14519
-
无压烧结银VS有压烧结银:谁更胜一筹?2024-07-13 4153
-
150度无压烧结银用于功率器件,提升效率降低成本2024-05-23 1162
-
无压烧结银AS9377的参数谁知道?2023-12-17 3835
-
低温无压烧结银对镀层的四点要求2023-11-25 1976
-
无压烧结银成为 DA5联盟选择功率芯片连接材料的优选方案之一2023-01-02 1223
-
无压和有压烧结银工艺流程介绍2022-04-09 6720
-
无压烧结银工艺和有压烧结银工艺流程区别2022-04-08 3099
-
AlwayStone AS9375是一款使用了银烧结技术的无压纳米银2022-04-02 2130
全部0条评论

快来发表一下你的评论吧 !

