

CAE热仿真中的芯片物性等效建模方法分析
电子说
描述
本文摘自网络,无法查找到原创出处。若有侵权,请联系删除。
准确、高效的仿真模型是完成虚拟仿真、实现精确设计、指导实际应用等功能的重要基础。在电力电子电能变换领域 不同设计阶段和应用背景下,对仿真模型的特性、精度和仿真速度有着不同要求。因此,根据需求提供满足一定要求的仿真模型是建模工作的关键。
本文在于研究用 ANSYS icepak/Flotherm建模的时候,主要探讨对芯片等材料属性的选取与设置,以及本体模型如何构建。文中给出相关材料属性的方法探讨也同样适用于其他CAE软件的建模。
在利用Flotherm或者Ansys Icepak等软件对电子产品进行热仿真时,一个避免不了话题就是如何对各种各样的芯片进行建模,这主要是因为芯片种类众多,而且内部结构相当复杂。
工程师通常无法获得芯片内部的具体结构信息,只能草草的按芯片的外形尺寸画一个BLOCK了事。实际上,业界对此已有应对措施,这就是Compact thermal modeling-压缩热模型。
本文将详细介绍元件的方块模型,详细模型和压缩热模型,讲解如何在热仿真中使用这三种模型。
元件模型分类
在热仿真中,按照元件的建模方式,可以将元件模型分为三类,这就是方块模型,详细模型和压缩热模型。其中,压缩模型又可以分为双热组模型和Delphi模型,如下图所示。

方块模型
方块模型,英文写作Cuboid,是热仿真中最简单的元件模型。顾名思义,即以一个与元件外形尺寸一致的方块来代替元件,然后为此元件赋予一个集总的热传导系数和热损耗来进行热仿真,如下图所示。

方块模型的优点:
模型简单,建模速度快
网格少
可以用于估计模型周围的空气温度和PCB温度
方块建模的缺点:
无法得到元件结温
需要估计模型集总热传导系数
元件温度仿真精度不高
通过上面方块模型的优缺点分析,我们可以得知,当一个芯片的损耗较小,发热不是很严重时,且对其结温不是很关心时,可以选择方块模型来进行建模。对于芯片模型的热传导系数,建议采用软件材料库内的材料,如果材料库没有对应的元件封装,则建议塑胶封装按5W/mK,陶瓷封装按20W/mK来进行设置。如果在热仿真中发现该方块模型的温度比较高,则建议采用其它建模方式来进行建模。
详细模型
详细模型,英文写作Detail thermal model,很多文献里简称为DTM,即Detail thermal model的缩写。详细模型理解起来很简单,即按照芯片元件的外部和内部的详细尺寸,材料建立元件模型。下图为一QFN芯片的详细模型与实物的对比。
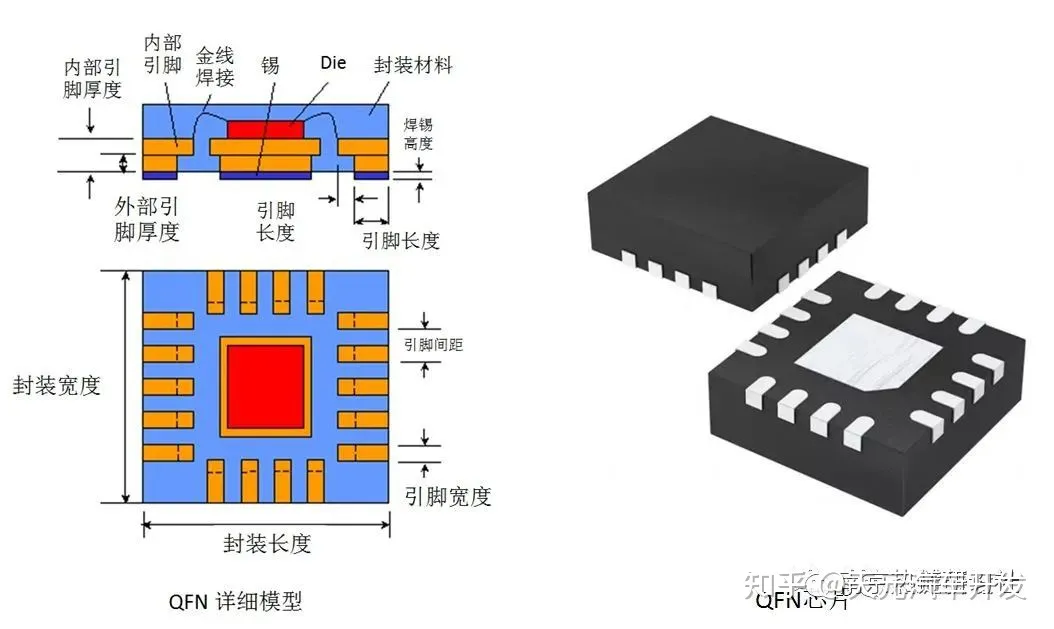
详细模型优点:
仿真精度高
可以得到精确的结温
可以得到精确的壳温
详细模型缺点:
由于芯片厂商怕泄露芯片设计,模型内部结构难以甚至不可能得到
网格非常多
通过上面的详细模型优缺点分析,我们可以得知,虽然详细模型的仿真精度非常高,但是由于对于系统里的仿真来说,非常难以得到芯片的内部结构信息,对于系统级的仿真来说,并不适用。通常情况下来说,仅适用芯片生产厂家使用。
压缩热模型
如前所述,由于方块模型的仿真精度不高,且无法得到模型结温,而详细模型虽然精度高且可以得到结温,但是对于系统级的仿真来说,又通常难以得到芯片内部结构。
有鉴于此,业界提出了压缩热模型这一概念并制定了相关的标准。压缩热模型,英语写作Comapct thermal model,通常简写为CTM。压缩热模型这一概念是在热阻模型的基础上产生的,其定义如下:
元件封装内包括一个完整的电路,且其温度可以由内部一结点的温度来代替,即我们通常说的元件结温
元件安装于PCB板上
元件内部产生的热从元件内部流到:
元件上表面,再经过元件上表面流到空气中或者散热器中
元件侧面
元件底面或者元件引脚,再通过元件底面和引脚流到PCB上
利用热阻网络来表示热流途径
元件每个外表面可以视作一个温度结点,或者可以将每个外表面细分为多个温度结点
在仿真实际中,通常根据JEDEC15标准,将压缩热模型分为双热阻模型和Delphi多热阻模型。
双热阻模型
双热阻模型,英文为2 Resistances,简写为2R。在双热阻模型中,假定元件工作时产生的热仅会从元件上表面和元件底面或者引脚传出,不会从元件侧面传出。因此,可以使用元件结点到壳结点的热阻和元件结点到PCB板的热阻来建立元件模型。双热阻模型示意图如下图所示。
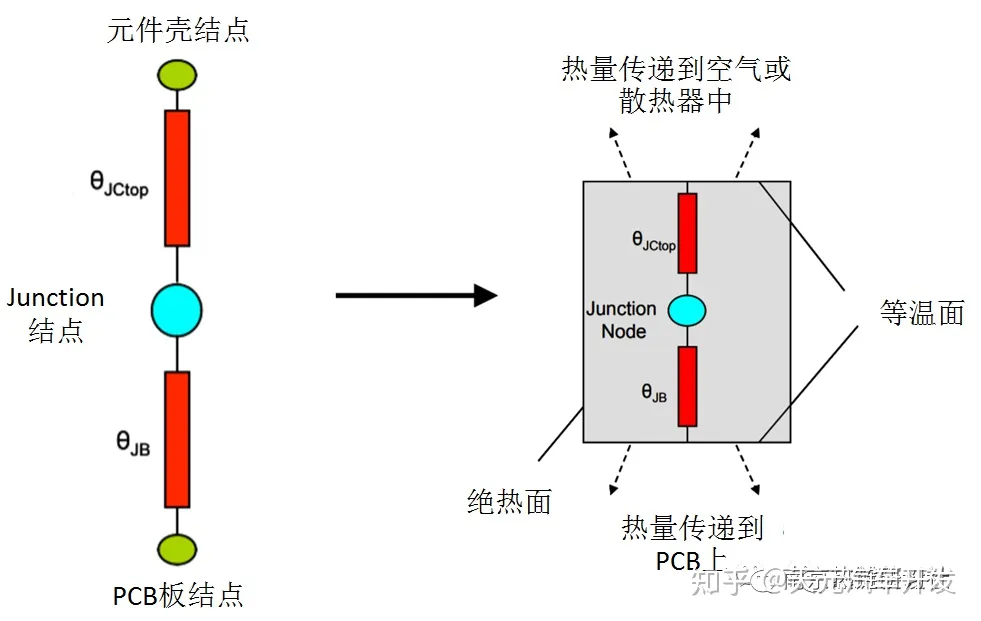
假设一块PCB板上仅有一个元件,则当使用双热阻模型来对此元件进行建模时,其热传递途径如下图所示,从图中我们可以清晰的看出,元件结点到壳结点的热阻和元件结点到PCB板的热阻两者之间为并联关系。
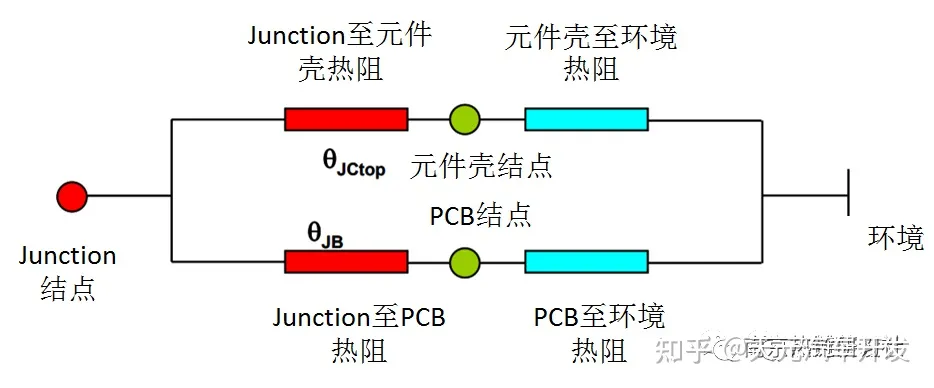
双热阻模型优点:
模型简单
网格少
模型参数比较少,仅两个,且容易得到,部分可以从芯片规格书查知或者直接向厂家索取
对于模型周围的空气温度和PCB温度,仿真精度比方块模型高
可以得到结温
双热阻模型缺点:
由于忽视了元件侧面,引脚等较多的的热传递途径,仿真精度在某些情况下达不到要求
通过上面的分析,可以得出以下结论,双热阻模型仿真精度比方块模型高,但是与芯片真实散热情况还有距离。在系统级的仿真中,可以利用双热阻模型得到精确的芯片周围空气温度和PCB板温度,以及不是那么精确的结温,其结温误差最大可达20%。
Delphi模型
Delphi模型,有时也称之为Multi Resistances模型,即多热阻模型。与双热阻模型相比,多热阻模型增加了更多的节点,可以考虑更多的散热途径。下图为一QFP芯片的Delphi模型,在此模型中,除了考虑元件顶面和底面的热传递外,还增加了元件引脚到PCB的热阻,同时更将芯片顶面和底面分为内部节点和外部节点,增加了元件结点到它们的热阻值。
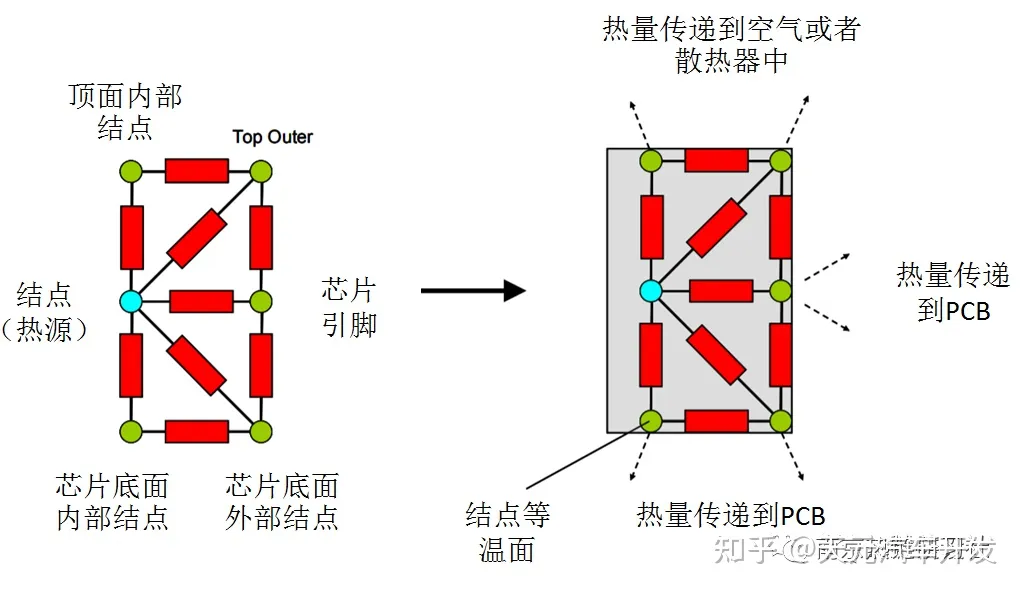
下图为另一QFP模型的结点示意图。
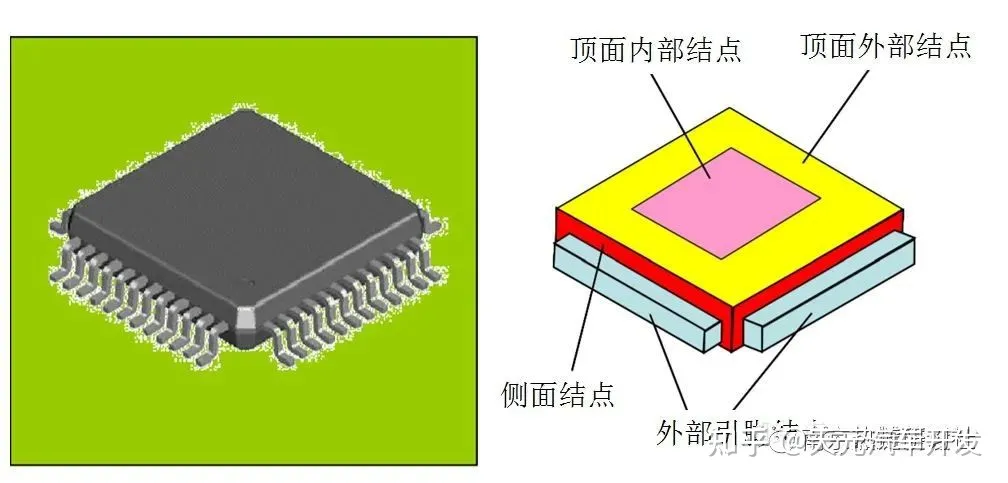
Delphi模型优点:
模型简单
网格少
对于模型周围的空气温度和PCB温度,仿真精度比2R模型高
可以得到准确的结温
Delphi模型缺点
需要输入的热阻参数较多,且不可能从芯片规格书查知,需要向厂家索取
使用Delphi模型,可以得到比较准确的元件结温和模型周围的空气温度以及PCB温度,因此,在条件允许的情况下,应尽量向厂家索取Delphi模型或者热阻值以进行仿真。
审核编辑 黄宇
-
等效物性建模的三种方法2024-12-19 1098
-
微变等效电路和小信号等效电路分析方法的区别2024-07-16 4190
-
详解部分元等效电路法在电磁仿真中的应用2023-12-07 2976
-
ANSYS Icepak如何对芯片ECAD进行热仿真?2023-03-22 14490
-
CAE仿真在通信连接器EMC设计中的应用2023-01-03 3414
-
IPOSIM仿真中的散热器热阻参数Rthha解析2022-08-01 4076
-
电子元器件如何在电路仿真中进行建模?2021-04-06 3536
-
连接器的热设计与热仿真和热测试2020-07-07 3504
-
电子设备电磁兼容仿真缝隙转移阻抗等效建模思想2019-05-30 2624
-
基于设计数据共享的板级热仿真技术研究(二)2018-09-26 2485
-
直流控制系统机电暂态等效建模2018-01-05 1053
-
一种面向动态分析的PCB板等效建模方法_刘孝保2016-06-16 643
-
电子元器件在电路仿真中的建模2010-12-28 536
-
电子元器件在电路仿真中如何建模2010-04-12 13137
全部0条评论

快来发表一下你的评论吧 !

