

SMU数字源表测试IC芯片电性能方案
电子说
描述
芯片测试作为芯片设计、生产、封装、测试流程中的重要步骤,是使用特定仪器,通过对待测器件DUT(DeviceUnderTest)的检测,区别缺陷、验证器件是否符合设计目标、分离器件好坏的过程。其中直流参数测试是检验芯片电性能的重要手段之一,常用的测试方法是FIMV(加电流测电压)及FVMI(加电压测电流)。
传统的芯片电性能测试需要数台仪表完成,如电压源、电流源、万用表等,然而由数台仪表组成的系统需要分别进行编程、同步、连接、测量和分析,过程复杂又耗时,又占用过多测试台的空间,而且使用单一功能的仪表和激励源还存在复杂的相互间触发操作,有更大的不确定性及更慢的总线传输速度等缺陷,无法满足高效率测试的需求。
实施芯片电性能测试的最佳工具之一是数字源表(SMU),数字源表可作为独立的恒压源或恒流源、电压表、电流表和电子负载,支持四象限功能,可提供恒流测压及恒压测流功能,可简化芯片电性能测试方案。
此外,由于芯片的规模和种类迅速增加,很多通用型测试设备虽然能够覆盖多种被测对象的测试需求,但受接口容量和测试软件运行模式的限制,无法同时对多个被测器件(DUT)进行测试,因此规模化的测试效率极低。特别是在生产和老化测试时,往往要求在同一时间内完成对多个DUT的测试,或者在单个DUT上异步或者同步地运行多个测试任务。
基于CS系列多通道插卡式数字源表搭建的测试平台,可进行多路供电及电参数的并行测试,高效、精确地对芯片进行电性能测试和测试数据的自动化处理。主机采用10插卡/3插卡结构,背板总线带宽高达 3Gbps,支持 16 路触发总线,满足多卡设备高速率通信需求;汇集电压、电流输入输出及测量等多种功能,具有通道密度高、同步触发功能强、多设备组合效率高等特点,最高可扩展至40通道。

开短路测试(Open-Short Test,也称连续性或接触测试),用于验证测试系统与器件所有引脚的电接触性,测试的过程是借用对地保护二极管进行的,测试连接电路如下所示:

漏电流测试,又称为Leakage Test,漏电流测试的目的主要是检验输入Pin脚以及高阻状态下的输出Pin脚的阻抗是否够高,测试连接电路如下所示:
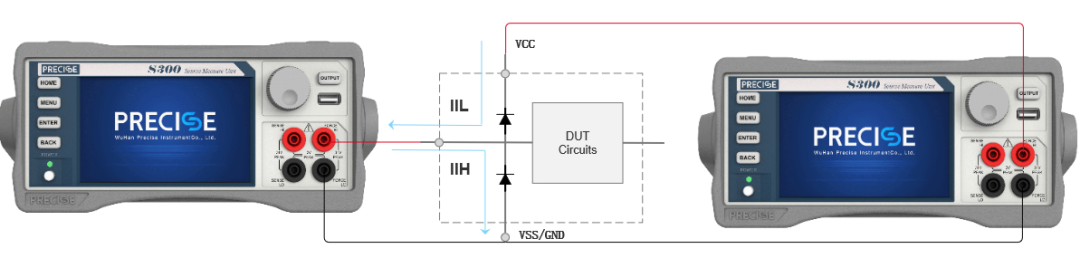
DC参数的测试,一般都是Force电流测试电压或者Force电压测试电流,主要是测试阻抗性。一般各种DC参数都会在Datasheet里面标明,测试的主要目的是确保芯片的DC参数值符合规范:

审核编辑 黄宇
-
SMU数字源表连接探针台示意图及注意事项2024-10-30 1685
-
SMU数字源表IV扫描测试纳米材料电性能方案2024-03-05 2026
-
新的高性价比 英国 Aim TTi进口数字源表 SMU42012023-05-18 1418
-
技术方案 吉时利Keithley2602B数字源表2022-03-01 31896
-
二手keithley吉时利2612A数字源表SMU介绍2021-11-08 656
-
美国Keithley吉时利2425数字源表(SMU)源度量单元2021-10-11 405
-
现金回收 Keithley 2657A 数字源表2021-09-02 560
-
吉时利Keithley 2450数字源表 Keithley 2460 2461数字源表 收购二手2021-08-10 1261
-
数字源表的相关问答2021-07-06 944
-
关于2600B系列数字源表源测量单元(SMU)仪表的介绍2021-05-10 2167
-
2450数字源表测量单元(SMU)吉时利24502020-05-30 752
-
电池综合性能测试方案2020-02-12 2374
-
出售吉时利Keithley 2636B数字源表2019-11-28 551
-
吉时利数字源表产品介绍2019-09-12 4733
全部0条评论

快来发表一下你的评论吧 !

