

氧化镓器件,高压电力电子的未来之星
描述
超宽带隙(UWBG)半导体相比si和宽带隙材料如SiC和GaN具有更优越的固有材料特性。在不同的UWBG材料中,氧化镓正逐渐展现出其在高压电力电子领域的未来应用潜力。本文总结了氧化镓材料的一些固有特性,并展示了近期在高压器件方面的一些进展。
氧化镓的固有材料特性
氧化镓的β相(β-Ga2O3)已成为评估UWBG材料选择的关键候选。多个因素促成了这一点。表1列出了硅、碳化硅、氮化镓和β-Ga2O3的一些基本材料特性。
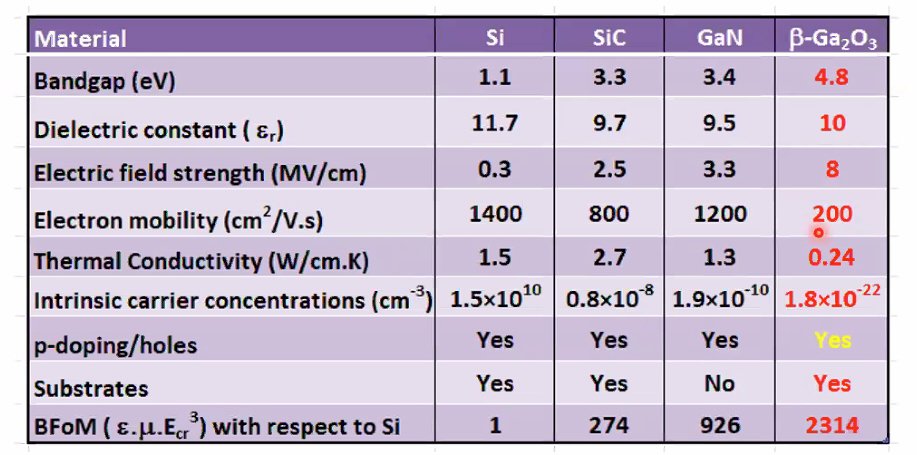 表1:Si、SiC、GaN 和 β-Ga2O3 的一些基本特性
表1:Si、SiC、GaN 和 β-Ga2O3 的一些基本特性
β-Ga2O3的高带隙和电场强度是其两大优势。这使得在高压电力器件中能更有效地进行器件缩放,并能同时改善导通和开关损耗的指标。
表1中所示的理想Baliga优值(BFOM)通常用于描述导通态电阻损耗与击穿场之间的权衡。然而,这并未包括两个重要因素:
掺杂剂的不完全电离;衬底中的背景杂质
浅掺杂剂的可获得性是接近理论BFOM极限实现性能的关键。然而,UWBG材料可能缺乏此类掺杂剂。以氮化铝(AlN)和钻石为例,高掺杂剂电离能使得在室温下有效实现高水平的激活掺杂剂变得困难,导致电导率低。幸运的是,β-Ga2O3拥有浅的n型施主掺杂剂(锡、硅)。
带隙内的杂质态可以进一步补偿掺杂剂密度并降低器件性能,与硅相比,UWBG材料中的杂质水平可以高出几个数量级。AlN和钻石都受到此影响,背景浓度可达1e16/cm3范围。在宽带隙材料中,氮化镓的背景浓度也相对较差,超过1e15/cm3。β-Ga2O3在此方面再次具有优势,通过外延和衬底生长的进展,背景电荷浓度低于1e15/cm3。
低背景掺杂和高带隙的重要性的一个好例子是额定6.5 kV的硅IGBT,需要最小阻断电压厚度为220 µm,背景杂质低于4e13/cm3,这难以实现,并且无论如何都会导致非常高的RDS(on),而β-Ga2O3只需要8 µm厚的阻断层,净掺杂浓度为3e16/cm3。
考虑上述效应的修正BFOM比较如图1所示。这些图显示了β-Ga2O3在高于1 kV电压额定值时相对于其他材料的优势。
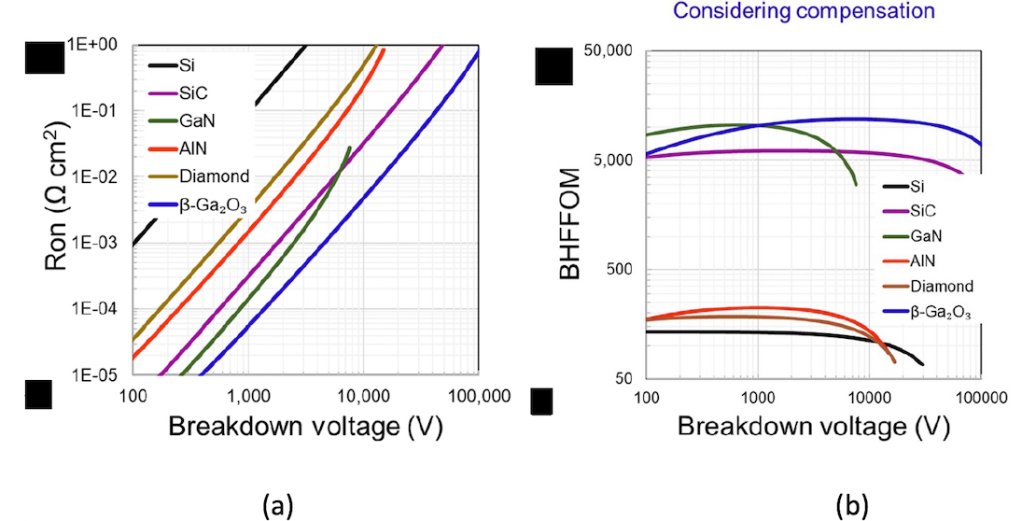 图1
图1
衬底生长
通过熔融生长,可以以相对较低的成本制造高质量的β-Ga2O3衬底,类似于硅。这是与碳化硅等宽带隙材料相比的关键优势,后者需要使用昂贵的升华方法。例如,日本Novel Crystal Technology公司正在生产100 mm的β-Ga2O3衬底。
β-Ga2O3高压器件
现在让我们看看Singisetti团队和其他人在创建β-Ga2O3高压电力器件方面所做的一些工作。已经使用了几种原子层沉积(ALD)电介质作为栅极电介质来创建横向n沟道MOSFET器件。二氧化硅(SiO2)是一个有前途的候选,具有大的导带偏移和室温下的低界面态。
最初创建的MOSFET在沟道区域外显示出击穿。故障分析指向栅极场板(GFP)区域上方的空气中高场。使用复合场板电介质(包括PECVD和ALD SiO2),凹陷的MBE生长沟道和GFP上方的高场强度环氧聚合物(SU-8)钝化膜,导致在横向MOSFET中报告的最高击穿电压(BV)超过8 kV。
这项工作表明,场管理技术至关重要。该器件的横截面示意图和BV曲线如图2所示。
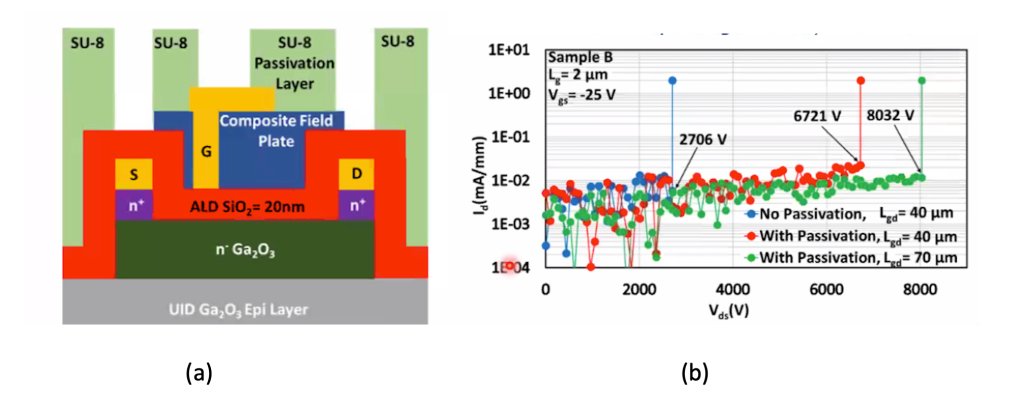 图2
图2
这些器件仍然受到相对较差的RDS(on)的困扰。发现真空退火后RIE蚀刻产生的损伤恢复并改善了RDS(on),而不影响BV。
具有肖特基栅的MESFET器件显示出潜力。使用氮化硅钝化电介质,已经展示了4.4 kV的MOSFET,其功率FOM(PFOM = BV2 ÷ RDS(on))超过100 MV/cm2,特定RDS(on) ≈ 20 Ω-mm2。
虽然这个PFOM远优于理论上可实现的硅数值,但仍远低于β-Ga2O3的理论极限。使用改进的外延生长技术和FINFET MESFET结构已经展示了184 cm2/V-s的电子迁移率。这种4.4 kV的器件,使用25个1.2至1.5 µm的鳍宽,实现了0.95 GW/cm2的记录PFOM。
高温操作
如表1所示,β-Ga2O3的热导率较差。这可能会在高功率应用中对冷却要求造成负担。然而,一些固有优势帮助β-Ga2O3在高温下表现良好。极低的本征载流子密度和其他因素的组合使得能够实现低热退化系数。与氮化镓相比,其RDS(on)在125°C时可能是25°C时的两倍以上,β-Ga2O3的RDS(on)随温度变化,变化不大。
SBD在600 K下运行,并在500 V下从300 K到500 K的反向泄漏电流增加了十倍,相比之下,垂直氮化镓和碳化硅SBD在类似额定值下的增加至少是百倍。MESFET在测量到的500°C下运行。这些例子展示了β-Ga2O3器件在高温高压操作中的潜在用途。
还进行了改进封装以降低热阻的工作。使用双面封装的大面积(4.6 × 4.6 mm)β-Ga2O3垂直SBD器件,额定电流为15 A,在芯片两侧使用银烧结。顶部阳极结至环境的热阻测量为0.5 K/W,低于类似额定值的碳化硅SBD。这项和其他涉及将衬底厚度减至低于100 µm的工作强调,低热导率不一定是高压高功率应用的障碍。
使用异质结/超结创建双极器件
由于缺乏浅受体和强自陷孔,β-Ga2O3的p掺杂困难。使用n掺杂β-Ga2O3与p掺杂镍氧化物的异质结和超结器件已成功展示为二极管和MOSFET。这两种材料之间成功创建了高质量界面,并实现了良好的器件性能,创造了p-n结的优势,包括雪崩和浪涌能力,这在许多电力系统应用中是一个关键的鲁棒性标准。
-
武汉特高压:高压电力测试的领航者2025-02-26 5922
-
直流高压电源技术发展浅析2024-11-28 1187
-
高压电机启动柜和高压配电柜原理2024-06-13 4741
-
高压电阻的特点及选型2023-12-29 2915
-
高压电工和低压电工哪个更实用2023-12-20 5328
-
高压电容怎么测量好坏2023-12-14 6709
-
2021年高压电工考试APP答案和解析2021-09-16 2430
-
2021年高压电工最新解析及高压电工复审考试相关资料分享2021-07-12 1992
-
2021年高压电工考试内容及高压电工考试相关资料分享2021-07-09 1400
-
高压电机启动方式2019-04-26 16182
-
高压氮化镓的未来是怎么样的2018-08-30 2714
-
高压电力系统中的谐振怎么理解2016-01-29 2195
-
高压电源的典型应用2011-03-10 3403
全部0条评论

快来发表一下你的评论吧 !

