

多晶硅栅耗尽效应简述
描述
当栅与衬底之间存在压差时,它们之间存在电场,静电边界条件使多晶硅靠近氧化层界面附近的能带发生弯曲,并且电荷耗尽,从而形成多晶硅栅耗尽区。该耗尽区会在多晶硅栅与栅氧化层之间产生一个额外的串联电容。当栅氧化层厚度减小到 2nm 以下,此电容的影响也会变得越来越严重,已经不再可以忽略。
多晶硅栅耗尽的宽度不像衬底量子效应那么复杂,它只需要采用简单的静电学就可以估算栅耗尽区的宽度。重掺杂的栅的掺杂浓度比轻掺杂的沟道的掺杂浓度要高,在亚阈值区,氧化层界面电位移的连续性意味着栅极的能带弯曲小于衬底的能带弯曲。考虑一个偏置到反型区的NMOS 的n型重掺杂的多晶硅,平带电压(VFB)和衬底电压降(Φs)、栅电压降(Φg)、氧化层电压降(Vox)之和等于栅压(Vg):

利用栅氧化层的边界条件和高斯定理对公式(2-17)进行化简求解,当Vg>Vth时,求得栅耗尽的宽度Xgd的公式如下:

图2~21a所示为栅极耗尽层的宽度Xgd,图2-21b所示为栅耗尽的等效电容、栅氧化层的等效电容和衬底量子效应的等效电容的等效电路图,图2-21c所示为栅耗尽和衬底量子化的示意图。
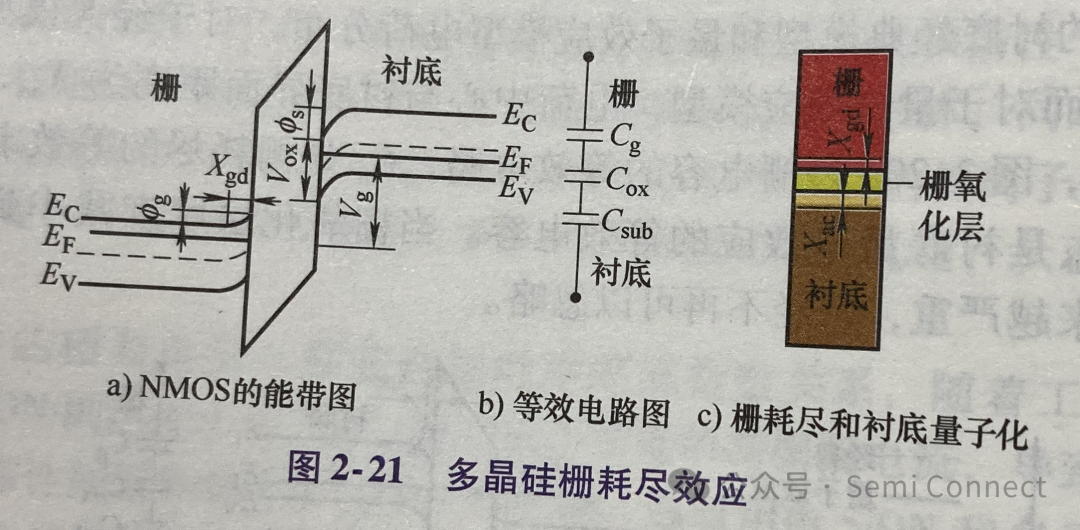
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
为什么采用多晶硅作为栅极材料2025-02-08 1746
-
多晶硅栅工艺的制造流程2024-11-07 3266
-
多晶硅内掺杂物的扩散效应2023-06-11 2776
-
多晶硅栅(Poly-Si Gate)2022-11-17 9540
-
#MOS晶体管 小尺寸效应-多晶硅耗尽电子技术那些事儿 2022-09-30
-
FZ多晶硅24吨2020-01-20 1351
-
低温多晶硅的工作原理是什么?2019-09-18 3271
-
多晶硅生产流程是什么_单晶硅与多晶硅的区别2017-12-18 62950
-
为什么多晶硅栅上还要再摞一层钨?不用不行吗?2012-01-12 5420
-
低温多晶硅,低温多晶硅是什么意思2010-03-27 1142
-
多晶硅光电池2009-10-23 787
-
什么是多晶硅2009-04-08 3039
全部0条评论

快来发表一下你的评论吧 !

