

芯片失效分析中常见的测试设备及其特点
描述
文章来源:半导体工程师
原文作者:芯片失效分析
在芯片失效分析中,常用的测试设备种类繁多,每种设备都有其特定的功能和用途,本文列举了一些常见的测试设备及其特点。
显微镜:显微镜是芯片失效实验室中最基础的仪器,用于观察芯片中微小的结构和缺陷。
体式显微镜: 放大倍率从几倍到150倍,适用于初步的外观检查。
金相显微镜 (如设备型号LV150N):放大倍率从50倍到1000倍,分辨率达到0.2um,适合观察芯片中的微裂纹等结构。
扫描电子显微镜(SEM): 一种非常先进的显微镜,可以在纳米级别下观察芯片结构,直接观察到微观缺陷、线路断裂等。
C-SAM(超声波扫描显微镜): 用于无损检查,能够检测材料内部的晶格结构、杂质颗粒、裂纹、分层缺陷、空洞等。
X-Ray设备: 用于分析半导体BGA、线路板等内部位移,判别空焊、虚焊等BGA焊接缺陷。例如德国Fein微焦点X-ray,标准检测分辨率<500纳米,几何放大倍数达到2000倍,最大放大倍数可达10000倍。
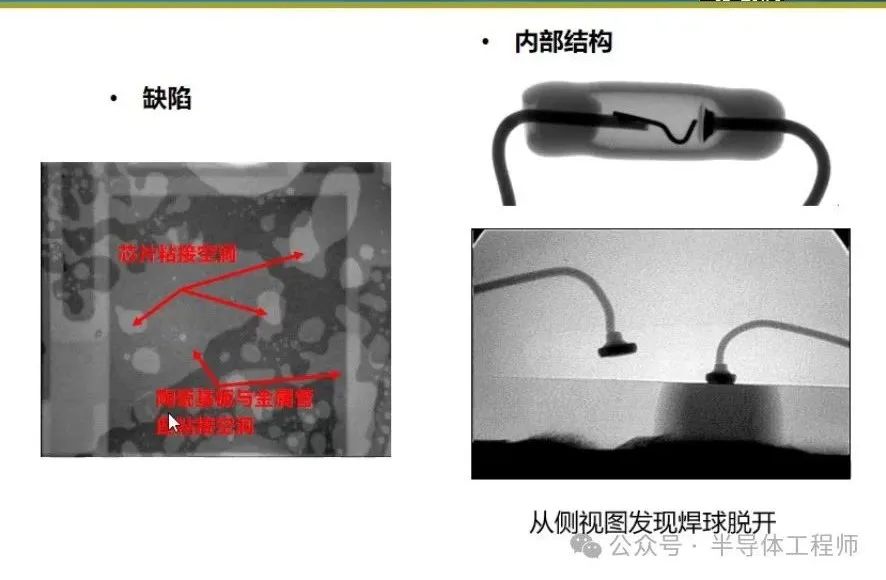
X-ray检测
半导体参数测试仪和探针台: 用于电性能测试,判断失效现象是否与原始资料相符,分析失效现象可能与哪一部分有关。例如IV曲线测量仪(设备型号CT2-512X4S),最大电压10V,最大电流100mA。
示波器: 能够显示电路中随时间变化的电压波形,适用于测试芯片的模拟电路和数字电路。
逻辑分析仪: 一种常用的数字电路测试工具,通过连接到芯片的引脚,捕捉芯片输出的数字信号,并转换成可视化的波形,帮助判断芯片是否工作正常。
红外线相机: 用于检测芯片中的温度变化,帮助测试人员检测芯片是否存在热点问题。
声学显微镜: 将声音转换为光信号,通过观察芯片表面上的光反射来检测芯片中的缺陷。
FIB(聚焦离子束): 用于线路修改、切线连线、切点观测、TEM制样、精密厚度测量等。
这些测试设备在芯片失效分析中各有侧重,可以根据具体需求选择适合的设备进行分析。同时,随着技术的不断发展,新的测试设备和方法也在不断涌现,为芯片失效分析提供了更多的可能性。
-
芯片失效步骤及其失效难题分析!2025-07-11 3326
-
芯片失效分析方法 芯片失效原因分析2023-08-29 6769
-
常用的芯片失效分析方法2022-10-12 6452
-
总结嵌入式系统开发中常见的存储器及其特点2021-12-17 1494
-
LED芯片失效分析2020-10-22 3364
-
芯片失效分析探针台测试2020-10-16 4249
-
失效分析常用的设备及功能2020-08-07 4476
-
芯片IC可靠性测试、静电测试、失效分析2020-04-26 5577
-
芯片失效分析含义,失效分析方法2020-04-07 7341
-
失效分析方法---PCB失效分析2020-03-10 3850
-
芯片失效分析2013-06-24 5799
-
视频监控系统中常见故障及其排除2012-08-20 5983
-
网络设备中常见术语含义及故障分析2011-12-27 15248
-
油系统设备常见故障分析及其消除方法2009-06-12 740
全部0条评论

快来发表一下你的评论吧 !

