

分析芯片内部不同硬件资源对于SEU效应敏感性的问题
FPGA/ASIC技术
描述
摘 要: 目前星载信号处理平台中大量使用商用芯片,但商用芯片抗辐射能力较弱,在空间环境下常出现单粒子翻转(Single Event Upset,SEU),从而造成系统功能紊乱,甚至中断。提出以星载信号处理平台中大量使用的SRAM型FPGA为研究对象,采用故障注入的方式研究FPGA中不同硬件资源对于SEU效应的敏感性问题。根据不同资源对SEU效应表现出不同敏感性的结论,可在SRAM型FPGA的抗SEU防护上进行有针对性的设计。
0 引言
随着星载信号处理平台对于信号处理能力需求的不断提升,宇航级芯片已越来越难以满足需求,而商用芯片相对宇航级芯片拥有更强的处理能力和更多的处理资源。所以基于商用芯片构建星载处理平台的商用现成技术(Commercial Off-The-Shelf,COTS)成为当前卫星通信平台设计领域的研究热点。
由于商用芯片向着高密集度、低操作电压的方向迅速发展,使得它们在空间辐射环境下的可靠性大大降低。其中软故障是主要故障,它是由带电粒子和PN结相互作用引起的一种暂态故障,可造成芯片严重的运行错误[1]。所以如何弥补商用芯片本身抗辐照能力的不足是需要解决的重要问题。
国内外研究机构对于星载信号处理平台抗SEU方法目前主要分为两类:一类是针对SEU的屏蔽,包括各种抗SEU加固结构设计、高性能抗SEU的CMOS(Complementary Metal Oxide Semiconductor)工艺等[2];另一类是针对SEU的修复,如动态可重构技术、编码纠正[3]等方法。另外,由于星载平台中包含大量的诸如FIR(Finite Impulse Response)滤波和FFT(Fast Fourier Transform)的处理过程,故近年来针对各种滤波器和信号处理算法本身抗SEU的方法研究特别广泛,如文献[4]、文献[5]分别实现FIR滤波器和FFT算法的容错技术。
相对于上述研究思路,本文则重点关注芯片内部各种不同硬件资源对于SEU事件的敏感性。以星载平台上应用广泛的SRAM型FPGA为研究对象,通过模拟星载平台和故障注入的实验,根据各种资源在故障源注入后诱发系统出现功能紊乱的概率总结出各种资源对于SEU敏感性高低的结论。
1 SEU敏感性研究模型
为验证SRAM型FPGA不同资源对于SEU存在不同的敏感性,需要模拟星载信号处理平台SRAM型FPGA在外部空间遭遇SEU效应的整个过程。即在地面上模拟采用SRAM型FPGA的星载信号处理平台,模拟FPGA出现的SEU错误,以及将模拟的SEU错误注入到FPGA内部不同资源中。据此提出SEU敏感性研究的模型,如图1所示。
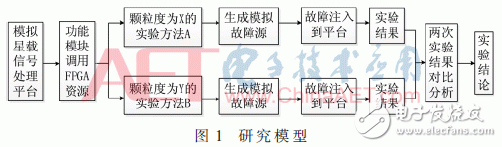
根据研究模型,首先可以采用基于商用芯片的星地联合处理平台来模拟星载平台,其硬件环境如图2所示。其中CPCI(Compact Peripheral Component Interconnect)总线用来模拟星地链路,星载处理板模拟星载信号处理平台,处理板采用了多片SRAM型FPGA芯片作为实验的测试芯片。

为调用FPGA内部资源,采用两种功能相同但实现方式不同的功能模块,因此可以针对两种模块设计颗粒度不同的实验A和实验B来分别进行实验。基于功能模块通过故障注入的方式生成模拟的SEU错误,在系统正常运行的情况下,将错误注入到平台FPGA的功能模块中,观察注入前后的输出状态,对比两次实验结果,得出SEU敏感性研究的结论。
2 SEU敏感性实验设计
2.1 基于IP核的FFT敏感性实验设计
通常星载平台中拥有大量的FFT运算,而这些运算大都通过在FPGA中调用IP核来实现。因此以基于IP核的FFT来进行SEU敏感性实验是合理的。SRAM型FPGA芯片由6个部分组成,其中Slice资源是可编程逻辑单元的基本逻辑单元,RAM资源是FPGA常用的硬核模块,两种资源都是FPGA内部广泛分布且应用较多的资源。所以基于IP核的FFT敏感性实验所针对的资源就是Slice和RAM。
Slice资源内部主要的配置关系是逻辑关系,即“+”、“~”、“*”关系;RAM资源内部主要的配置关系是数值关系,即0、1数值关系。所以针对这两种资源的故障注入将分别围绕这两种配置关系进行修改。利用FPGA_Editor查看网表文件,并对其进行修改,生成差异比特文件,即模拟故障源。在FFT模块正常运行后通过测试电脑经模拟星地链路,反复将故障源注入到FFT模块中,通过chipscope抓取结果,根据结果得出结论。
2.2 基于软件实现的FFT敏感性实验设计
为进一步验证上述结论,在前述实验的基础上,设计了另一种颗粒度更高的实验来加以证明。该实验运用VHDL语言编程实现16点的FFT功能模块,该模块调用更多的FPGA资源,采用相同的星地联合处理平台,同样针对Slice和RAM两种资源进行故障注入实验。
设16点数据为x(0)、x(1)…x(15)的16位的实数数据,按时间抽取的基2 FFT算法原理可得该16点FFT的蝶形交织运算,如图3所示,其结果即是X(0)~X(15)的16点FFT输出。由图可知,该FFT算法原理的核心是每一层的蝶形交织运算,因此整个16点FFT程序设计的关键是四层的蝶形交织运算。

设计程序分成五部分,即顶层的输入输出和4个蝶形交织层。最初输入16点的16位实数数据,然后通过每层的蝶形交织计算得到最终FFT的输出。将结果与MATLAB仿真进行对比,验证该FFT模块是否编写正确。确认模块功能正确后,同样针对Slice和RAM进行修改;然后进行故障注入试验,通过chipscope抓取结果;最后根据结果得出结论。
3 SEU敏感性实验及分析
3.1 基于IP核的FFT敏感性实验及分析
通过FPGA_Editor可得知IP核FFT模块拥有1 227个Slice、17个RAM资源。将1 227个Slice资源中每连续的20个左右分为一组,共分为60组。对每一组资源中的每一个Slice都在数量为10处进行逻辑修改。将17个RAM资源划为17组,对每一个RAM分别进行数量统一为10处的数值修改。最后得到60个Slice和17个RAM的差异比特文件,并对每一个差异比特文件进行100次的反复注入。
3.1.1 实验结果
针对Slice资源的故障注入结果分为四个程度,分别如图4~图7所示。所有60组试验中只有4组结果正确,其余组都出现各种错误。
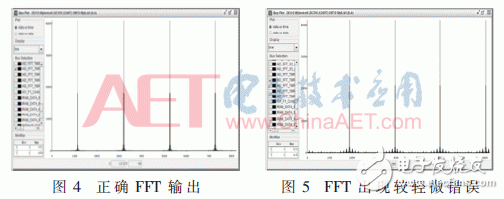

针对RAM资源的故障注入结果分为三个程度,如图4、图8和图9所示。所有试验中只有4组出现错误。
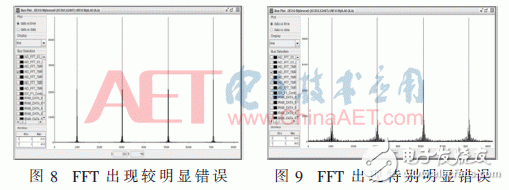
3.1.2 实验结论
(1)在Slice颗粒度约为20个一组、共60组的情况下,根据大量反复注入的试验结果,利用统计数据可得针对Slice资源故障注入后模块的故障率为:θ1=(56/60)×100%=93.3%;针对RAM资源故障注入后的故障率为:θ2=(4/7)×100%=23.5%。故在SEU效应敏感度上,Slice强于RAM。
(2)试验中每组故障注入的数量一致,但注入的位置各不相同。通过每组最后的结果对比可知,不同位置的故障注入将对模块产生不同程度的影响。
(3)在77组故障注入试验中,结果是逻辑修改引起的模块故障率更高。故SEU造成逻辑上的故障对整个模块影响要明显强于数值故障造成的影响。
3.2 基于软件实现的FFT敏感性实验及分析
为了验证该编写的FFT模块功能正确,首先在MATLAB中实现FFT算法,然后将其每层蝶形交织结果与VHDL程序的每一层蝶形交织结果进行对比。对比输出结果如图10所示,左侧为MATLAB仿真结果,右侧为VHDL程序运行结果。

由对比可知,VHDL程序运行结果与MATLAB仿真吻合,证明该程序具备正确的FFT功能,可作为本次实验的模块。通过FPGA_Editor可知,生成的FFT模块拥有2 265个Slice、2个RAM资源。
与前述实验类似,将该FFT中的2 265个Slice资源每连续的10个左右分为一组,共分为240组,对每个Slice进行数量为10处的故障注入;将2个RAM资源划为2组,对每个RAM进行数量10处的数值修改。最后生成240个Slice和2个RAM差异比特文件,并对每个文件进行100次的反复注入。
3.2.1 实验结果
针对Slice资源试验,所有试验中有32组结果正确,其余出现明显错误,如图11所示。针对RAM资源的试验结果2组都正确,如图12所示。

3.2.2 实验结论
(1)本次实验在前述实验的基础上将Slice测试颗粒度提高1倍,试验组数提高4倍。由大量反复注入的试验结果,利用统计数据可得针对Slice注入模块故障率为:θ1=(208/240)×100%=86.7%;针对RAM资源故障注入后的FFT模块故障率为:θ2=(0/2)×100%=0%。所以有θ1>θ2,故在SEU效应敏感度上,Slice强于RAM。
(2)每组故障注入的数量相同,但位置不同。结果发现不同位置的注入对模块产生不同程度的影响。
(3)该次实验依然是针对Slice资源进行逻辑修改,针对RAM资源进行数值修改。从结果来看,依然是逻辑的错误对整个模块的影响强于数值错误。
4 结论
本文重点分析芯片内部不同硬件资源对于SEU效应敏感性的问题。以SRAM型FPGA为研究对象,设计进行了两种颗粒度不同的故障注入实验。结果表明,在FPGA内部资源中,Slice资源对于SEU效应的敏感性很强,RAM相对较弱。SEU效应引起的逻辑错误比数值错误更能诱发系统的功能紊乱。所以,可针对FPGA中占用Slice资源较多的模块进行防护,重点针对逻辑错误进行防护。
-
两种感应电机磁链观测器的参数敏感性研究2025-06-09 322
-
使用Phase Lab2024A计算合金抗裂敏感性2024-12-04 1669
-
温度敏感性药品不同储运容器的温度监测方法2024-07-19 1081
-
EMC 敏感性 NCV7693 LED 控制器的最佳实践2022-11-14 584
-
请问怎样去处理潮湿敏感性元件?2021-04-22 1719
-
元器件湿度敏感性等级2020-10-19 46316
-
什么是湿度敏感性试验(*** Test)?测试流程是什么?2020-05-29 6580
-
pcb板上的潮湿敏感性元件怎样处理2019-09-16 1722
-
潮湿敏感性元件的处理2018-09-11 1666
-
怎样处理潮湿敏感性元件2017-12-04 1218
-
静电放电敏感性测量2017-03-20 1091
-
组合电路功耗敏感性统计分析2011-06-29 1069
-
铍的YAG激光焊接裂纹敏感性研究2010-11-30 696
-
如何处理潮湿敏感性元件2009-11-19 1182
全部0条评论

快来发表一下你的评论吧 !

