

GaN基微波半导体器件分析和比较
RF/无线
描述
宽禁带半导体材料氮化镓(GaN)以其良好的物理化学和电学性能成为继第一代元素半导体硅(Si)和第二代化合物半导体砷化镓(GaAs)、磷化镓(GaP)、磷化铟(InP)等之后迅速发展起来的第三代半导体材料。与目前绝大多数的半导体材料相比,GaN 具有独特的优势:禁带更宽、饱和漂移速度更大、临界击穿电场和热导率更高,使其成为最令人瞩目的新型半导体材料之一。目前,GaN 基发光器件的研究已取得了很大进展[1~ 3] ,在国外工作于绿光到紫光可见光区内的GaN LED 早已实现了商业化[2];国内多家单位成功制作了蓝色发光二极管,并初步实现了产业化[3]。而众多的研究[4~ 14] 表明,GaN 材料在制作耐高温的微波大功率器件方面也极具优势。笔者从材料的角度分析了GaN 适用于微波器件制造的原因,介绍了几种GaN 基微波器件最新研究动态,对GaN 调制掺杂场效应晶体管(MODFETs)的工作原理以及特性进行了具体分析,并同其他微波器件进行了比较,展示了其在微波高功率应用方面的巨大潜力。
1、材料特性
GaN 基微波器件所展现出的良好性能与其基础材料特性是密不可分的。从表1 可看出,与Si、GaAs 和SiC 相比,GaN 的禁带宽度最宽、击穿电场最高、热导性也明显优于Si 和GaAs,充分表明GaN 材料在微波大功率器件制造方面所具有的巨大的优势。
表1、GaN 材料特性参数
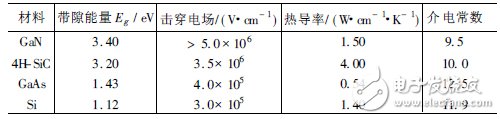
图1是300 K 时GaN、Si、SiC 以及GaAs 的电子漂移速度同电场的关系。从图中可看出GaN 的电子饱和漂移速度明显高于其他材料,表明GaN 非常适于制造高功率、大电流器件[15]。另一方面,GaN 具有较高的电子迁移率(体材料中为1 000 cm/(V·s)),使得在制造GaN 微波器件时会产生低的寄生和通道电阻,从而获得具有良好特性的器件。此外,作为直接带隙半导体材料,GaN 与AlN 可形成带隙从3.4 eV到6.2 eV连续变化的合金,形成可掺杂、可调制的AlGaN/ GaN 异质结结构,利用这种结构形成的量子化二维电子气(2DEG)效应可以获得更高的电子迁移率和饱和电子漂移速度。目前,AlGaN/ GaN 异质结构正逐步被应用于微波器件制造领域。笔者对AlGaN/ GaN 异质结和AlGaAs/ GaAs 异质结的一些重要参数进行了比较,见表2。从表中可看出,AlGaN/GaN 异质结结构比AlGaAs/ GaAs 异质结具有明显的材料优势,更适于微波应用。西安电子科技大学利用MOCVD 分别在蓝宝石和SiC 衬底上生长出优质的AlGaN/ GaN 异质结材料,目前在蓝宝石上得到的该材料室温下2DEG 的迁移率与面电荷密度积已经达到2X1016/(V·s)。
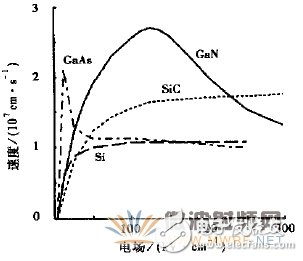
图1、300K 时GaN、Si、SiC 及GaAs电子漂移速度同电场的关系
表2、AlGaN/ GaN 异质结与AlGaAs/ GaAs 异质结关键参数的比较

2、GaN基微波器件
低的热产生率和高的击穿电场已经使GaN 成为研究和制造微波高功率器件的重要半导体材料。目前,随着生长技术的不断发展以及薄膜生长关键技术的突破,多种GaN 异质结构已被成功地生长出来,包括金属半导体场效应晶体管(MESFET)、异质结场效应晶体管(HFET)、调制掺杂场效应晶体管(MODFET)以及金属绝缘场效应晶体管(MISFET)等微波器件。
2.1、MESFETs
采用宽禁带半导体GaN 制作MESFET,具有广阔的微波功率放大的应用前景。人们通常直接利用GaN 具有宽的禁带及简单的制造工艺优势,采用传统的MESFETs 基本理论制造GaN MESFETs。
1993 年,Khan 等人[16] 采用低压MOCVD 方法在蓝宝石衬底上首次制造了GaN MESFET。他们采用薄的AlN 层作为缓冲层以提高GaN 膜的质量,用Ti/ Au 作为源漏欧姆接触,银作为栅肖特基,分别用H+ 离子注入和离子束腐蚀台面,实现器件的隔离。最终获得的器件栅长为1μm,在- 1V栅偏压处的跨导为23mS/ mm。
随后,S.C.Binari 等人[4] 报道了具有较好微波性能的GaN MESFETs。与以往不同之处在于,他们采用有机物金属汽相外延技术在蓝宝石衬底上生长一个无意识掺杂的GaN 外延层,剖面结构如图2 所示。他们首先在衬底温度为450℃时生长40 nm厚的AlN 缓冲层,随后在1050℃的温度下在缓冲层上生长了一个3m厚的无掺杂高电阻GaN 层。图3 是S.C.Binari 等人所制造的0.7μm栅长器件的电流增益|h21| 和单边增益U 随频率的变化曲线。从图中可看出,其截止频率f T 和最大振荡频率f max 为8GHz和17GHz。1997 年,S.C.Binari 等人[5]又研制了新型的GaN MESFETs,其源漏间距为5 μm,栅宽为150μm,栅长为0.7~ 2.0 μm。当栅长为1.5 μm时,MESFET 的最大跨导gm 为20mS/mm,最大漏电流IDSI 为120mA/ mm。当漏电流为1mA/ mm时漏偏压为75V,S.C.Binari 预测其微波输出功率将大于1W/ mm。另外,S.C.Binari 等人还预测随着设计和工艺技术的提高,GaN MESFETs 的f T 将达到20~ 40 GHz。
-
未来5年,GaN功率半导体市场会发生哪些变化?2015-09-15 4125
-
半导体器件热谱分析方法2016-04-18 5201
-
芯言新语 | 从技术成熟度曲线看新型半导体材料2017-02-22 4398
-
第三代半导体材料盛行,GaN与SiC如何撬动新型功率器件2017-06-16 3794
-
报名 | 宽禁带半导体(SiC、GaN)电力电子技术应用交流会2017-07-11 5073
-
MACOM:适用于5G的半导体材料硅基氮化镓(GaN)2017-07-18 3822
-
第三代半导体材料氮化镓/GaN 未来发展及技术应用2019-04-13 5954
-
GaN基微波半导体器件材料的特性2019-06-25 3585
-
适用于5G毫米波频段等应用的新兴SiC基GaN半导体技术2020-12-21 2657
-
《炬丰科技-半导体工艺》GaN 基板的表面处理2021-07-07 2021
-
《炬丰科技-半导体工艺》GaN 半导体材料与器件手册2021-07-08 3045
-
什么是基于SiC和GaN的功率半导体器件?2023-02-21 10289
-
半桥GaN功率半导体应用设计2023-06-21 1798
-
半导体材料:Si、SiC和GaN2020-08-27 14017
-
GaN基蓝光半导体激光器的发展2023-10-31 705
全部0条评论

快来发表一下你的评论吧 !

