

PCB高可靠性化要求与发展——PCB高可靠性的影响因素(上)
电子说
描述
在电子工业的快速发展中,印刷电路板(PCB)的可靠性始终是设计和制造的核心考量。随着集成电路(IC)的集成度不断提升,PCB不仅需要实现更高的组装密度,还要应对高频信号传输的挑战。这些趋势对PCB的可靠性提出了更为严格的要求,特别是在焊接点的结合力、热应力管理以及焊接点数量的增加等方面。本文将探讨影响PCB可靠性的关键因素,并分析当前和未来提高PCB可靠性的制造技术发展趋势。
1 PCB焊接点界面间结合力减小对可靠性的影响
在很大的程度上,PCB的可靠性是由PCB与元器件焊接点界面之间的结合力大小来确定的,而焊接点界面的结合力大小是由焊接点面积与焊接的结合强度之积来表达的。所以,PCB与元器件焊接点的界面结合力必须保证足够大,使其结合力能够抵抗各种产生“拉扯”内应力的“破坏”,才能保证可靠性。
1.1 PCB高密度化带来焊接点面积减小。
PCB和元器件之间焊接点面积是随着PCB高密度化的提高而减小的。大家知道,PCB由插装技术(THT)走向表面安装技术(SMT)、再走向芯片级封装(CSP)的过程中,PCB的高密度化一直在提高着。目前,随着IC集成度提高、组装技术的进步,要求PCB必须高密度化。目前,CSP组装技术已经走向或集中在0.5 mm的节距,其相应的PCB线宽/间隔(L/S)要求为50 μm/50 μm,正在向0.3 mm节距发展,要求PCB线宽/间隔为30 μm/30 μm!安装面积将缩小16倍之多!随着焊接点面积的减少,会增加焊接难度而增加故障数量,从而加大故障率,即使故障率不变,也会增加故障数量,因为焊接点数增加了。PCB焊接点面积缩小的结果见表1所示。
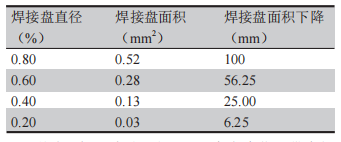
表1 焊接盘直径的减小而带来焊接圆盘面积的下降(以0.80 mm盘径为基准)
从表1中可看到,由于PCB高密度化而带来焊接盘径从0.80 mm减小到0.2 mm时,焊接点的面积便减小到原来的1/16(6.25%)。
1.2 焊接点面积减小带来的焊接结合力的减小。
高密度化的发展与进步,不仅带来线宽/间隔(L/S)、孔径细小化,而且连接盘面积也随着缩小,这意味着元组件与PCB之间的连接的结合力也减少了。因为,元组件与PCB之间焊接点的结合力(F 结合)的大小是由结合强度(f 强度)和连接点面积(S 面积)之积来决定的,一旦焊接材料和方法确定后,结合强度f 强度是不变的,主要是焊接面积来决定着结合力的大小。
F结合= f强度×S面积 ……………… (1)
从公式(1)中可看出:随着PCB高密度化的发展,焊接点面积(S 面积)将减小,必然带来焊接点结合力(F 结合)的减小。以方形焊接面积为例,其边长从0.8 mm减小到0.2 mm时,则焊接面积将从0.64 mm2→0.04 mm2,假设结合强度f强度不变,则焊接点的结合力将下降到原来的6.25%。如表2所示。
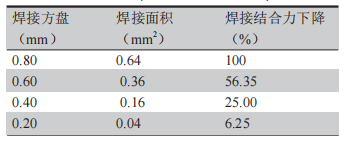
从表2可看出,当焊接 方盘从0.8 mm下降到0.2 mm 时(结合强度保持不变),焊接盘的结合力仅为原来的1/16(6.25%),所以高密度化的发展结果必然带来连接界面的结合力迅速的减少!
1.3 增加焊接点界面结合力的方法。
在PCB的密度不高时,焊接点的形状大都采用圆形的,有利于设计和加工制造。但是,当PCB的密度越来越高时,由于圆形面积最小,焊接点的结合力也最小!为了提高结合力,增加焊接点直径受到导体间隔的限制,当然可以直径为边长的方形或长方形而形成的焊接盘就可以提高焊接面积,从而提高焊接点的结合力,达到提高焊接点的可靠性(表3)。

从表3 中可看到,以圆形直径为边长的方形焊盘的结合力比圆形的结合力将提高26%,而采用长方形(1:2)的焊接盘可以一倍多(152%)地增加焊接点的结合力!这就是为什么在高密度化PCB中的焊接盘大多采用方形焊盘或长方形焊盘的根本原因!
2 PCB焊接点界面间热应力增加对可靠性的影响
2.1 热应力的实质是热膨胀系数差别带来的结果
任何物质都存在着热胀冷缩和“湿胀干缩”的物理现象。“湿胀干缩”的变化是个缓慢的过程,因而引起尺寸变化要慢得多、也小得多!而热(温度)变化是往往是在瞬间(如几秒时间)就发生了尺寸的大变化,所以温度(热)膨胀系数(CTE)才是我们主要关注的课题。元器件和PCB(主要基板)的温度膨胀系数和湿度膨胀系数的数据列于表4中。

从表4中可看到,只有玻璃基板和陶瓷基板的CTE和元器件的CTE最接近,而PCB的CTE要比元器件的CTE要大得多,这就是元器件和PCB在焊接点界面处发生“拉扯”内应力的本质所在!因为PCB在应用过程必然有引起温升,由于PCB和元器件的CTE大小不同,在焊接点处由温升发生尺寸变化也就不一样,即元器件的CTE小、其尺寸伸长小,而PCB的CTE大得多,其尺寸伸长就大得多,因此,在焊接点界面处必然存在着尺寸变化大的“拉扯”着尺寸伸长小的而形成“拉扯”(热)应力!如果温升很高,这种“拉扯”内应力也就很大,一旦这种“拉扯”内应力接近或大于焊接点的结合力时,就会引起焊接点界面发生断裂而失效率!
2.2 热应力的本质是PCB内部温升的结果
PCB和元器件焊接点界面处的热应力产生的实质是由于两者的CTE不同引起尺寸伸长不一样的结果,温升才是形成热应力的必然结果!那么焊接点的温升是怎样发生呢?热的来源主要有三个方面:
(1)PCB高密度化程度;(2)PCB内信号传输高频化程度;(3)PCB上负载(功率)大小(密度)。这三个方面将决定着内部温升的大小。
2.2.1 PCB高密度化引起的温升
PCB高密度化的结果,不仅会带来焊接点结合力的减小,而且PCB内部负载的增加,而这种内部负载增加是指在单位体积内将有更多的“导电”通过(信号传输),这就必然带来更多的导电损耗(αc)和介质损耗(αd).
α=αc +αd …………………………式(2)
这就是PCB在使用过程中内部产生(除了元器件发热和传导热外)热的根本原因,而PCB高密度化就意味着发生的热更多了,也就意味着PCB内部产生的温升更多和加快。
2.2.2 PCB内信号传输高频化引起的温升
PCB内信号传输高频化意味着在单位时间内通过的信号传输次数增加了,在也意味着在单位时间内发生导电损耗(αc)和介质损耗(αd).等次数也增加了,这些导电损耗(αc)和介质损耗(αd).等增加次数都会在PCB内部增加温升的速度和程度!
2.2.3 PCB上负载(功率)增加
PCB上的负载增加是只在PCB安装的大功率元器件而通过的信号所带来的更大的导电损耗(αc)和介质损耗(αd)等,当然会产生更大的温升速度和程度!以上三方面的增加温升速度和程度是组成PCB高温度化的根本原因!由于PCB高温化和PCB与元器件之间的CTE存在着大的差别值,因而它们之间的焊接点界面处会因温、湿度变化而发生“拉扯”内应力。一旦这个“拉扯”内应力≥PCB焊接点之间的结合力,必然会引起焊接点界面处发生断裂问题,这往往是造成焊接点失效而带来故障的可靠性问题。
(未完,接下篇)
审核编辑 黄宇
-
高可靠性PCB的十一大重要特征2023-11-20 1417
-
高频PCB板材:高可靠性、信号传输速度快2023-11-02 2899
-
资料分享 | 评估PCB是否具备高可靠性的四大要点2022-05-09 9744
-
两招教你判断高可靠性PCB2021-09-22 3046
-
如何实现高可靠性电源的半导体解决方案2021-03-18 2300
-
【PCB】为什么华秋要做高可靠性?2020-07-09 11991
-
为什么华秋要做高可靠性?2020-07-08 14218
-
【PCB】什么是高可靠性?2020-07-03 11991
-
高可靠性汽车用PCB如何确保产品满足要求2019-10-15 4536
-
基于集成电路的高可靠性电源设计2019-07-25 2814
-
高可靠性技术概述2016-04-12 875
-
高可靠性PCB的十四大重要特征2016-02-20 6323
-
高可靠性红外热像仪的设计方法2015-12-31 1187
全部0条评论

快来发表一下你的评论吧 !

