

SiO2薄膜的刻蚀机理
描述
本文介绍了SiO2薄膜的刻蚀机理。
干法刻蚀SiO2的化学方程式怎么写?刻蚀的过程是怎么样的?干法刻氧化硅的化学方程式?
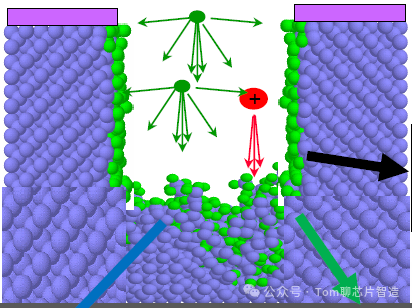
如上图,以F系气体刻蚀为例,反应的方程式为: SiO2(s)+ CxFy +Ar(+)>SiF4 (g)+ CO(g) CxFy是来自刻蚀气体(如CF₄、CHF₃)解离产生的氟自由基,用于氧化硅的化学刻蚀。 Ar(+)是被加速的高能离子,起到物理轰击的作用。 SiF4 :四氟化硅,气相形式的挥发性产物。 CO:一氧化碳,副产物。 红色箭头代表离子轰击,高能离子轰击表面,破坏SiO₂分子的键,为自由基提供更多反应位点,同时起到“方向性”作用,使刻蚀更具各向异性。 绿色箭头代表氟自由基,即CxFy。Ar离子轰击与化学刻蚀的结合,才能显著提高刻蚀速率。单一的物理或化学机制均不足以实现高效刻蚀。 离子与中性粒子比值对反应速率的影响

如上图: 中性粒子(自由基)浓度:Ar(+)浓度:当比值较低时,刻蚀速率主要受自由基的浓度限制。在高比值时,Ar离子轰击成为限制因素,刻蚀速率趋于饱和。
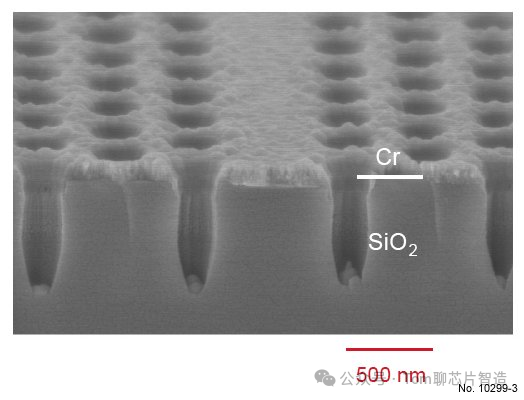
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
[VirtualLab] SiO2膜层的可变角椭圆偏振光谱(VASE)分析2026-04-09 90
-
sio2薄膜的厚度量测原理2024-09-27 1697
-
硅和SiO2的湿化学蚀刻机理2022-07-11 3069
-
芯片表面SiO2薄膜2022-03-29 5878
-
SiO2在氢氟酸中的刻蚀机理2021-12-31 6160
-
二氧化硅薄膜应用领域及特性的详细资料说明2020-03-10 4861
-
PECVD沉积SiO2和SiN对P-GaN有什么影响2018-12-17 2199
-
基于SiO2薄膜的915nm半导体激光器的无杂质空位诱导量子阱混合研究2018-02-10 923
-
sio2_sio2是什么意思2011-12-13 22923
-
丰田通商试销采用SiO2纳米粒子的窗用保温隔热薄膜2011-10-12 1547
-
镀复SiO2膜的电容器介质膜2009-12-08 956
-
ITO玻璃技术之SiO2阻挡膜层规格2008-10-25 2214
全部0条评论

快来发表一下你的评论吧 !

