

背金工艺的工艺流程
描述
本文介绍了背金工艺的工艺流程。
本文将解析一下背金工艺的具体的工艺流程及每步的工艺原理。
背金工艺的工艺流程

如上图,步骤为: tape→grinding →Si etch → Detape → Pre-treatment →back metal 即贴胶纸→减薄→硅刻蚀→撕胶纸→前处理→背面金属化
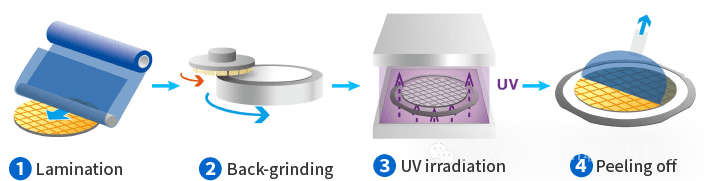
1,tape
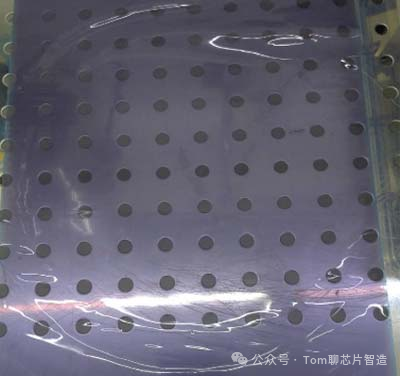
在晶圆正面贴上上图所示的蓝色胶带,保护晶圆正面的图形。 2,grinding :将硅片背面研磨,减薄到适宜厚度,采用机械抛光的方法 3,Si etch:在背面减薄之后,硅片背面会有很多缺陷,并且有硅粉残留。此时wafer内部应力很大,容易碎片,硅腐蚀可以消除其内部应力,并且使其表面粗糙度更大,金属更容易在其上淀积。

常用硝酸和氢氟酸进行刻蚀处理,方程式为: Si+HNO3+6HF=H2SiF6+H2NO2+H2O+H2 4,Pre-treatment:硅片背面的清洁度对种子层金属与Si的结合力影响很大,因此要保证足够的清洁。一般用BOE洗去硅表面的自然氧化层。

5,back metal:用电子束蒸发或磁控溅射的方法,沉积相应的金属层,以Ti/Ni/Au(Ag)为例,我曾见过的对应的金属厚度为:Ti1kÅ,Ni3.5kÅ,Au(Ag)1kÅ(6kÅ),当然厚度可以根据具体的场景而不同。 END 转载内容仅代表作者观点 不代表中国科学院半导体所立场
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
背金工艺之前 ,背面如何处理?2011-01-07 15545
-
PCB工艺流程详解2013-05-22 10213
-
详解PCB线路板多种不同工艺流程2017-06-21 3891
-
多种电路板工艺流程2017-12-19 4840
-
多种不同工艺的PCB流程简介2018-08-29 2265
-
SMT贴装基本工艺流程2018-08-31 3497
-
PCB电路板多种不同工艺流程详细介绍2018-09-17 2735
-
晶体管管芯的工艺流程?2019-05-26 3461
-
关于黑孔化工艺流程和工艺说明,看完你就懂了2021-04-23 3534
-
样板贴片的工艺流程是什么2021-04-26 3482
-
pcb工艺流程2016-02-24 1390
-
pcb化学镍金工艺流程介绍2018-05-03 17364
-
螺母加工工艺流程2023-09-06 4974
-
PCB工艺流程.zip2022-12-30 999
-
背金工艺是什么_背金工艺的作用2025-02-10 3588
全部0条评论

快来发表一下你的评论吧 !

