

纳芯微集成式压差传感器NSPGL1的焊接与组装说明
描述
摘要
在汽车电子系统的开发中,传感器焊接与组装的可靠性直接影响产品性能。NSPGL1是纳芯微的一款汽车级集成式表压传感器,采用汽车级信号调理芯片对贵金属MEMS芯体输出进行校准和补偿,能够将±5kPa~±100kPa的压力信号转换为可自定义输出范围(0~5V)的模拟输出信号。NSPGL1特有的陶瓷基板封装工艺使得其能够耐油气等介质腐蚀。
本篇应用笔记将围绕如下三点对NSPGL1的焊接与组装进行说明。
①通过Pin1标识,正确放置芯片;根据推荐的炉温曲线进行回流焊;
②焊接完成后进行功能测试,然后在芯片周围涂underfill胶,以提高器件结构强度和可靠性;
③组装时需要在陶瓷面进气口处选择合适密封方式如密封垫或密封圈进行密封,以防止漏气。
1焊接说明
1.1.焊接条件推荐

焊接参数
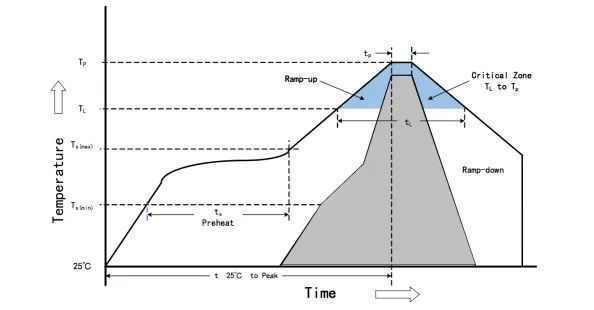
炉温曲线
1.2.Pin 1标识点说明
陶瓷背面塑封盖上有Pin 1圆形标识点,如下图所示。
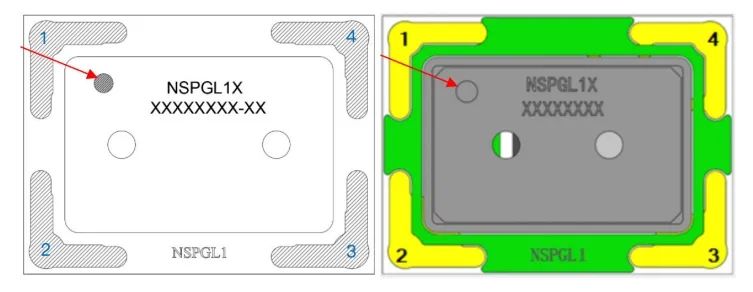
Pin 1标识点

引脚定义
1.3.PCB Layout说明
PCB Layout有以下两种方式:
①NSPGL1焊盘放在PCB顶层,此时焊盘是俯视角度,需要将引脚定义镜像,焊接时芯片需要倒置放入。
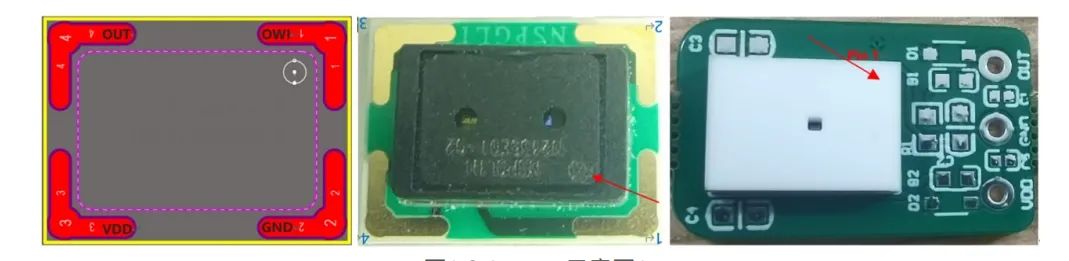
Layout示意图1
②NSPGL1焊盘放在PCB底层,此时焊盘是顶视角度,焊接时芯片底面贴装。

Layout示意图2
2底部填充胶(Underfill)工艺介绍
2.1.Underfill介绍
Underfill工艺是指在集成电路芯片(Die)与芯片封装基板(Substrate)或其它芯片亦或转接板(Interposer)之间填充高分子(树脂)基复合材料进而提高封装稳定性的技术。Underfill材料应用的基本原理是通过其填充在芯片底部并经加热固化后形成牢固的粘接层和填充层,降低芯片与基板之间因热膨胀系数差异所造成的热应力失配,提高器件结构强度和可靠性,增强芯片和基板间的抗跌落性能。
2.2.Underfill流程
Underfill流程如图2.1所示,Underfill通常在电路板组装完成后,且通过电性功能测试以确定电路板功能没有问题后才会执行。Underfill后很难对芯片进行Repair或Rework。

Underfill流程
Underfill点胶后需要静置一段时间(通常为2h),以保证胶水与基材充分浸润。接着需要经过高温烘烤加速胶水固化,烘烤时间需要根据所选胶水推荐的时间来确定,最后还需要对传感器的功能进行测试。
2.3.点胶机与胶水推荐
点胶机:铭赛、诺信、武藏等
胶水型号:NEU218-3(或其他underfill胶)
烘烤温度:建议不高于130℃。
纳芯微电子(简称纳芯微,科创板股票代码688052)是高性能高可靠性模拟及混合信号芯片公司。自2013年成立以来,公司聚焦传感器、信号链、电源管理三大方向,为汽车、工业、信息通讯及消费电子等领域提供丰富的半导体产品及解决方案。
纳芯微以『“感知”“驱动”未来,共建绿色、智能、互联互通的“芯”世界』为使命,致力于为数字世界和现实世界的连接提供芯片级解决方案。
-
助力汽车燃油与尾气系统满足国六标准,纳芯微推出全新压力传感器2025-01-24 3323
-
纳芯微发布两款车规级压力传感器新品2024-10-30 1796
-
纳芯微发布全新NSM2311集成式电流传感器芯片2024-05-24 2165
-
纳芯微推出车规级CMOS集成式温度传感器2024-05-17 2172
-
纳芯微推出车规级、小阻抗、高隔离、集成式电流传感器NSM20192023-06-20 1580
-
纳芯微推出采用MEMS工艺的汽车级压差传感器NSPGM2系列2023-05-30 1613
-
跃芯微AMP83系列表压类压力传感器介绍2023-05-16 1054
-
纳芯微全新差压压力传感器NSPDSx系列,可应用于新风系统和消防余压监测2022-12-14 1824
-
纳芯微推出全新集成电流路径霍尔传感器:NSM201X系列2022-10-27 3774
-
差压传感器的作用是什么,差压传感器的特点是什么2021-01-20 17865
-
压阻式差压传感器的特殊性能和实用优势2020-07-07 2040
-
微压差传感器工作原理_微压差传感器安装2020-01-08 8382
-
差压传感器的工作原理_静压传感器与压差传感器有什么区别2018-02-28 16253
-
MDM390型压阻式差压传感器2011-01-01 989
全部0条评论

快来发表一下你的评论吧 !

