

芯片制造中的浅沟道隔离工艺技术
描述
文章来源:半导体与物理
原文作者:jjfly686
浅沟道隔离(STI)是芯片制造中的关键工艺技术,用于在半导体器件中形成电学隔离区域,防止相邻晶体管之间的电流干扰。本文简单介绍浅沟道隔离技术的作用、材料和步骤。
浅沟道隔离(STI)是芯片制造中的关键工艺技术,用于在半导体器件中形成电学隔离区域,防止相邻晶体管之间的电流干扰。其核心是在硅衬底上刻蚀出浅层沟槽,并填充绝缘材料(如二氧化硅),从而将不同晶体管或电路模块分隔开。例如,PMOS和NMOS晶体管通过STI结构实现物理隔离,避免因载流子聚集导致的漏电问题。
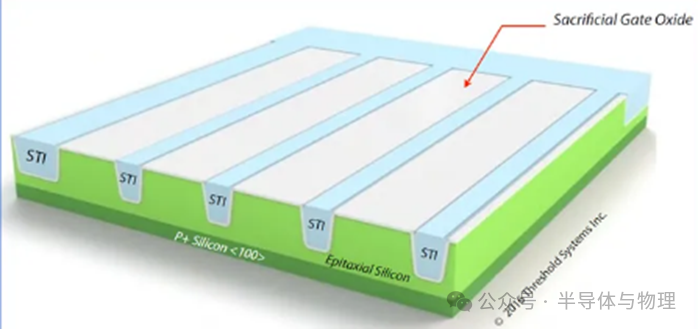
浅沟道隔离的作用
电气隔离 :防止相邻器件间的电流串扰,提升芯片稳定性。
降低漏电 :通过优化沟槽底部的内衬层结构,减少载流子聚集,避免漏电。
提升性能 :采用多级沟槽设计(如宽度逐级递减)可增加栅极沟道宽度,降低电阻,增强电流驱动能力。
工艺兼容性 :与CMOS工艺高度兼容,适用于高密度集成电路制造。
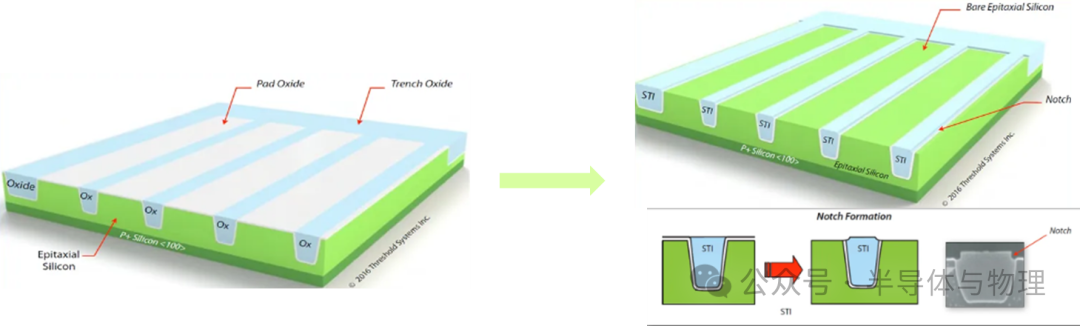
浅沟道隔离的材料
STI结构的材料分为多个功能层:
| 层次 | 材料 | 功能描述 |
|---|---|---|
| 衬底材料 | 单晶硅片 Si | 提供基础支撑 |
| 热氧化层 | 二氧化硅SiO₂ | 在沟槽侧壁和底部生长,钝化表面缺陷 |
| 内衬层 | 氮化硅 SiN | 增强隔离效果,底部去除以防止载流子聚集 |
| 填充材料 | 氧化硅 SiO₂ | 使用SOD旋涂工艺填充沟槽,确保无空隙 |
浅沟道隔离的制程工艺
STI工艺主要包含以下核心步骤(图2a-2d):
1. 沟槽刻蚀
在硅衬底上通过光刻和干法刻蚀形成浅沟槽(深度通常为0.2-0.5μm)。
2. 热氧化层生长
在沟槽内壁生长一层SiO₂(约10-20nm),修复刻蚀损伤并降低界面态密度。
3. 内衬层沉积与处理
沉积氮化硅等材料作为内衬,随后选择性去除沟槽底部的内衬层,避免漏电。
4. 高密度等离子体氧化物填充
使用SOD旋涂填充SiO₂,之后进行回火工艺固化SiO₂。
5. 化学机械抛光(CMP)
去除表面多余的氧化物,使硅片表面平坦化,为后续工艺(如栅极制作)做准备。
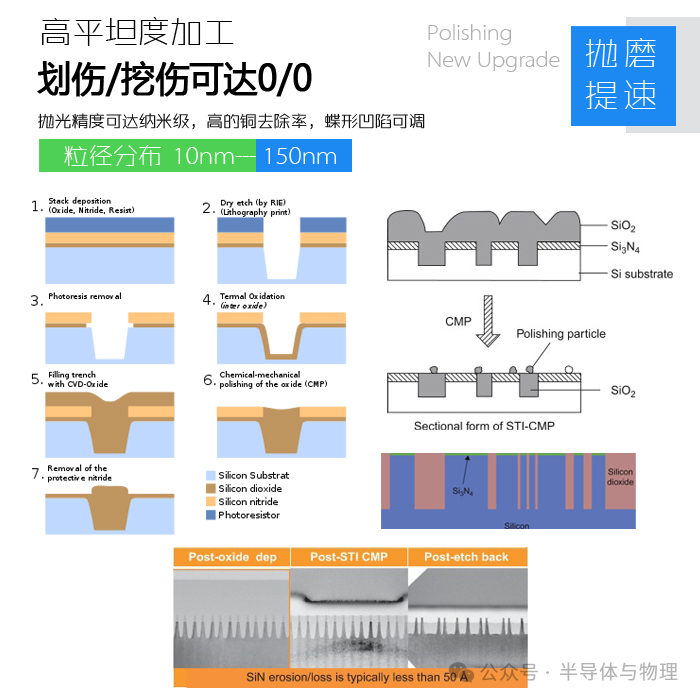
-
集成电路芯片制造工艺技术演变2026-05-07 223
-
STI隔离工艺的制造过程2024-11-01 4141
-
3B39:隔离工艺电流输出数据表2021-05-25 685
-
7B39:隔离工艺电流输出数据表2021-04-25 744
-
7B32:隔离工艺电流输入数据表2021-04-20 709
-
IBM推出一项微芯片工艺技术中的新改进2021-03-26 2100
-
SONNET中的工艺技术层介绍2019-10-08 2906
-
半导体工艺技术的发展趋势是什么?2019-08-20 4612
-
半导体工艺技术的发展趋势2019-07-05 4661
-
半导体工艺技术2016-05-26 1291
-
EMC设计、工艺技术基本要点和问题处理流程2015-08-25 5133
-
ADI完成制造工艺技术的升级,有效提高晶圆制造效率2009-12-24 1012
-
Sic mesfet工艺技术研究与器件研究2009-10-06 6808
全部0条评论

快来发表一下你的评论吧 !

