

DSA技术:突破EUV光刻瓶颈的革命性解决方案
描述
为了补偿光子不足,制造商可能会增加曝光剂量,这又会延长光刻过程中停留的时间。然而,这种做法直接影响了生产效率,使得整个过程变得更慢,经济性降低。此外,随着几何尺寸的缩小以适应更小的技术节点,对更高剂量的需求也加剧,从而造成了生产力的瓶颈。
DSA技术:一种革命性的方法
DSA技术通过利用嵌段共聚物的分子行为来解决EUV光刻面临的挑战。嵌段共聚物由两个或多个化学性质不同的聚合物链共价结合而成。当在特定条件下(如热退火)处理时,这些聚合物会自发相分离成在基材上具有良好定义的纳米结构,如线条或圆柱体。这种自组装过程能够创建具有最小线宽波动(LWR)和高度均匀特征尺寸的图案,独立于光刻工具分辨率的限制。
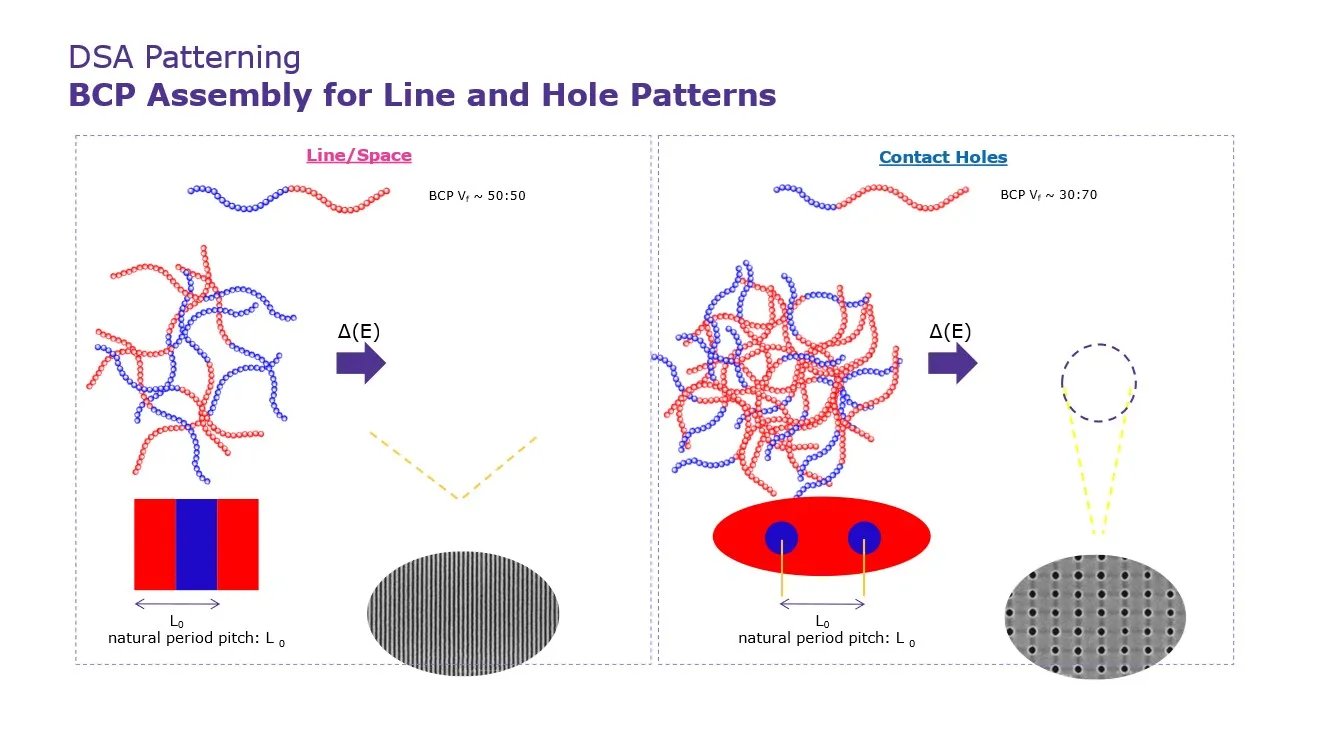
DSA技术的关键优势在于它能够修正因EUV过程而产生的LWR和其他图案缺陷。通过将DSA与EUV光刻相结合,制造商可以先使用传统的EUV过程创建引导图案,然后在图案上涂覆嵌段共聚物。嵌段共聚物的自组装能够细化粗糙的图案,生成高度均匀且变异性低的图案,这些图案可以转移到硅片上。
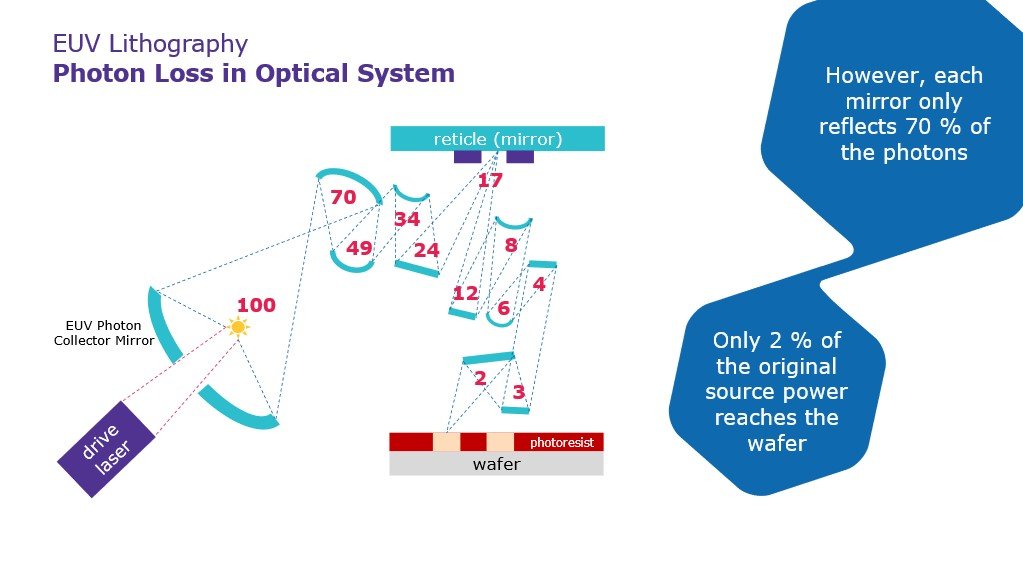
集成与工艺流程
将DSA集成到半导体制造过程中涉及几个关键步骤:
硬掩模形成:该过程从沉积硬掩模层开始,通常采用氮化硅或氧化硅等材料制成。这个硬掩模为后续的图案化步骤提供基础。
使用EUV光刻进行引导图案化:在硬掩模上使用EUV光刻创建引导图案。尽管该图案粗糙且存在LWR,但它作为DSA过程的模板。
嵌段共聚物涂覆和退火:然后,将嵌段共聚物涂覆到基材上。聚合物的选择及其成分至关重要,因为它们决定了图案的最终间距和特征尺寸。接着,基材经过热退火处理,促使嵌段共聚物自组装成高度有序的结构。
图案修正:通过嵌段共聚物自组装产生的图案有效地“修正”了粗糙的EUV图案,平滑LWR并产生最小缺陷的均匀图案。
刻蚀和最终图案转移:经过精细化的图案通过一系列刻蚀步骤转移到底下的硬掩模上,最终转移到硅片中。硬掩模作为记忆层,允许在需要时进行进一步的图案化步骤。
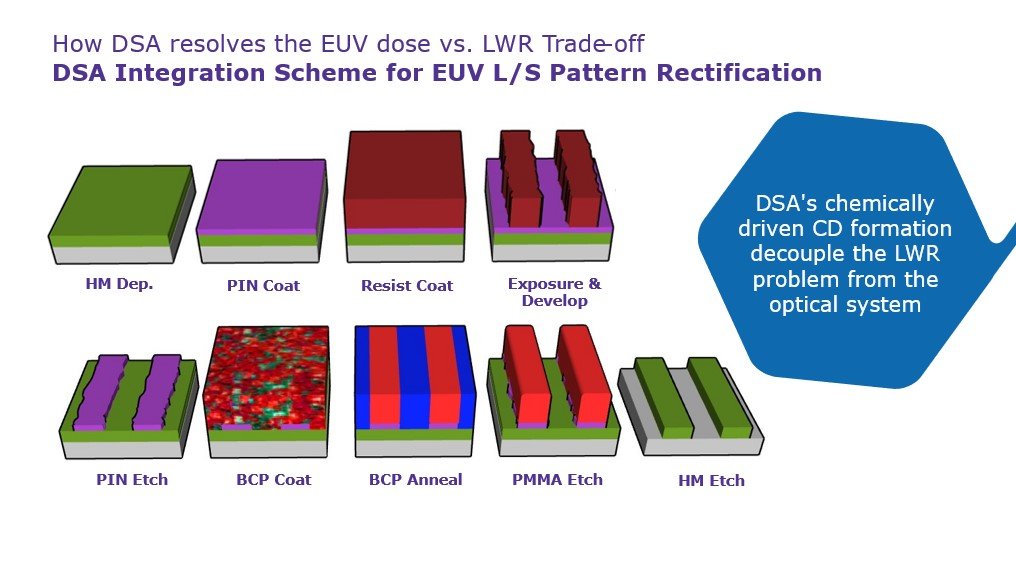
利益与前景
将DSA与EUV光刻结合应用带来了几个显著的好处:
改善图案质量:DSA显著减少了LWR,从而产生更高质量的图案,这对先进半导体器件的性能至关重要。
提高生产力:通过解决LWR和光子效率问题,而不需要增加曝光剂量,DSA提高了产出率,减少了生产时间,使得过程更具成本效益。
可扩展性:DSA无缝延续了摩尔定律,促进了更小特征尺寸的创建,而无需全新光刻工具。
互补技术:DSA并非旨在取代EUV光刻,而是作为补充,提供解决当前限制的方法,扩展其在未来技术节点的适用性。
DSA代表了克服EUV光刻所面临障碍的关键进展。随着半导体制造不断推动微型化的边界,将DSA与EUV光刻进行集成对于保持生产力、减少缺陷,以及推动下一代电子设备的发展至关重要。DSA技术的持续演进和完善有望进一步增强其能力,确保其作为先进半导体制造的基石的地位。
-
革命性LED驱动方案2013-07-19 3334
-
无线AP该如何突破瓶颈?2016-08-18 3800
-
恩智浦发布革命性简单易用的LPC800.pdf2016-09-19 1468
-
革命性的笔HeatVanish,写出来的字加热就会消失2016-12-17 3193
-
EUV热潮不断 中国如何推进半导体设备产业发展?2017-11-14 6867
-
SDR应用的革命性解决方案AD9361是如何诞生的?2018-08-23 3382
-
Eduscope显示屏革命性产品2018-11-22 2579
-
什么是革命性MU-MIMO算法?2019-08-15 3140
-
光刻机工艺的原理及设备2020-07-07 17564
-
华为p10上市时间:革命性的突破!这项技术黑科技国际第一?2017-02-01 2530
-
助力高级光刻技术:存储和运输EUV掩模面临的挑战2019-07-03 2843
-
EUV光刻技术相关的材料2022-07-22 4222
-
微纳制造技术:定向自组装(DSA)终于找到了立足点2023-08-22 7368
-
日本大学研发出新极紫外(EUV)光刻技术2024-08-03 2773
-
EUV光刻技术面临新挑战者2025-02-18 3303
全部0条评论

快来发表一下你的评论吧 !

