

HMC-MDB277 DBL-BAL混频器芯片技术手册
描述
概述
HMC-MDB277是一款无源双平衡MMIC混频器,采用GaAs异质结双极性晶体管(HBT)肖特基二极管技术,可用作上变频器或下变频器。 所有焊盘和芯片背面都经过Ti/Au金属化,Shottky器件已完全钝化以实现可靠操作。
HMC-MDB277双平衡混频器可兼容常规的芯片贴装方法,以及热压缩和热超声线焊,非常适合MCM和混合微电路应用。 这款紧凑型MMIC可以取代混合型双平衡式混频器,而且体积要小得多,性能更加稳定。 此处显示的所有数据均是芯片在50 Ohm环境下使用RF探头接触测得。
数据表:*附件:HMC-MDB277 DBL-BAL混频器芯片技术手册.pdf
应用
- 短程/高容量无线电
- FCC E波段通信系统
- 汽车雷达
- 传感器
- 测试和测量设备
特性 - 宽IF带宽: DC - 18 GHz
- 无源双平衡拓扑结构
- LO输入功率: +14 dBm
- 裸片尺寸: 1.55 x 1.4 x 0.1 mm
框图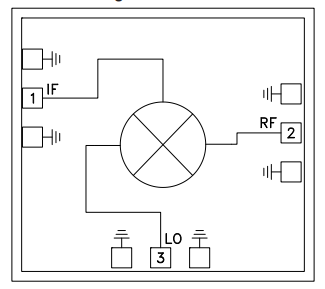
外形图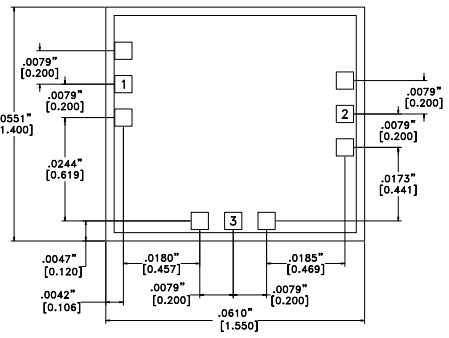
焊盘描述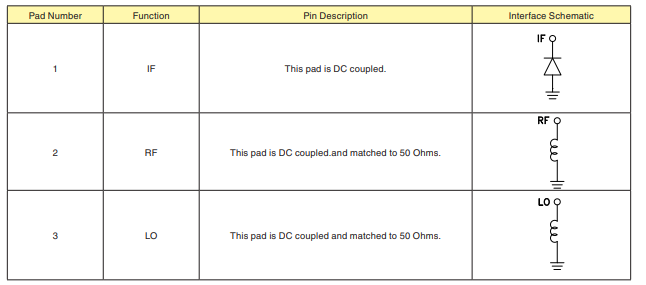
毫米波砷化镓单片微波集成电路(GaAs MMIC)的安装与键合技术
芯片应通过共晶方式或使用导电环氧直接附着到接地层(详见HMC通用操作、安装、键合说明 )。建议使用0.127毫米(5密耳)厚的氧化铝薄膜衬底制作50欧姆微带传输线,用于芯片的射频信号输入输出(图1)。若使用0.254毫米(10密耳)厚的氧化铝薄膜衬底,则芯片需凸起0.150毫米(6密耳),使芯片表面与衬底表面齐平。一种实现方法是先附着0.102毫米(4密耳)厚的芯片,再加上0.150毫米(6密耳)厚的钼散热片(钼片),然后将其连接到接地层(图2)。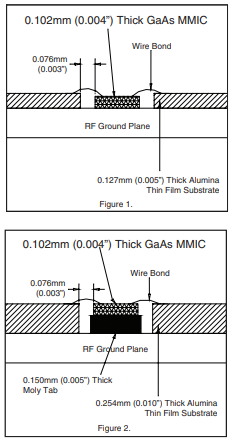
为缩短键合线长度,微带衬底应尽量靠近芯片放置。芯片与衬底的典型间距为0.076 - 0.152毫米(3 - 6密耳)。
操作注意事项
遵循以下预防措施,避免造成永久性损坏:
- 存储 :所有裸芯片应置于基于醚华夫格或凝胶的静电防护容器中,然后密封在静电防护袋中运输。静电防护袋一旦打开,芯片应存放在干燥的氮气环境中。
- 清洁度 :在清洁环境中操作芯片,请勿使用液体清洁系统清洁芯片。
- 静电敏感度 :遵循静电防护措施,防止静电冲击。
- 瞬态 :施加偏置时,抑制仪器和偏置电源的瞬态。使用屏蔽信号线和偏置电缆,减少电感拾取。
- 一般操作 :使用真空吸笔或锋利的弯头镊子沿芯片边缘操作。芯片表面有脆弱的空气桥,请勿用真空吸笔、镊子或手指触碰。
安装
芯片背面已金属化,可使用金锡共晶预制件或导电环氧进行芯片贴装。贴装表面应清洁平整。
- 共晶芯片贴装 :推荐使用80/20的金锡预制件,工作表面温度255°C,工具温度265°C。使用90/10的氮氢混合气体时,工具尖端温度应为290°C。芯片温度不得超过320°C,持续时间不超20秒,贴装过程中擦拭时间不超3秒。
- 环氧贴装 :在贴装表面涂抹少量环氧,芯片就位后其周边应形成一圈薄环氧边。按制造商固化时间表固化环氧。
引线键合
- 射频键合 :推荐使用0.003英寸×0.0005英寸的带状键合线,热压键合,压力40 - 60克。直流键合推荐使用直径0.001英寸(0.025毫米)的键合线,热压键合。
- 球键合 :推荐使用直径0.0015英寸(0.038毫米)的键合线进行球键合,压力18 - 22克,键合阶段温度150°C。施加最小限度的超声波能量以实现可靠键合,键合长度尽量短,小于12密耳(0.31毫米)。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
HMC-C014 DBL-BAL混频器模块,16-32GHz技术手册2025-04-03 1055
-
HMC-MDB169 DBL-BAL混频器芯片技术手册2025-04-01 1244
-
HMC351:高IP3 DBL-BAL搅拌机SMT,0.7-1.2 GHz过时数据Sheet2021-05-18 715
-
HMC316:高IP3 DBL-BAL搅拌机SMT,1.5-3.5 GHz过时数据Sheet2021-04-28 687
-
HMC423:DBL-BAL搅拌机w/LO Amplifer SMT,0.6-1.3 GHz过时的数据Sheet2021-04-24 757
-
HMC168:DBL-BAL搅拌机SMT,4.5-8.0 GHz过时的数据Sheet2021-04-14 723
-
HMC-MDB277 DBL-BAL混频器芯片,70 - 90 GHz2019-02-22 728
全部0条评论

快来发表一下你的评论吧 !

