

如何计算晶圆中芯片数量
描述
来源:版图设计LayoutArt,作者:JK_LayoutArt
在之前文章如何计算芯片(Die)尺寸?中,讨论了Die尺寸的计算方法,在本文中,将讨论如何预估一个晶圆中有多少Die,也就是DPW(Die per Wafer)。
在具体讨论如何预估一个晶圆中有多少Die之前,需要问一个问题:为什么要预估一个晶圆中有多少Die?
这又是一个关于成本考虑的问题。一般来说,在一个项目立项时,除了评估这个芯片需要具备哪些功能,需要达到什么性能,还需要评估做这个项目的收益如何。根据估算的DPW,晶圆价格,类似功能芯片等信息,去评估这个项目值不值得做。
需要注意的是,这里计算DPW用的是预估,因为除了我们画好的版图尺寸是确定的,决定DPW的还有其他很多参数,比如工艺监测结构PCM大小,放Wafer信息的面积,圈边的尺寸等等。
在不同的Fab厂商,即使是相同规格的晶圆,版图尺寸一样的(比如相同工艺节点,不同工艺厂家的工艺Porting),DPW也会不一样。
用一个简单的公式,看一下决定DPW大致有哪些参数;

d:晶圆的直径
WEdge :晶圆边缘去除的宽度
W:Die的长度
H:Die的宽度。
有些计算DPW的网站,是基于以下公式计算:

从上面公式中,可以很直观的看到,决定一个晶圆上有多少Die,与晶圆的直径,芯片的面积,晶圆边缘去除的尺寸有关。
晶圆面积
晶圆面积和晶圆的规格有关,比如常用的晶圆尺寸200mm,300mm的,也就是我们常说的8英寸、12英寸晶圆。根据该尺寸,可以得到晶圆的面积。
芯片面积
芯片面积,和我们设计的芯片大小有关。这里面需要注意划片槽的尺寸(即切割道宽度),在如何计算芯片(Die)尺寸?中提到,根据划片能力,以及Fab厂的要求来看,这是个可变的参数。此处的芯片面积不需要去除之前文章中提到的切割损耗的尺寸。
边缘损失
在晶圆生产中,晶圆边缘的厚度不均,机械应力等,导致边缘区域有缺陷,一般会去除3mm到5mm,。比如200mm晶圆(8寸),去除5mm,晶圆的有效直径就只有190mm,损失大概9.75%;300mm晶圆(12寸),去除5mm,晶圆的有效直径就只有290mm,损失大概6.56%的面积;从上面两个规格晶圆,去除相同尺寸的边缘后,300mm比200mm的晶圆损失的少,可利用率更高。
DPW计算器
大部分情况,我们只需知道大概怎么计算就可以。在工作中,通常可以找DPW计算器计算。比如以下几个计算DPW的网址:
1. https://www.innotronix.com.cn/?page_id=1766
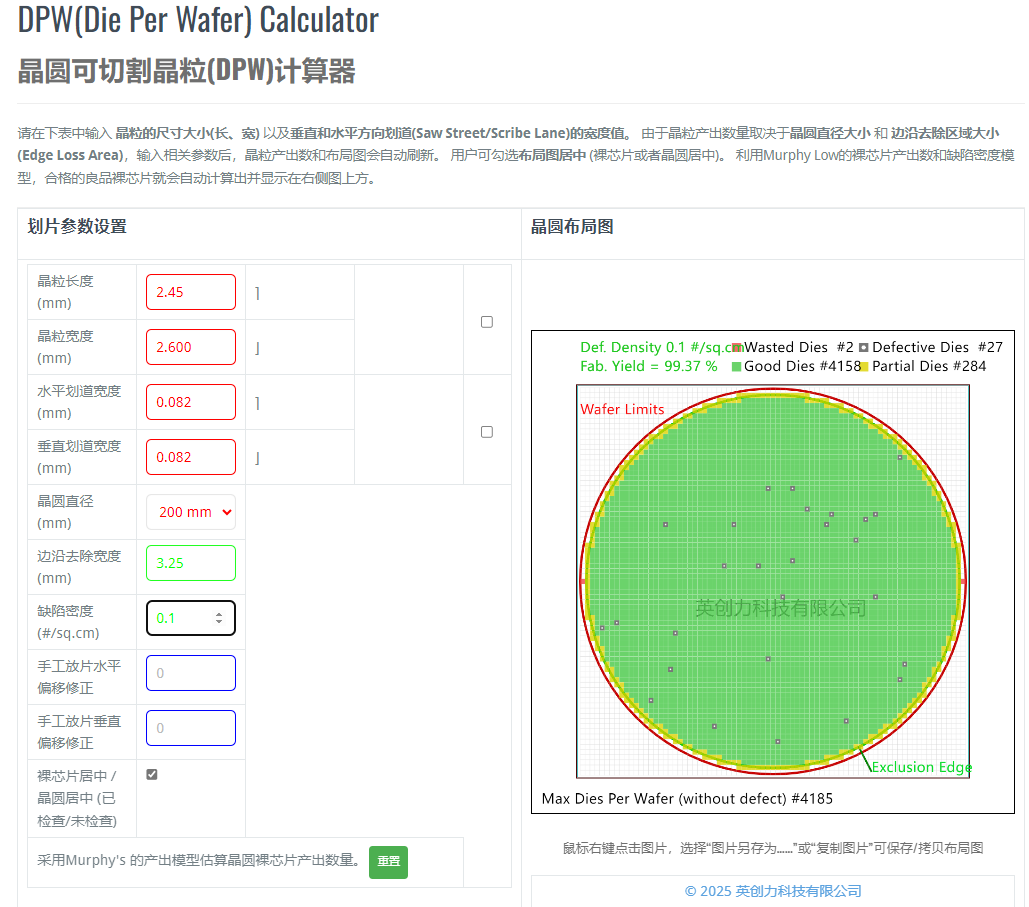
2. http://silicon-edge.co.uk/j/index.php/resources/die-per-wafer

3. https://anysilicon.com/die-per-wafer-formula-free-calculators/

4. Fab厂提供的DPW计算器。
大家也可以在网上找其他的DPW计算器,然后和Fab厂反馈回来的Wafer信息比对,挑选一个计算比较接近的计算器。
-
晶圆级芯片封装有什么优点?2019-09-18 5717
-
再生晶圆数量创新高 再生晶圆的市场需求持续增长2019-08-07 6914
-
晶圆和芯片的关系,晶圆能做多少个芯片2022-01-29 62841
-
带您探秘芯片与晶圆测试世界中的神器2023-05-10 2096
-
晶圆制造与芯片制造的区别2023-06-03 21307
-
为什么芯片是方的,晶圆是圆的?2022-12-19 4478
全部0条评论

快来发表一下你的评论吧 !

