

PCBA代工代料加工中,透锡不良的“元凶”是谁?5大核心因素解析
电子说
描述
在PCBA(Printed Circuit Board Assembly)代工代料加工中,透锡质量是焊接可靠性的核心指标之一。透锡不足会导致焊点虚焊、冷焊,直接影响产品性能和寿命;透锡过度则可能引发桥连、短路等风险。那么,究竟哪些因素在加工过程中“操控”着透锡效果?本文将深度解析影响PCBA透锡的五大关键因素,助您精准避坑。
一、焊膏选择:透锡的“原材料密码”
焊膏是透锡效果的第一道门槛,其成分、颗粒度及活性直接决定焊接质量:
合金成分:Sn63/Pb37(熔点183℃)与无铅焊膏(如SAC305,熔点217℃)的流动性差异显著,需根据工艺温度匹配。
颗粒度:Type 3(25-45μm)焊膏适合精细间距元件,但流动性较弱;Type 4(20-38μm)更易填充但需控制飞溅。
助焊剂活性:高活性助焊剂可增强润湿性,但残留可能腐蚀焊点,需平衡清洁工艺。
优化建议:针对产品特性选择匹配的焊膏,并通过SPI(焊膏检测仪)实时监控印刷厚度与均匀性。
二、钢网设计:透锡的“流量控制器”
钢网是焊膏转移的“模具”,其开孔尺寸、厚度及孔壁处理直接影响透锡量:
开孔比例:通常建议焊盘面积与钢网开孔面积比为1:1~1:1.2,大焊盘需增加开孔分块设计。
钢网厚度:0.1-0.15mm适合常规元件,0.08mm以下用于01005等微型元件,但需避免透锡不足。
孔壁工艺:激光切割+电抛光可减少孔壁毛刺,提升焊膏释放率10%-15%。
案例实测:某电源板QFN芯片透锡不良,将钢网开孔由1:1改为1:1.1并增加外延0.2mm后,透锡率从60%提升至95%。
三、回流焊温度曲线:热力学的“精准艺术”
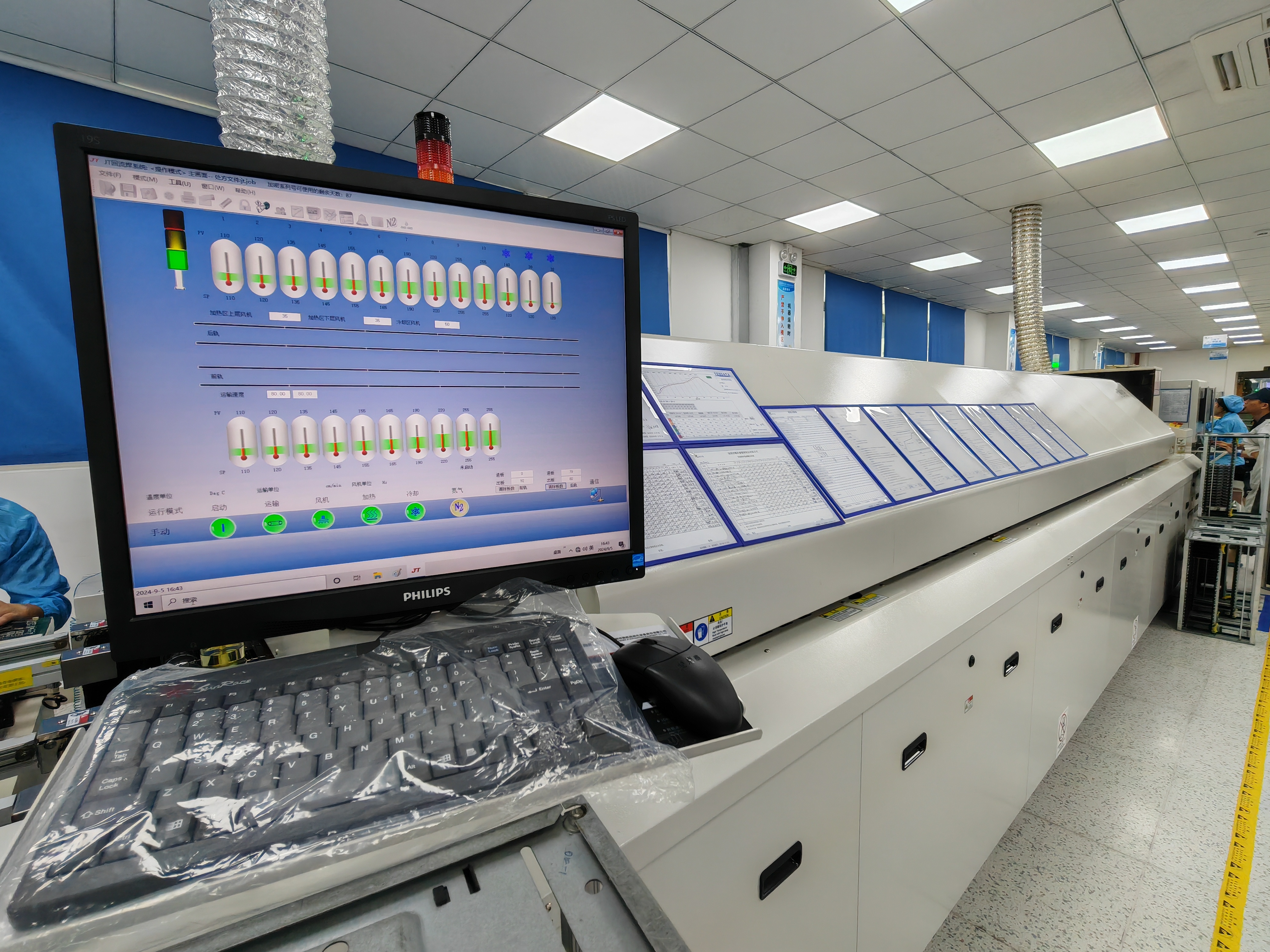
回流焊的温度曲线是透锡的“指挥棒”,需精确控制四个阶段:
预热区(升温速率1-3℃/s):过快会导致助焊剂挥发不充分,形成气孔。
活性区(150-180℃,60-90秒):助焊剂充分活化,去除氧化层。
回流区(峰值温度较焊膏熔点高20-40℃):SAC305需达240-250℃并保持40-60秒。
冷却区(斜率≤4℃/s):快速冷却可细化晶粒,但需避免热应力裂纹。
关键数据:实测显示,峰值温度偏差±5℃会导致透锡高度波动15%-20%。
四、元器件与PCB的“润湿博弈”
焊点界面润湿性是透锡的微观战场:
元器件引脚材质:铜引脚润湿性优于铁合金,镀层氧化(如镀锡发黄)会导致拒焊。
PCB焊盘处理:HASL(喷锡)成本低但平整度差;ENIG(化学沉金)润湿性好,适合高密度板。
存储环境:湿度>60%或存放超6个月,PCB焊盘氧化风险剧增,需氮气柜存储。
应急方案:对轻微氧化的PCB,可增加助焊剂喷涂量或采用氮气回流焊。
五、工艺控制:细节中的“魔鬼”
贴片压力:压力过大导致焊膏被挤压外溢,透锡量不足。
车间环境:温度25±3℃、湿度40%-60%为佳,湿度超标会引发焊膏吸潮。
设备维护:回流焊炉膛积灰会导致热风不均匀,建议每月清洁发热丝与风机。
结语:透锡是系统工程,需全链路协同
透锡质量绝非单一环节所能决定,从物料选型、工艺设计到过程管控,每个细节都需科学验证。建议企业建立DOE(实验设计)机制,针对关键参数(如钢网开孔、峰值温度)进行多因子优化,并结合X-Ray检测、切片分析等工具持续改进。唯有全链路精准把控,才能铸就“零缺陷”焊点。
小贴士:关注我们,下期将揭秘《如何通过X-Ray图像快速诊断透锡不良》!
审核编辑 黄宇
-
汽车电子PCBA加工中影响焊点透锡率的因素2026-01-26 607
-
从设计到生产:影响PCBA代工代料价格的隐形关卡2025-07-07 867
-
PCBA代工必看!X-Ray图像5步快速锁定透锡不良,告别隐性缺陷2025-04-11 2993
-
PCBA加工中波峰焊出现透锡不良怎么解决2024-04-02 3283
-
PCBA加工中波峰焊透锡不良如何应对?2023-10-26 3860
-
影响PCBA代工代料透锡的因素2021-08-06 1265
-
PCBA代工代料是什么,该如何选择PCBA代工代料2021-06-24 4985
-
浅谈影响PCBA透锡的因素2021-05-12 1939
-
PCBA代工代料的优点都有哪些2021-04-30 2442
-
什么是PCBA代工代料,PCBA代工代料有哪些类型2020-07-19 5577
-
pcba代工代料生产过程中透锡需要注意的事项2020-06-16 2579
-
PCBA加工透锡一般会受到哪些因素的影响2020-06-02 2862
-
影响PCBA代工代料成本的主要因素有哪些2020-01-16 4197
全部0条评论

快来发表一下你的评论吧 !

