

介绍一种MEMS器件主流加工技术
描述
硅基MEMS加工技术主要包括体硅MEMS加工技术和表面MEMS加工技术。体硅MEMS加工技术的主要特点是对硅衬底材料的深刻蚀,可得到较大纵向尺寸可动微结构。表面MEMS加工技术主要通过在硅片上生长氧化硅、氮化硅、多晶硅等多层薄膜来完成MEMS 器件的制作。利用表面工艺得到的可动微结构的纵向尺寸较小,但与IC工艺的兼容性更好,易与电路实现单片集成。
目前国外表面工艺与体硅工艺并行,其中表面工艺已发展成标准化的工艺流程,有多条工艺线面向多用户提供加工服务。国外也有多条面向多用户提供标准体硅加工的工艺线,如美国的IMT、法国的Tronics 等,国内主要采用了体硅MEMS加工技术,目前主要的体硅工艺包括湿法SOG (玻璃上硅) 工艺、干法SOG 工艺、正面体硅工艺、SOI (绝缘体上硅)工艺,在国内这些工艺基本形成了标准化工艺,国内的中国电子科技集团公司第13 研究所、北京大学、上海微系统与信息技术研究所等都对外提供标准化MEMS加工服务,另外基于以上工艺的多层晶片键合工艺、多层晶片键合是圆片级封装(WLP)以及三维(3D)垂直集成封装的基础,结合穿硅通孔(TSV)技术实现与IC 的集成,也是一个重要发展趋势。
湿法SOG加工工艺
SOG 工艺是通过阳极键合技术形成牢固的硅—氧键将硅圆片与玻璃圆片粘在一起硅作为MEMS器件的结构层玻璃作为MEMS 器件的衬底层,如图1 所示
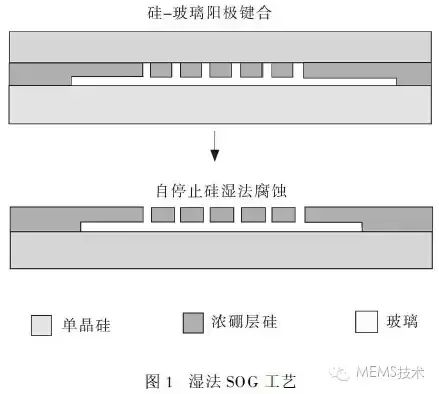
结构层由浓硼层形成,对于各向异性的腐蚀液EDP、KOH 或者TMAH,当硼掺杂原子浓度不小于1019 cm-3 时, KOH 腐蚀速率下降5 ~ 100倍(相对同样的单晶硅),对于EDP 腐蚀液, 腐蚀速率下降250倍,利用各向异性腐蚀液对高掺杂层的低腐蚀速率特性达到腐蚀停止的目的。采用深反应离子刻蚀(DRIE)工艺在浓硼层上形成各种设计的MEMS结构再与玻璃键合,采用自停止腐蚀去除上层多余的单晶硅完成加工。图2 是实物SEM照片。
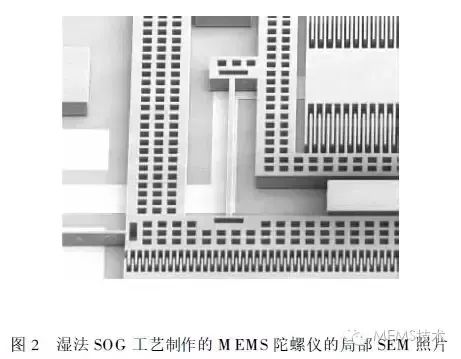
受扩散深度与浓度的限制,MEMS 器件结构层的厚度一般小于30 μm ,而且由于高浓度掺杂会造成硅结构损伤带来结构应力,另外硅与玻璃的材料不匹配性也会带来较大结构应力,自停止硅湿法腐蚀具有较低的加工精度,这些也是湿法SOG 加工技术的缺点,另外由于存在高温工艺也不适用于与IC 的单片集成,但此工艺比较成熟,工艺简单,也适合一些性能要求不高的MEMS器件的加工以及批量加工。湿法SOG 加工技术适合多种MEMS芯片的加工如MEMS陀螺仪、加速度计、MEMS执行器等。
干法SOG加工工艺
基本工艺结构类似湿法SOG工艺,同湿法SOG工艺相比,干法SOG工艺主要变化在于去掉了浓硼掺杂与湿法腐蚀步骤,而是采用磨抛减薄的工艺形成MEMS芯片的结构层省去高温长时间硼掺杂会降低对结构层的损伤,也避免了有毒或者容易带来工艺沾污的湿法腐蚀步骤,这些也是干法SOG加工技术的优点,与湿法SOG一样干法SOG同样具有不利于与IC 集成的缺点。干法SOG加工技术适合多种MEMS 芯片的加工,如MEMS 陀螺仪、MEMS 加速度计、MEMS光开关、MEMS衰减器等。干法SOG加工技术采用了先键合后刻蚀(DRIE) 结构的过程如图3 所示。
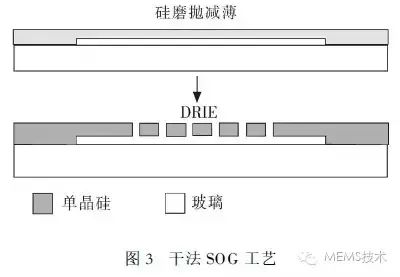
图4 是采用干法SOG工艺加工的MEMS器件照片。
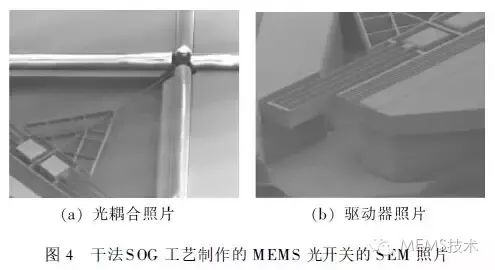
正面体硅加工技术
正面体硅工艺结合了深刻蚀、浓硼掺杂与湿法腐蚀工艺步骤,如图5 所示,首先对n型硅片进行浓硼掺杂,浓度满足硅湿法自停止腐蚀要求,然后DRIE硅结构,刻蚀深度大于浓硼层的厚度,最后在自停止腐蚀液里进行腐蚀,释放结构。一次掺杂正面体硅工艺的结构厚度一般小于30 μm,采用两次掺杂的正面体硅工艺的结构厚度可达60 μm 。

图6 是采用正面体硅工艺制作的MEMS器件实物照片。

体硅SOI 加工技术
与其他工艺相比,SOI工艺采用全硅结构,通过硅-硅键合技术将硅与硅片粘接在一起,由于是全硅结构,因此不存在由于热膨胀系数带来的应力影响,结构层厚度可达80μm,并具有较高的加工精度,易于电路单片集成。SOI工艺具有与IC 工艺更好兼容性的特点,适用于更多的MEMS器件的制造,可用于制作MEMS 惯性器件(包括陀螺、加速度计、振动传感器等)、MEMS光学器件(包括光开关、衰减器等)、生物MEMS、流体MEMS等多种MEMS器件,具有更广的适用性,可实现批量加工需求,是目前的一个主流加工工艺和发展趋势。工艺流程与实物照片如图7 和图8 所示。
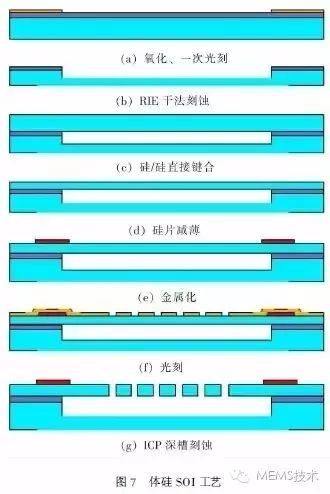
硅MEMS表面加工工艺
表面硅MEMS加工技术是在集成电路平面工艺基础上发展起来的一种MEMS工艺技术。它利用硅平面上不同材料的顺序淀积和选择腐蚀来形成各种微结构。它的基本思路是:先在基片上淀积一层称为牺牲层的材料,然后在牺牲层上面淀积一层结构层并加工成所需图形。在结构加工成形后,通过选择腐蚀的方法将牺牲层腐蚀掉,使结构材料悬空于基片之上,形成各种形状的二维或三维结构。表面硅MEMS加工技术工艺成熟,与IC 工艺兼容性好,可以在单个直径为几十毫米的单晶硅基片上批量生成数百个MEMS 装置。
图9 是一套表面牺牲层加工工艺流程。首先在衬底上淀积牺牲层材料(氧化硅)并形成可动微结构与衬底之间的连接窗口,然后淀积作为微结构的材料并光刻出所需的图形,最后利用湿法腐蚀去掉牺牲层,这样就形成了既能够活动又与衬底相连的微结构。
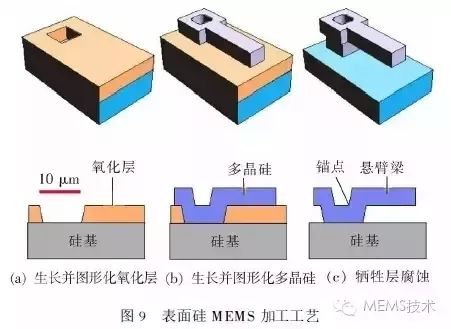
图10 是采用表面工艺制作的MEMS开关实物照片。
结束语
硅基加工技术是MEMS 器件的一个主流加工技术,包括体硅与表面加工工艺,体硅工艺比较适合制作高深宽比、高灵敏度MEMS 芯片,但与IC工艺兼容性稍差,而表面工艺加工的MEMS结构的深宽比较小,但易与IC 兼容,国内外有多个MEMS标准工艺加工服务的工艺线,目前国内主要采用体硅MEMS 加工技术,湿法SOG 、干法SOG 、正面体硅与体硅SOI 等几种体硅MEMS 工艺具有各自的优缺点适合于多种MEMS芯片的加工。
- 相关推荐
- 热点推荐
- MEMS麦克风
-
电子元器件加工技术如何塑造未来2023-11-21 2544
-
介绍超声加工技术的发展概况、研究现状及未来发展趋势2022-11-12 7624
-
主流的MEMS器件原理解析2021-04-09 9819
-
三种最常用的MEMS制造技术解析2020-07-29 8983
-
关于MEMS的技术简介2020-05-12 4284
-
MEMS传感器概念和分类等基础知识详解2018-11-12 2762
-
表面硅MEMS加工技术的关键工艺2018-11-05 3101
-
SMT贴片加工技术的组装方式介绍2018-09-18 2477
-
MEMS元器件的组成部分2018-09-07 2813
-
基于绿色机械加工技术的应用与研究2018-03-06 3592
-
MEMS传感器是什么?mems的工艺是什么?2016-12-09 9206
-
MEMS加工技术在机械手表制作中的应用2014-07-29 3433
-
细化了解SMT加工技术,掌握好SMT加工2014-06-07 2795
-
超精密加工技术2010-09-01 580
全部0条评论

快来发表一下你的评论吧 !

