

印刷电路板的热结构分析
描述
印刷电路板(PCB)在电子设备和其他相关应用中无处不在。一般来说,PCB是由多层层压材料和多层树脂粘合而成的。这些层嵌入有导电金属部件和垂直穿过这些层的金属通孔。
在有限元分析(FEA)中,将PCB中的主体和迹线建模为单元通常使用具有耦合或接触的实体、壳和梁单元。然而,由于PCB的每个树脂层中所涉及的嵌入体数量巨大,该方法通常是困难和耗时的
网格独立增强单元技术通过使用MESH200单元定义嵌入区域的拓扑并无缝创建嵌入增强单元,为PCB建模和网格化提供了更好的选择。不涉及复杂的接触建模、耦合或困难的网格划分技术。
该示例问题演示了如何使用独立于网格的增强单元来执行印刷电路板(PCB)的热结构分析。
重点介绍了以下特性和功能:
使用离散和涂抹的加固单元进行建模。
热分析后进行下游结构分析。
问题描述:
分析分为两部分:
步骤1. 求解热边界条件引起的热分析。
步骤2. 解决热载荷引起的下游结构分析。
由于运行载荷而在一些嵌入式金属迹线上产生的热量会导致整个PCB的温度梯度。梯度会导致PCB在操作期间变形,并引起热应力和应变。
建模
用于稳态热分析的模型使用ANSYS Mechanical创建,生成初始网格的单元:
表示小铜通孔的线体用LINK33划分网格。
代表树脂中嵌入铜和较大通孔的其他表面体用SHELL131划分。
使用SOLID70对层压板和树脂实体进行网格化。SOLID70单元进行了修改(EMODIF),以创建SOLID278单元,以支持增强单元的生成。
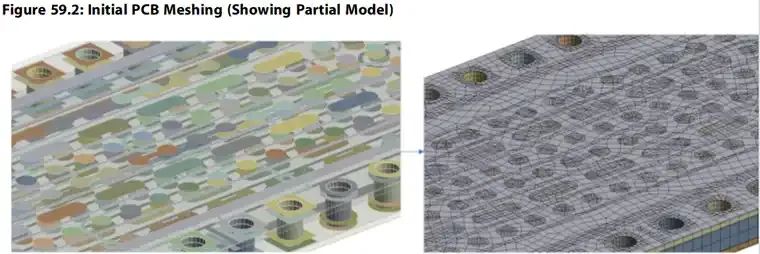
每个固体层压板和树脂体在内表面处彼此默认接合接触,从而形成六个接合接触对。
为了创建嵌入的加强单元(REINF264和REINF265),LINK33和SHELL131单元被修改(EMODIF)以创建等效的MESH200单元。
厚度为0.042 mm的涂抹加固的截面特性定义如下:

截面积为0.16053 mm2的离散加固的截面特性定义如下:

在选择适当的基础SOLID278和MESH200单元后,将创建加强构件(EREINF)并成形(/ESHAPE):

对于下游结构分析,修改了SOLID278单元(EMODIF)以创建等价SOLID185单元。作为热结合接触对的一部分的CONTA174单元也被修改以说明结构解决方案。然后重新选择增强单元REINF264和REINF265,以实现它们的结构自由度(EREINF)。
材料属性
以下是22°C下铜、层压材料和树脂材料的热性能和结构材料性能:

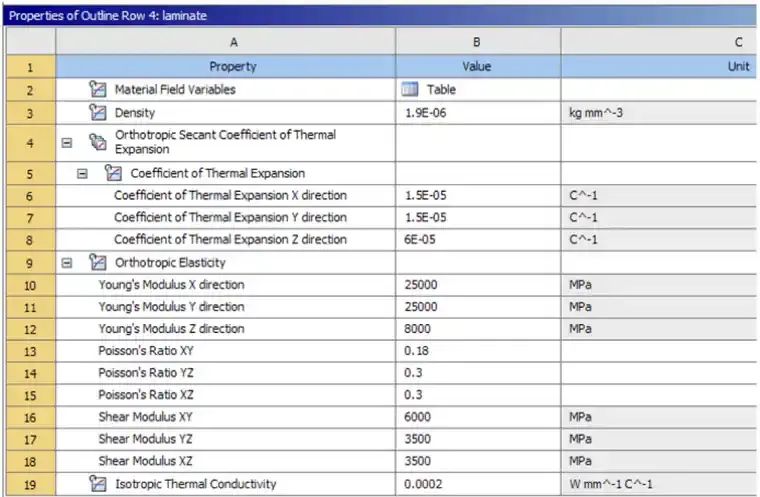
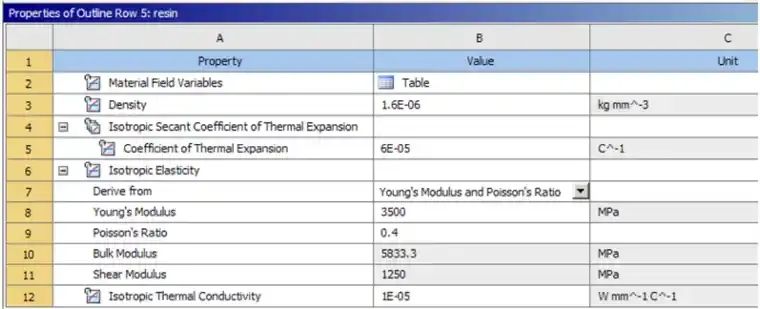
边界条件和加载
稳态热分析:边界条件和加载
将内部发热载荷应用于代表嵌入式铜迹线和通孔的选定MESH200单元组件:
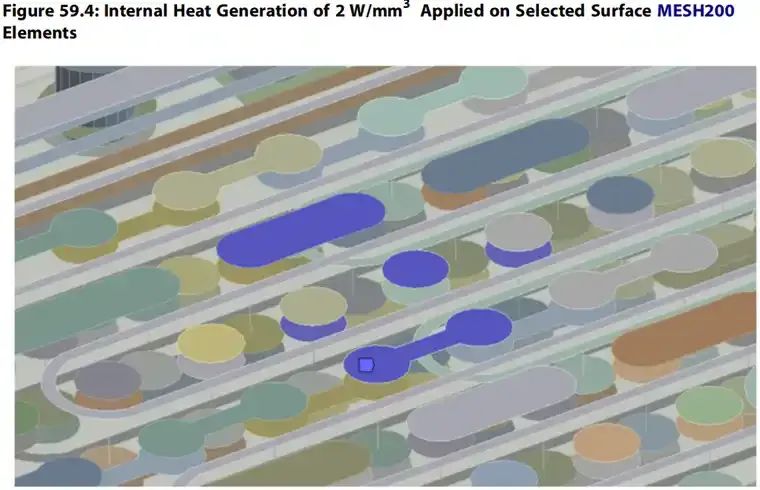

在从MESH200和基础构件交叉点创建加固(EREINF)后,应用于MESH200的边界条件被转移到涂抹加固构件(BFPORT):
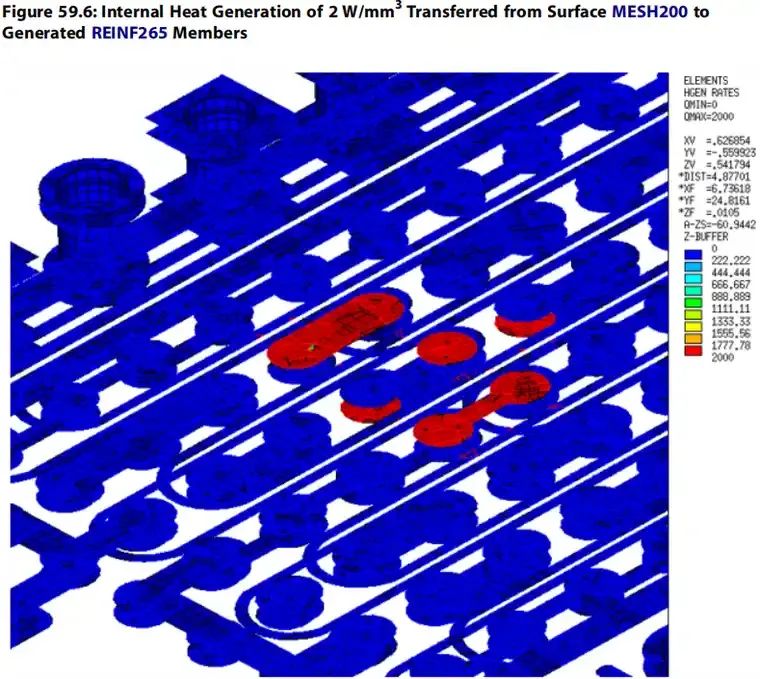
对流边界条件应用于PCB的顶面和底面:


下游结构分析:边界条件和加载
PCB的端部受到所有位移自由度的约束(以绿色表示):

分析和求解控制
该求解包括稳态热分析和下游结构分析。
在应用热产生载荷和对流边界条件后,稳态热解是直接的。
随后的结构解涉及从.rth文件(LDREAD)读取温度。
通过定义至少五个子步,可以实现大挠度。
位移收敛被启用,热流收敛被禁用(CNVTOL)。在求解结构分析之前,取消选择之前为对流定义的SURF152单元。
结果和讨论
在稳态热分析之后,温度结果是最重要的。以下是部分涂抹加固件的结果:
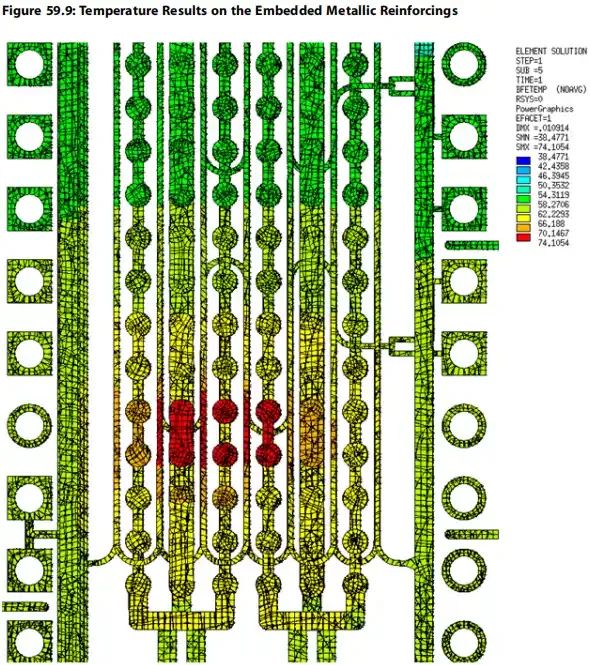
温度梯度导致下游结构分析中的变形和应力。
以下是涂抹加固件同一部分的变形结果:

整个PCB的等效热应变图(从正X轴侧观察)显示,应变发生在预期位置,并对应于热分析的加载条件:

孔隙压力分布在某些方面与参考文献的结果不同进行类似分析时,考虑以下提示和建议:
为实心基础单元选择足够大的尺寸,以避免过于精细的基础网格。如果基础单元小于嵌入部件的横截面或厚度,则热产生载荷可能不会充分分布,从而导致对受影响区域的热结果的过度估计。
对加固单元使用适当的截面控制设置(SECCONTROL),以提高结果。
考虑对所有支撑基础材料使用基底移除选项,对均质嵌入构件使用全膜选项。
-
什么是PCB助焊剂?印刷电路板焊接的目的2020-11-23 5963
-
如何设计和创建自己的印刷电路板2020-10-20 3374
-
印刷电路板图设计的基本原则和要求2019-04-12 4573
-
印刷电路板设计2018-03-28 1073
-
印刷电路板设计基础课程2017-01-05 1112
-
印刷电路板图设计的基本原则2014-05-15 3295
-
Protel设计印刷电路板应考虑的问题2010-04-16 1188
-
印刷电路板焊接缺陷研究2010-03-10 1771
-
印刷电路板的设计与制作2010-02-11 1150
-
软性印刷电路板及产品详细介绍2009-12-10 2275
-
什么是单面印刷电路板?2009-12-09 2868
-
印刷电路板设计的基本原则2009-11-17 812
-
印刷电路板2009-09-30 1979
-
什么是柔性印刷电路板?2006-04-16 1930
全部0条评论

快来发表一下你的评论吧 !

