

硅片的 TTV,Bow, Warp,TIR 等参数定义
电子说
描述
引言
在半导体制造领域,硅片作为核心基础材料,其质量参数对芯片性能和生产良率有着重要影响。TTV、Bow、Warp、TIR 等参数是衡量硅片质量与特性的关键指标。本文将对这些参数进行详细定义与阐述,明确其在硅片制造和应用中的重要意义。
TTV(Total Thickness Variation,总厚度变化)
定义
TTV 指的是在硅片同一表面上,硅片最大厚度与最小厚度的差值,用于表征硅片厚度的均匀性。其计算公式为:TTV = T_{max} - T_{min},其中T_{max}为硅片表面的最大厚度值,T_{min}为硅片表面的最小厚度值 。在先进半导体制造工艺中,对硅片 TTV 的要求极为严格,通常需控制在几微米甚至更小的范围内,以确保后续光刻、刻蚀等工艺的精确性。
测量意义与方法
TTV 值过大,会导致光刻胶涂覆不均匀、光刻图形转移精度下降,影响芯片的电学性能和成品率。目前,常用激光扫描技术测量硅片 TTV,通过激光传感器在硅片表面进行多点扫描,获取不同位置的厚度数据,进而计算出 TTV 值 。
Bow(弯曲度)
定义
Bow 是指硅片受外力或内部应力作用,导致硅片中心面偏离理想平面,硅片中心到边缘参考平面的最大距离。它反映了硅片在某一方向上的弯曲程度 。硅片在制造、加工或运输过程中,因温度变化、机械应力等因素,容易产生 Bow 现象。
测量意义与方法
Bow 值过大可能造成光刻时曝光不均匀、键合工艺中硅片贴合不良等问题。一般采用非接触式光学测量方法,如激光干涉仪,通过测量硅片表面的干涉条纹,计算出硅片的 Bow 值。
Warp(翘曲度)
定义
Warp 表示硅片整个表面偏离其理想平面的程度,是硅片表面最高点与最低点之间的距离。与 Bow 不同,Warp 考虑的是硅片整体表面的起伏情况,能更全面地反映硅片的形状畸变 。
测量意义与方法
较大的 Warp 值会影响硅片在设备中的定位精度,导致工艺处理的不一致性。测量 Warp 常用的方法是光学轮廓仪测量,通过对硅片表面进行三维扫描,获取表面形貌数据,从而确定 Warp 值。
TIR(Total Indicator Reading,总指示读数)
定义
TIR 指的是在硅片表面上,测量点相对于某一基准平面的高度差的最大值与最小值之差。它综合反映了硅片表面的平整度和形状误差 ,在一定程度上体现了硅片表面的整体质量状况。
测量意义与方法
TIR 值过大可能影响硅片与其他器件的集成效果。通常使用高精度的表面轮廓测量仪进行 TIR 测量,通过逐点扫描硅片表面,获取各点高度数据,进而计算出 TIR 值。
TopMap Micro View白光干涉3D轮廓仪
一款可以“实时”动态/静态 微纳级3D轮廓测量的白光干涉仪
1)一改传统白光干涉操作复杂的问题,实现一键智能聚焦扫描,亚纳米精度下实现卓越的重复性表现。
2)系统集成CST连续扫描技术,Z向测量范围高达100mm,不受物镜放大倍率的影响的高精度垂直分辨率,为复杂形貌测量提供全面解决方案。
3)可搭载多普勒激光测振系统,实现实现“动态”3D轮廓测量。

实际案例

1,优于1nm分辨率,轻松测量硅片表面粗糙度测量,Ra=0.7nm

2,毫米级视野,实现5nm-有机油膜厚度扫描
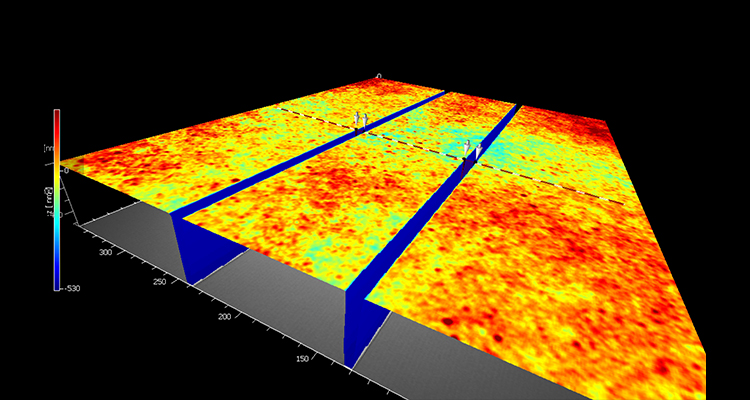
3,卓越的“高深宽比”测量能力,实现光刻图形凹槽深度和开口宽度测量。
审核编辑 黄宇
-
晶圆背面磨削工艺中的TTV控制深入解析2025-08-05 5316
-
wafer晶圆厚度(THK)翘曲度(Warp)弯曲度(Bow)等数据测量的设备2025-05-28 7113
-
wafer晶圆几何形貌测量系统:厚度(THK)翘曲度(Warp)弯曲度(Bow)等数据测量2025-05-23 1795
-
利用 Bow 与 TTV 差值于再生晶圆制作超平坦芯片的方法2025-05-21 1616
-
碳化硅衬底的特氟龙夹具相比其他吸附方案,对于测量碳化硅衬底 BOW/WARP 的影响2025-01-23 286
-
不同的氮化镓衬底的吸附方案,对测量氮化镓衬底 BOW/WARP 的影响2025-01-17 420
-
氮化镓衬底的环吸方案相比其他吸附方案,对于测量氮化镓衬底 BOW/WARP 的影响2025-01-16 366
-
不同的碳化硅衬底的吸附方案,对测量碳化硅衬底 BOW/WARP 的影响2025-01-14 400
-
晶圆的环吸方案相比其他吸附方案,对于测量晶圆 BOW/WARP 的影响2025-01-09 639
-
晶圆的TTV,BOW,WARP,TIR是什么?2024-12-17 1972
-
降低晶圆TTV的磨片加工有哪些方法?2024-10-31 548
-
TIR1000 独立 IrDA 编码器,解码器2018-10-16 704
全部0条评论

快来发表一下你的评论吧 !

