

半导体分层工艺的简单介绍
描述
文章来源:半导体与物理
原文作者:jjfly686
本文介绍了芯片的分层制造工艺。
在指甲盖大小的硅片上建造包含数百亿晶体管的“纳米城市”,需要极其精密的工程规划。分层制造工艺如同建造摩天大楼:先打地基(晶体管层),再逐层搭建电路网络(金属互连),最后封顶防护(封装层)。这种将芯片分为FEOL(前道工序) 与 BEOL(后道工序) 的智慧,正是半导体工业的基石。
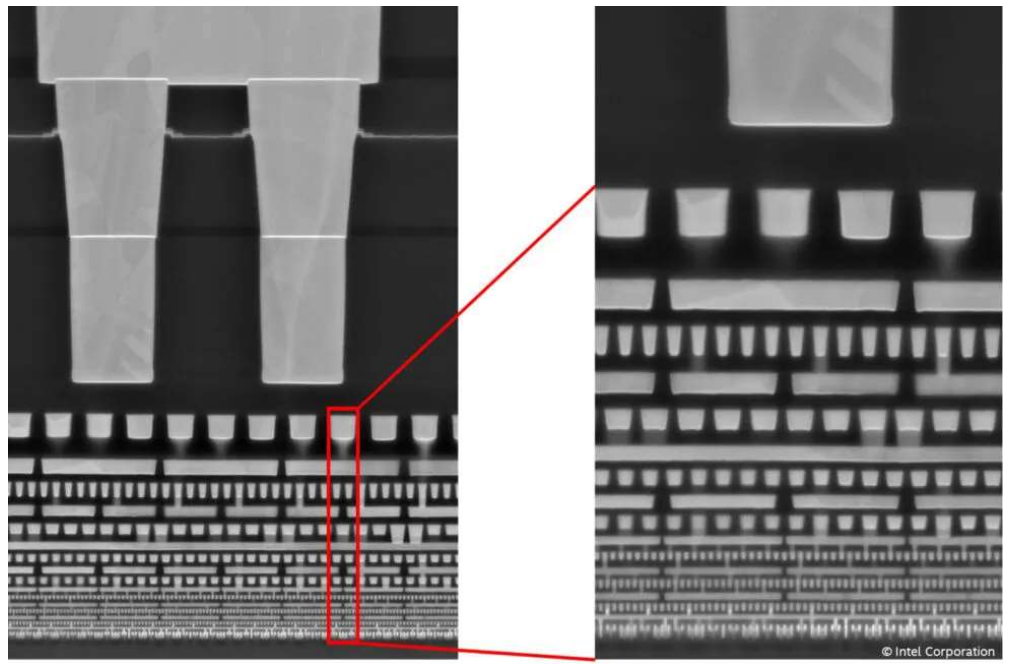
一、芯片:从硅衬底到金属穹顶
下图展示了典型集成电路的剖面结构,自上而下共分三大功能区:
▲ 顶层防护层(Overcoat)
氮化硅保护层(SiN)—— 防潮防刮
氧化硅绝缘层(SiO₂)—— 电气隔离
焊盘开口(Bond Pad Opening)—— 连接外部引脚
▲ 后道工序层(BEOL:Back End Of Line)
金属6-5层(Cu)—— 全局电源/时钟信号
金属4-1层(Cu/Co)—— 局部数据互连
▲ 前道工序层(FEOL:Front End Of Line)
晶体管层(NFET/PFET)—— 开关核心
多晶硅(Poly)—— 电路导线
浅槽隔离(STI)—— 晶体管间绝缘
N阱(N-well)—— 高压器件隔离
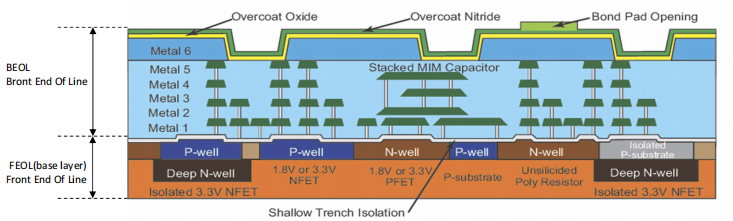
二、FEOL:建造晶体管
前道工序(FEOL) 在裸硅晶圆上直接制造晶体管,如同城市的地基建设:
核心工艺与功能
| 浅槽隔离(STI) | 刻蚀沟槽→填充SiO₂ | 隔离相邻晶体管,防止漏电 |
| 深N阱 | 高能磷注入 | 创建独立电势区 |
| 晶体管沟道 | 离子注入+退火 | 形成NMOS/PMOS导电通道 |
| 多晶硅栅 | LPCVD沉积+光刻 | 控制电子开关 |
| 硅化物阻挡层 | 氮化硅掩膜 | 保护导电区域 |
| 结构 | 制造工艺 | 核心作用 |
|---|
技术突破:
应变硅技术:在PMOS源漏区嵌入SiGe,空穴迁移率提升40%;
高k金属栅:HfO₂替代SiO₂,栅极漏电流降低1000倍。
三、BEOL:编织电路
后道工序(BEOL) 在晶体管层之上构建金属互连网络,如同城市的道路与电网:
核心结构解析
1. 金属互连层(Metal 1-6)
铜互连(Cu)替代铝,电阻降低37%;钴镶边(Co Liner)抑制电迁移,寿命提升10倍。Metal 1:晶体管直接连接(线宽10-20 nm);Metal 4:模块间互连(如CPU与缓存);Metal 6:全局电源网络(厚度1 μm,载流>1A)。
2. 堆叠电容(MIM Capacitor)结构
TaN-绝缘层(Al₂O₃)-TaN“三明治”;作用:为模拟电路(如PLL)提供稳定电荷;密度:5 fF/μm²,占面积仅为传统MOS电容的1/5。
3. 通孔(Via)与沟槽(Trench)
双大马士革工艺:同步刻蚀通孔+导线槽,铜一步填充;深宽比极限:3 nm节点达5:1,ALD沉积2 nm钽阻挡层。
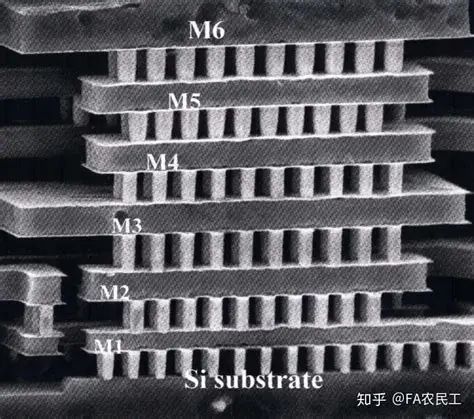
四、顶层防护
氧化硅覆盖层(Overcoat Oxide)阻挡湿气腐蚀;
氮化硅密封层(Overcoat Nitride)抗划伤强度抵御封装应力;
焊盘开口(Bond Pad Opening)激光开窗露出铝焊盘。
创新防护技术低k聚合物涂层:填充金属线间隙,减少信号串扰30%;原子层沉积密封:Al₂O₃薄膜隔绝钠离子污染。
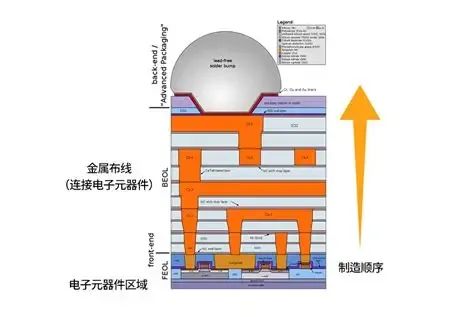
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1885
-
半导体清洗工艺介绍2024-01-12 5425
-
《炬丰科技-半导体工艺》半导体行业的湿化学分析——总览2021-07-09 4964
-
半导体光刻蚀工艺2021-02-05 7143
-
半导体工艺几种工艺制程介绍2020-12-10 11373
-
主流的射频半导体制造工艺介绍2019-07-29 3988
-
适合用于射频、微波等高频电路的半导体材料及工艺情况介绍2019-06-27 6232
-
半导体器件与工艺2012-08-20 46018
-
[课件]半导体工艺2012-02-26 24587
-
半导体工艺讲座2009-11-18 98133
-
有关半导体工艺的问题2009-09-16 5889
全部0条评论

快来发表一下你的评论吧 !

