

AI算力需求激增,芯片散热材料如何选?
描述
根据Canalys预测,兼容AI的个人电脑将从2025年开始快速普及,预计至2027年约占所有个人电脑出货量的60%,AI 有望提振消费者需求。在高性能AI处理器的加持以及消费者需求下,消费电子终端产品持续向高集成、轻薄化方向发展的大趋势下,芯片和元器件体积不断缩小,功率密度却在快速增加,消费电子产品的散热方案需要不断升级。
封装材料成本通常会占到整体封装成本的 40%~60%,其中多种封装材料决定了芯片散热性能的优劣,如固晶胶/膜、热界面材料(TIM)、均热片及散热器以及底部填充料(Underfill)等。
特此分享方正证券《半导体材料行业专题报告—芯片功耗提升,散热重要性凸显》,供大家了解市场需求、主要封装材料及其发展趋势。
内容大纲:
1 芯片性能提升催生散热需求,封装材料市场稳健增长
2 黏接材料:由 DAP 向 DAF 升级
3 散热材料:芯片功率提升的重要防线
3.1 热界面材料(TIMs)
3.2 均热片
3.3 散热器
4 Underfill:倒装芯片封装的关键材料





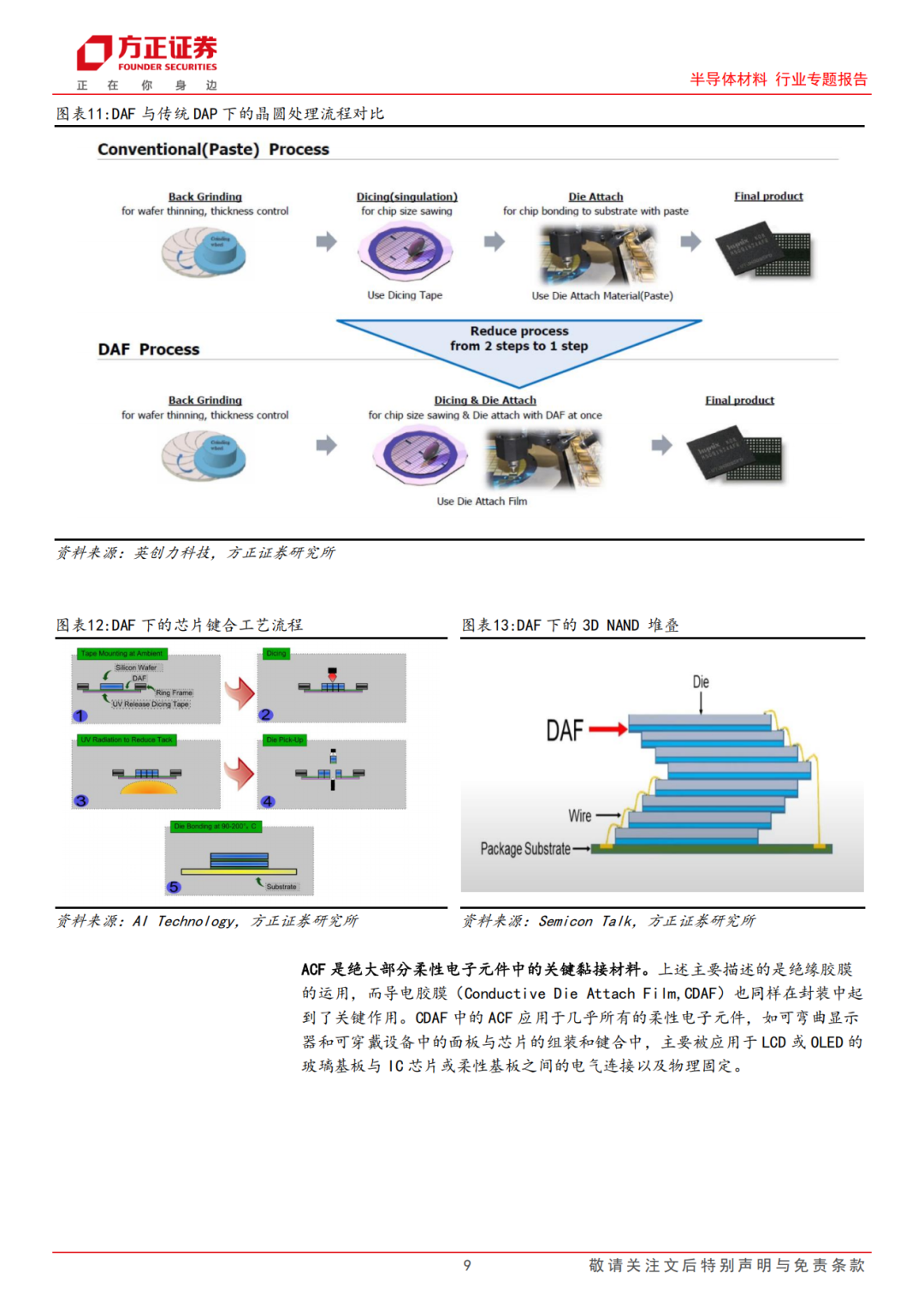






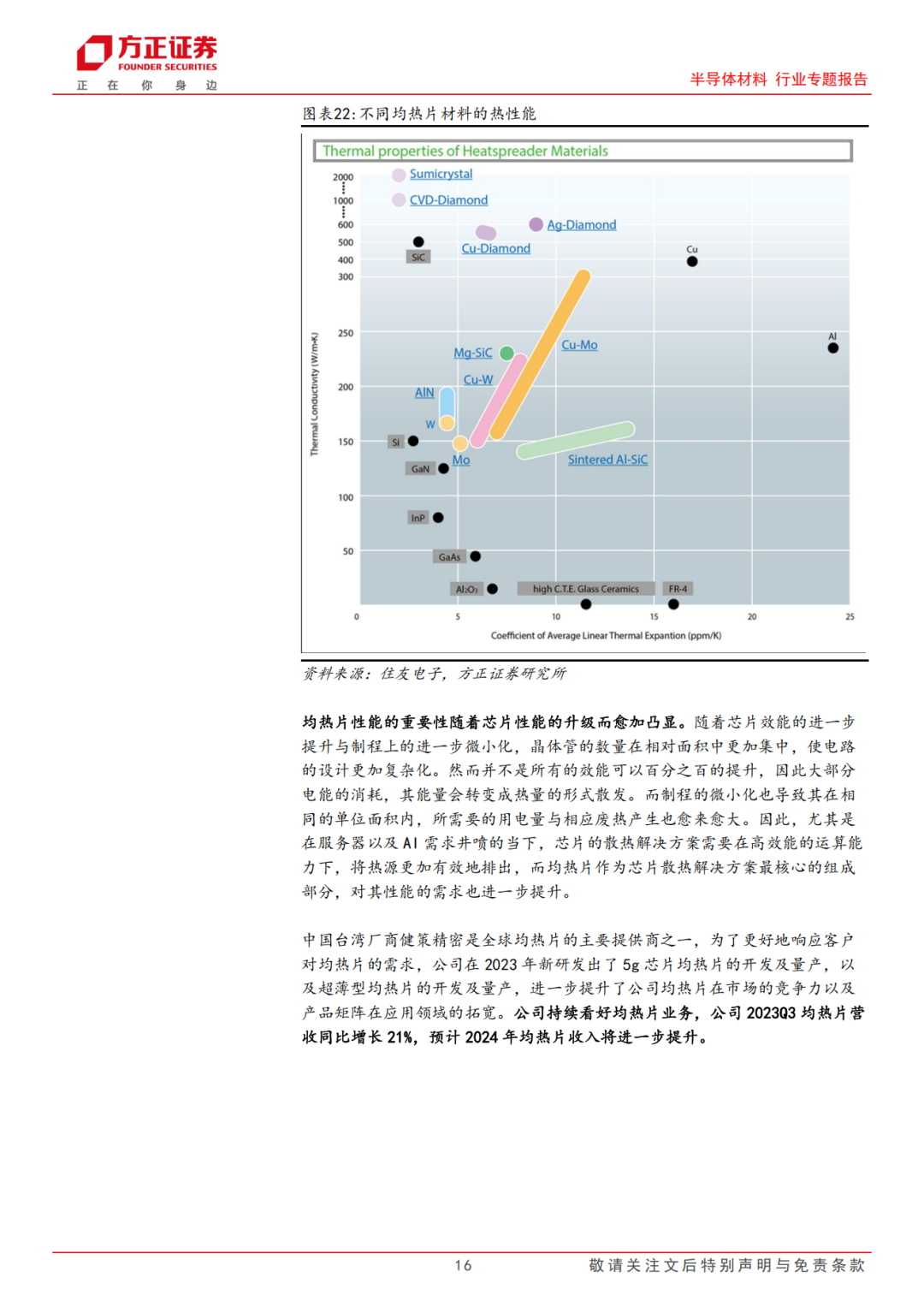
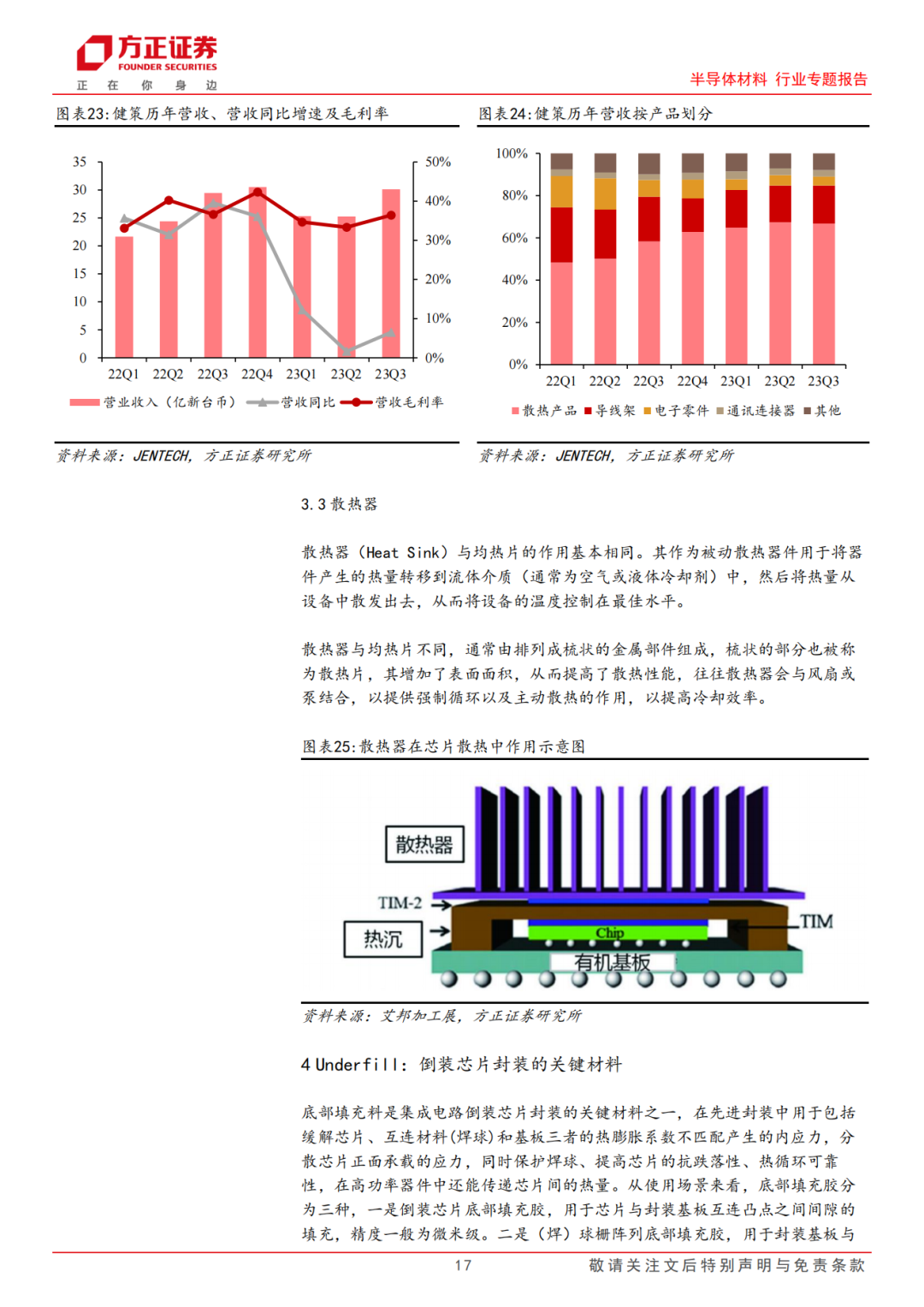



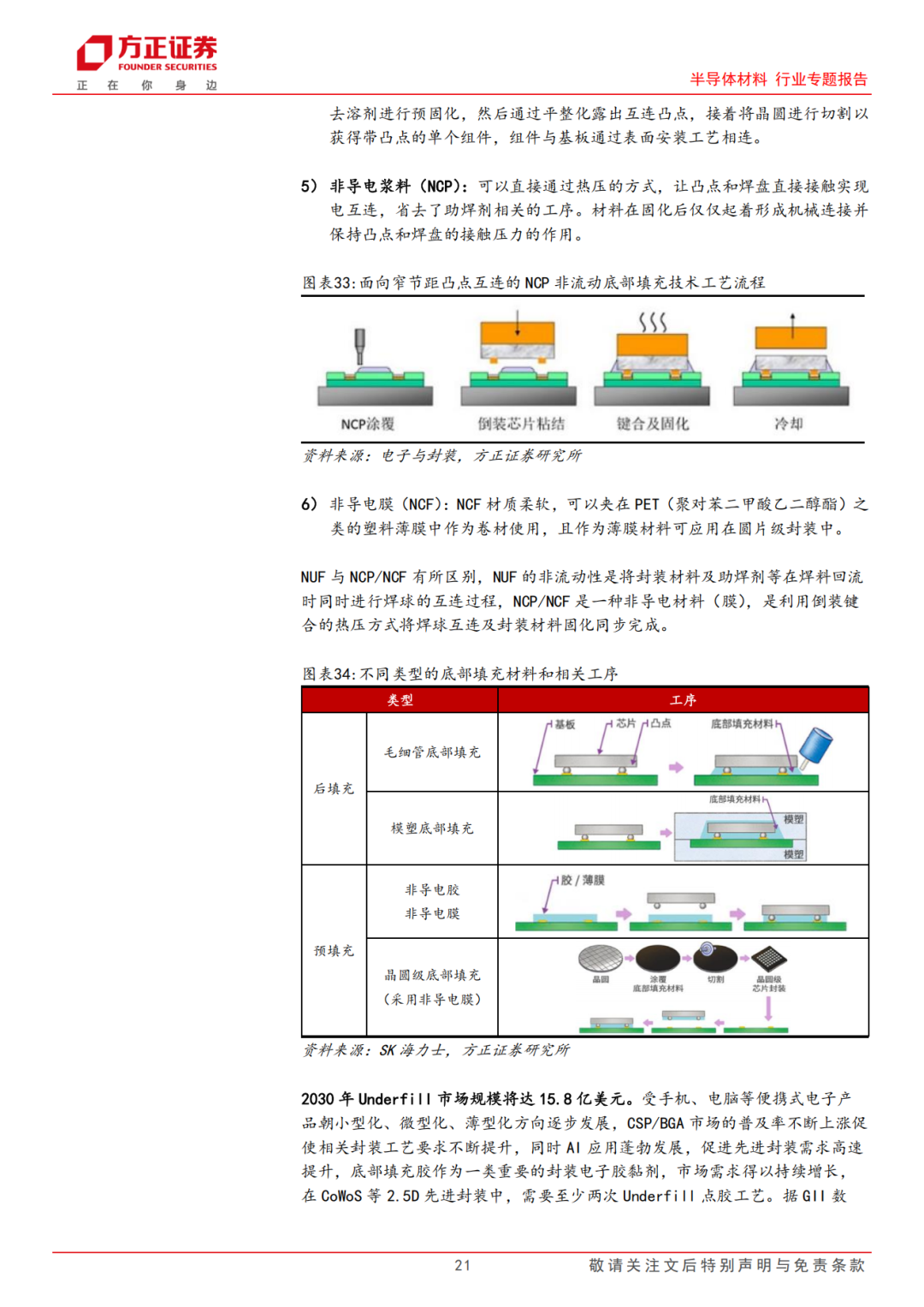

来源:天通智造、新材料在线、方正证券
以上部分资料转载“车乾6G”网络平台,文章仅用于交流学习版权归原作者。如有侵权请告知立删。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
大模型时代的算力需求2024-08-20 1016
-
DeepSeek推动AI算力需求:800G光模块的关键作用2025-03-25 938
-
国产AI芯片真能扛住“算力内卷”?海思昇腾的这波操作藏了多少细节?2025-10-27 2281
-
华为发布最外那个算力AI芯片2019-08-23 4036
-
昆仑芯AI芯片以AI算力服务实体经济 筑底算力经济新基建2022-10-19 3303
-
ai芯片和算力芯片的区别2023-08-09 9200
-
浅谈为AI大算力而生的存算-体芯片2023-12-06 821
-
AI高算力服务器散热,需要用到哪些导热界面材料?2024-05-30 2100
-
企业AI算力租赁是什么2024-11-14 3020
-
AI算力需求激增,数据中心如何应对能源挑战2025-02-22 1187
-
大算力芯片的生态突围与算力革命2025-04-13 2803
-
30+AI 算力热管理材料供应商推荐2025-04-25 834
-
AI安防选什么主板?杰和IB3-761靠“算力精准+多接口”出圈2025-09-22 21
-
赋能电源芯片国产替代,智芯谷助力AI算力稳定前行2025-12-30 255
全部0条评论

快来发表一下你的评论吧 !

