

芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量
描述
随着物联网(IoT)和人工智能(AI)驱动的半导体器件微型化,对多层膜结构的三维无损检测需求急剧增长。传统椭偏仪仅支持逐点膜厚测量,而白光干涉法等技术难以分离透明薄膜的多层反射信号。本文提出一种单次曝光光谱分辨干涉测量法,通过偏振编码与光谱分析结合,首次实现多层膜厚度与3D表面轮廓的同步实时测量。并使用Flexfilm探针式台阶仪对新方法的检测精度进行验证。
1
技术原理:单次曝光干涉测量系统
flexfilm
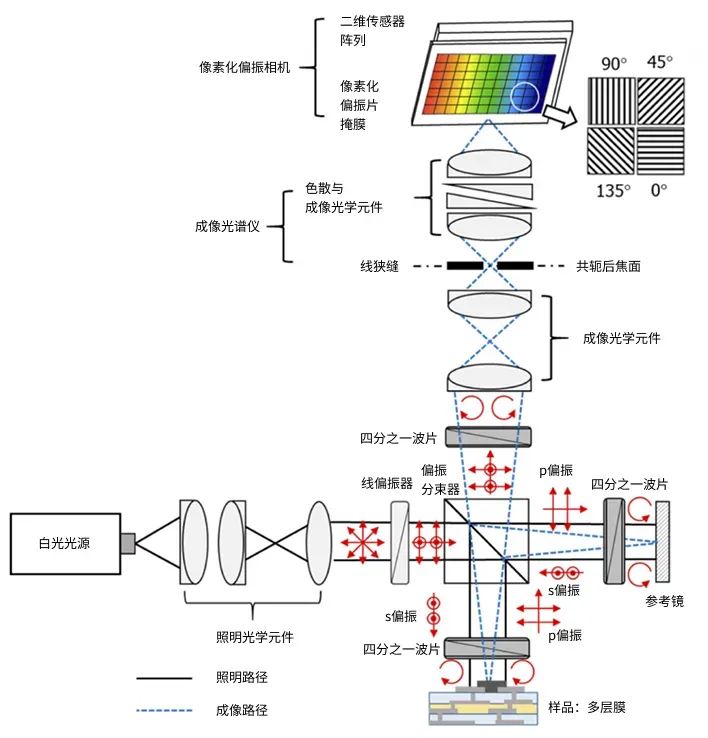
实时测量多层膜3D厚度轮廓的动态单次干涉测量系统原理图
该技术的核心在于将像素化偏振相机(PPC)与成像光谱仪耦合,构建了能够单次测量获取宽光谱范围内四组相移干涉图的光学系统。光源采用 400-800nm 的钨卤素灯,通过柯勒照明实现均匀照度,线性偏振器与消色差四分之一波片组合调控光束偏振状态,使从样本和参考镜反射的正交圆偏振光在 PPC 的微偏振器阵列(0°、45°、90°、135°)上形成相移干涉图案。
- 数据处理
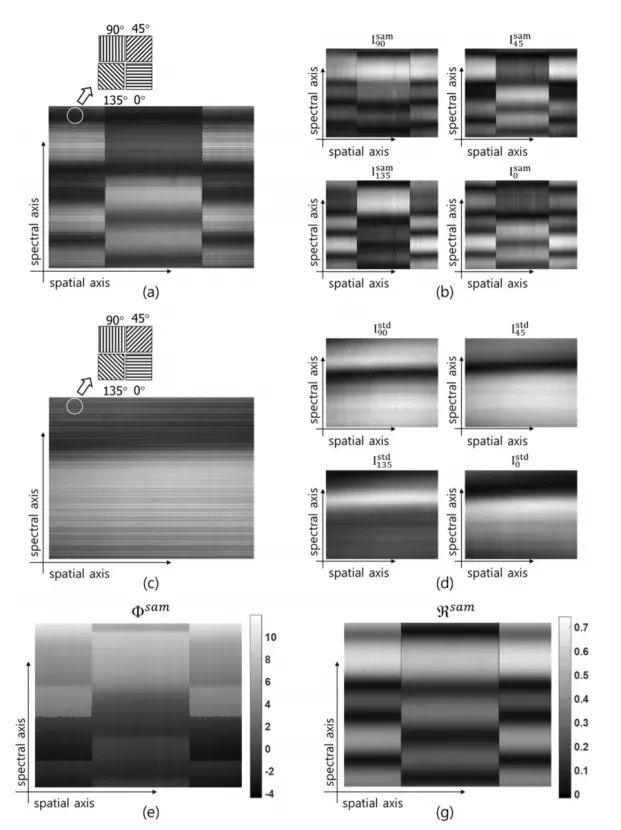
单次光谱分辨干涉测量原理
- 相位计算:通过以下公式从四个相移子图中提取光谱相位,分离线性与非线性分量。非线性相位反映薄膜厚度变化,线性相位对应表面高度。

- 反射率校准:以裸硅片为标准参考,通过下面公式计算样品的绝对反射率。

- 联合反演:构建目标函数,结合非线性相位与反射率数据,优化各层厚度;

- 再通过下面公式拟合总相位,确定表面轮廓。

2
实验验证:五层膜3D计量
flexfilm
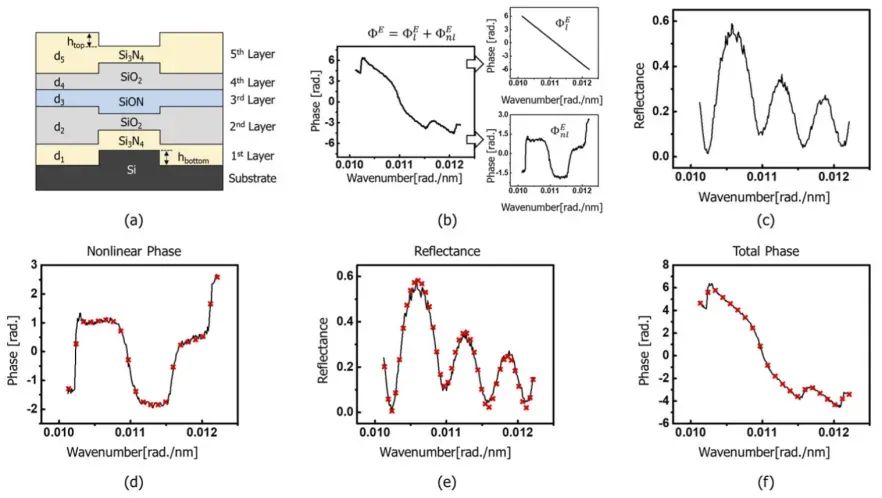 测量流程示例
测量流程示例
样品与校准:五层薄膜(Si₃N₄-SiO₂-SiON-SiO₂-Si₃N₄)通过光刻工艺制备,每层沉积后均用椭偏仪和探针式台阶仪记录厚度与表面数据。为了确保测量的准确性,实验前使用HgAr灯校准光谱轴,并以裸硅片为参考进行反射率归一化。
- 膜厚精度
五层膜膜厚测量结果对比(单位:nm) 与椭偏仪对比:10次测量标准差<1.6nm,最大偏差14nm(第4层SiO₂)例如第5层Si₃N₄:椭偏仪1343.6nm vs 本文方法1344.7±0.8nm
与椭偏仪对比:10次测量标准差<1.6nm,最大偏差14nm(第4层SiO₂)例如第5层Si₃N₄:椭偏仪1343.6nm vs 本文方法1344.7±0.8nm
- 表面轮廓精度
表面台阶高度测量对比(单位:nm)

五层膜3D厚度轮廓测量结果(a-e) 各层膜厚分布(第1-5层), (f) 顶层表面形貌, (g) 三维重构厚度轮廓, (h) A-A'线各层截面轮廓

A-A'线表面轮廓测量结果对比(a)硅基底 (b)第1层Si₃N₄ (c)第2层SiO₂(d)第3层SiON (e)第4层SiO₂ (f)第5层Si₃N₄
表面轮廓:重构的三维厚度分布与探针式台阶仪的对比显示,最大偏差小于12 nm,表面台阶高度一致。本文提出了一种新型光谱分辨干涉技术,通过单次测量获取光谱干涉条纹,并从中分析得到宽波长范围的光谱相位和反射率变化,从而同步、无损地测量多层膜各层的膜厚和表面轮廓。该技术基于线扫描,通过横向扫描和拼接即可实现3D厚度轮廓测量。使用标准样品进行校准后,通过对五层膜样本的测量,并与商用椭圆偏振仪和探针式台阶仪的独立测量结果对比,验证了该方法的可行性和准确性。这种单脉冲干涉法有望应用于半导体和显示领域的在线检测。
Flexfilm探针式台阶仪
flexfilm

在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
- 配备500W像素高分辨率彩色摄像机
- 亚埃级分辨率,台阶高度重复性1nm
- 360°旋转θ平台结合Z轴升降平台
- 超微力恒力传感器保证无接触损伤精准测量
在本文研究中,Flexfilm探针式台阶仪作为表面轮廓测量的金标准,通过与新方法的测量结果对比(最大偏差<12nm),直接验证了单次曝光干涉技术对多层膜三维表面轮廓的无损检测精度。原文出处:《Single-shot spectrally resolved interferometry for the simultaneous measurement of the thickness and surface profile of multilayer films》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
涡流膜厚检测电路图2009-07-09 1723
-
印刷电子制造中的厚膜光刻技术2022-01-17 2703
-
台阶仪膜厚测量:工业与科研中的纳米级精度检测2024-05-11 1418
-
膜厚测试仪的测量范围 膜厚测试仪的操作注意事项2024-12-19 2408
全部0条评论

快来发表一下你的评论吧 !

