

薄膜质量关键 | 半导体/显示器件制造中薄膜厚度测量新方案
描述
在半导体和显示器件制造中,薄膜与基底的厚度精度直接影响器件性能。现有的测量技术包括光谱椭偏仪(SE)和光谱反射仪(SR)用于薄膜厚度的测量,以及低相干干涉法(LCI)、彩色共焦显微镜(CCM)和光谱域干涉法(SDI)用于基板厚度的测量。本研究提出SR-SDI集成光学系统,通过可见光反射谱与近红外干涉谱的协同处理,实现跨尺度同步厚度测量,并开发模型化干涉分析算法,将基底厚度测量误差降至8 nm以下。
1
光谱反射仪(SR)
flexfilm
首先,通过拟合理论反射谱到实验反射谱来确定薄膜的厚度。理论反射谱由薄膜层两个界面处的多次反射和透射建模得出。公式如下: 其中,r01和 r12分别是空气到薄膜和薄膜到基板的菲涅尔反射系数,λ 是波长,N~1 是薄膜材料的已知折射率。实验反射谱通过测量参考基板和薄膜试样的反射强度谱得出。
其中,r01和 r12分别是空气到薄膜和薄膜到基板的菲涅尔反射系数,λ 是波长,N~1 是薄膜材料的已知折射率。实验反射谱通过测量参考基板和薄膜试样的反射强度谱得出。
2
光谱域干涉仪(SDI)
flexfilm
其次,通过分析干涉谱的周期来确定基板的厚度。干涉谱的周期取决于光程差,可以通过傅里叶变换后的峰值位置和光速计算得出。公式如下: 其中,I1,I2,I3和 I4分别是四个测量光束的干涉信号幅度。通过模型分析干涉谱,可以有效减小薄膜对基板厚度测量的影响。
其中,I1,I2,I3和 I4分别是四个测量光束的干涉信号幅度。通过模型分析干涉谱,可以有效减小薄膜对基板厚度测量的影响。
3
实验验证
flexfilm
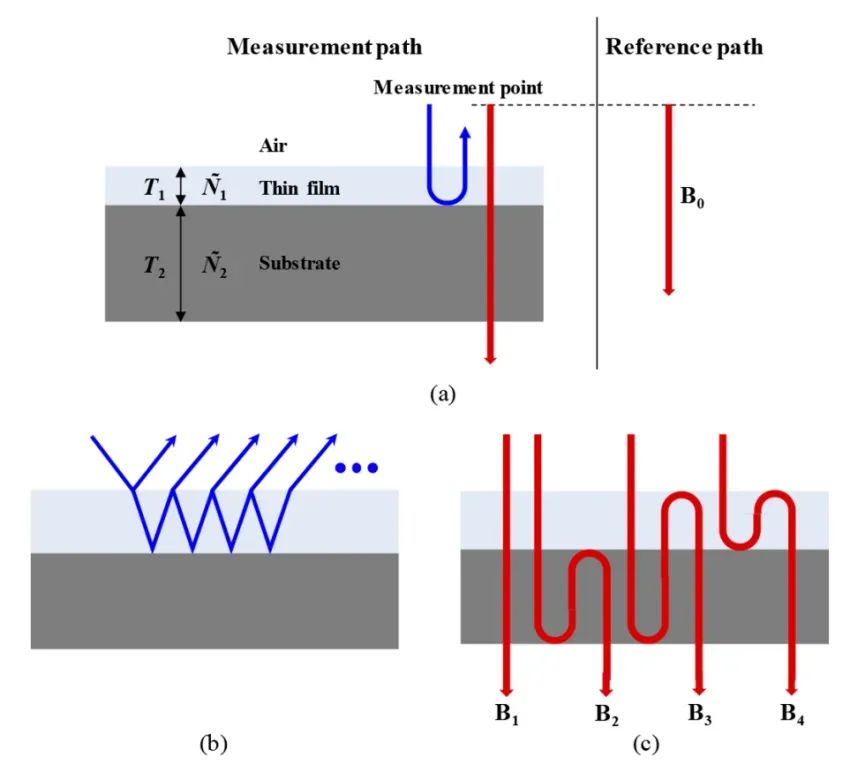
SR与SDI的光束传播路径:(a) SR(蓝)和SDI(红)的测量/参考光束;(b) SR详细光路;(c) SDI详细光路
实验系统采用可见 - 近红外双波段光源:SR 使用钨卤素灯(300–2600 纳米)与可见光谱仪,SDI 使用超辐射二极管(1550 纳米中心波长)与近红外光谱仪,通过二向色分束器实现光路集成。
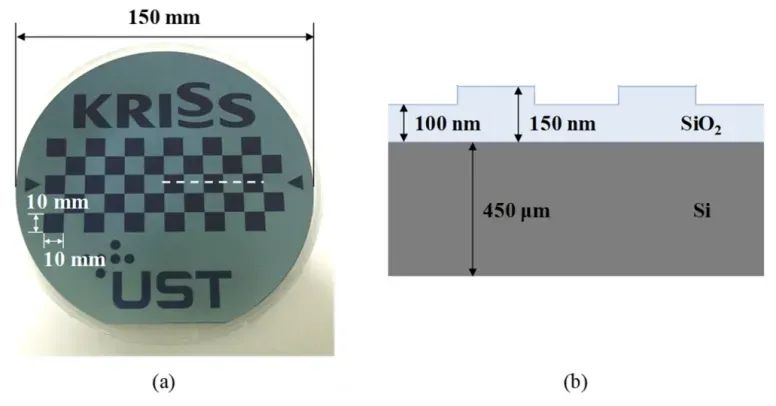
薄膜样品示意图:(a) 俯视图(b) 图(a)白虚线截面的剖面结构

厚度分布测量结果:(a) SR模式薄膜厚度分布;(b) SDI模式基底厚度分布;(c)–(d) 沿黑虚线的厚度剖面
对 450 微米硅基底上 100 纳米与 150 纳米的SiO₂薄膜样品进行扫描测量,薄膜厚度分布清晰地显示了100nm和150nm的两个不同厚度水平,而基板厚度分布显示出逐渐变化的厚度,与薄膜厚度分布明显不同。这证实了薄膜和基板的厚度可以在同一时间内测量,且互不干扰。
4
不确定度评估
flexfilm
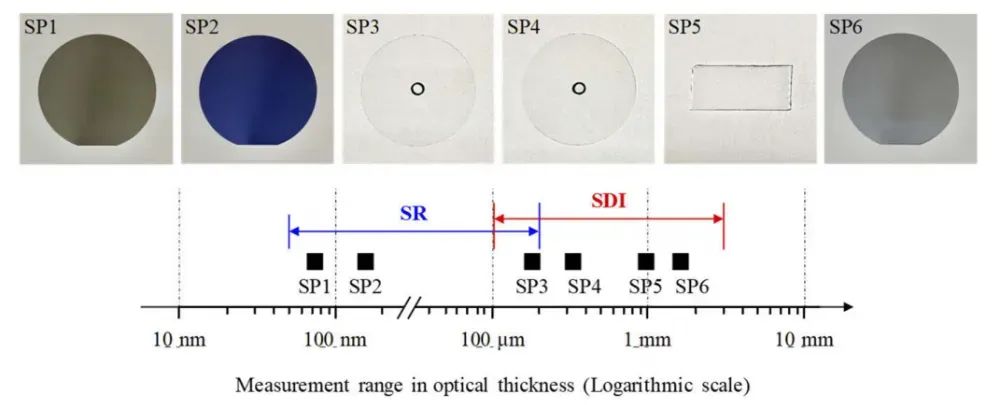
分布在宽厚度范围内的厚度参考样品

薄膜厚度测量不确定度为 0.12 纳米k=2,薄膜样品中基底为 0.094 微米k=2,单个基底为 0.076 微米k=2,验证了方法的可靠性。六组参考样品的对比测量显示,测量值与认证值在扩展不确定度内一致,En 值均小于 1,证实了多尺度厚度测量的准确性。本文实现了一种基于光谱反射仪和光谱域干涉仪集成的光学测量系统,能够同时测量薄膜和基板的厚度。通过模型分析干涉谱,有效减小了薄膜对基板厚度测量的影响。实验结果验证了该方法的有效性和可靠性,测量结果与标准测量设备一致。
FlexFilm自动膜厚仪
flexfilm
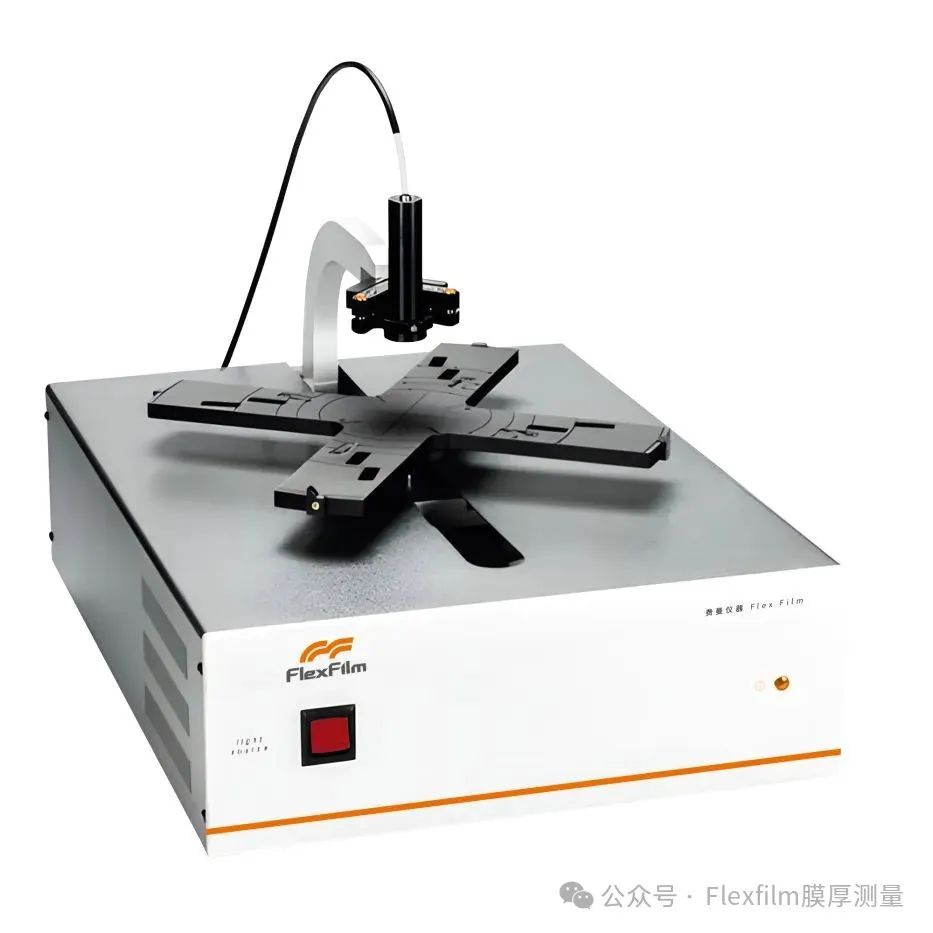
对样品进行无损、快速、高精度测量,可用于反射率、透射率、膜厚等参数测量。广泛应用于光学镀膜、半导体薄膜、液晶显示、薄膜层和生物医学等厚度的测量方案中。
- 光学干涉方式,无损测量
- Mapping成像模式,轻松表征材料膜厚的均一性
- 多类解析算法,可精准和估算测量,满足不同测量需要
- 软件简洁,测量一键操作,简单易用
FlexFilm自动膜厚仪可以对半导体和显示器件制造中的薄膜厚度进行精准测量,来实现器件的性能优化。原文出处:《Optical method for simultaneous thickness measurements of two layers with a significant thickness difference》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
椭偏仪在半导体的应用|不同厚度c-AlN外延薄膜的结构和光学性质2025-12-26 1465
-
四探针薄膜测厚技术 | 平板显示FPD制造中电阻率、方阻与厚度测量实践2025-09-29 1204
-
椭偏仪在半导体薄膜厚度测量中的应用:基于光谱干涉椭偏法研究2025-09-08 2367
-
薄膜厚度测量技术的综述:从光谱反射法(SR)到光谱椭偏仪(SE)2025-07-22 2953
-
芯片制造中薄膜厚度量测的重要性2025-02-26 3359
-
薄膜在线红外测厚仪:精确测量薄膜厚度的利器2024-04-17 2299
-
半导体晶圆形貌厚度测量设备2024-01-18 1405
-
请问一下在芯片制造中如何测薄膜的厚度呢?2023-08-17 1633
-
薄膜晶体管液晶显示器件的制造_测试与技术发展2021-04-15 1135
-
半导体单晶和薄膜制造技术2021-04-08 1838
-
MEMS制造中精确测量薄膜厚度的方法研究与比较_陈莉2017-03-19 959
-
测厚仪 ZM100测透明薄膜的厚度2015-04-08 3530
-
半导体薄膜厚度检测设备设备出售2015-04-02 4817
全部0条评论

快来发表一下你的评论吧 !

