

基于像散光学轮廓仪与单点膜厚技术测量透明薄膜厚度
描述
透明薄膜在生物医学、半导体及光学器件等领域中具有重要应用,其厚度与光学特性直接影响器件性能。传统接触式测量方法(如触针轮廓仪)易损伤样品,而非接触式光学方法中,像散光学轮廓仪(基于DVD激光头设计)虽具备高分辨率全场扫描能力,但对厚度小于25 μm的薄膜存在信号耦合问题。本研究通过结合FlexFilm单点膜厚仪的光学干涉技术,开发了一种覆盖15 nm至1.2 mm的全尺度薄膜表征系统,实现无损、高精度厚度测量与三维成像。
1
厚度计算方法
flexfilm
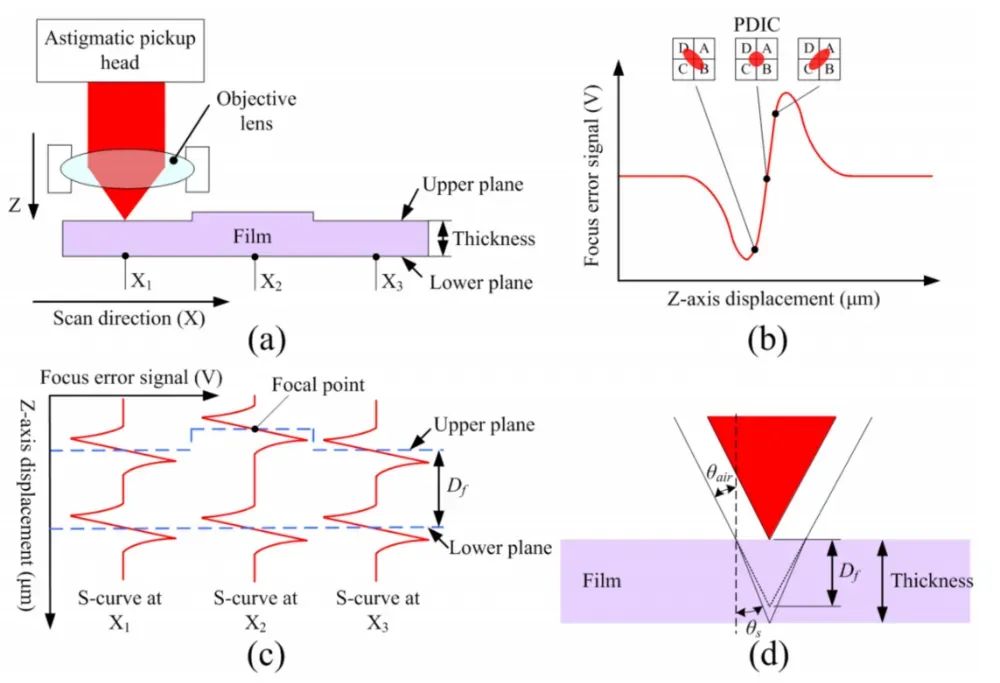
像散光学轮廓仪的厚度计算模型
激光通过像散拾音器聚焦于样品表面,反射光由四象限光电探测器(PDIC)接收,通过聚焦误差信号(FES)与 z 轴位移的非线性关系(S 曲线)定位上下表面焦点。厚度计算需考虑光的折射效应,公式为:

其中,θair = 36.87°为入射角(由物镜数值孔径 NA=0.6 计算得出),ns为样品折射率。
2
S曲线解耦算法
flexfilm

存在耦合问题的FES-z轴位移曲线;(b) 由两条S曲线合成的叠加曲线;(c) 平方误差和与位移偏移量Dₛ的关系
对于厚度 < 25 μm 的薄膜,上下表面反射光的 S 曲线会发生耦合,无法直接分离。本研究提出解耦方法:通过 Matlab 将原始 FES 数据拟合为 8 个正弦函数叠加的曲线Cf(i),并利用同材料厚膜的纯净 S 曲线合成叠加信号Cs(i)。通过计算不同位移偏移量Ds下的均方误差(SSE),最小值对应的Ds即为真实厚度。对于解耦难度极高的薄膜,可引入单点膜厚仪的光谱数据优化拟合模型,例如通过其测量的折射率ns修正 S 曲线形状,提升解耦精度。硬件系统设计:系统采用共振扫描器(频率1.6 kHz,行程87 μm)提升成像速度,结合XYZ压电平台(行程100 μm)实现三维扫描。FPGA控制器与定制放大器确保信号实时处理。
3
单点厚度测量
flexfilm
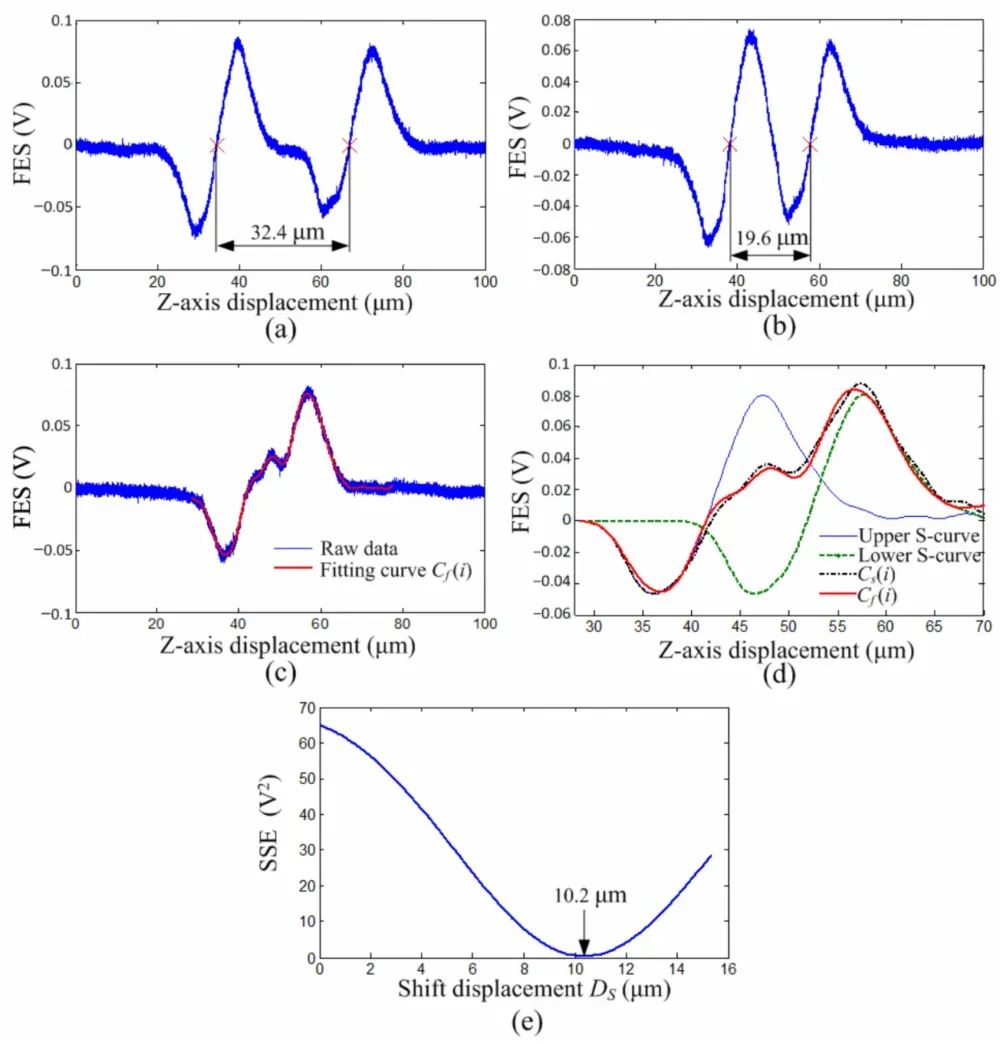
OPP薄膜(厚度55 μm、33 μm、18 μm)的FES-z轴位移曲线
- 像散光学轮廓仪结果:
对 55 μm 和 33 μm 的聚丙烯薄膜(OPP),直接通过 S 曲线线性拟合计算厚度分别为 55.2 μm 和 33.4 μm,与共聚焦显微镜结果(53.2 μm 和 32.7 μm)吻合。对 18 μm OPP 薄膜,通过解耦算法得到厚度 17.4 μm,SSE 最小值对应Ds=10.2 μm。
- 单点膜厚仪交叉验证:
利用 单点膜厚仪对 18 μm OPP 薄膜进行反射光谱测量,通过 Tauc-Lorentz 模型反演厚度为 17.6±0.1 μm,与像散法结果误差 < 1.2%。同时,单点膜厚仪测得 OPP 薄膜折射率ns=1.49±0.01,为像散法的折射角计算θs=23.75°提供精确参数,进一步降低厚度计算误差。
4
3D 成像与光学特性分析
flexfilm
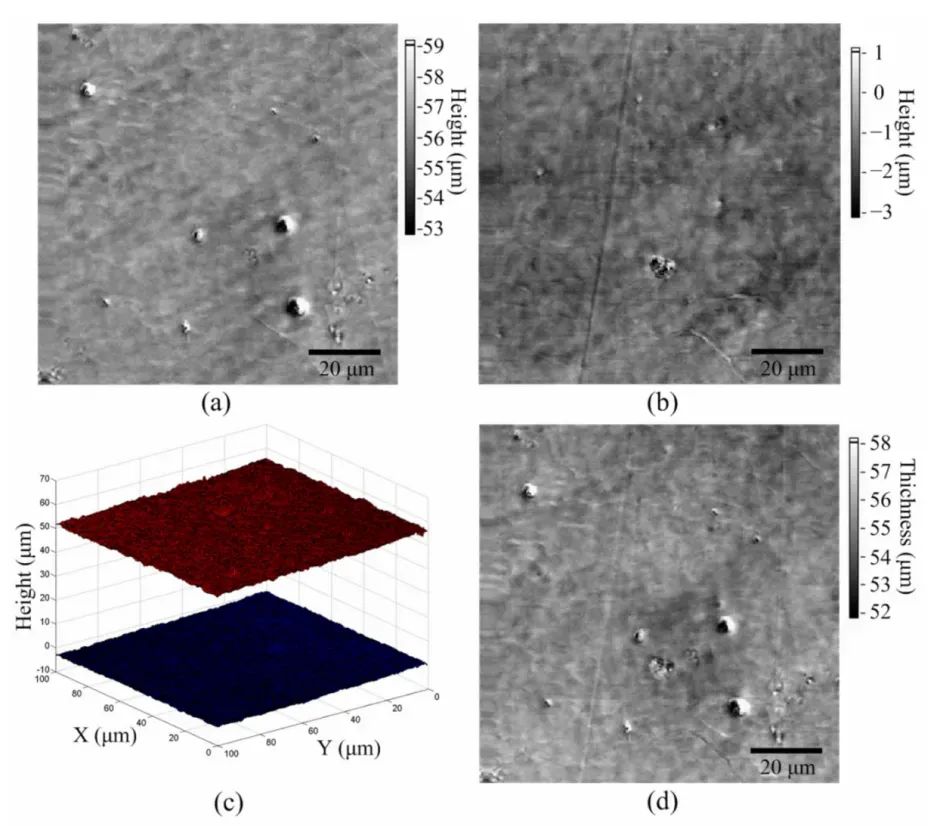
(a)上表面高度图像;(b)下表面高度图像;(c)上下表面三维图像;(d)厚度分布图像
像散光学轮廓仪对 55 μm OPP 薄膜进行 100 μm×100 μm 区域扫描,获取上下表面 3D 图像,显示表面颗粒与划痕缺陷,厚度均匀性为 55.2±0.6 μm。结合单点膜厚仪对缺陷区域的光谱分析,可同步获取局部光学常数变化(如缺陷处折射率波动 < 0.03),揭示形貌与光学性能的关联性。本研究开发的像散光学轮廓仪实现了 18–100 μm 透明薄膜的厚度测绘与 3D 成像,结合单点膜厚仪的光学干涉技术,进一步覆盖了 15 nm–70 μm 的薄薄膜测量,形成全尺度表征能力。其中,像散法适用于微米级厚膜的全场扫描,单点膜厚仪则通过光谱分析为薄薄膜测量提供精准验证与光学常数支持。
FlexFilm单点膜厚仪
flexfilm

FlexFilm单点膜厚仪 是一款专为纳米级薄膜测量设计的国产高精度设备,采用光学干涉技术实现无损检测,测量精度达±0.1nm,1秒内即可完成测试,显著提升产线效率。
- 高精度测量:光学干涉技术,精度±0.1nm,1秒完成测量,提升产线效率。
- 智能灵活适配:波长覆盖380-3000nm,内置多算法,一键切换材料模型。
- 稳定耐用:光强均匀稳定(CV<1%)年均维护成本降低60%。
- 便携易用:整机<3kg,软件一键操作,无需专业培训。
像散光学轮廓仪与FlexFilm单点膜厚仪的协同应用,为透明薄膜的非接触式测量提供了互补方案,其结合光学反射的全场扫描能力与光学干涉的精准定量特性,对半导体、光学器件及生物医学领域的薄膜研发与生产具有重要意义。
-
台阶仪精准测量薄膜工艺中的膜厚:制备薄膜理想台阶提高膜厚测量的准确性2025-09-05 934
-
芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量2025-07-21 1004
-
光学轮廓仪有着以下几大技术特点2025-05-21 1056
-
膜厚测试仪的测量范围 膜厚测试仪的操作注意事项2024-12-19 2405
-
微观特征轮廓尺寸测量:光学3D轮廓仪、共焦显微镜与台阶仪的应用2024-06-07 744
-
3d光学轮廓仪测微光学器件应用及其重要意义2024-01-02 983
-
台阶仪和轮廓仪区别2023-10-26 1141
-
台阶仪和轮廓仪区别是什么?2023-10-25 2049
-
光学3D表面轮廓仪可以测金属吗?2023-08-21 10176
-
CP系列台阶仪测量ITO导电薄膜厚度2023-06-27 1415
-
怎么用轮廓仪测量表面粗糙度?2022-07-19 6713
-
轮廓仪有几种,光学轮廓仪、接触式轮廓仪什么时候用2021-10-05 4799
-
中图仪器光学3D表面轮廓仪在光学行业中的应用2018-03-15 2437
全部0条评论

快来发表一下你的评论吧 !

